共用設備検索結果
ICP高密度プラズマエッチング装置(フッ素) (ICP-RIE Etching Systems(F))
- 設備ID
- HK-620
- 設置機関
- 北海道大学
- 設備画像
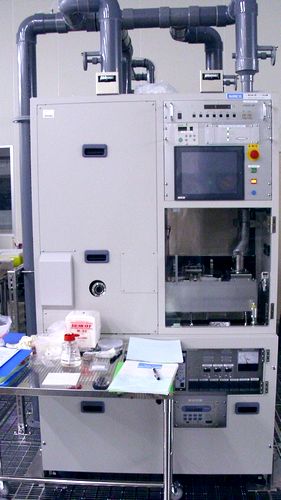
- メーカー名
- サムコ (samco)
- 型番
- RIE-101iPH
- 仕様・特徴
- 使用ガス:SF6、C4F8、CF4、Ar、O2、CHF3、C3F8
試料サイズ:最大4インチ
反応性イオンエッチング装置 (Reactive ion Etching Systems)
- 設備ID
- HK-621
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- サムコ (samco)
- 型番
- RIE-10NRV
- 仕様・特徴
- 使用ガス:CF4、Ar、O2、CHF3
試料サイズ:最大8インチ
NLDドライエッチング装置 (NLD Dry Etching System)
- 設備ID
- HK-622
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- NLD-500
- 仕様・特徴
- 使用ガス:SF6、CF4、CHF3、Ar、O2、C3F8
試料サイズ:最大4インチ
イオンミリング装置 (Ion milling system)
- 設備ID
- HK-623
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- IBE-6000S
- 仕様・特徴
- 使用ガス:Ar
試料サイズ:最大3インチ
シリコン深掘りエッチング装置 (Si Deep RIE System)
- 設備ID
- HK-624
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- SPPテクノロジーズ (SPP Technologies)
- 型番
- APX-Pegasus-Polestar
- 仕様・特徴
- 使用ガス:SF6、C4F8、Ar、O2
試料サイズ:最大4インチ
高分解能電界放射型走査型電子顕微鏡 (Field emission electron microscope)
- 設備ID
- HK-625
- 設置機関
- 北海道大学
- 設備画像
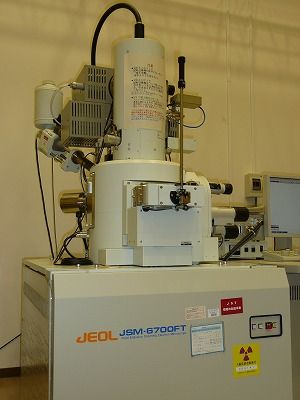
- メーカー名
- 日本電子 (JEOL)
- 型番
- JSM-6700FT
- 仕様・特徴
- 加速電圧:5-30kV
EDS機能
試料サイズ:小片~25mm角
光学干渉式膜厚計 ( Film thickness measurement instruments)
- 設備ID
- HK-626
- 設置機関
- 北海道大学
- 設備画像
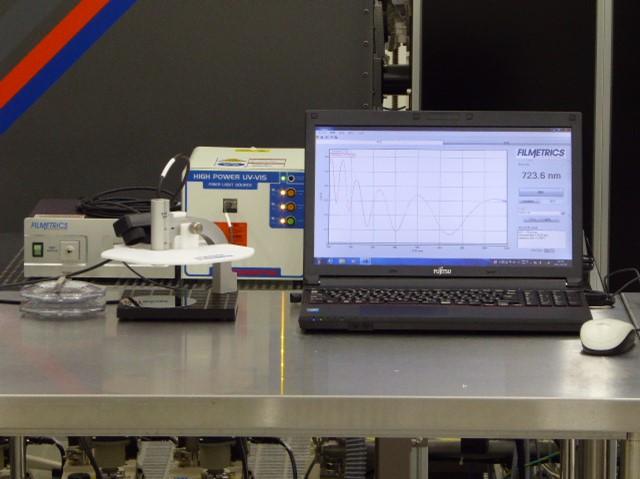
- メーカー名
- フィルメトリクス (Filmetrics)
- 型番
- F20-UV
- 仕様・特徴
- 膜厚測定範囲:1nm - 40µm
測定波長域:190-1100nm
真空紫外露光装置 (Vacuum ultraviolet light exposure system)
- 設備ID
- HK-627
- 設置機関
- 北海道大学
- 設備画像
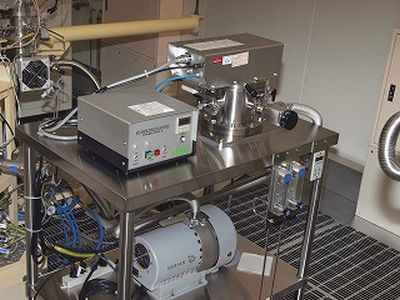
- メーカー名
- エヌ工房 (N ceator)
- 型番
- PC-01-H
- 仕様・特徴
- 試料サイズ:最大1インチ
電子ビーム描画装置(30kV) (Electron-beam lithography system(30kV))
- 設備ID
- HK-701
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-3700
- 仕様・特徴
- 電子銃エミッター:LaB6
加速電圧:1~30kV
最小線幅:100nm
試料サイズ:最大4インチ
円弧スキャン可
両面マスクアライナ (Double-side alignment Mask aligner)
- 設備ID
- HK-702
- 設置機関
- 北海道大学
- 設備画像
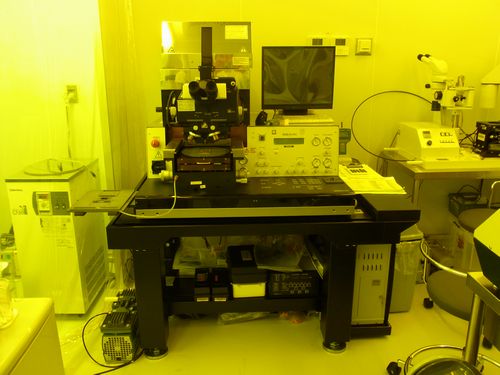
- メーカー名
- ズースマイクロテック (SUSS)
- 型番
- MA-6
- 仕様・特徴
- 両面、露光精度0.6ミクロン
試料サイズ:最大6インチ
基板サイズ:不定形小片~150mm角