共用設備検索結果
顕微紫外可視近赤外分光装置 (UV/Vis/NIR Microscopic Spectrophotometer)
- 設備ID
- HK-409
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- 日本分光 (JASCO)
- 型番
- MSV-5200
- 仕様・特徴
- 反射、透過測定
光電子増倍管、冷却型PbS光導電素子
測定波長域:200nm-2700nm
カセグレン対物32倍
自動XYZステージ
超高精度電子ビーム描画装置(100kV) (Ultra-high precision electron-beam lithography system(100kV))
- 設備ID
- HK-601
- 設置機関
- 北海道大学
- 設備画像
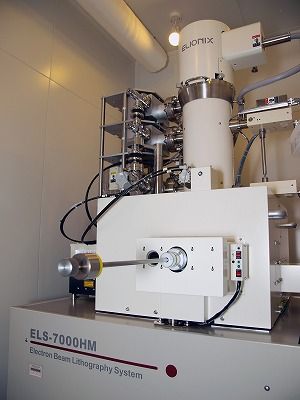
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-7000HM
- 仕様・特徴
- 加速電圧:100kV
試料サイズ:最大6インチ
超高精度電子ビーム描画装置(125kV) (Ultra-high precision electron-beam lithography system(125kV))
- 設備ID
- HK-602
- 設置機関
- 北海道大学
- 設備画像
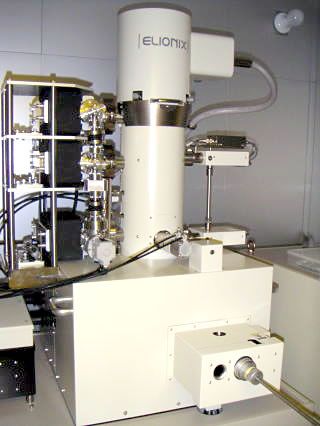
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F125
- 仕様・特徴
- 加速電圧:125kV
試料サイズ:最大6インチ
超高速スキャン電子線描画装置(130kV) (High-speed scanning electron-beam lithography system(130kV))
- 設備ID
- HK-603
- 設置機関
- 北海道大学
- 設備画像
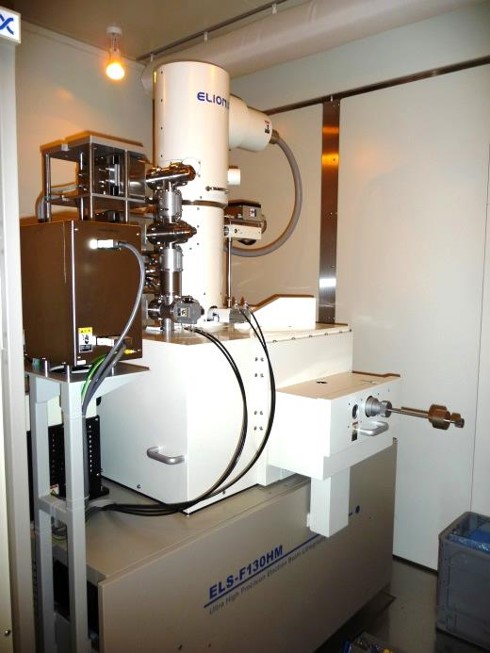
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F130HM
- 仕様・特徴
- 加速電圧:130kV
試料サイズ:最大8インチ
レーザー描画装置 (Laser lithography system)
- 設備ID
- HK-604
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+
- 仕様・特徴
- 光源:405nm半導体レーザー
描画エリア:最大8インチ角
最小描画線幅:0.3ミクロン(HiRes)、0.8ミクロン(WMII)
255階調グレースケールモード搭載
バックアライメント機能
レーザー直接描画装置 (Laser direct lithography system)
- 設備ID
- HK-605
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ネオアーク (NEOARK)
- 型番
- DDB-201
- 仕様・特徴
- 光源:375nm半導体レーザー
描画エリア:最大50mm
試料サイズ:最大6インチ
マスクアライナ (Mask aligner)
- 設備ID
- HK-606
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ミカサ (MIKASA)
- 型番
- MA-20
- 仕様・特徴
- コンタクト露光
試料サイズ:最大4インチ
マスクサイズ:最大5インチ
EB蒸着装置 (EB vacuume evaporation system)
- 設備ID
- HK-607
- 設置機関
- 北海道大学
- 設備画像
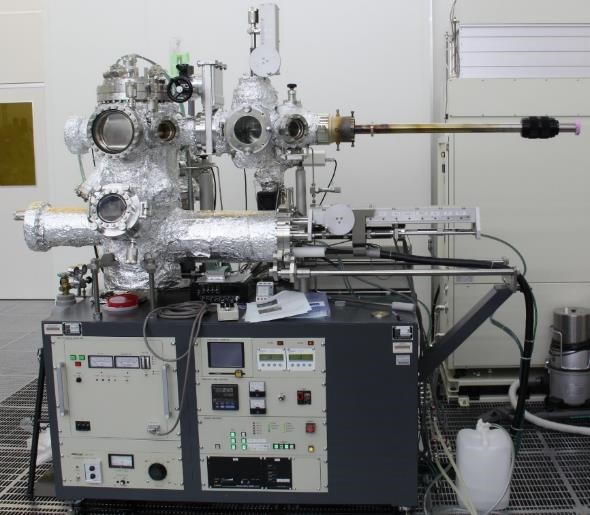
- メーカー名
- エイコー (Eiko)
- 型番
- EB-580S
- 仕様・特徴
- 蒸着源:Au,Ti,Al,Cu,Nb
基板加熱可(600℃程度まで)
水晶振動式膜厚計
真空蒸着装置 (Vacuume evaporation system)
- 設備ID
- HK-608
- 設置機関
- 北海道大学
- 設備画像
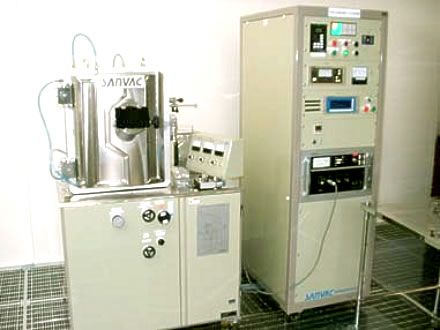
- メーカー名
- サンバック (SANVAC)
- 型番
- ED-1500R
- 仕様・特徴
- 蒸着源:抵抗加熱3元、EB3元
基板加熱可
水晶振動式膜厚計
ヘリコンスパッタリング装置 (Helicon sputtering system)
- 設備ID
- HK-609
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- MPS-4000C1/HC1
- 仕様・特徴
- カソード:3元(マグネトロン4インチ、ヘリコンDC2インチ、ヘリコンRF2インチ)
成膜材料:Au,Cr,Ti
試料サイズ:最大4インチ