共用設備検索結果
マスクアライナ (Mask aligner)
- 設備ID
- NU-251
- 設置機関
- 名古屋大学
- 設備画像
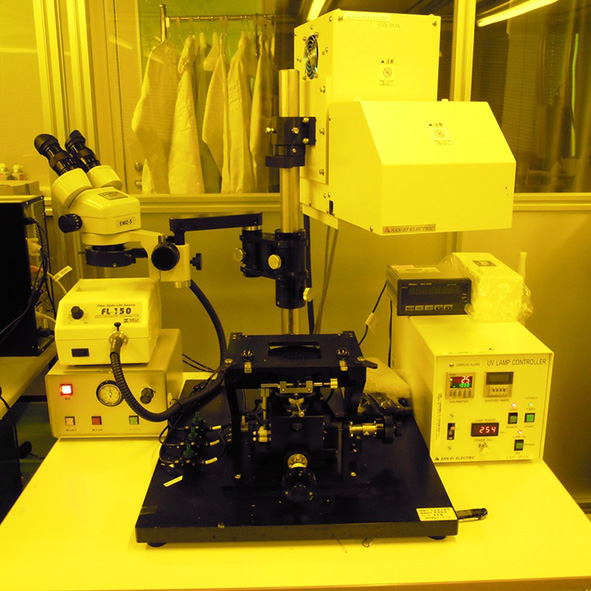
- メーカー名
- ナノテック (Nanometric Technology)
- 型番
- LA410
- 仕様・特徴
- ・適応マスク:最大 5 inch
・適応資料:最大Φ4 inch
・有効露光範囲:Φ80 mm以上
共焦点レーザ顕微鏡 (Confocal laser microscope)
- 設備ID
- NU-252
- 設置機関
- 名古屋大学
- 設備画像
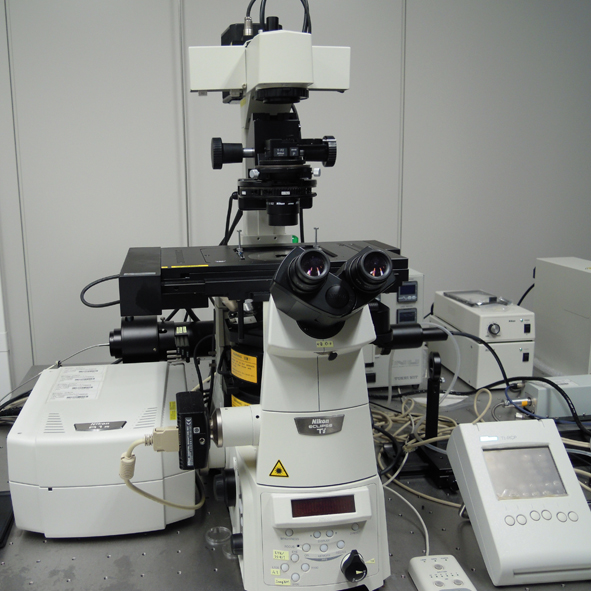
- メーカー名
- ニコン (Nikon)
- 型番
- A1Rsi-N
- 仕様・特徴
- ・蛍光励起レーザ:405 nm,488 nm,561 nm,635 nm
・対物レンズ:100倍,10倍,20倍
SEM用断面試料作製装置 (Cross section polisher)
- 設備ID
- NU-253
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- JEOL (JEOL)
- 型番
- SM-09010
- 仕様・特徴
- ・イオン加速電圧:2~6 kV
・イオンビーム径:500 μm(半値幅)
・最大搭載試料サイズ:幅11 mm × 長さ10 mm × 厚さ2 mm
・試料移動範囲:X軸:±3 mm,Y軸:±3 mm
デジタルマイクロスコープ (Digital microscope)
- 設備ID
- NU-254
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- KEYENCE (KEYENCE)
- 型番
- VK-9700
- 仕様・特徴
- ・分解能:高さ方向 0.01 μm
・水平方向 0.13 μm
・最大観察倍率:3,000倍
・測定用光源:波長 408 nm
デジタルマイクロスコープ (Digital microscope)
- 設備ID
- NU-255
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- KEYENCE (KEYENCE)
- 型番
- VK-9510
- 仕様・特徴
- ・分解能:高さ方向 0.01 μm
・水平方向 0.14 μm
・最大観察倍率:3,000倍
・測定用光源:波長 408 nm
Deep Si Etcher (Deep Si Etcher)
- 設備ID
- NU-256
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- Multiplex-ASE
- 仕様・特徴
- ・ウェーハサイズ:6 inch
・ボッシュプロセス対応
両面露光用マスクアライナ (Mask aligner)
- 設備ID
- NU-257
- 設置機関
- 名古屋大学
- 設備画像
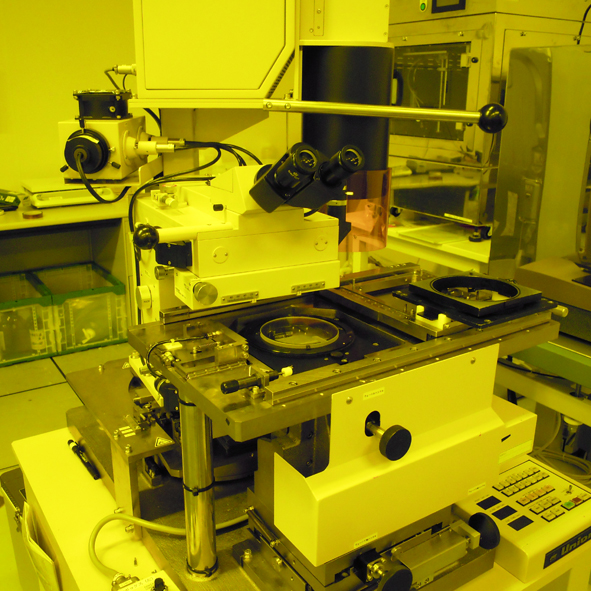
- メーカー名
- ユニオン光学 (Union)
- 型番
- PEM800
- 仕様・特徴
- ・両面露光が可能
・対応基板サイズ:最大4インチ
・最小パターン:3.0μm
フーリエ変換赤外分光分析 (Fourier transform infrared spectroscopy)
- 設備ID
- NU-258
- 設置機関
- 名古屋大学
- 設備画像
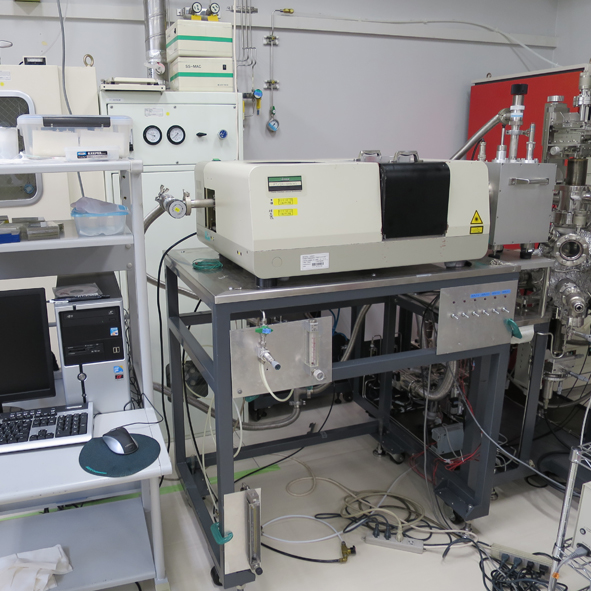
- メーカー名
- 日本分光 (JASCO)
- 型番
- FT/IR-615V
- 仕様・特徴
- ・測定波数範囲: 7800~350cm-1
・透過および全反射測定対応
・干渉計、試料室、検出器部真空引き可能
磁気特性評価システム群 (Magnetic properties measurement system)
- 設備ID
- NU-259
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- Lakeshore 玉川製作所 東英工業 (Lakeshore TAMAKAWA TOEI)
- 型番
- MicroMag 2900 TM-VSM271483-HGC TRT-2
- 仕様・特徴
- ・交番磁界勾配型磁力計:感度10-8emu,20kOe
・振動試料型磁力計:感度10-7emu,29kOe
・トルク磁力計:2×10-3erg,15kOe
・磁気光学スペクトロメータ:2×10-3deg,16kOe