共用設備検索結果
小型微細形状測定機 (Surface profiler)
- 設備ID
- NU-220
- 設置機関
- 名古屋大学
- 設備画像
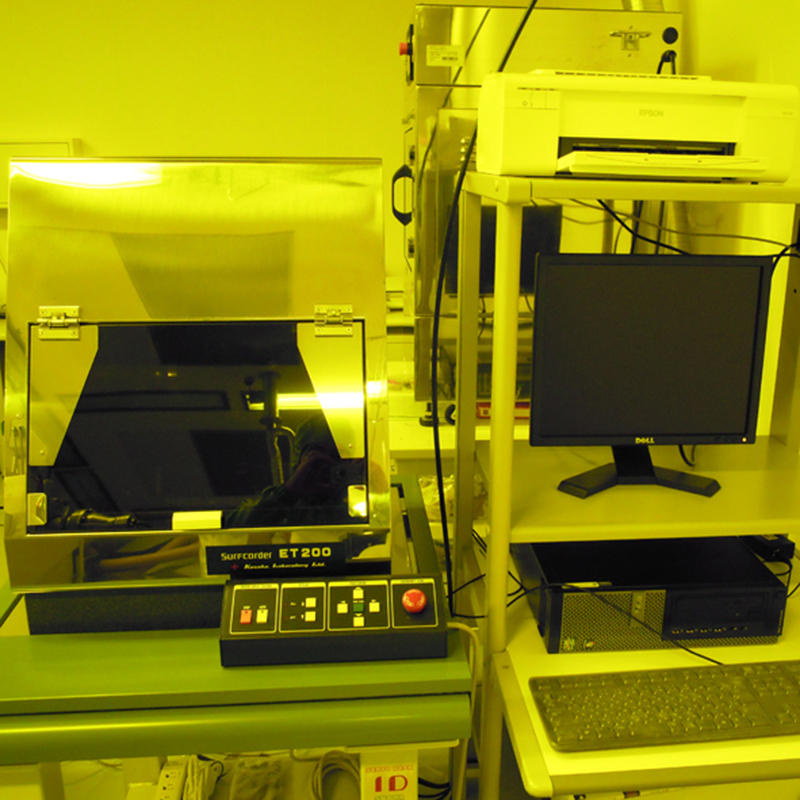
- メーカー名
- 小坂研究所 (Kosaka Laboratory)
- 型番
- ET200
- 仕様・特徴
- ・最大サンプルサイズ:φ160×厚さ48mm
・再現性 :1σ 1nm以内
・測定範囲 :Z:600 µm,X:100mm
・分解能 :Z:0.1 nm,X:0.1 µm
・測定力:10 µN〜500 µN
プラズマCVD装置 (Plasma CVD)
- 設備ID
- NU-221
- 設置機関
- 名古屋大学
- 設備画像
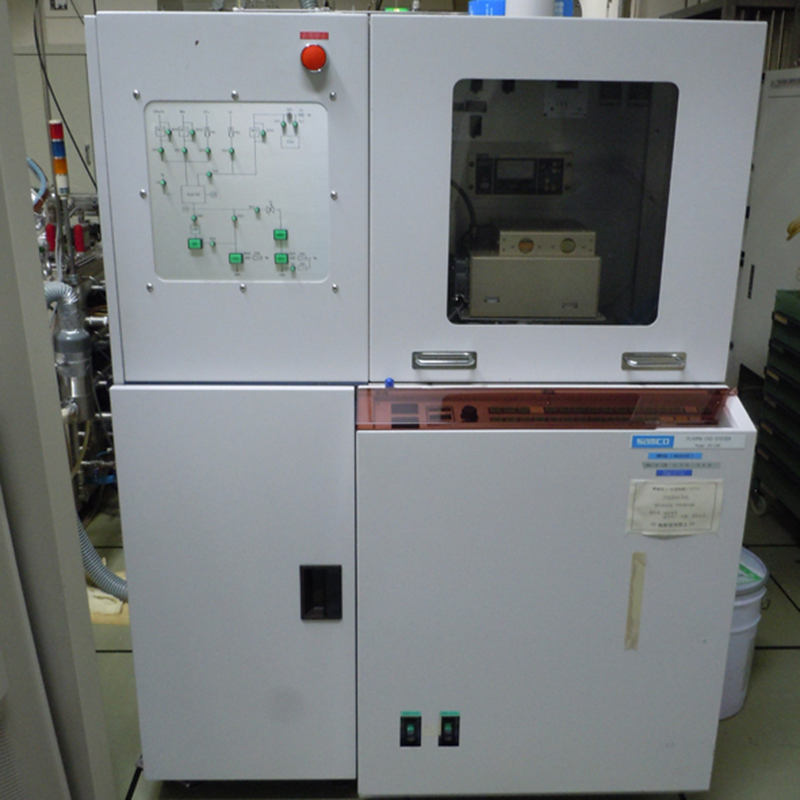
- メーカー名
- サムコ (Samco)
- 型番
- PD-240
- 仕様・特徴
- ・基板加熱:抵抗加熱式 (~400℃)
・適正ウェハ寸法:不定形~3インチ径
・供給ガス:TEOS, O2
レーザー描画装置 (Laser lithography)
- 設備ID
- NU-222
- 設置機関
- 名古屋大学
- 設備画像
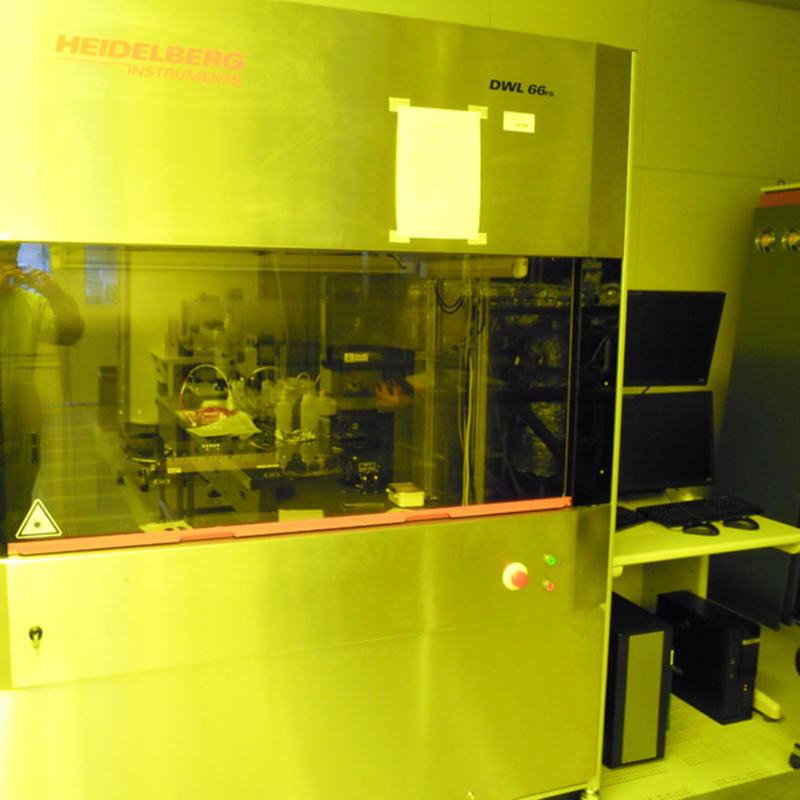
- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- DWL66FS
- 仕様・特徴
- ・最小描画サイズ:0.6 µm
・最大描画サイズ:200mm x 200mm
・直描およびガラスマスク作製
フォトリソグラフィ装置群 (photo lighography system)
- 設備ID
- NU-223
- 設置機関
- 名古屋大学
- 設備画像
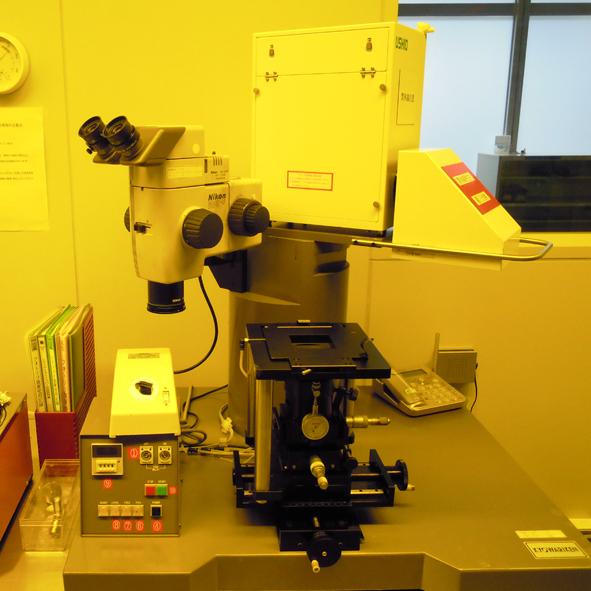
- メーカー名
- 共和理研 (Kyowariken)
- 型番
- K310P100S
- 仕様・特徴
- ・最大2インチ基板
・マスクサイズ:3インチ
・最小パタンサイズ 2µm
・スピンコータ,ベーク炉,ドラフトチャンバー利用可
電子ビーム蒸着装置 (Electron beam evaporation)
- 設備ID
- NU-224
- 設置機関
- 名古屋大学
- 設備画像
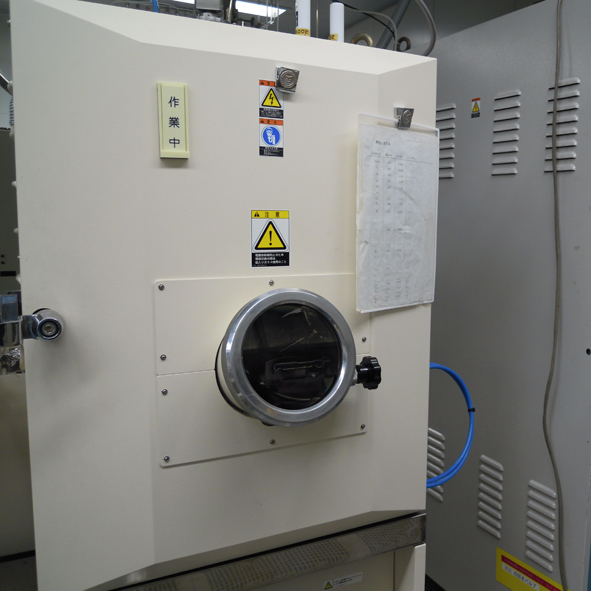
- メーカー名
- アルバック (ULVAC)
- 型番
- EBX-10D
- 仕様・特徴
- ・最大投入電力:5kW
・るつぼ数4
・ハースライナー使用
ICPエッチング装置 (ICP etching)
- 設備ID
- NU-225
- 設置機関
- 名古屋大学
- 設備画像
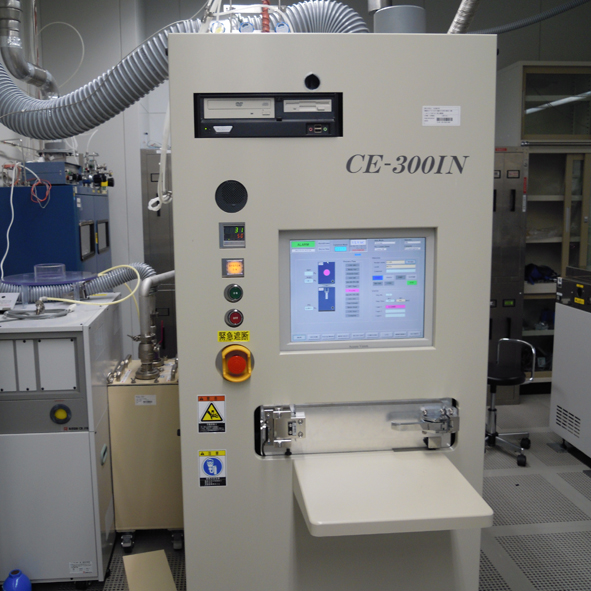
- メーカー名
- アルバック (ULVAC)
- 型番
- CE-300I
- 仕様・特徴
- ・化合物エッチング
・対応基板サイズ:最大6インチ基板
・プロセスガス:Cl2
RIEエッチング装置 (RIE etching)
- 設備ID
- NU-226
- 設置機関
- 名古屋大学
- 設備画像
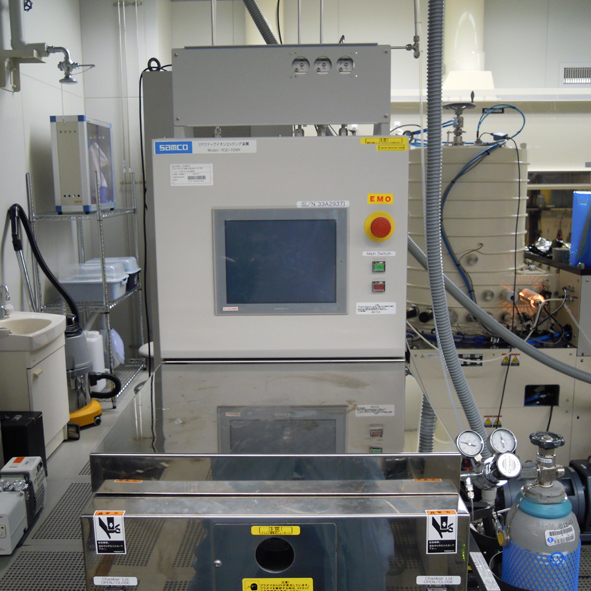
- メーカー名
- サムコ (Samco)
- 型番
- RIE-10NR
- 仕様・特徴
- ・シリコン系エッチング
・対応基板サイズ:最大8インチ
・プロセスガス:CF4,Ar,SF6,O2
走査型電子顕微鏡 (Scanning electron microscope)
- 設備ID
- NU-227
- 設置機関
- 名古屋大学
- 設備画像
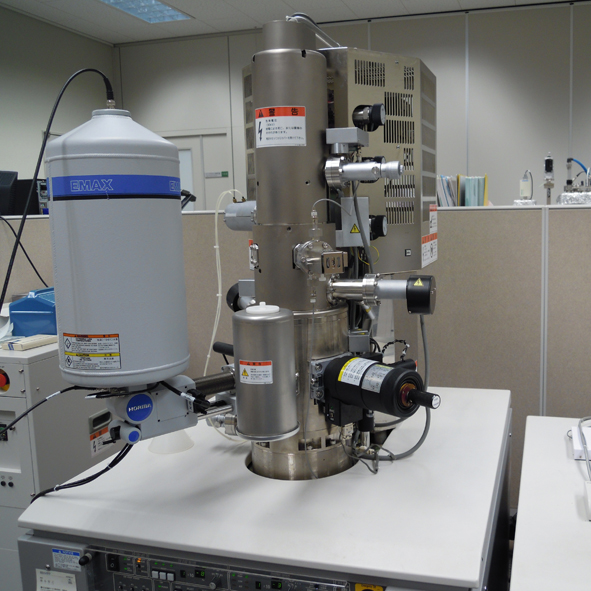
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S5200
- 仕様・特徴
- ・加速電圧:0.5kV~30kV
・分解能:0.5nm(30kV)
・倍率:~2,000,000
・最大試料サイズ:5mm x 9.5mm
走査型電子顕微鏡 (Scanning electron microscope)
- 設備ID
- NU-228
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S4300
- 仕様・特徴
- ・加速電圧:0.5kV~15kV
・分解能:15nm(30kV)
・倍率:~500,000
・最大試料サイズ:直径100 mm
スパッタ絶縁膜作製装置 (Insulator sputtering system)
- 設備ID
- NU-229
- 設置機関
- 名古屋大学
- 設備画像
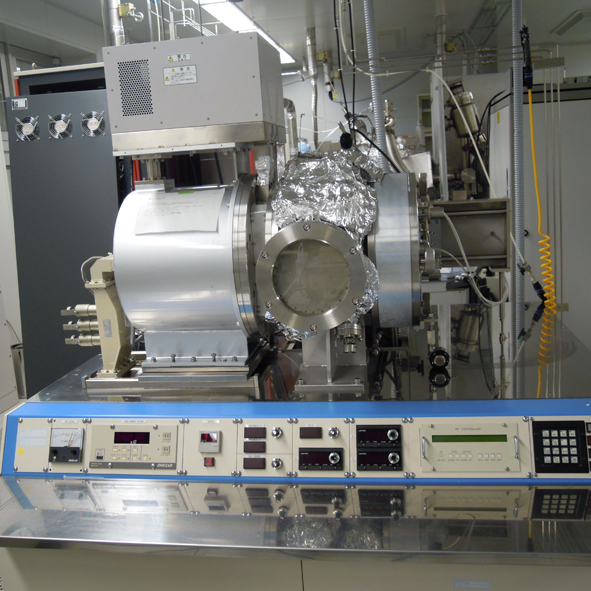
- メーカー名
- MESアフティ (MES Afty)
- 型番
- AFTEX-3420
- 仕様・特徴
- ・対応基板サイズ:最大3インチ
・酸化膜,窒化膜用