共用設備検索結果
環境制御マニュアルプローバステーション (Environmental control manual prober station)
- 設備ID
- UT-305
- 設置機関
- 東京大学
- 設備画像
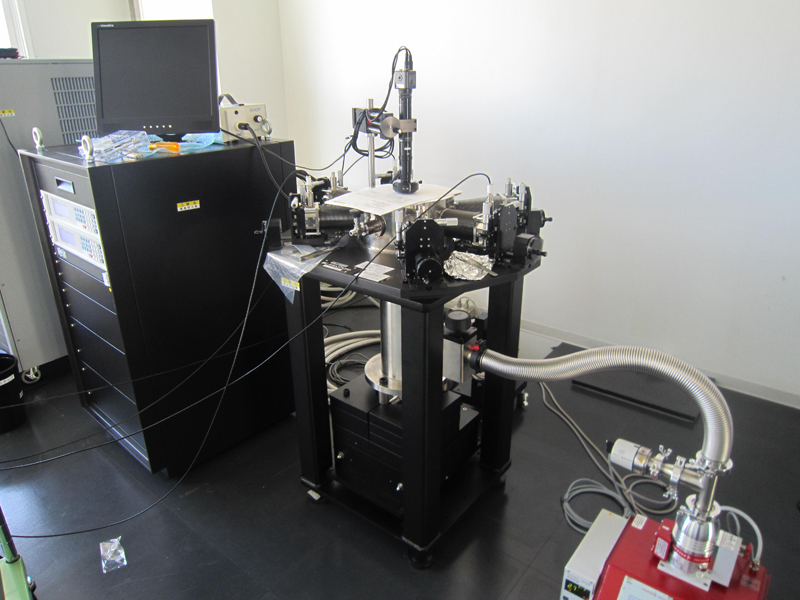
- メーカー名
- (東陽テクニカ等) (Toyo Corporation)
- 型番
- ①半導体特性評価システム4200-SCS ②強誘電体特性評価システムFCE1EEA-200型 ③誘電体インピーダンス測定システム1260 ④極低温プローバー装置CPX-VF
- 仕様・特徴
- □ 主な仕様
・低温プローバ(CRX-4K):6K~350K
・高温プローバ(HCP-401/400):室温~400度
・半導体パラメータ測定(4200-SCS型)
・誘電体測定(FCE1EEA-200型)
・インピーダンス測定(ソーラートロン1260)
□主な用途
・ 強誘電体分極評価測定
・インピーダンス周波数測定
・キャパシタ周波数測定など
超微量元素計測システム(SIMS) (SIMS)
- 設備ID
- UT-306
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- カメカ (Cameca)
- 型番
- NanoSIMS 50L
- 仕様・特徴
- □主な用途
微小領域の分析、高空間分解能でのイメージング分析に優れた二次イオン質量分析装置。
□主な用途
・ 一次イオン源:セシウムおよび酸素
・最小ビーム径:50nm (セシウム)
・質量分析計:高性能二重収束型質量分析計
・高感度、高質量分解能での元素・同位体測定が可能。
・最大7種類の二次イオン像の同時検出ができる
原子直視型超高圧電子顕微鏡 (Ultra-high voltage electron microscope)
- 設備ID
- UT-401
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-ARM1250
- 仕様・特徴
- □主な仕様
(1)本体
加速電圧 : 400、600、800、1,000、1,250kV
電子線源 : 単結晶LaB6
焦点距離 : 8.2mm
球面収差係数 : 1.4mm
色収差係数 : 2.5mm
分解能 : 0.1nm(粒子像)
試料最大傾斜角 : ±35°
真空度 : 7×10-6Pa以下(試料室)
排気方式 : ターボ分子、イオン、クライオポンプ併 用(完全ドライ方式)
(2)電子線損傷低減装置(MDS) 組込
(3)画像記録 シートフィルムおよびイメージングプレート(25μm/ピクセル)
(4)収束電子線回折装置 組込
収束角(2α)/最小スポット径 :
4.0mrad./15nm~2.0mrad./30nm
最大加速電圧 : 1,250kV
最大試料傾斜角 : ±25°
ウルトラミクロトーム (Ultramicrotome)
- 設備ID
- UT-403
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ライカバイオシステムズ㈱ (Leica Microsystems K.K.)
- 型番
- EM UC7
- 仕様・特徴
- □特 徴
・静電気式ピックアップ法
・視認性の高LED照明システム
・ユーセントリック動作を搭載した実体顕微鏡
高速大面積電子線描画装置 (Ultrarapid Electron Beam Direct Writing and Photo Mask Fabrication Machine)
- 設備ID
- UT-500
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アドバンテスト (ADVANTEST)
- 型番
- F5112+VD01
- 仕様・特徴
- ・長方形・矩形の大きさを任意に変更してショットする(可変整形)ことのできる高速電子線描画装置。
・カケラ基板から8インチ丸基板までの任意形状に対応
・加速電圧50kV
卓上アッシング装置 (Compact Ashing Machine)
- 設備ID
- UT-501
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- サムコ (SAMCO)
- 型番
- FA-1
- 仕様・特徴
- SAMCO FA-1 コンパクトなドライエッチャー。東大微細加工拠点では酸素アッシング専用装置として使っています。
主用途はフォトマスクのウェットエッチング直前の処理(デスカム)で、プラズマの作用によりエッチング面が濡れ性となり、フォトマスクの仕上がり寸法とエッジのシャープさが向上します。
光リソグラフィ装置PEM800 (Photomask aligner PEM-800)
- 設備ID
- UT-502
- 設置機関
- 東京大学
- 設備画像
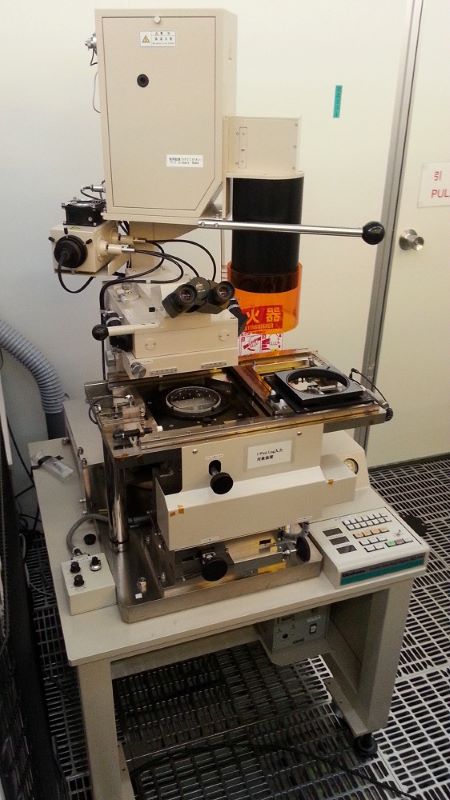
- メーカー名
- ユニオン (UNION)
- 型番
- PEM800
- 仕様・特徴
- 光によるリソグラフィを行う装置。
いわゆる両面4”マスクアライナーと呼ばれる装置。
マスクは5009、4009、2509サイズを取り付け可能。
超高速大面積電子線描画装置 (Ultrarapid Electron Beam Direct Writing and Photo Mask Fabrication Machine)
- 設備ID
- UT-503
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アドバンテスト (ADVANTEST)
- 型番
- F7000S-VD02
- 仕様・特徴
- カケラから8インチ丸基板までの任意形状に対応。R2年度補正予算改造により、更に高速性がアップしました。
(厚みに制限あり。ご相談ください)
可変整形ビーム(VSBモード)による、高速描画が可能
内蔵ステンシル(CPモード)による、階段近似の無い滑らかな曲線等の高速描画が可能。
データはGDS-IIストリームフォーマットから変換
光リソグラフィ装置MA-6 (MA6 Suss 6” Mask Aligner)
- 設備ID
- UT-504
- 設置機関
- 東京大学
- 設備画像
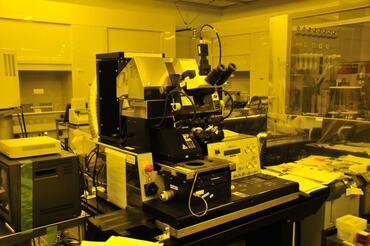
- メーカー名
- ズースマイクロテック (SUSS MicroTec)
- 型番
- MA6
- 仕様・特徴
- 精密な位置合わせ(表裏1ミクロン精度)が可能で、欠片から6インチまでの露光が可能なマスクアライナー。普段は混合で利用していますが必要であればi線フィルターをかけることができます。
レーザー直接描画装置 DWL66+2018 (Laser Drawing System DWL66+2018)
- 設備ID
- UT-505
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+ (2018,405nm)
- 仕様・特徴
- 波長406nm 小片アライメントオプション、両面アライメント機能付き。1024階調の「グレイスケールリソグラフィー」により,フォトレジストの立体形状段差をある程度自由に作れる。また、GenISys社の変換ソフトウェア「BEAMER」を使うと、形状を得るために、近接効果の影響を計算して露光補正が可能。