共用設備検索結果
インピーダンスアナライザ (Impedance Analyzer)
- 設備ID
- RO-514
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アジレント (Agilent)
- 型番
- 4294他
- 仕様・特徴
- 周波数 40Hz~110MHz 16048H
ホール効果測定装置 (Hall effect measuring device)
- 設備ID
- RO-515
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- ACCENT (ACCENT)
- 型番
- HL5500PC
- 仕様・特徴
- 試料の抵抗値、キャリア濃度及び移動度を測定可
試料サイズ:Φ25mm以内
電流設定範囲:0.1μA~19.9mA
磁石強度は0.32T
EBSD解析装置 (EBSD analyzer)
- 設備ID
- RO-522
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 日本電子 (JEOL Ltd.)
- 型番
- JSM-7100F
- 仕様・特徴
- 【技術代行専用】
EBSD測定により試料結晶面方位、結晶粒マッピング等の結晶構造解析を行う。
二次イオン質量分析装置 (SIMS)
- 設備ID
- RO-523
- 設置機関
- 広島大学
- 設備画像
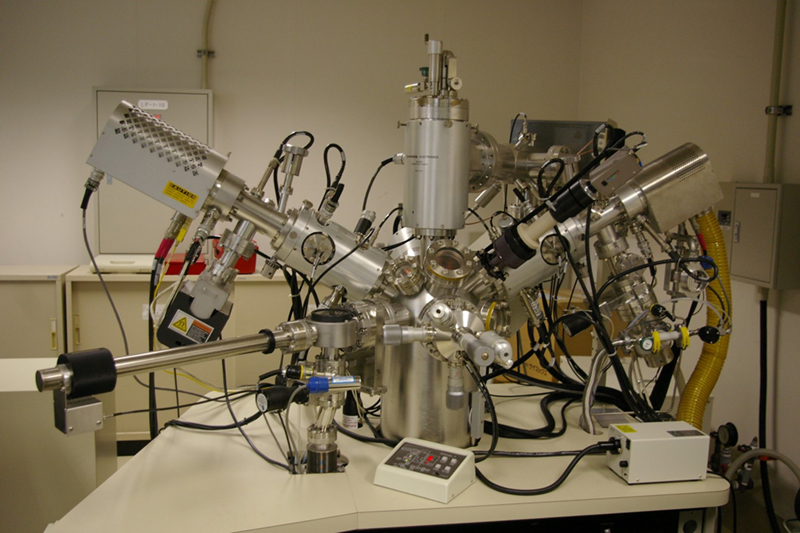
- メーカー名
- アルバックファイ (ULVAC-PHI, Inc.)
- 型番
- SIMS6650
- 仕様・特徴
- Cs,Oガン装備四重極型質量分析機、
一次イオン最小加速エネルギー1keV
蛍光X線分析装置(XRF) (XRF)
- 設備ID
- RO-524
- 設置機関
- 広島大学
- 設備画像
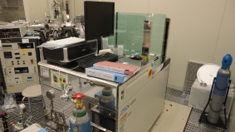
- メーカー名
- リガク ()
- 型番
- ZSX-400
- 仕様・特徴
- 対応wafer:12inch以下
波長分散型XRF 金属などの組成分析
X線光電子分光装置(XPS) (X-ray photoelectron spectroscopy)
- 設備ID
- RO-525
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- クレイトスアナリティカル ()
- 型番
- ESCA-3400
- 仕様・特徴
- 試料サイズ:5mm角程度
エミッション電流:20 mA、accel HT:10 kV、測定範囲:1150~-10 eV
X線源:Mg Kα, 電子結合エネルギー走査範囲:1150 ~ -10 eV
薄膜構造評価X線回析装置(XRD) (X-ray diffraction spectrometer)
- 設備ID
- RO-526
- 設置機関
- 広島大学
- 設備画像
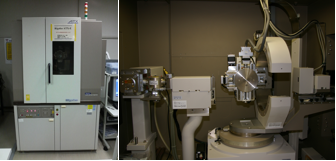
- メーカー名
- リガク ()
- 型番
- ATX-E
- 仕様・特徴
- 角度分解能 0.0002度(2θ)
分光エリプソメーター (Spectroscopic ellipsometer)
- 設備ID
- RO-531
- 設置機関
- 広島大学
- 設備画像
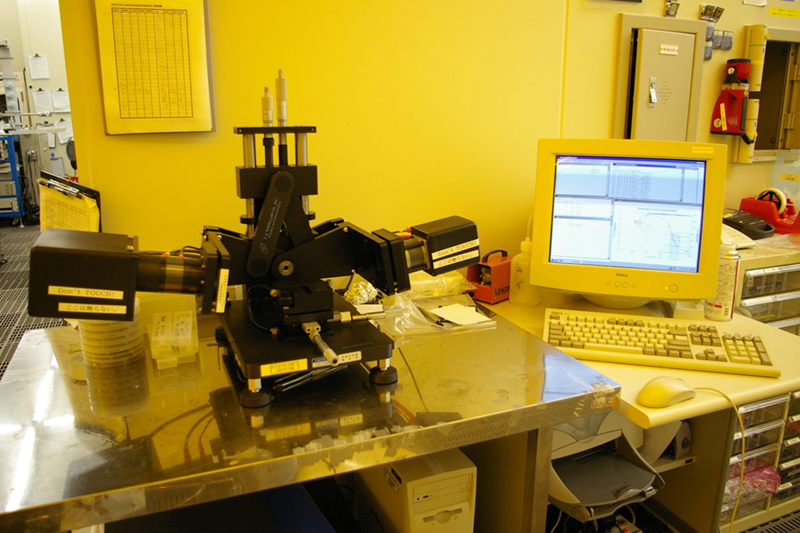
- メーカー名
- J.A. Woollam Japan (J.A. Woollam Japan)
- 型番
- M2000-D
- 仕様・特徴
- 測定可能最小膜厚10nm,分光波長範囲193~1000nm、
干渉式膜厚計 (Spectroscopic reflectometer)
- 設備ID
- RO-532
- 設置機関
- 広島大学
- 設備画像
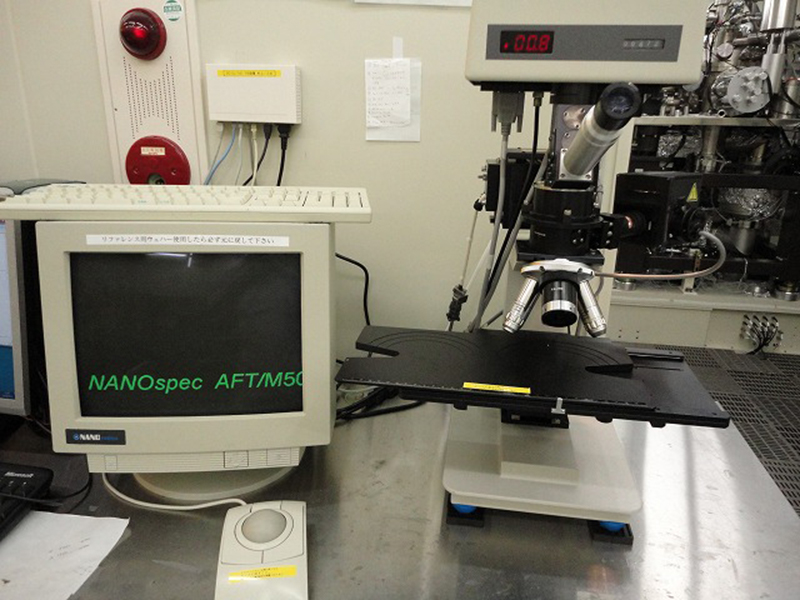
- メーカー名
- ナノメトリクスジャパン (Nanometrics Inc)
- 型番
- AFT 5000
- 仕様・特徴
- 可視光及び紫外光光源、多層膜対応解析ソフト搭載。
原子間力顕微鏡 (AFM)
- 設備ID
- RO-533
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- セイコーインスツルメンツ (Seiko Instruments Inc.)
- 型番
- SPI3800
- 仕様・特徴
- 分解能:z:0.01nm, X、Y:0.1nm,
視野:最小5nm角、最大 20μm角、