共用設備検索結果
プラズマCVD(PECVD)装置 (Plasma-enhanced CVD reactor)
- 設備ID
- RO-315
- 設置機関
- 広島大学
- 設備画像
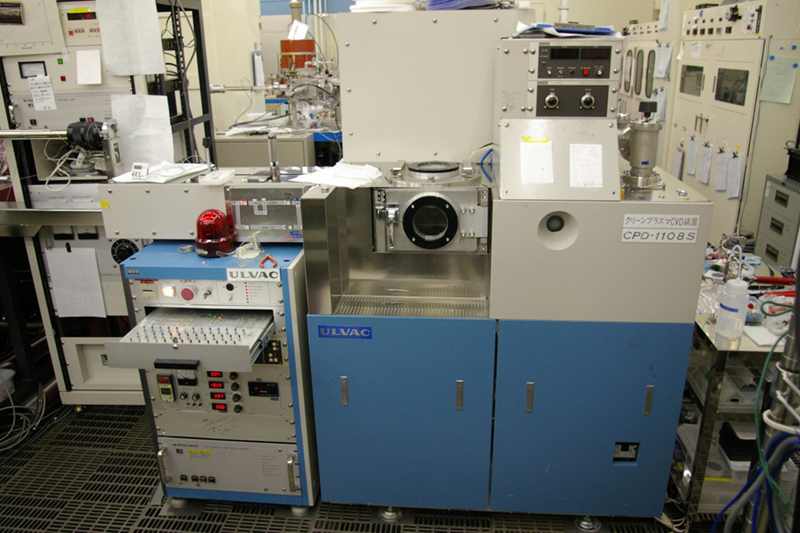
- メーカー名
- アルパック (ULVAC, Inc.)
- 型番
- CPD-1108S
- 仕様・特徴
- 対応wafer:2inch、cut wafer
SiO2,SiN薄膜の堆積
ICP - CVD装置 (ICP - CVD reactor)
- 設備ID
- RO-316
- 設置機関
- 広島大学
- 設備画像
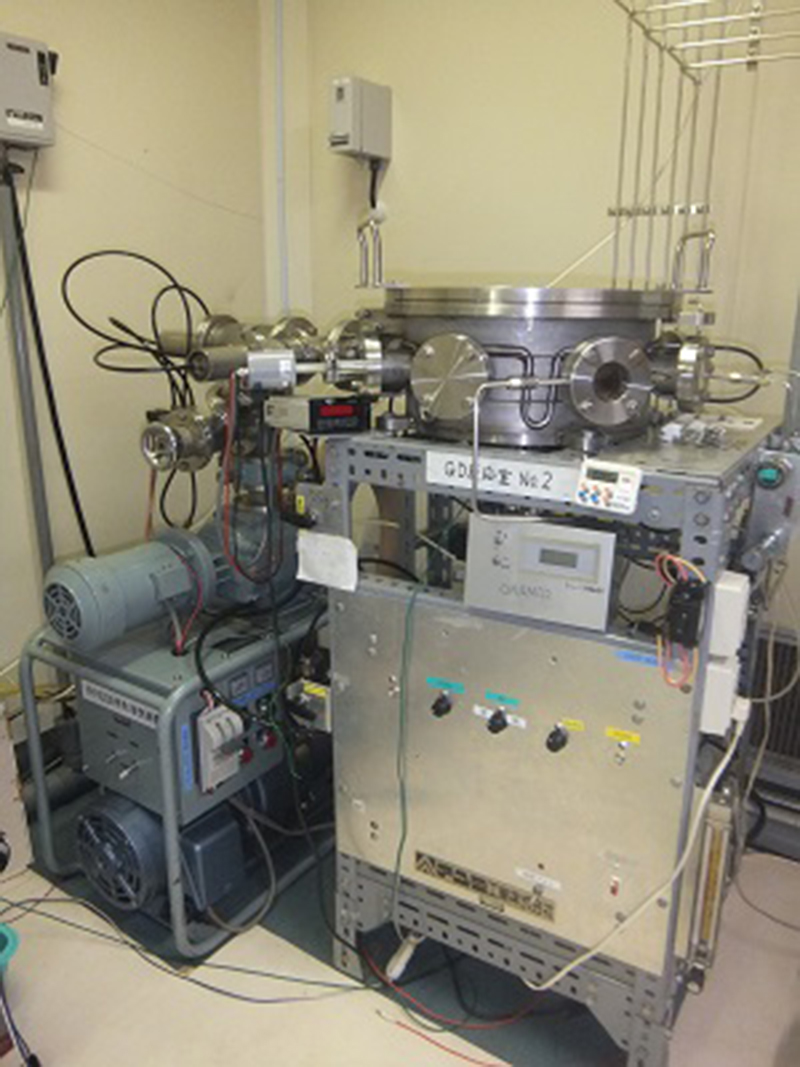
- メーカー名
- アユミ工業 (Ayumi INDUSTRY CO.,LTD.)
- 型番
- 仕様・特徴
- 対応wafer:4inch以下
【技術代行専用】
アモルファスシリコン膜、アモルファスゲルマニウム膜の成膜
CCP - CVD装置 (CCP - CVD reactor)
- 設備ID
- RO-317
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アユミ工業 (Ayumi INDUSTRY CO.,LTD.)
- 型番
- 仕様・特徴
- 対応wafer:4inch以下
【技術代行専用】
n型アモルファスシリコン膜の成膜
リモートPECVD装置 (Remote Plasma-enhanced CVD reactor)
- 設備ID
- RO-318
- 設置機関
- 広島大学
- 設備画像
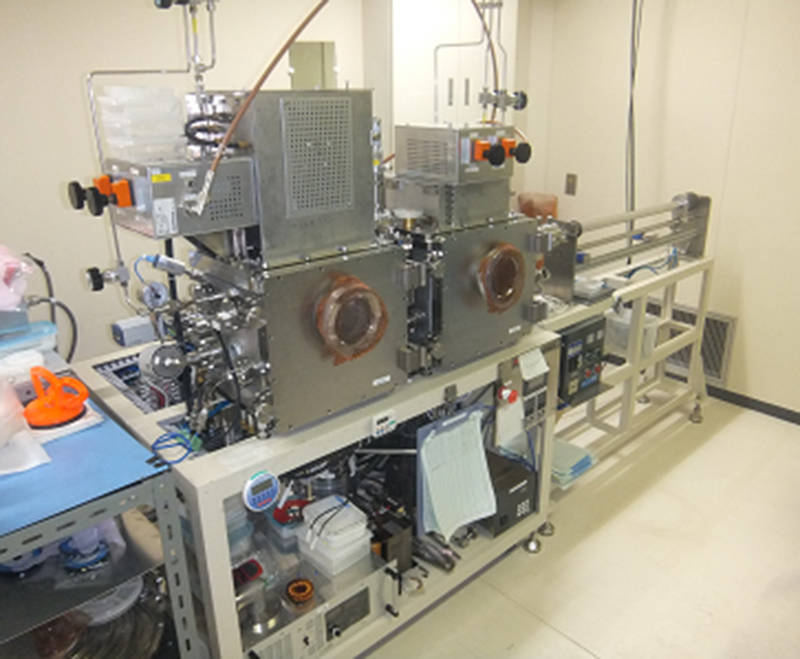
- メーカー名
- アユミ工業 (Ayumi INDUSTRY CO.,LTD.)
- 型番
- 仕様・特徴
- 対応wafer:4inch以下
【技術代行専用】
SiO2、SiNx膜等の絶縁膜を成膜
スパッタ装置(Al用) (Sputtering system for Al, Ti, and TiN deposition)
- 設備ID
- RO-321
- 設置機関
- 広島大学
- 設備画像
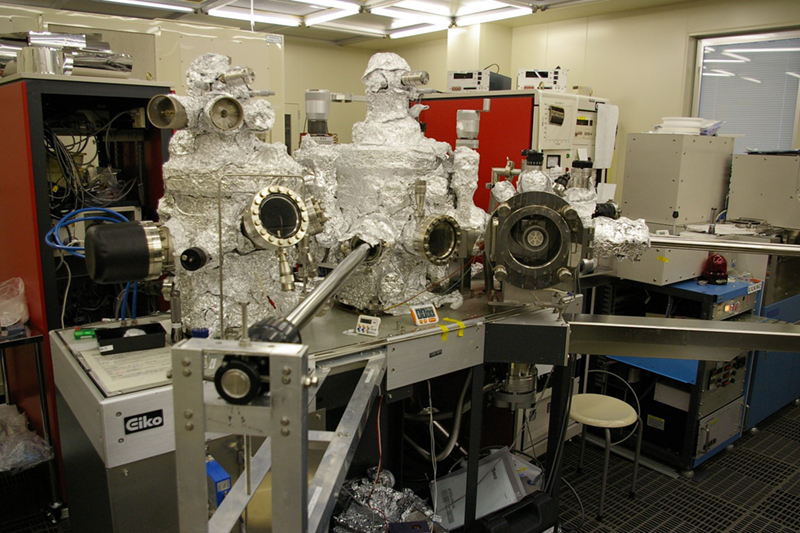
- メーカー名
- 株式会社エイコー (EIKO CORPORATION)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
超高真空仕様、Al以外にTi, TiNのスパッタが可能
スパッタ装置(汎用) (Sputtering system for general purpose)
- 設備ID
- RO-322
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 株式会社エイコー (EIKO CORPORATION)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
各種材料スパッタ用
(3インチターゲット交換により広範な材料に対応)
スパッタガス(Ar・O2・N2)
スパッタ装置(Cu用) (Sputtering system for Cu deposition)
- 設備ID
- RO-323
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 株式会社エイコー (EIKO CORPORATION)
- 型番
- 仕様・特徴
- 対応wafer:2inch
スパッタレート500 nm/8 min
多元スパッタ装置 (Multi-target Sputtering system)
- 設備ID
- RO-324
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アネルバ (Anelva)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
3元スパッタ
真空蒸着装置 (Vacuum evaporation system)
- 設備ID
- RO-331
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アルパック (ULVAC, Inc.)
- 型番
- 仕様・特徴
- 対応wafer:2inch以下
抵抗加熱型の蒸着装置。
2種類の材料をセットして多層膜を作成することも可能。
Al、Au等。
エッチング装置(RIE SiO2用) (Reactive ion etching system for SiO2)
- 設備ID
- RO-411
- 設置機関
- 広島大学
- 設備画像
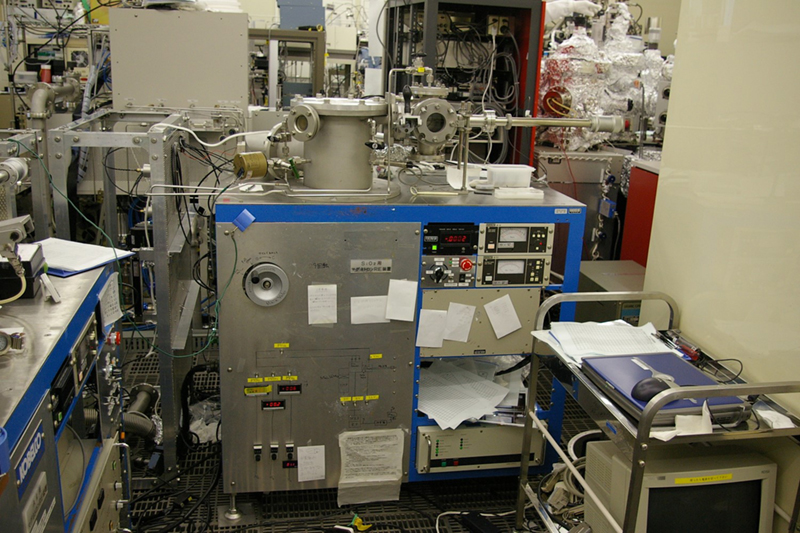
- メーカー名
- 神戸製鋼 (Kobe Steel, Ltd.)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut waferは2inchに貼り付けて対応可
CF4, H2使用可能