共用設備検索結果
インプラ後アニール炉 (Diffusion furnaces for dopant activation)
- 設備ID
- RO-223
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 370MI- MINI
- 仕様・特徴
- 対応wafer:2inch、cut wafer
最高使用温度1150℃
ウェル拡散炉 (Well diffusion furnaces)
- 設備ID
- RO-224
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 370MI- MINI
- 仕様・特徴
- 対応wafer:2inch、cut wafer
最高使用温度1150℃
ポストメタライゼーションアニール(PMA)炉 (Post-metallization annealing furnaces)
- 設備ID
- RO-225
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 神港精機 (SHINKO SEIKI Co., LTD)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
N2=2slm、H2=0.5slm (400℃)
最高使用温度900℃
燐拡散炉 (Phosphorus diffusion furnaces)
- 設備ID
- RO-226
- 設置機関
- 広島大学
- 設備画像
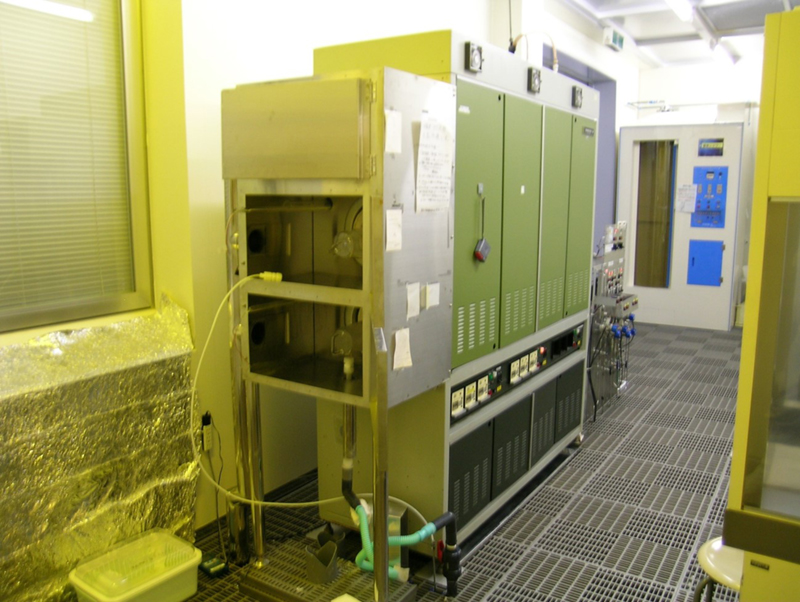
- メーカー名
- 神港精機 (SHINKO SEIKI Co., LTD)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
最高使用温度900℃
汎用熱処理装置 (Annealing furnaces for general purpose)
- 設備ID
- RO-227
- 設置機関
- 広島大学
- 設備画像
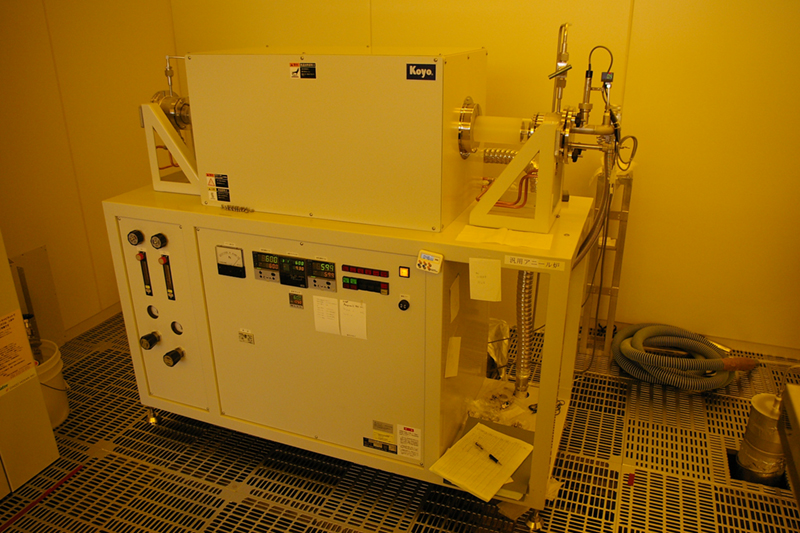
- メーカー名
- 光洋サーモシステム ()
- 型番
- KTF453N-VP
- 仕様・特徴
- 対応wafer:2inch、cut wafer
各種材料窒素アニール用(400~1000℃)
O2とN2又はH2のどちらか一方が使用可能
連続発振レーザアニール装置(レーザ結晶化装置) (CW OSC Laser annealing (Laser crystallization))
- 設備ID
- RO-231
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- (自作) ()
- 型番
- (自作)
- 仕様・特徴
- 対応wafer:2inch、cut wafer
【技術代行専用】
レーザ出力:0.24 ~ 10.0 W、
レーザ径:1.15 mm×50μm (ラインビーム)、
スキャン速度:0.1 ~ 10 cm/s
LPCVD装置(poly-Si用) (Low-pressure chemical vapor deposition (CVD) reactor for poly-Si deposition)
- 設備ID
- RO-311
- 設置機関
- 広島大学
- 設備画像
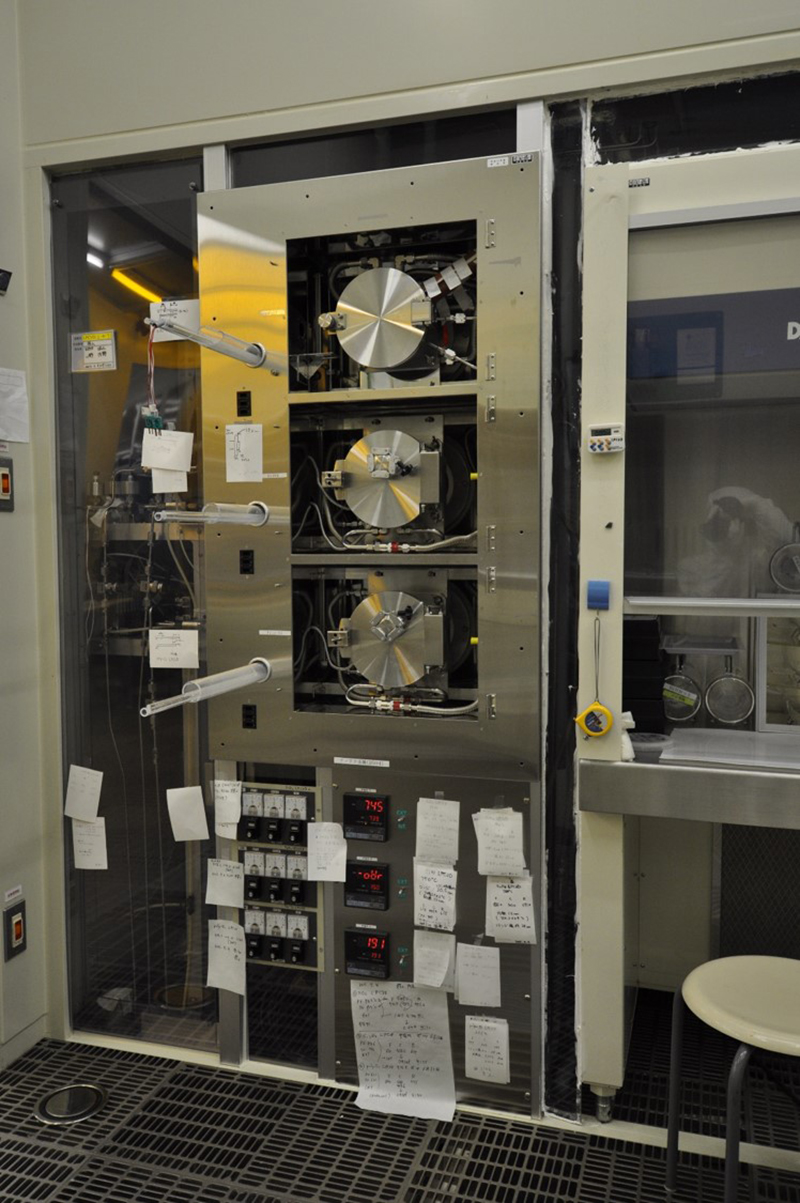
- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
モノシランの熱分解、650℃
LPCVD装置(SiN用) (Low-pressure CVD reactor for SiN deposition)
- 設備ID
- RO-312
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
ジクロルシランとアンモニアの反応、基板温度750℃
LPCVD装置(SiO2用) (Low-pressure CVD reactor for SiO2 deposition)
- 設備ID
- RO-313
- 設置機関
- 広島大学
- 設備画像
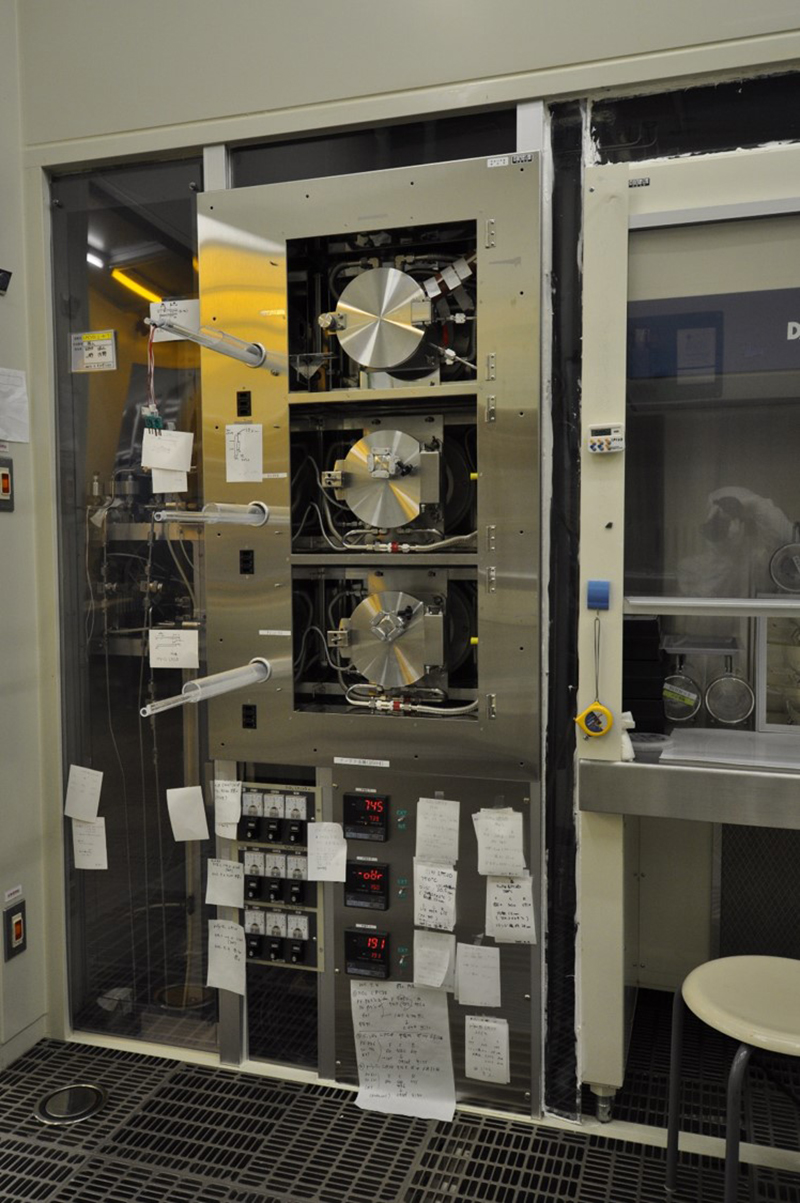
- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
モノシランと一酸化窒素の混合モード、
TEOS+オゾン の2つのモード可能、
最高温度850℃
常圧SiO2CVD装置 (Atmospheric pressure CVD reactor for SiO2 deposition)
- 設備ID
- RO-314
- 設置機関
- 広島大学
- 設備画像
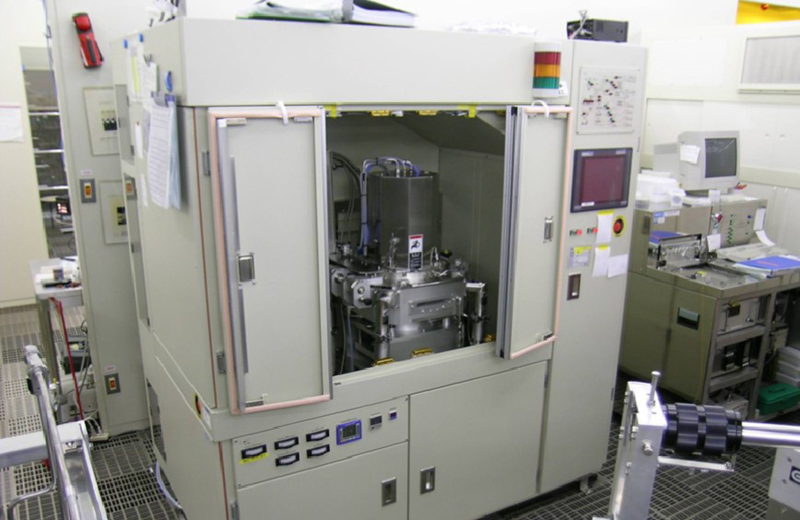
- メーカー名
- 天谷製作所 (Amaya Co., Ltd.)
- 型番
- M01
- 仕様・特徴
- 対応wafer:2inch (一度に~6枚まで可能)
基板温度400℃、
PおよびBドープ可能