共用設備検索結果
住友精密PECVD (Sumitomo PECVD)
- 設備ID
- TU-153
- 設置機関
- 東北大学
- 設備画像
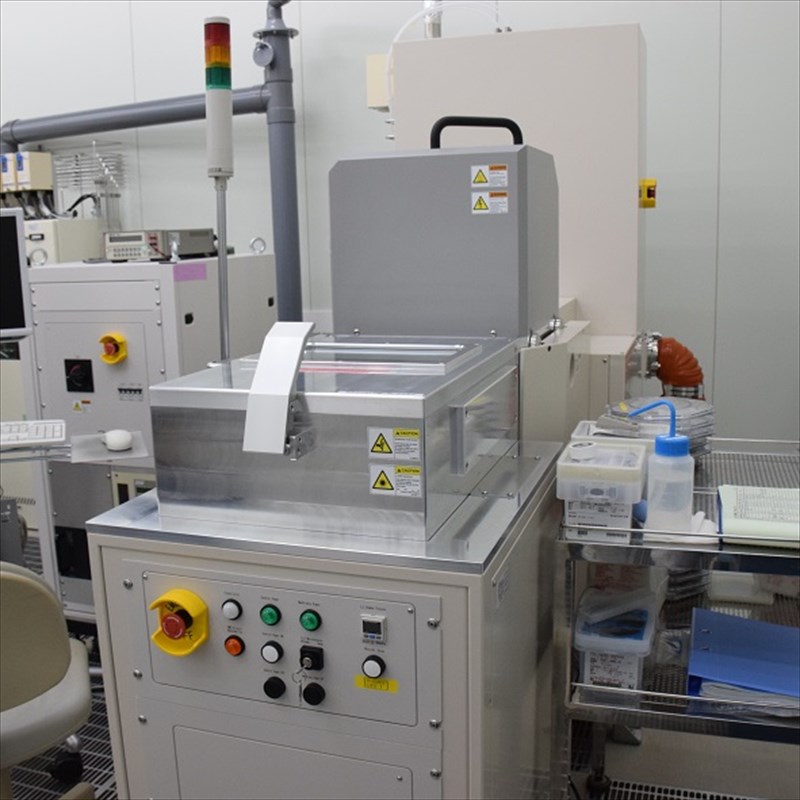
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- MPX-CVD
- 仕様・特徴
- サンプルサイズ:小片~8インチ
基板温度:最高350℃
住友精密TEOS PECVD (Sumitomo TEOS PECVD)
- 設備ID
- TU-154
- 設置機関
- 東北大学
- 設備画像
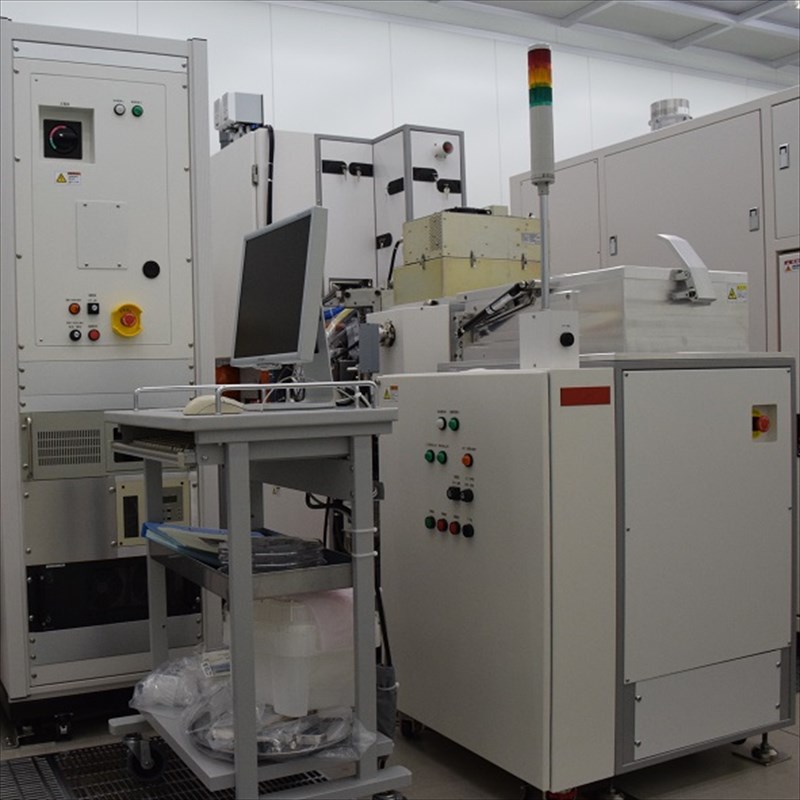
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- MPX-CVD
- 仕様・特徴
- サンプルサイズ:小片~8インチ
基板温度:最高350℃
SPPテクノロジーズ TEOS PECVD (SPP Technologies TEOS PECVD)
- 設備ID
- TU-155
- 設置機関
- 東北大学
- 設備画像
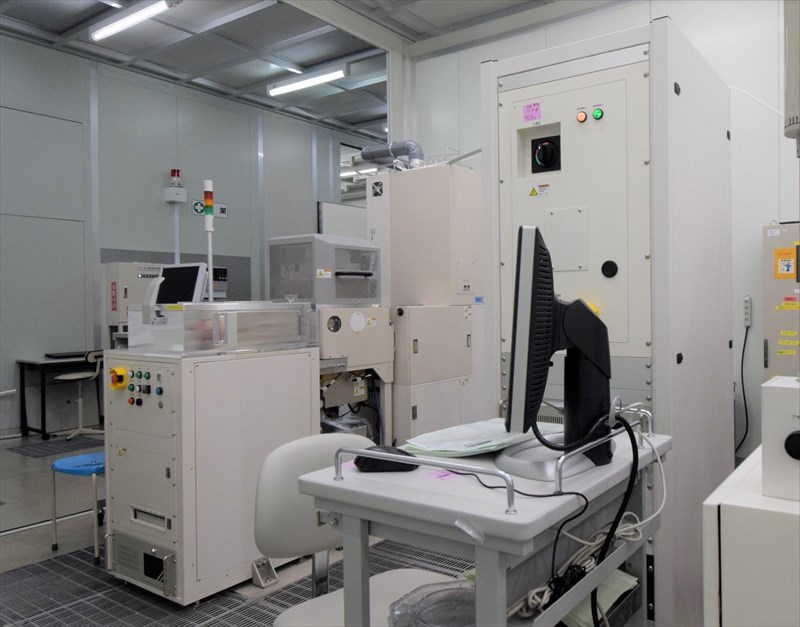
- メーカー名
- SPPテクノロジーズ (SPP Technologies)
- 型番
- APX-Cetus
- 仕様・特徴
- サンプルサイズ:小片~8インチ
基板温度:350℃
JPEL PECVD (JPEL PECVD)
- 設備ID
- TU-156
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- 日本生産技術研究所 (JPEL)
- 型番
- VDS-5600
- 仕様・特徴
- 同時処理枚数:4インチ×13枚、または6インチ×8枚
W-CVD (W-CVD )
- 設備ID
- TU-157
- 設置機関
- 東北大学
- 設備画像
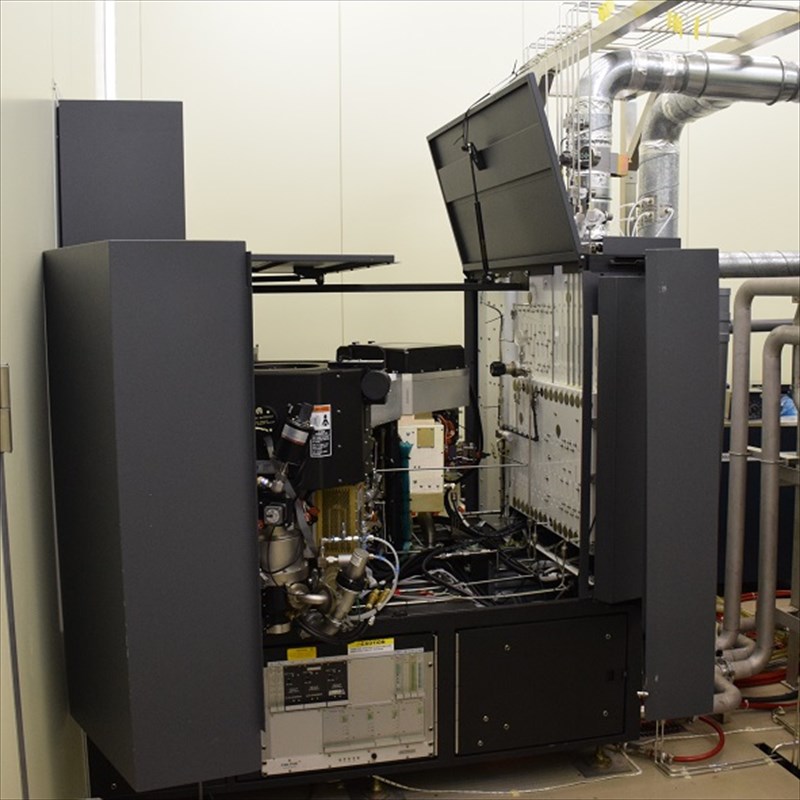
- メーカー名
- Applied Materials (Applied Materials)
- 型番
- P-5000
- 仕様・特徴
- サンプルサイズ:小片~4インチ
成膜温度:450℃(ランプ加熱方式)
カセットtoカセット
プロセスガス:SiH4、H2、WF6、NF3、Ar、N2
芝浦スパッタ装置(加熱型) (Shibaura sputtering (Heating))
- 設備ID
- TU-158
- 設置機関
- 東北大学
- 設備画像
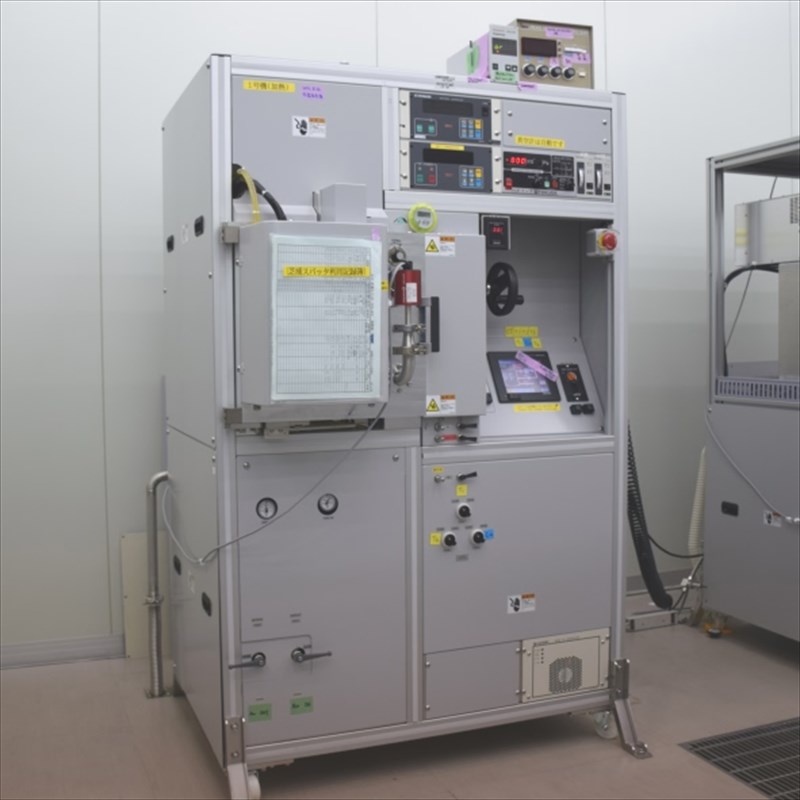
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- CFS-4ESII
- 仕様・特徴
- サンプルサイズ:小片~6インチ
サンプルステージ:直径200mm
基板温度:室温~300℃
電源:RF×1
ターゲット:3インチ×3
方式:スパッタSIDE
到達真空度:3E-4Pa
芝浦スパッタ装置(冷却型) (Shibaura sputtering (Cooling))
- 設備ID
- TU-159
- 設置機関
- 東北大学
- 設備画像
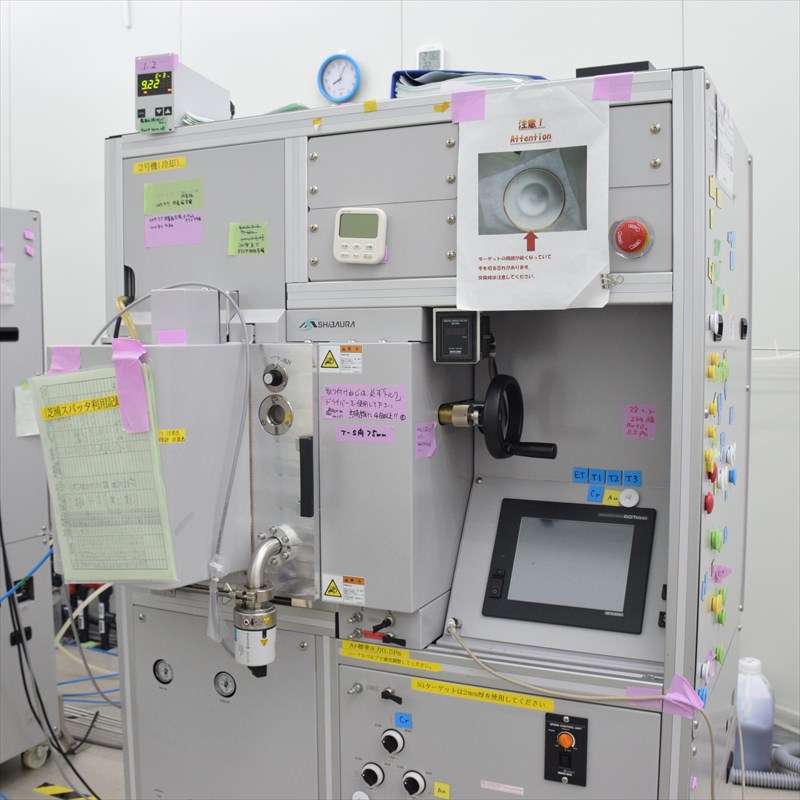
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- CFS-4ESII
- 仕様・特徴
- サンプルサイズ:小片~6インチ
サンプルステージ:直径200mm
基板温度:約20℃
電源:RF×1
ターゲット:3インチ×3
方式:スパッタSIDE
到達真空度:3E-4Pa
自動搬送 芝浦スパッタ装置(加熱型) (Automatic Shibaura sputtering (Heating))
- 設備ID
- TU-160
- 設置機関
- 東北大学
- 設備画像
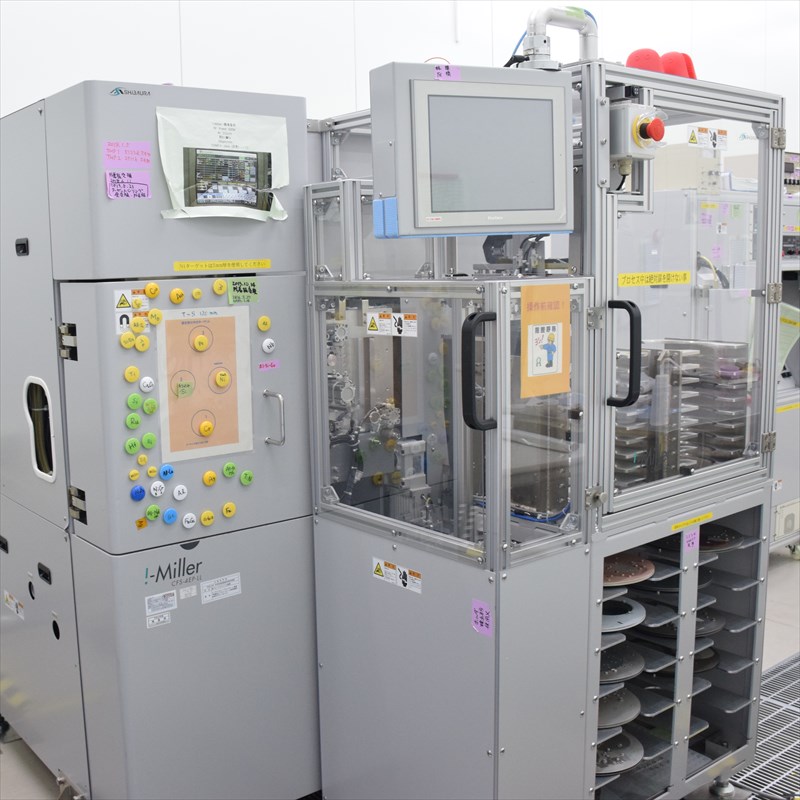
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- !-Miller CFS-4EP-LL
- 仕様・特徴
- サンプルサイズ:小片~8インチ
サンプルステージ:直径220mm
基板温度:室温~300℃
電源:RF×1
ターゲット:3インチ×4
方式:スパッタSIDE
到達真空度:8E-5Pa
ECRロングスロースパッタ (ECR long-throw sputter)
- 設備ID
- TU-162
- 設置機関
- 東北大学
- 設備画像
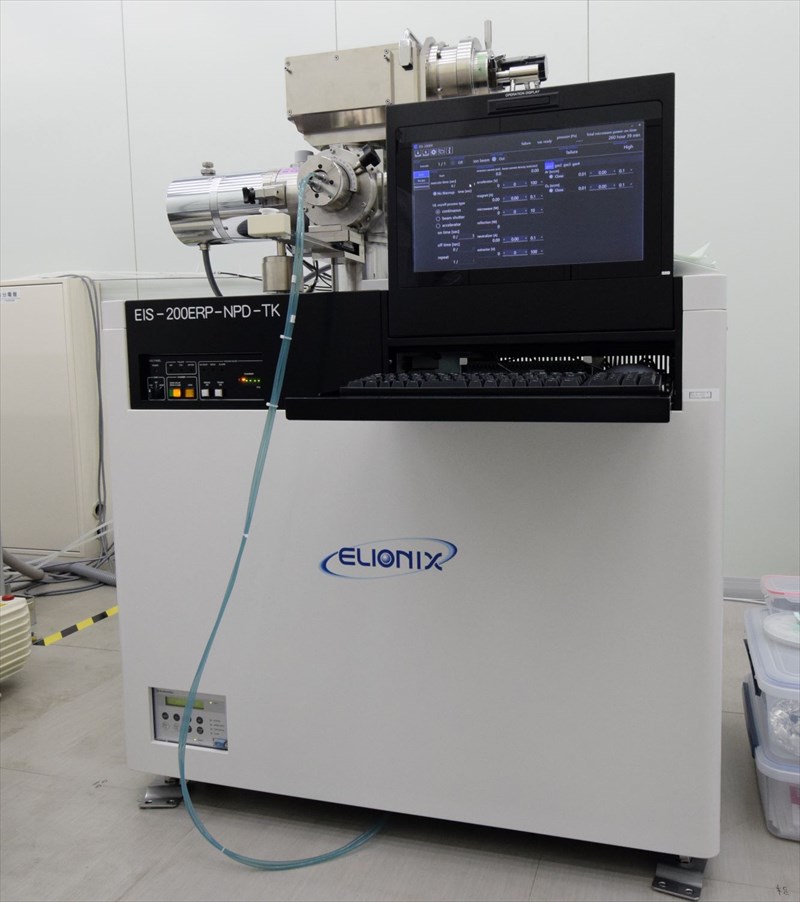
- メーカー名
- エリオニクス (Elionix)
- 型番
- EIS-200ERP-NPD-TK
- 仕様・特徴
- サンプルサイズ:小片~6インチ
基板温度:20℃
ターゲット:4インチ× 2
ターゲット‐ステージ間距離 :350mm
到達真空度:3E-4Pa
エッチング可
アネルバマルチスパッタ (Anelva multi-sputtering)
- 設備ID
- TU-163
- 設置機関
- 東北大学
- 設備画像
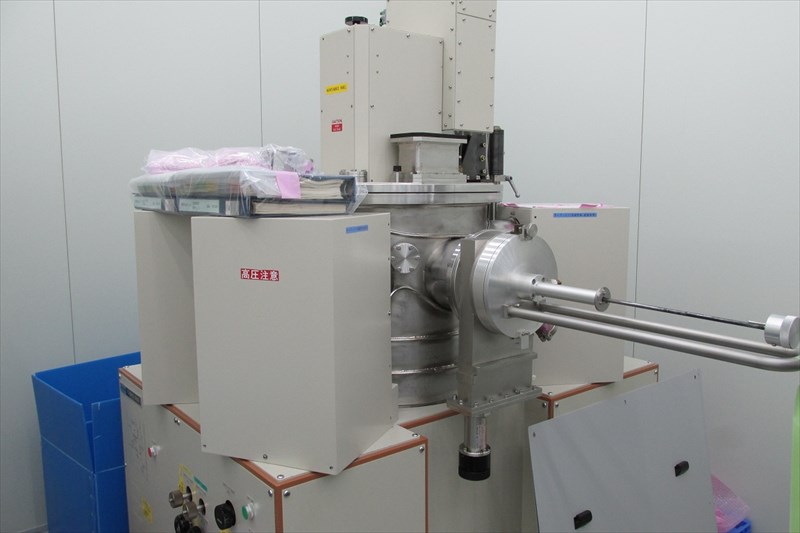
- メーカー名
- アネルバ (Anelva)
- 型番
- SPC-350
- 仕様・特徴
- サンプルサイズ、同時処理枚数:4インチ×6枚
基板温度:室温~650℃
電源:DC×2、RF×1(同時放電可能)
ターゲット:6インチ×3(強磁性体対応)