共用設備検索
共用設備検索結果
"豊田工業大学"で検索した結果 25件
- 25件中 1~10件
- 1
- 2
- 3
- >
- 設備ID
- TT-034
- 設置機関
- 豊田工業大学
- 設備画像
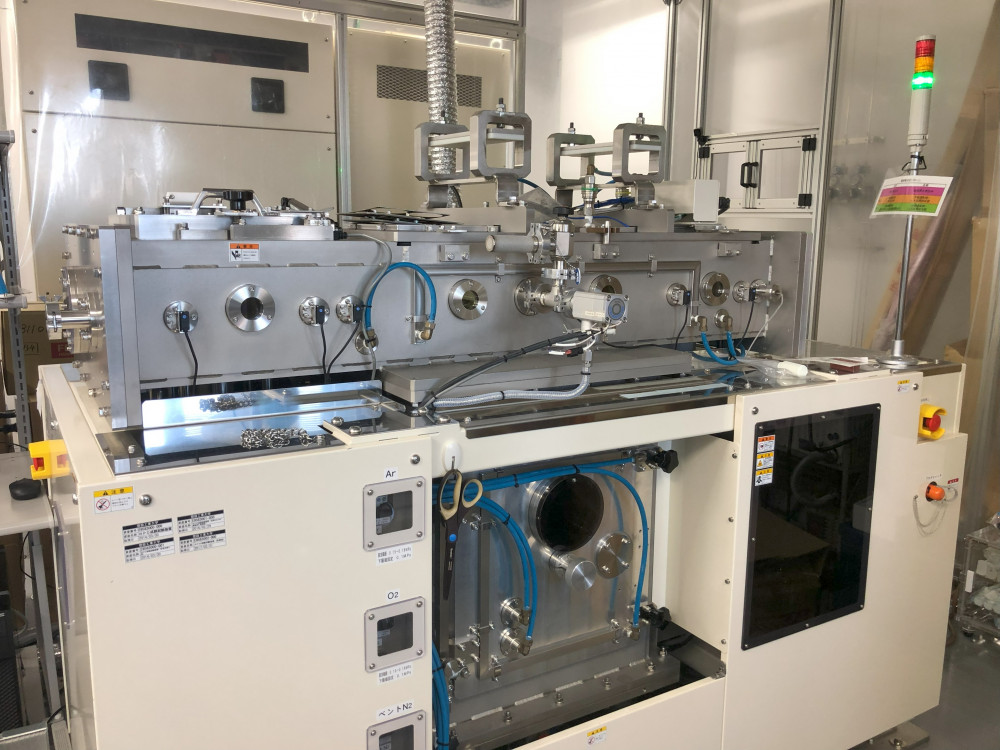
- メーカー名
- 住友重機械工業 (Sumitomo Heavy Industries, Ltd.)
- 型番
- RPD-PCS4/LC
- 仕様・特徴
- ITO透明導電膜成膜
基板サイズ 156×156mm
基板温度 max200℃
- 設備ID
- TT-001
- 設置機関
- 豊田工業大学
- 設備画像
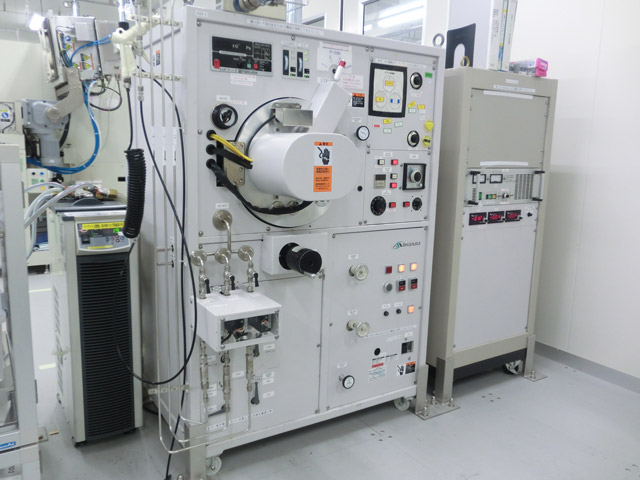
- メーカー名
- 芝浦エレテック (Shibaura eletec Corporatoin)
- 型番
- CFS-4ES
- 仕様・特徴
- ・平行平板型
・ターゲット現有(Ti, Al, Ag, Pd, SiO2, Al2O3, SiN, Au)
- 設備ID
- TT-002
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- BC2925(特注装置)
- 仕様・特徴
- 超高真空仕様
RF2元、DC2元
ターゲット2インチΦと、分子線エピタキシーMBE3元(EBガン)の複合利用可能
多層膜作成可能、主に磁性材料用
- 設備ID
- TT-003
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- Ultratech/Cambridge Nano Tech (Ultratech/Cambridge Nano Tech)
- 型番
- Fiji F200
- 仕様・特徴
- 成膜する試料は、基板表面に蒸気圧の高い物質が露出していないことが条件。
半導体デバイスのパッシベーションに用いており、汚染を防ぐためであり、ご理解をお願いします。
- 設備ID
- TT-005
- 設置機関
- 豊田工業大学
- 設備画像
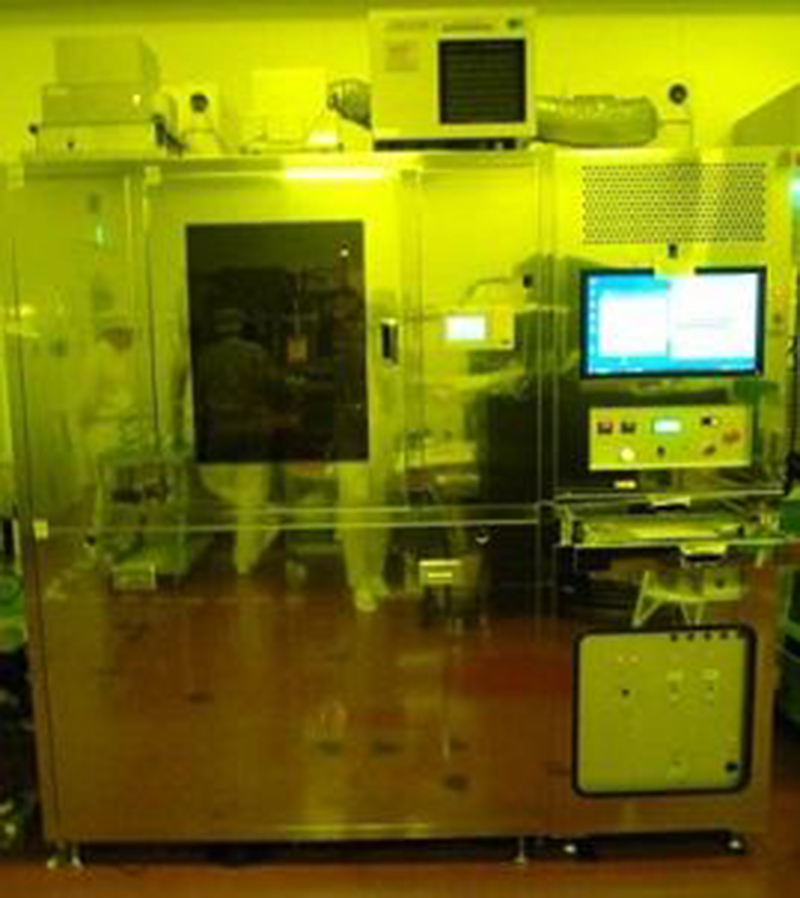
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1204
- 仕様・特徴
- φ4インチにポジ型フォトレジスト(膜厚1μm以上)に、2μm幅のラインアンドスペースを全面(外周3mm除く)に描いたときに、描画時間が30分程度。
露光パターン幅のバラツキが100 nm(1σ)以下。
- 設備ID
- TT-006
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- ズース・マイクロテック (SUSS MicroTec)
- 型番
- MA6
- 仕様・特徴
- ・裏面アライメント可能、i線フィルタ付き
・付帯装置:レジストのスピンコータ共和理研K-359SDなど
- 設備ID
- TT-007
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- VICインターナショナル (VIC international)
- 型番
- VPA-100改造
- 仕様・特徴
- ・材料制限は少ない(要相談)
・φ4インチまで
・付帯装置:UVキュア処理装置(自作)
- 設備ID
- TT-008
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- 東朋テクノロジー (Toho Technology Co.)
- 型番
- 特注
- 仕様・特徴
- シリコン専用および化合物半導体専用のドラフト群
小型~太陽電池156mm角基板等
- 設備ID
- TT-009
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- 縦型:ディー・エス・アイ テクノロジー
横型:光洋サーモシステム (縦型:DSITechnology Co.LTD
横型:Koyo Thermo Systems Co., Ltd.)
- 型番
- 縦型:MD-100P
横型:4001PSI
- 仕様・特徴
- 横型および縦型酸化・拡散炉一式
・シリコンウェハの酸化および不純物拡散(リンおよびボロン)
・φ3インチまでのシリコン基板
- 設備ID
- TT-010
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- サムコ (Samco Inc.)
- 型番
- RIE-10NR
- 仕様・特徴
- CF4, O2, SF6を用いたレジストアッシングや、SiおよびSiO2、石英ガラス、窒化膜のエッチング
Φ6インチまでのガラス及びシリコン基板に対応
"豊田工業大学"で検索した結果 25件
- 25件中 1~10件
- 1
- 2
- 3
- >