共用設備検索
共用設備検索結果
"早稲田大学"で検索した結果 29件
- 29件中 1~10件
- 1
- 2
- 3
- >
- 設備ID
- WS-032
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社堀場製作所 (HORIBA, Ltd.)
- 型番
- GDA750
- 仕様・特徴
- 軽元素(N, O, H等)の分析可能、分析範囲4mmφ以上、10mm□以上4"までのSi、ガラス基板
- 設備ID
- WS-031
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社 エビデント (EVIDENT)
- 型番
- FLUOVIEW FV3000RS
- 仕様・特徴
- ・対物レンズ:10倍、20倍、40倍、60倍
・励起光源:405nm, 445nm, 488nm, 514nm, 561nm, 640nm
・高精細イメージング:最大4096x4096ピクセル
・高速イメージング:30fps(512x512ピクセル)
・Zドリフトコンペンセーター(IX3-ZDC)によるフォーカスの自動補正機能
・電動ステージ付き
- 設備ID
- WS-030
- 設置機関
- 早稲田大学
- 設備画像
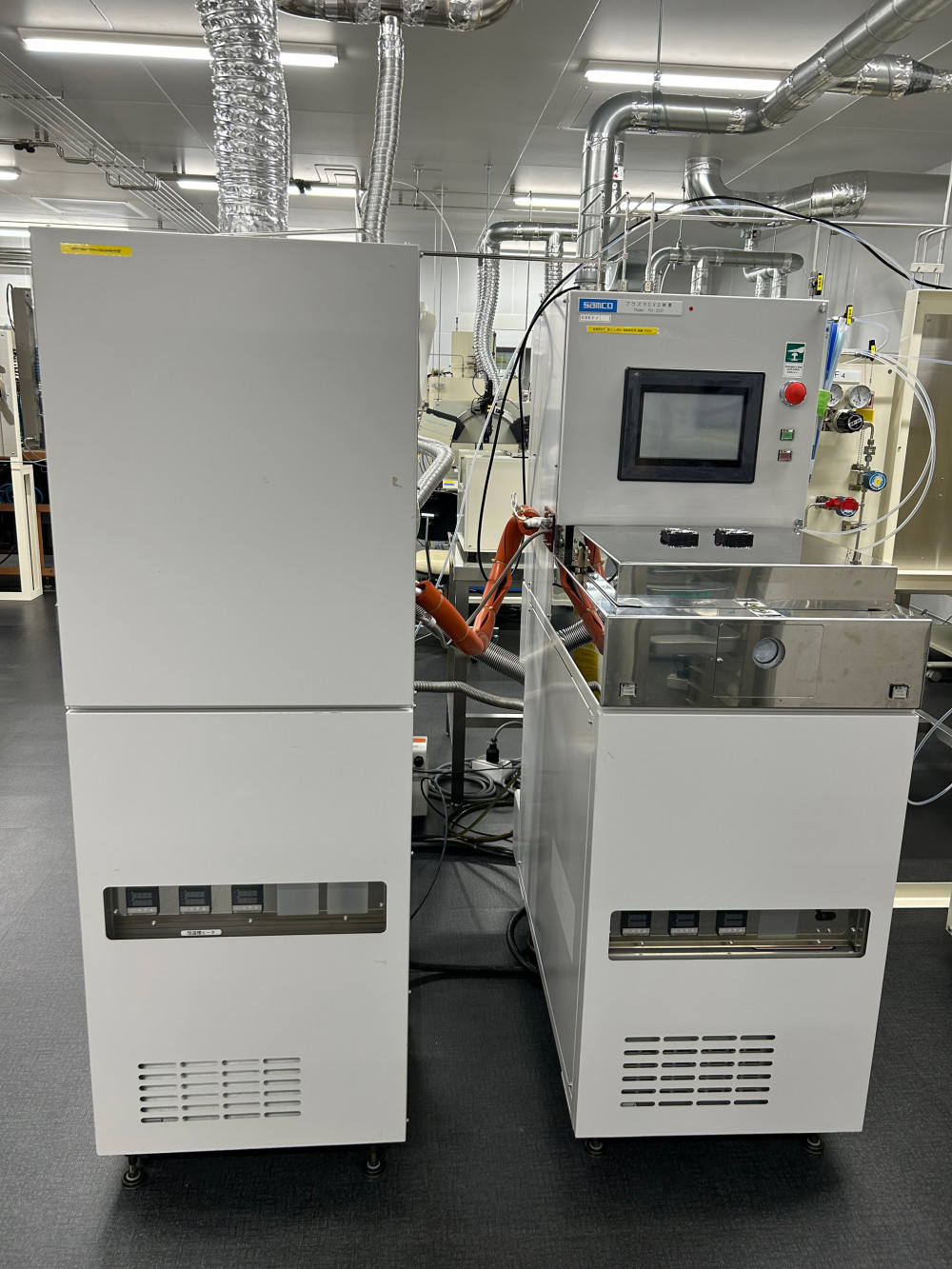
- メーカー名
- サムコ株式会社 (Samco Inc.)
- 型番
- PD-220
- 仕様・特徴
- プラズマCVDの原理による成膜
高いカバレッジ成形
基板サイズ6インチ以下
面内分布 5%以内(仕様)
標準条件での基板温度300℃
- 設備ID
- WS-001
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 伯東株式会社 (Hakuto Co., Ltd.)
- 型番
- MILLATRON 820
- 仕様・特徴
- デュアルイオンビームスパッタ装置
試料サイズ 4インチ以下
4ターゲット
基板昇温可能(約400℃)
- 設備ID
- WS-002
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- キヤノンアネルバ株式会社 (CANON ANELVA CORPORATION)
- 型番
- EVC-1501
- 仕様・特徴
- 試料サイズ 4インチ以下
Au, Cr, Ti専用
4インチウエハ18枚同時成膜可能(プラネタリーホルダー)
- 設備ID
- WS-003
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社アルバック (ULVAC, Inc.)
- 型番
- EBX-6D
- 仕様・特徴
- 試料サイズ 4インチ以下(プラネタリーホルダーにより、複数枚成膜可能)
金属(Cu, Cr, Ni, Al, Au, Ag等)および絶縁膜(SiO2, ZnO等)の成膜
- 設備ID
- WS-004
- 設置機関
- 早稲田大学
- 設備画像
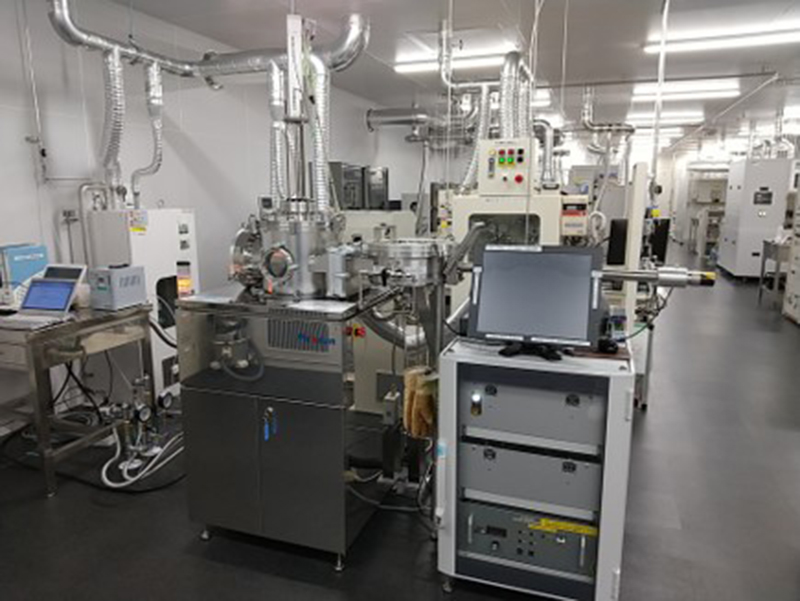
- メーカー名
- PICOSUN JAPAN株式会社 (Picosun Japan Co. Ltd.)
- 型番
- SUNALE R-150
- 仕様・特徴
- Al2O3膜を原子一層レベルで成膜可能
H2O及びO3使用可
基板サイズ小片~4インチ
4”, 6”ウエハ, 及び20×20mm試料対応
基板材料は原則としてダイヤモンドまたはSi
- 設備ID
- WS-005
- 設置機関
- 早稲田大学
- 設備画像
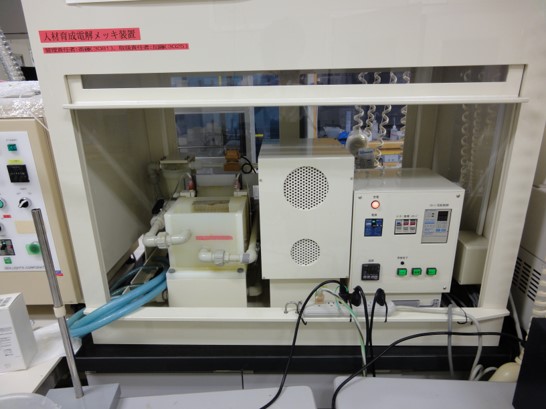
- メーカー名
- 特注品 (Custom-made products)
- 型番
- 特注品
- 仕様・特徴
- 各種無電解、電解めっきに対応、Auめっき、合金めっきに対応、基板サイズ4インチまで
- 設備ID
- WS-006
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- ヤマト科学株式会社 (Yamato Scientific Co., Ltd.)
- 型番
- PR500
- 仕様・特徴
- 使用ガス:O2ガス
試料サイズ:φ4インチ以下
用途:レジストの灰化除去
ドライエッチング後のO2アッシング)
有機系汚染物質のクリーニング
Si表面の親水化処理等
- 設備ID
- WS-007
- 設置機関
- 早稲田大学
- 設備画像
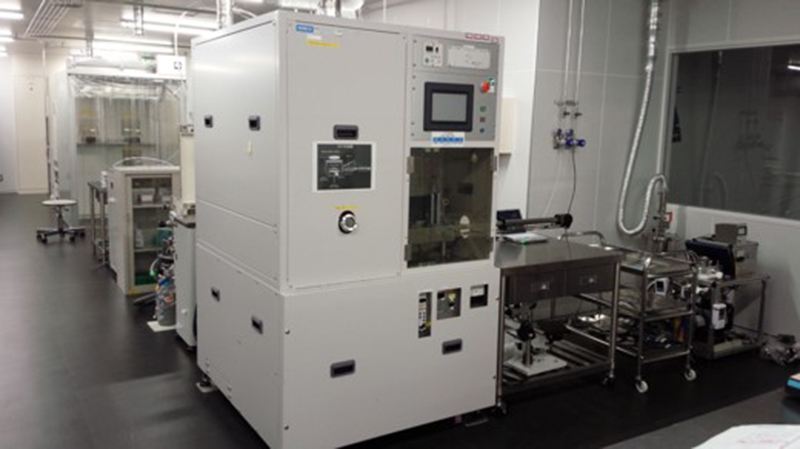
- メーカー名
- サムコ株式会社 (Samco Inc.)
- 型番
- RIE-101iPH
- 仕様・特徴
- 汎用反応性エッチング装置
Si、Ti等の微細エッチング可
基板サイズは~4inch
"早稲田大学"で検索した結果 29件
- 29件中 1~10件
- 1
- 2
- 3
- >