共用設備検索結果
電子ビーム描画装置(CRESTEC) (Electron Beam Lithography System (CRESTEC))
- 設備ID
- AT-001
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
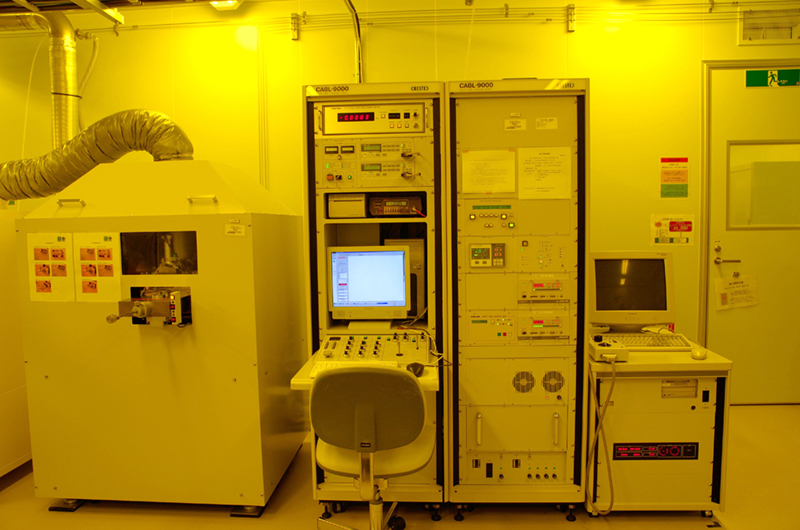
- メーカー名
- クレステック (CRESTEC)
- 型番
- CABL_9410TFNA
- 仕様・特徴
- ・型式:CABL-9410TFNA
・試料サイズ:6インチφ×4.6 mm(高さ)
・電子銃:熱電界放射型ZrO/Wエミッタ
・最小スポット:2 nmφ(加速電圧50 kV)
・描画可能な最小線幅:10 nm(レジスト膜厚100 nm)
・走査方式:ベクター走査、ラスター走査
・走査領域:最大1 mm□
・つなぎ合わせ描画領域:最大150 mm□
・つなぎ合わせ精度:50 nm以下
・重ね合わせ精度:50 nm以下
電界放出形走査電子顕微鏡[S4800_FE-SEM] (Field Emission SEM〔S4800/FE-SEM, HITACHI〕)
- 設備ID
- AT-004
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![電界放出形走査電子顕微鏡[S4800_FE-SEM]](data/facility_item/1651474199_14.jpg)
- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S4800
- 仕様・特徴
- ・型式:S-4800
・試料サイズ:15~150 mmφ
・電子銃:冷陰極電界放出型電子銃
・加速電圧:0.5~30 kV
・分解能:1.0 nm(加速電圧15 kV, WD = 4 mm)
・試料ステージ制御:5軸モーター制御
・可動範囲:X,Y:0~110 mm、Z:1.5~40 mm、R:360°、T:-5~70°
・検出器:2次電子検出器、エネルギー分散型X線検出器(EDX)
低真空走査電子顕微鏡 (Low Vacuum SEM (HITACHI))
- 設備ID
- AT-005
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 日立ハイテクノロジーズ (Hitachi High-Tech)
- 型番
- S-3500N
- 仕様・特徴
- ・型式:S-3500N(日立ハイテク)
・試料サイズ:15~150 mmφ
・電子銃:熱電子放出型Wヘアピンフィラメント
・加速電圧:0.3~30 kV
・分解能:高真空二次電子像:3.0 nm
・低真空反射電子像:5 nm
・低真空モードでの真空度設定:1~270 Pa
・試料ステージ:五軸モーター駆動
・可動範囲:100 mm×50 mm
・元素分析:エネルギー分散型X線検出器(EDX)
マスクレス露光装置 (Maskless Lithography System)
- 設備ID
- AT-006
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ナノシステムソリューション (Nano System-Solutions)
- 型番
- DL1000
- 仕様・特徴
- ・型式:DL1000
・試料サイズ:4インチφ、100mm□
・光源:波長405nm(LED)
・露光最小画素:1μm□
・最大露光領域:100mm□
・重ね合わせ精度:±1μm
コンタクトマスクアライナー[MJB4] (Contact Mask Aligner〔MJB4〕)
- 設備ID
- AT-009
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![コンタクトマスクアライナー[MJB4]](data/facility_item/AT-009.jpg)
- メーカー名
- ズース (SUSS MicroTec)
- 型番
- MJB4
- 仕様・特徴
- ・型式:MJB4
・基板サイズ:2インチφ~4インチφ、不定形小片~100mm
・解像度:約800nm (バキュームコンタクト使用時)
・波長:g線(436nm)、h線(405nm)、i線(365nm)
・ 照度 :約25mW/cm2
・露光モード:プロキシミティ、ソフトコンタクト、 ハードコンタクト、ソフトバキュームコンタクト、 バキュームコンタクト
・露光領域:2.5~5インチ対応マスクホルダー(最大40mm□)
4インチ, 5インチ対応マスクホルダー 最大110mmφ
i線露光装置 (i-Line Stepper)
- 設備ID
- AT-011
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
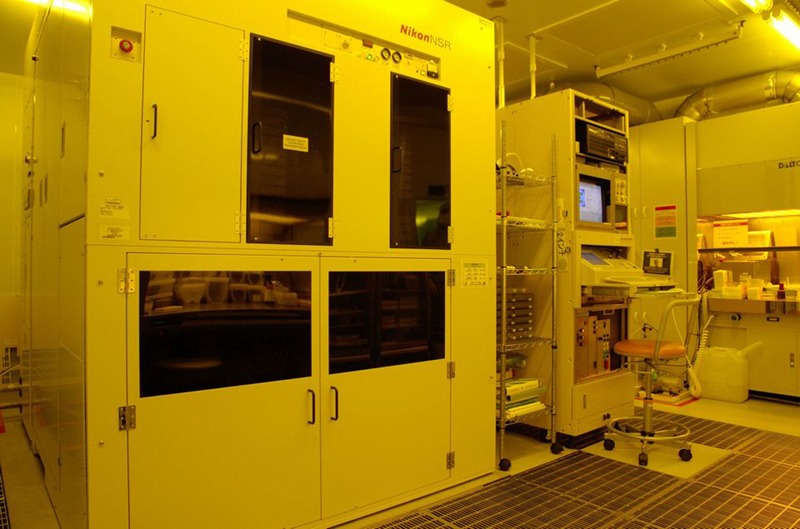
- メーカー名
- ニコン (Nikon)
- 型番
- NSR-2205i12D
- 仕様・特徴
- ・形式:NSR-2205i12D
・試料サイズ:2インチφ~8インチφ
20 mm, 18mm, 15 mm, 10 mm□クーポン
・露光光源:i線(波長365 nm)
・解像度:350 nm以下
・最大N.A.:0.63
・縮小倍率:5分の1倍
・露光範囲:22 mm□(ウェハー上)
・レチクル:6インチ石英ガラス(6025)
・総合アライメント精度:55 nm以下
反応性イオンエッチング装置 (RIE) (Reactive Ion Etching System(RIE))
- 設備ID
- AT-018
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
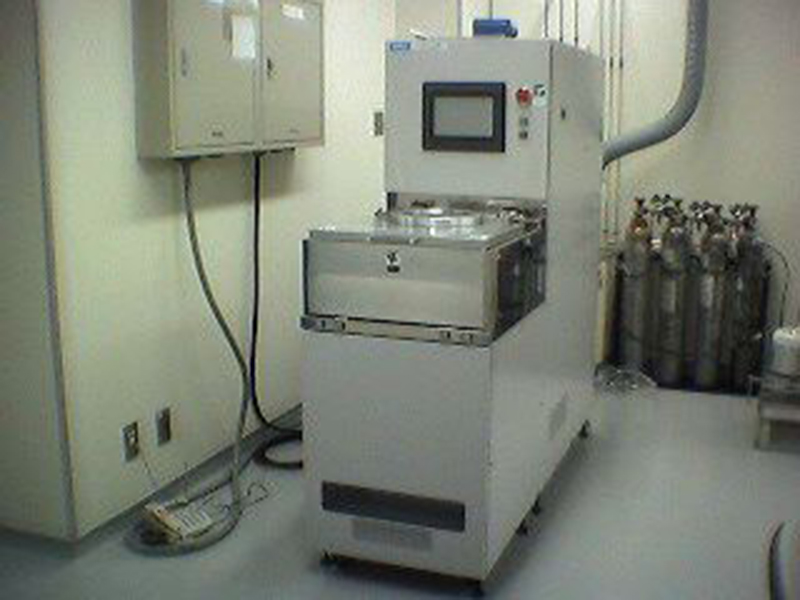
- メーカー名
- サムコ (Samco)
- 型番
- RIE-200L
- 仕様・特徴
- ・型式:RIE-200L
・試料サイズ:8インチφ, 8mmt
・高周波電源:最大300 W(13.56 MHz)
・RF制御:インピーダンスオートマッチング
・電極:セミ無遮蔽型電極、上部Al電極、下部SUS電極電極
・電極間隔:55 mm
・使用ガス:SF6, CF4, O2
・パージガス:N2ガス
多目的エッチング装置(ICP-RIE) (ICP Reactive Ion Etching System(ICP-RIE))
- 設備ID
- AT-019
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
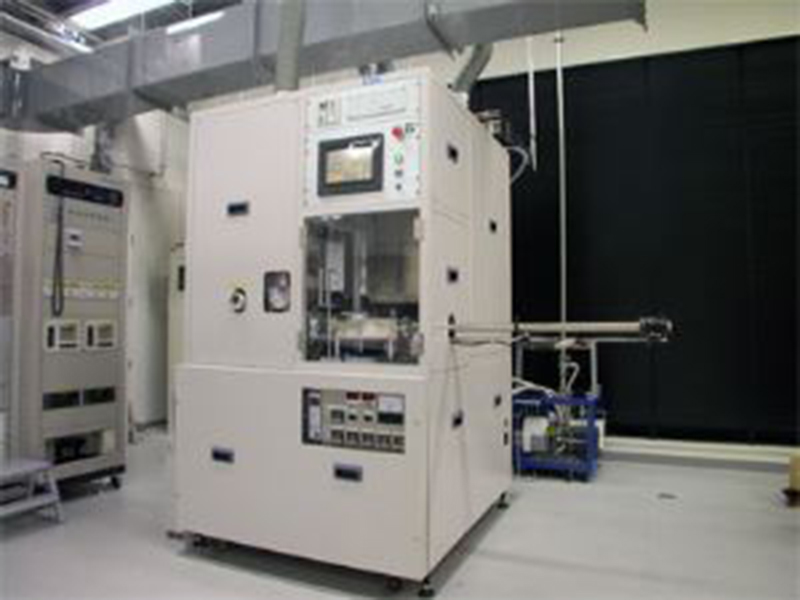
- メーカー名
- サムコ (Samco)
- 型番
- RIE-101iPHS-L
- 仕様・特徴
- ・型式:RIE-101iPHS-L
・試料サイズ:4インチφ, 5mmt
・放電方式: 誘導結合式プラズマ(ICP)
・ICP高周波電源: 最大500W(13.56 MHz)
・バイアス高周波電源: 最大200W(13.56 MHz)
・試料導入方式: ロードロック式
・試料温度制御: -18℃~常温
・使用ガス: SF6, CHF3, CF4, Ar, O2
電子ビーム真空蒸着装置 (Electeron Beam Vacuum Evaporator)
- 設備ID
- AT-023
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
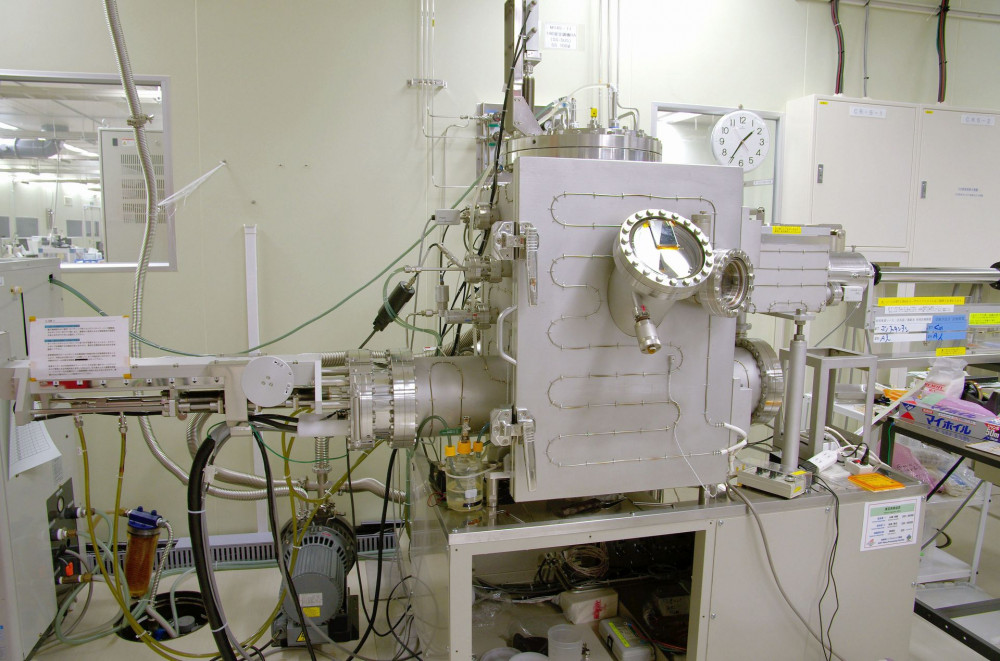
- メーカー名
- エイコーエンジニアリング (EIKO ENGINEERING)
- 型番
- 仕様・特徴
- ・試料サイズ:100 mm×100 mm×20 mm
・蒸着方式:電子ビーム加熱蒸発、180°配向型
・蒸発源:8連装(6 kW電子銃)
・クルーシブル容量:10 ml
・基板ホルダ:傾斜ホルダ、冷却機構付(マイナス10℃)
・蒸発源―基板間:300 mm
・試料導入:ロードロック自動搬送
・真空排気システム:到達圧力3×10-6 Pa以下、オイルフリー、自動排気
・成膜:水晶振動子膜厚モニタによる自動制御
・膜厚分布:10 %以内@Φ75mm
・ソース材料: Al, Al2O3, Ag, Au, Cr, Cu, Mo, Pt, Ru, SiO2, Ta, Ti, TiN, TiO2, W
抵抗加熱型真空蒸着装置 (Resistance Heating Vacuum Evaporator)
- 設備ID
- AT-024
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ビームトロン (Biemtron)
- 型番
- KIS_3
- 仕様・特徴
- ・型式:KIS_3
・試料サイズ:3インチφ以下
・蒸着方式:抵抗加熱蒸発
・蒸発源:3ポート
・加熱抵抗体:平板ボート、コイル、バスケット
・傾斜基板ホルダ:±15°
・蒸発源―基板間:250 mm
・試料導入:手動
・真空排気:手動、到達圧力5×10-5 Pa以下
・成膜制御:手動( 基板シャッター開閉及びヒーター電力調整)
・膜厚モニター:水晶振動子膜厚モニタ付
・ソース材料: Al, Ag, Au, Fe, Ni, Cr, Cu, Ti