共用設備検索
共用設備検索結果
"筑波大学"で検索した結果 26件
- 26件中 1~10件
- 1
- 2
- 3
- >
- 設備ID
- BA-027
- 設置機関
- 筑波大学
- 設備画像
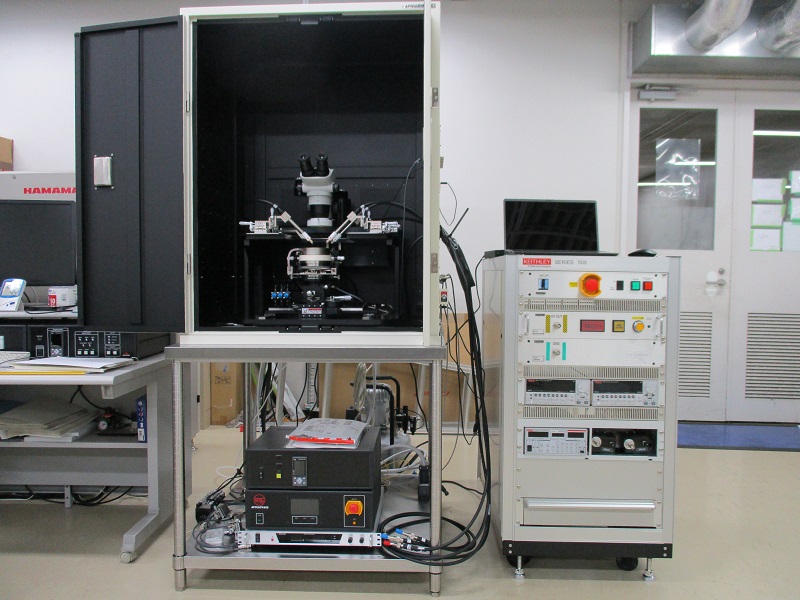
- メーカー名
- アポロウエーブ/テクトロニクス・ケースレーインスツルメンツ (Apollowave/Tektronics-Keithley)
- 型番
- α150PW/2290-10, 2636B
- 仕様・特徴
- 最大10kVの電圧印加によるリーク電流、耐圧測定
200V,1Aの汎用IV測定(SMU:4ch)
4端子デバイス測定
高温ステージ(最高300℃)のマニュアルプローバ(最大φ4インチ。5㎜□、φ2インチの吸着可)
- 設備ID
- BA-001
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- SILVACO (SILVACO)
- 型番
- ATHENA/ATLAS
- 仕様・特徴
- 2次元プロセスシミュレーター
2次元シリコン・デバイスシミュレーター
2次元先端材料・デバイスシミュレーター
3次元シリコン/先端材料・デバイスシミュレーター
- 設備ID
- BA-002
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL (i-miller)
- 仕様・特徴
- スパッタ方式:マグネトロン・サイドスパッタ RF500W (DC)
スパッタ源:3インチ×4(強磁性体材料用GUN1基含む)、逆スパッタ可
サンプルホルダ:最大φ220 mm/最小20 mm
(4インチウエハ用および不定形用ホルダあり)
加熱温度:室温~300℃
到達真空度・時間:10-5 Pa、10分以内に7 x 10-3 Pa
排気系:ロータリーポンプ、ターボ分子ポンプ、クライオトラップ
操作方式:全自動(レシピ設定可)
プロセスガス:Ar、N2、O2
- 設備ID
- BA-003
- 設置機関
- 筑波大学
- 設備画像
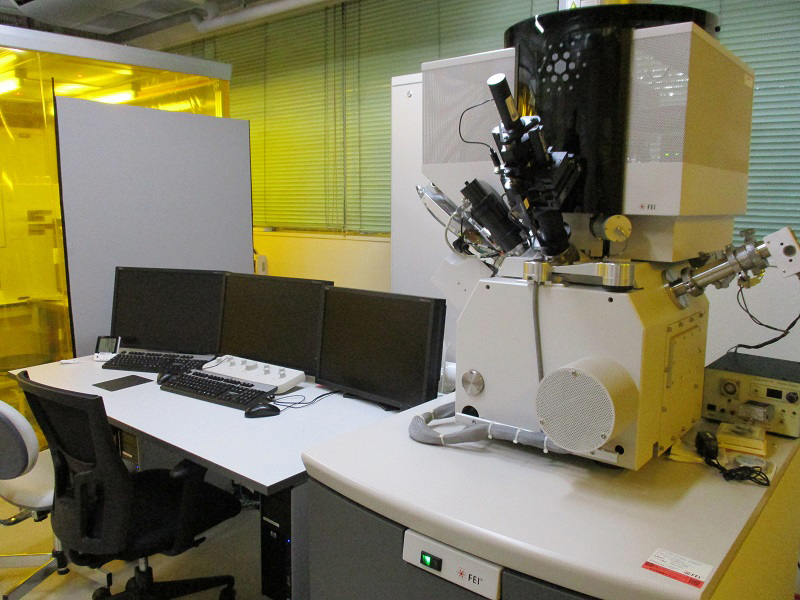
- メーカー名
- FEI (FEI)
- 型番
- Helios NanoLab 600i
- 仕様・特徴
- 電子とイオンの2種のソースにより、TEM試料作製、イオン照射による直接加工をSEM観察をしながら実施できる。
加速電圧:1-30kV(電子ビーム)
0.5-30kV(Gaイオンビーム)
デポジション用ガス:C,Ptガス
分析機能:EDS
- 設備ID
- BA-004
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- エイコー (eiko)
- 型番
- EB-350T
- 仕様・特徴
- 到達圧力:1.0×10-6 Pa以下
蒸発源:5 kW 5連EBガン
ルツボ容量:5 cc
基板ホルダー:φ3インチ
- 設備ID
- BA-005
- 設置機関
- 筑波大学
- 設備画像
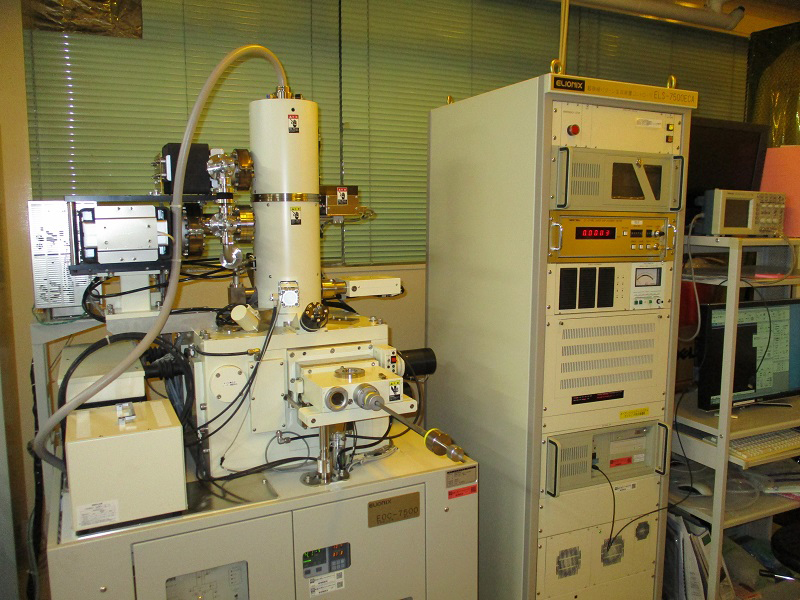
- メーカー名
- ELIONIX (ELIONIX)
- 型番
- ELS-7500EX
- 仕様・特徴
- 電子銃エミッター:ZrO/W熱電界放射型
加速電圧:5~50 kV
最小線幅:10 nm
試料サイズ:最大4インチ
ステージ移動範囲: X:100 mm以上 Y:110 mm以上
重ねあわせ精度:40 nm
フィールド継ぎ精度:40 nm
- 設備ID
- BA-006
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- Bruker (Bruker)
- 型番
- Dimension Icon
- 仕様・特徴
- 形状測定モード:
タッピングモード, コンタクトモード
物性測定モード:
電気・磁気特性(EFM/SSRM/KPFM/MFM他)
機械特性(粘弾性/水平力)
試料サイズ:直径 <Φ150mm, 厚さ <10mm
最大スキャン範囲:XY 90μmx90μm, Z 10μm
Z方向ノイズ:0.03nm RMS
測定環境:大気中, 液中(要相談)
- 設備ID
- BA-007
- 設置機関
- 筑波大学
- 設備画像
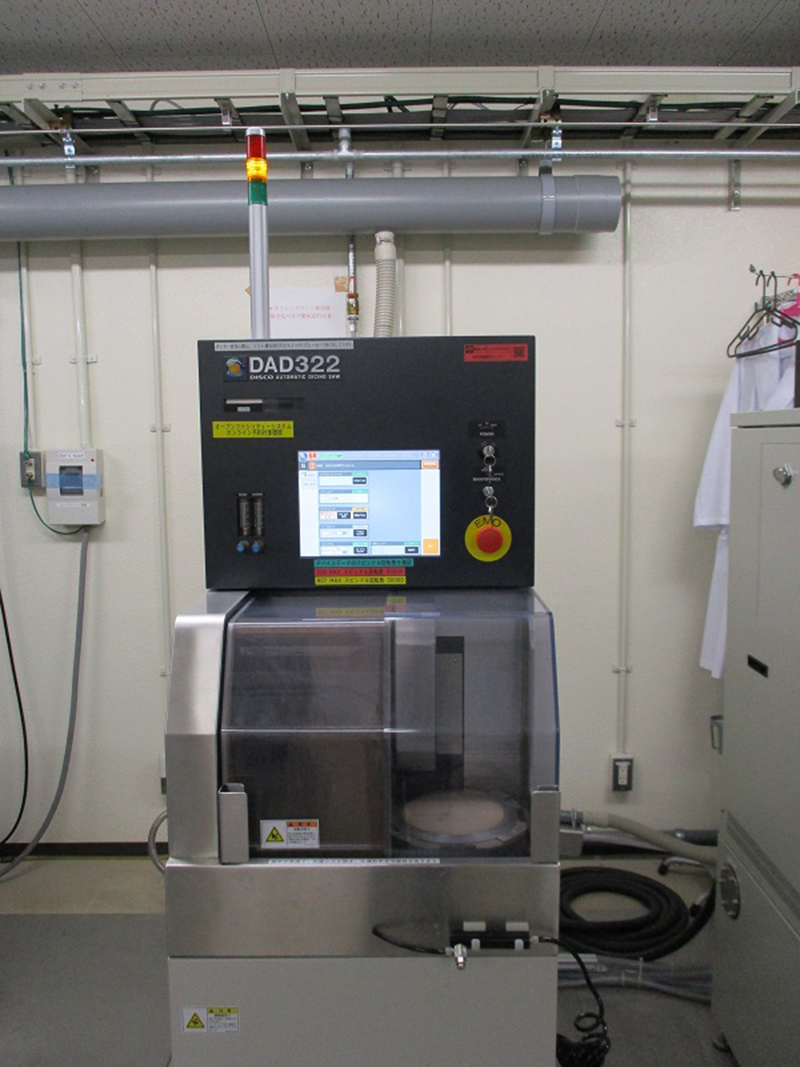
- メーカー名
- DISCO (DISCO)
- 型番
- DAD322
- 仕様・特徴
- ワークサイズ;φ6
切削可能範囲;160mm
送り速度範囲;0.1~500mm/s
- 設備ID
- BA-008
- 設置機関
- 筑波大学
- 設備画像
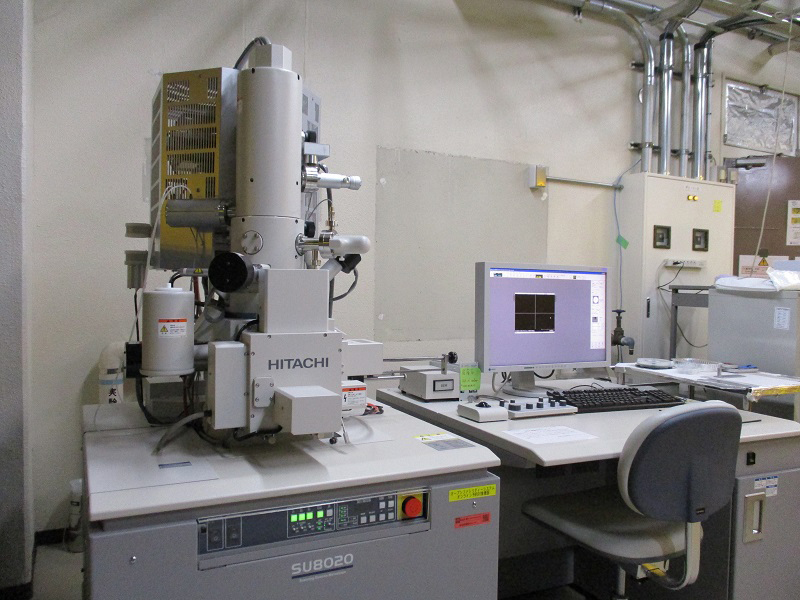
- メーカー名
- 日立ハイテク (Hitachi High-Tech)
- 型番
- SU-8020
- 仕様・特徴
- 二次電子分解能;1.0nm(加速電圧15kV,WD=4mm) 1.3nm(照射電圧1kV,WD=1.5mm)
照射電圧;0.1~30kV
低倍率モード;20~2,000倍(写真倍率)
高倍率モード;100~800,000倍(写真倍率)
SE/BSE信号可変方式
- 設備ID
- BA-009
- 設置機関
- 筑波大学
- 設備画像
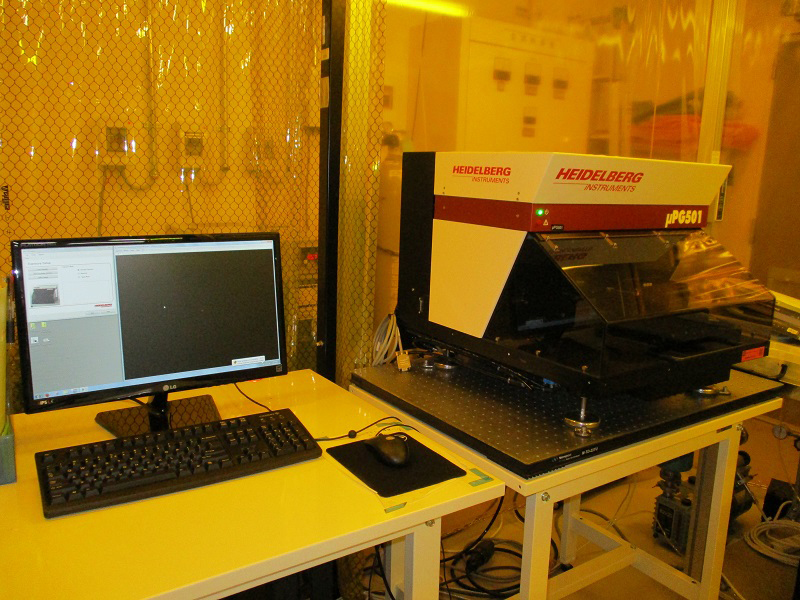
- メーカー名
- Heidelberg instruments (Heidelberg instruments)
- 型番
- μPG501
- 仕様・特徴
- 描画エリア;125×125mm2
最小描画サイズ;1.0μm
最小アドレッシンググリッド;50nm@1μm
描画スピード;50mm2/min@1μm,100mm2/min@2μm
"筑波大学"で検索した結果 26件
- 26件中 1~10件
- 1
- 2
- 3
- >