共用設備検索
共用設備検索結果
"膜加工・エッチング"で検索した結果 113件
- 113件中 1~10件
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 12
- >
- 設備ID
- GA-015
- 設置機関
- 香川大学
- 設備画像
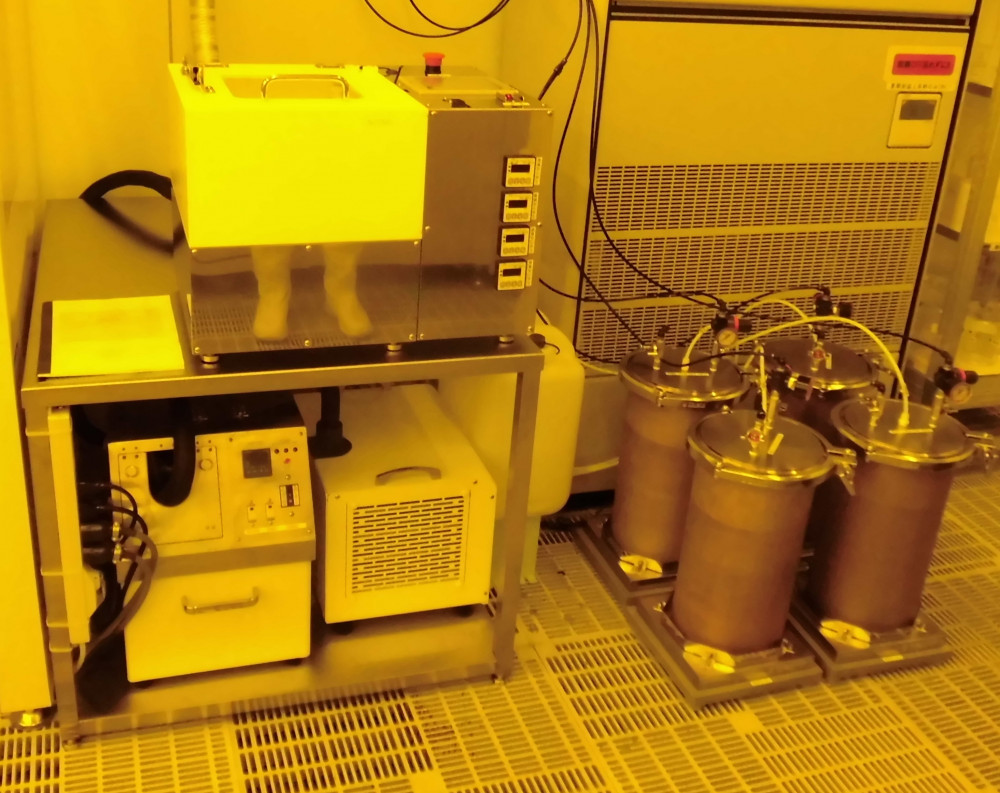
- メーカー名
- 滝沢産業 (TAKIZAWA SANGYO)
- 型番
- AD-1200(無機用),AD-1200(有機用)
- 仕様・特徴
- 基板サイズ:φ4"以下
基板ホルダー:真空吸着式
基板回転数:0~3000rpm 可変式
処理時間:999sec/stop(1sec単位)
使用薬液:無機系アルカリ液対応と有機溶剤対応
処理方法:スプレースイングアーム式
- 設備ID
- NU-267
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- RIE-10NR
- 仕様・特徴
- ・シリコン系エッチング
・対応基板サイズ:最大8インチ
・プロセスガス:CF4,Ar,O2
- 設備ID
- UT-510
- 設置機関
- 東京大学
- 設備画像
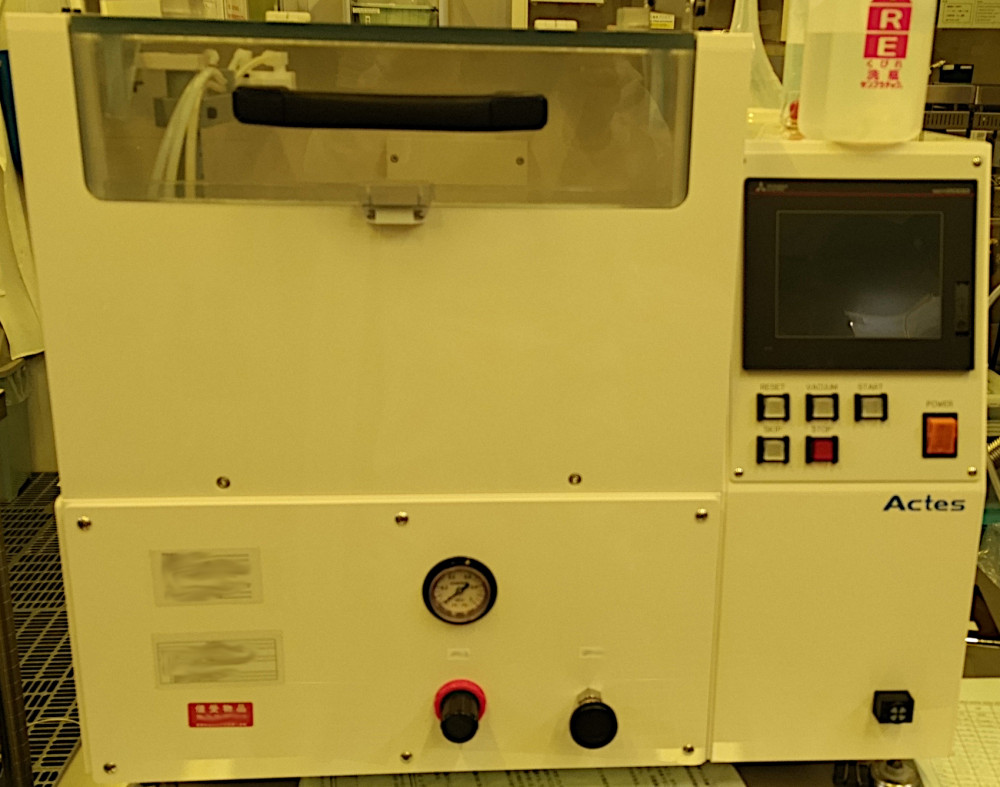
- メーカー名
- アクテス京三(株) (ActesKyosan Inc)
- 型番
- AEP-3000S
- 仕様・特徴
- 東京大学の電子線描画装置を用いて5009サイズのフォトマスクを作製するために使用する自動クロムエッチング装置。
試料サイズ:Φ2ーΦ6インチ、または100x100mm
プログラム設定:1プログラム最大99ステップ、50プログラム保存可能
回転数: 0-3000rpm
開店時間: 0-999sec
ノズル:薬液 2系等、リンス 1系統
- 設備ID
- NM-662
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![低ダメージ精密エッチング装置 [Spica]](data/facility_item/1707787439_11.jpg)
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- Spica
- 仕様・特徴
- プラズマ励起方式:誘導結合型
ICP出力:最大1kW
バイアス出力:最大300W
フッ素系ガスユニット:CHF3, CF4, C4F8, SF6, Ar, O2, N2
塩素系ガスユニット:Cl2, SiCl4, SF6, Ar, O2, N2
試料ステージ温度:10℃~30℃
最大試料サイズ:6インチΦ
- 設備ID
- NM-614
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![CCP-RIE装置 [RIE-200NL]](data/facility_item/NM-614.jpg)
- メーカー名
- サムコ (samco)
- 型番
- RIE-200NL
- 仕様・特徴
- ・用途:多種材料のドライエッチング
・プラズマ励起方式:平行平板型
・電源出力:最大300W
・プロセスガス:CHF3,CF4,SF6,Ar,O2,N2
・試料ステージ温度:室温
・最大試料サイズ:φ8inch
- 設備ID
- NM-615
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ICP-RIE装置 [RIE-101iPH]](data/facility_item/NM-615.jpg)
- メーカー名
- サムコ (samco)
- 型番
- RIE-101iPH
- 仕様・特徴
- ・用途:化合物半導体のドライエッチング
・金属薄膜のドライエッチング
・プラズマ励起方式:誘導結合型
・電源出力:ICP出力:最大1kW/バイアス出力:最大300W
・プロセスガス:Cl2,BCl3,Ar,O2,N2
・試料ステージ温度:200度以下
・最大試料サイズ:φ4inch
- 設備ID
- NM-616
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![シリコンDRIE装置 [ASE-SRE]](data/facility_item/NM-616.jpg)
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- MUC-21 ASE-SRE
- 仕様・特徴
- ・用途:MEMS等,シリコン深掘エッチング
・プラズマ励起方式:誘導結合型
・電源出力:ICP出力:最大1kW/バイアス出力:最大100W
・プロセスガス:SF6,C4F8,Ar,O2
・試料ステージ温度:室温
・最大試料サイズ:φ6inch
- 設備ID
- NM-617
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ICP-RIE装置 [RV-APS-SE]](data/facility_item/NM-617.jpg)
- メーカー名
- 住友精密工業 (Sumitomo Precision Products)
- 型番
- MUC-21 RV-APS-SE
- 仕様・特徴
- ・用途:SiC,SiN,SiO2等の高速エッチング
・プラズマ励起方式:誘導結合型
・電源出力:ICP出力:最大3kW/バイアス出力:最大1kW
・プロセスガス:CHF3,CF4,C4F8,SF6,Ar,O2,He
・試料ステージ温度:-10~+40度
・最大試料サイズ:φ6inch
・その他:SiO2エッチングレート:0.5μm/min以上,終点検出機能装備
- 設備ID
- NM-618
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![原子層エッチング装置 [PlasmaPro 100 ALE]](data/facility_item/NM-618.jpg)
- メーカー名
- オックスフォード・インストゥルメンツ (Oxford Instruments)
- 型番
- PlasmaPro 100 Cobra 300 ALE
- 仕様・特徴
- ・用途:GaN、GaAs、化合物半導体のドライエッチング
・プラズマ励起方式:誘導結合型
・電源出力:ICP出力:最大3kW/バイアス出力:最大300W
・プロセスガス:Cl2,BCl3,SF6,Ar,N2,O2
・試料ステージ温度:-30~+80度
・最大試料サイズ:φ6インチ(オプションで8インチ可)
・その他:ICP エッチング加工, ALE プロセス, 終点検出機能装備
- 設備ID
- TU-001
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- アズワン (As one)
- 型番
- PSH1200
- 仕様・特徴
- サンプルサイズ:小片~8インチ
"膜加工・エッチング"で検索した結果 113件
- 113件中 1~10件
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 12
- >
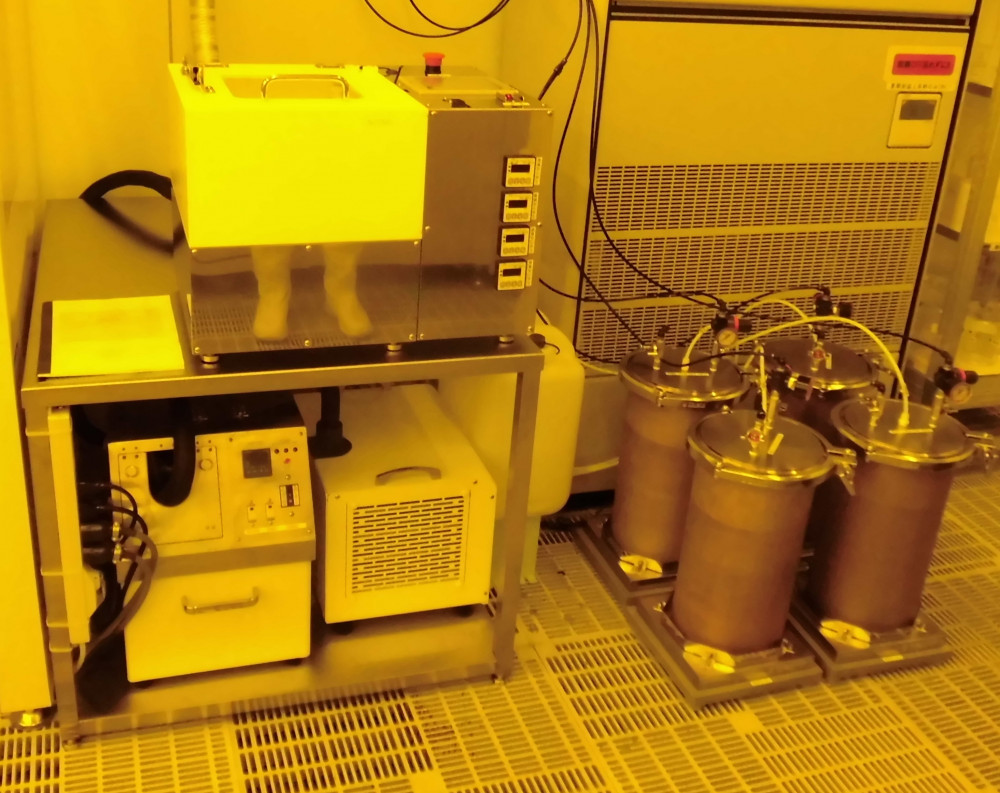

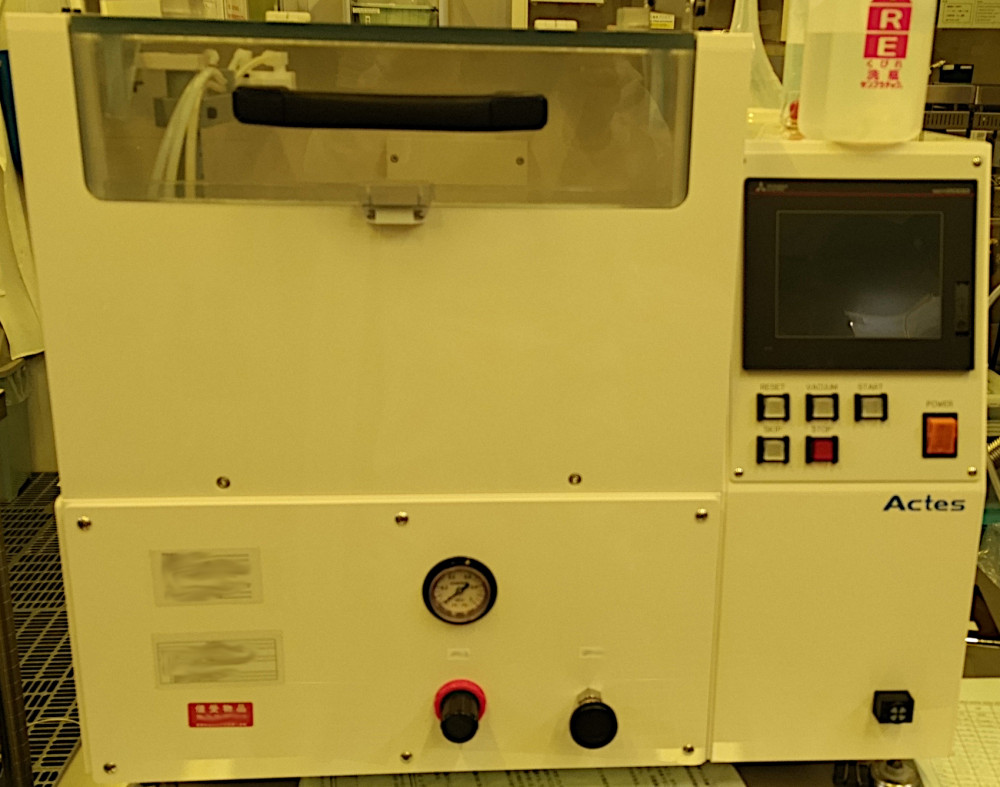
![低ダメージ精密エッチング装置 [Spica]](data/facility_item/1707787439_11.jpg)
![CCP-RIE装置 [RIE-200NL]](data/facility_item/NM-614.jpg)
![ICP-RIE装置 [RIE-101iPH]](data/facility_item/NM-615.jpg)
![シリコンDRIE装置 [ASE-SRE]](data/facility_item/NM-616.jpg)
![ICP-RIE装置 [RV-APS-SE]](data/facility_item/NM-617.jpg)
![原子層エッチング装置 [PlasmaPro 100 ALE]](data/facility_item/NM-618.jpg)
