共用設備検索結果
ウェッジワイヤボンダ (Ultrasonic Insulated Wire Bonder)
- 設備ID
- KT-223
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- ハイソル(株) (West Bond, Inc.)
- 型番
- 7476D
- 仕様・特徴
- 金線及びアルミ線をボンディング可能なマニュアルタイプのウエッジワイヤーボンダー
・ボンディング方式 US/TC/サーモソニック
・対応ワイヤ 18~50μmΦまでの金線及びアルミ線
ボールワイヤボンダ (Ball Wire Bonder)
- 設備ID
- KT-224
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- ハイソル(株) (West Bond, Inc.)
- 型番
- 7700D
- 仕様・特徴
- 金線ボンディング可能なマニュアルタイプのボールワイヤーボンダーとスイッチの切換えでバンプボンディングも可能
・ボンディング方式 US/TC/サーモソニック
・対応ワイヤ 18~50μmΦまでの金線
ダイボンダ (Dual Head Epoxy Die Bonder)
- 設備ID
- KT-225
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- ハイソル(株) (West Bond, Inc.)
- 型番
- 7200CR
- 仕様・特徴
- 銀ペースト,エポキシ材,UV硬化樹脂等の塗布及びチップのピックアンドプレスを行う事が可能なマニュアルタイプのダイボンダー
・ボンディング方式 荷重圧着方式
・最小チップサイズ □0.2mm
赤外透過評価検査・非接触厚み測定機 (Infrared MEMS Analyzer)
- 設備ID
- KT-227
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)モリテックス (MORITEX Corporation)
- 型番
- IRise-T
- 仕様・特徴
- 赤外線により、非接触にて対象物の観察(内部観察)を行い、かつシリコンウェハ上の薄膜の厚みを測定することができる。
・基板 最大Φ8インチウェハー
・画像分解能 0.26μm/画素
・厚さ分解能 0.01μm以下( 5~150μm )
高性能マッフル炉 (Muffle Furnace)
- 設備ID
- KT-229
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- アズワン(株) (AS ONE CORPORATION)
- 型番
- HPM-2N
- 仕様・特徴
- アズワン 高性能マッフル炉 HPM-2N
設定温度 100℃~1280℃
UVオゾンクリーナー・キュア装置 (UV Ozone Cleaner & DeepUV Cure Equipment)
- 設備ID
- KT-230
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- UV-300HKU
- 仕様・特徴
- サムコ株式会社 UV-300HKU
UVランプと高濃度オゾナイザを備える
Φ8インチウェハ対応
O2、N2ガス
ステージ加熱:室温~300℃
水蒸気プラズマクリーナー (Aqua Plasma Cleaner)
- 設備ID
- KT-231
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- AQ-500KU
- 仕様・特徴
- サムコ株式会社 Aqua Plasma クリーナー AQ-500KU
水蒸気(H2O)を用いたプラズマ処理
樹脂接合、金属酸化膜の還元、有機洗浄、超親水性処理
200mm角試料まで対応
真空蒸着装置(1) (Thermal Evaporator No.1)
- 設備ID
- KT-232
- 設置機関
- 京都大学
- 設備画像
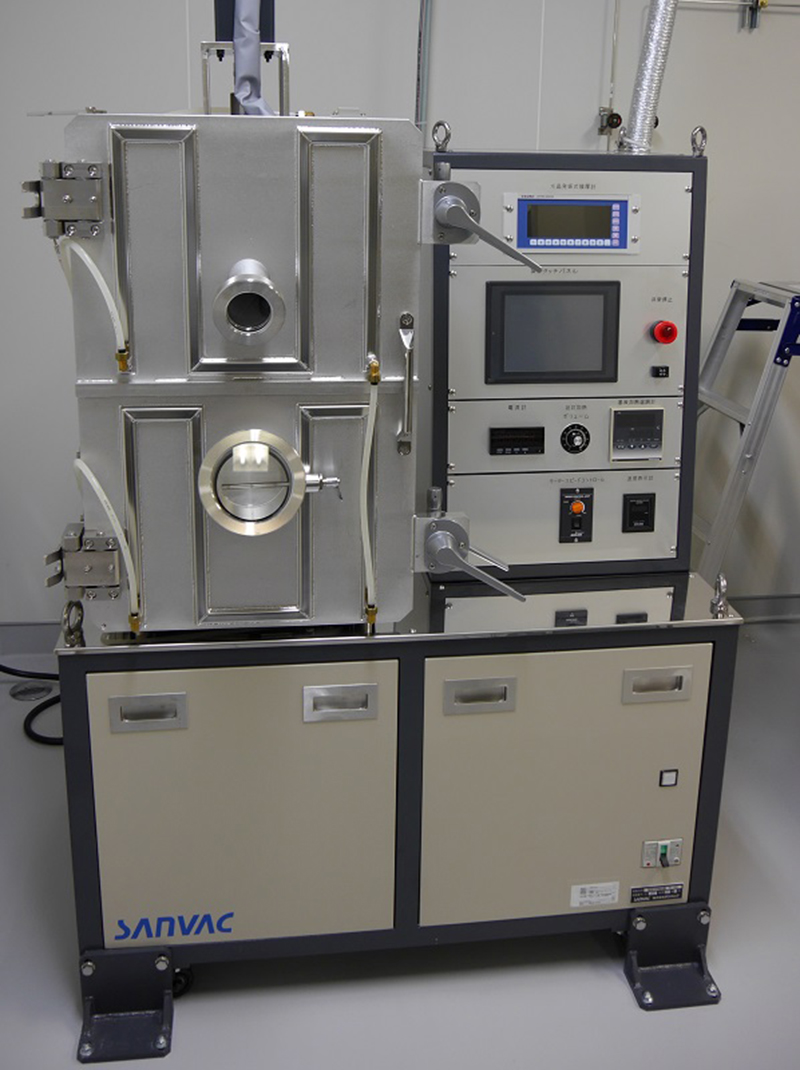
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃
真空蒸着装置(2) (Thermal Evaporator No.2)
- 設備ID
- KT-233
- 設置機関
- 京都大学
- 設備画像
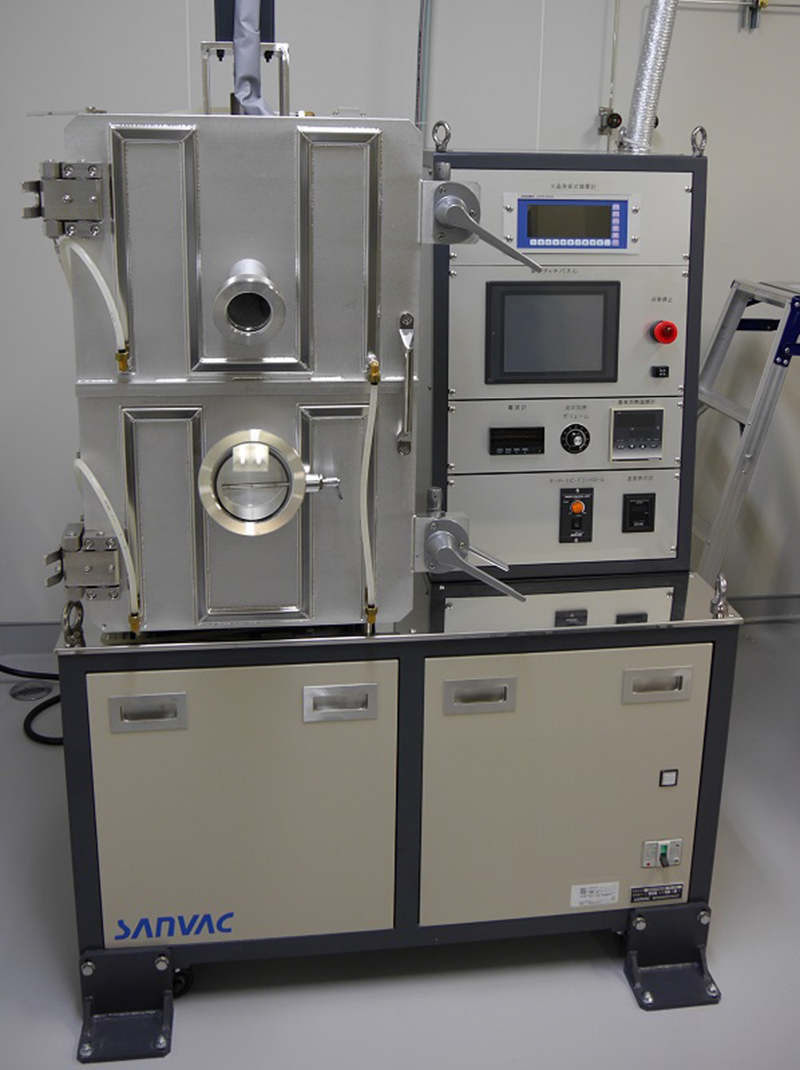
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃
深堀りドライエッチング装置(1) (Reactive Ion Deep Silicon Etcher No.1)
- 設備ID
- KT-234
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- RIE-800iPB-KU
- 仕様・特徴
- ボッシュプロセスを導入したMEMS用高速シリコンエッチング装置
(13.56MHz,400KHz 電源搭載)
・ボッシュプロセス
・基板サイズ Φ6ウエハ 用途:Si