共用設備検索
共用設備検索結果
- 設備ID
- KT-154
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- ユニオン光学(株) (Union Optical Co., Ltd.)
- 型番
- PEM-800
- 仕様・特徴
- 実験用両面マスクアライナ
・基板サイズ:Φ4
・マスクサイズ:□5
・両面露光、アライメント機能
- 設備ID
- KT-201
- 設置機関
- 京都大学
- 設備画像
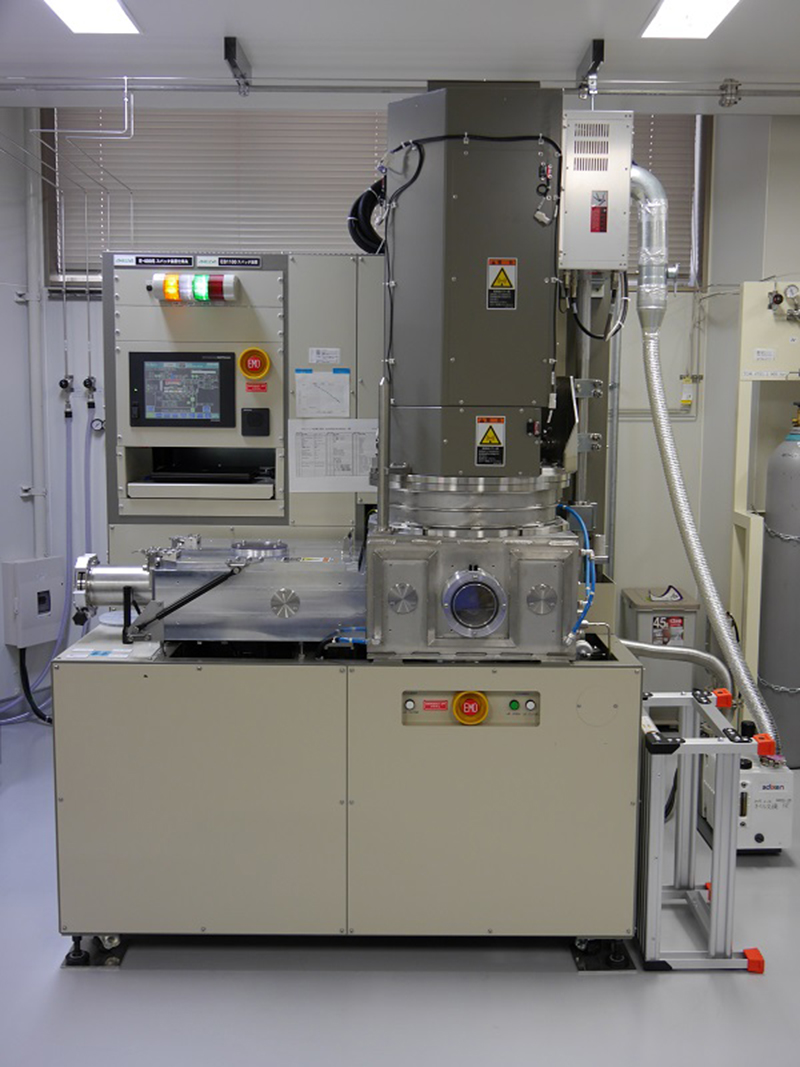
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1100
- 仕様・特徴
- 研究開発~小規模生産用の高性能RFマグネトロンスパッタリング装置(高温対応)。
・基板サイズ:Φ4、Φ6、不定形
・カソード:非磁性体Φ4PMC×4(RF電源:1,000W×2)
・TS距離:100~200mm
・温度:RT~800℃(ハロゲンランプ)
・ガス:Ar、O2
・ターゲット:Ti、Pt、PZT、PLT ほか
・ロードロック機構
- 設備ID
- KT-202
- 設置機関
- 京都大学
- 設備画像
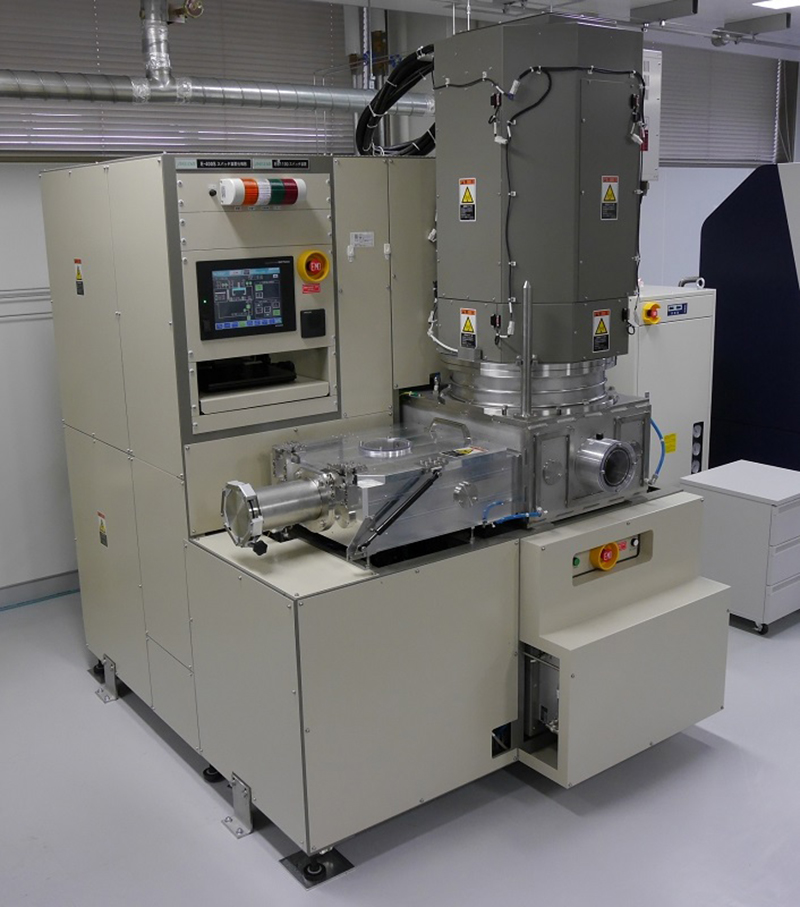
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1100
- 仕様・特徴
- 研究開発~小規模生産用の高性能RFマグネトロンスパッタリング装置(高温対応)。
・基板サイズ:Φ4、Φ6、不定形
・カソード:非磁性体Φ4PMC×3(RF電源:1,000W×3)
・TS距離:100~200mm
・温度:RT~800℃(ハロゲンランプ)
・ガス:Ar、O2、N2
・ターゲット: 各種メタル、各種金属酸化物 ほか
・ロードロック機構
- 設備ID
- KT-203
- 設置機関
- 京都大学
- 設備画像
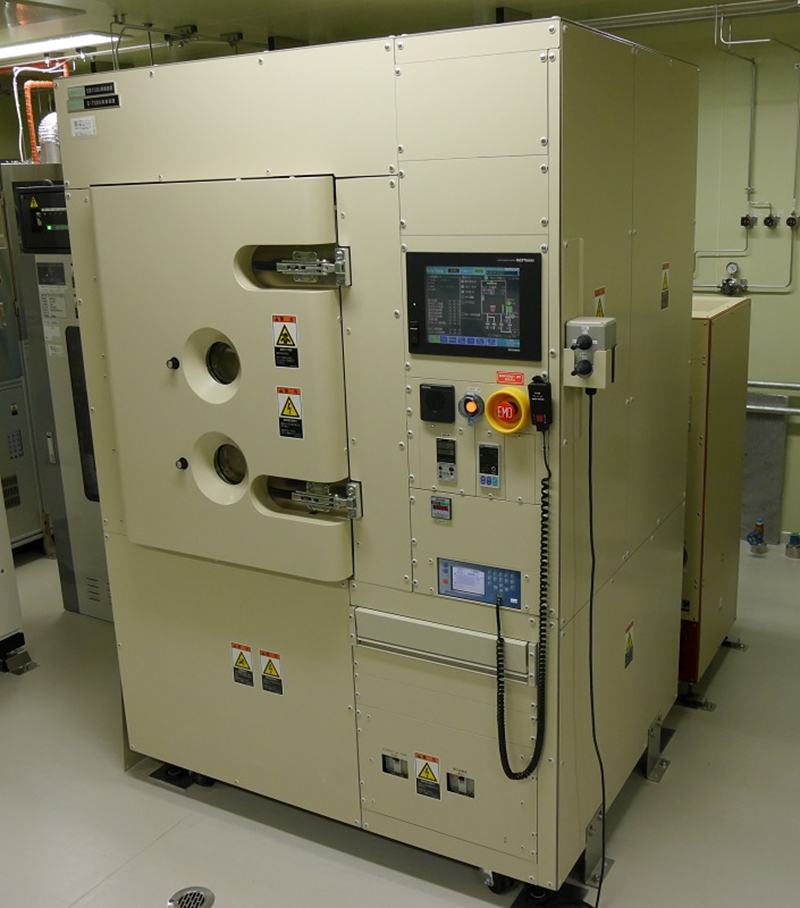
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1200
- 仕様・特徴
- リフトオフ対応の電子線蒸着装置
・基板サイズ:MAX Φ6×3枚
・電子銃:10kW 4連E型電子銃(22ml x 4)
・温度:RT~300℃(ハロゲンランプ)
・蒸着源-基板間距離:300mm(リフトオフ対応)
・蒸着材料:Al、Ti、Cr、Ni、Au、Pt、Ag、Pd ほか
- 設備ID
- KT-205
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 住友精密工業(株) (Sumitomo Precision Products CO., LTD.)
- 型番
- MPX-CVD
- 仕様・特徴
- 液体ソース(酸化膜/窒化膜用)を用いたプラズマCVD装置。
・基板サイズ:MAX Φ6
・RF電源:500W@上部(13.56MHz)、500W@下部(380kHz)
・プロセスガス:C4F8、H2 ほか
・液体ソース:TEOS(テトラエトキシシラン)、TSA(トリシリルアミン)
・温度:150~350℃
- 設備ID
- KT-206
- 設置機関
- 京都大学
- 設備画像
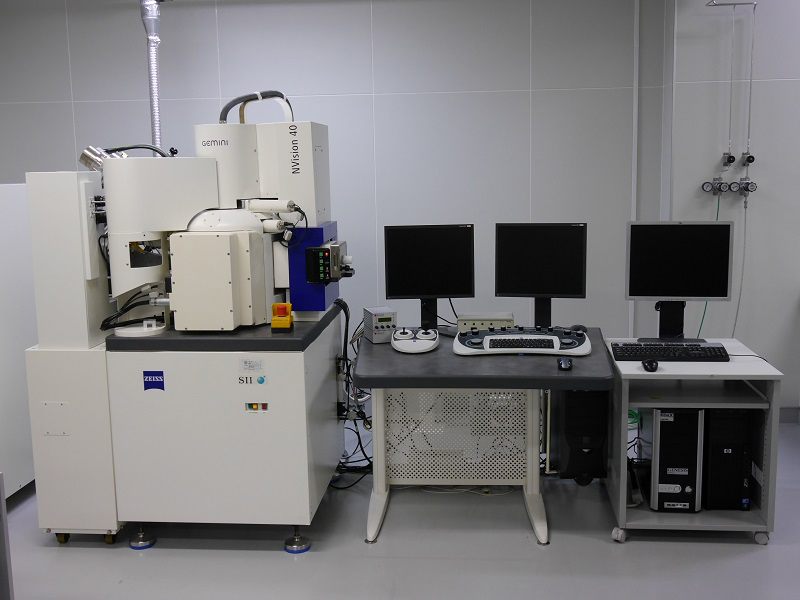
- メーカー名
- エスアイアイ・ナノテクノロジー(株) (SII NanoTechnology Inc.)
- 型番
- NVision40PI
- 仕様・特徴
- 高性能FIBとFE-SEMのクロスビーム装置(各種分析機能付)。
・基板サイズ:MAX Φ30mm
・検出器:SE×2(インレンズSE、チャンバーSE)、反射電子(EsB)
・ガスインジェクションシステム:C、W、SiOx
・マイクロプロービングシステム
・EDX/EBSDインテグレーションシステム:EDAX Pegasus
・ピコインデンターシステム
- 設備ID
- KT-207
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 光洋サーモシステム(株) (Koyo Thermo Systems Co., Ltd.)
- 型番
- MT-8X28-A
- 仕様・特徴
- ドライまたはウェット状態でウエハの高温加熱が可能(常用最高温度1,050℃)
・基板サイズ:MAXΦ6×25枚/バッチ
・常用最高温度:1,050℃
・雰囲気:N2、O2(乾燥または湿潤状態)
- 設備ID
- KT-209
- 設置機関
- 京都大学
- 設備画像
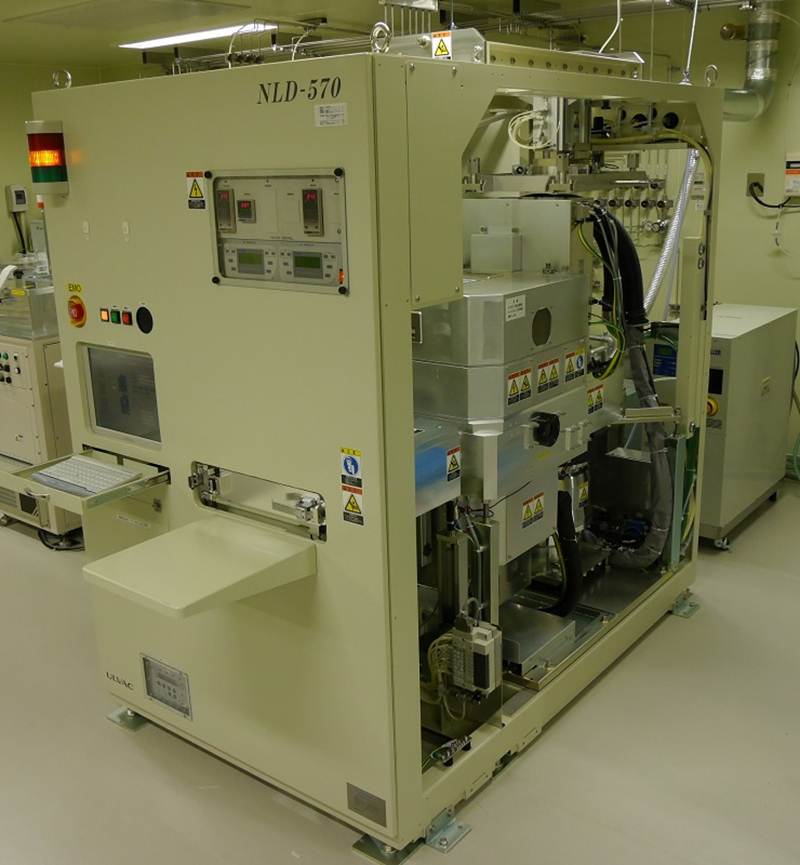
- メーカー名
- (株)アルバック (ULVAC, Inc.)
- 型番
- NLD-570
- 仕様・特徴
- 磁気中性線プラズマ(NLD)による低圧・低電子温度・高密度プラズマを搭載したドライエッチング装置。
・基板サイズ:Φ6
・RF電源:2kW@ICP(13.56MHz)、600W@BIAS(12.5MHz)
・プロセスガス:C4F8、CHF3、CF4、Cl2、BCl3 ほか
・用途:石英、ガラス、サファイア、金属酸化物 ほか
・ロードロック機構
- 設備ID
- KT-210
- 設置機関
- 京都大学
- 設備画像
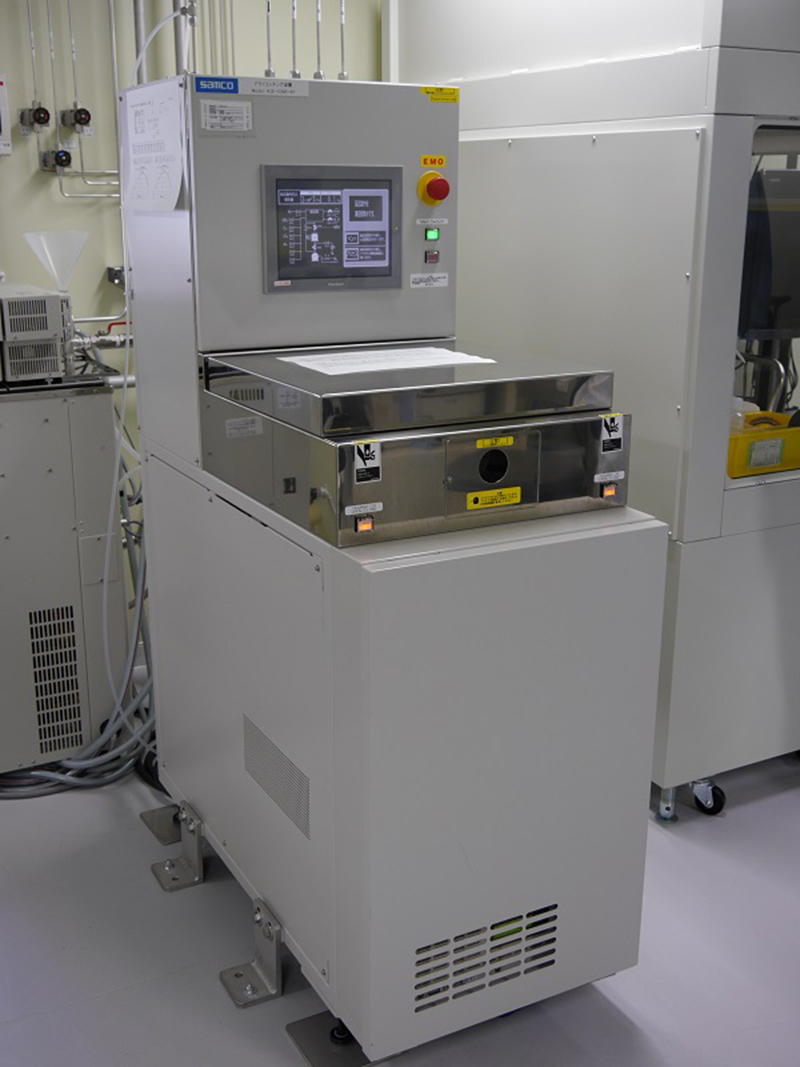
- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- RIE-10NR-KF
- 仕様・特徴
- 汎用的な平行平板型反応性イオンエッチング装置。
・基板サイズ:MAX Φ8
・プロセスガス:CHF3、CF4、Ar、O2
・用途: SiO2、SiN、アッシング ほか
- 設備ID
- KT-211
- 設置機関
- 京都大学
- 設備画像
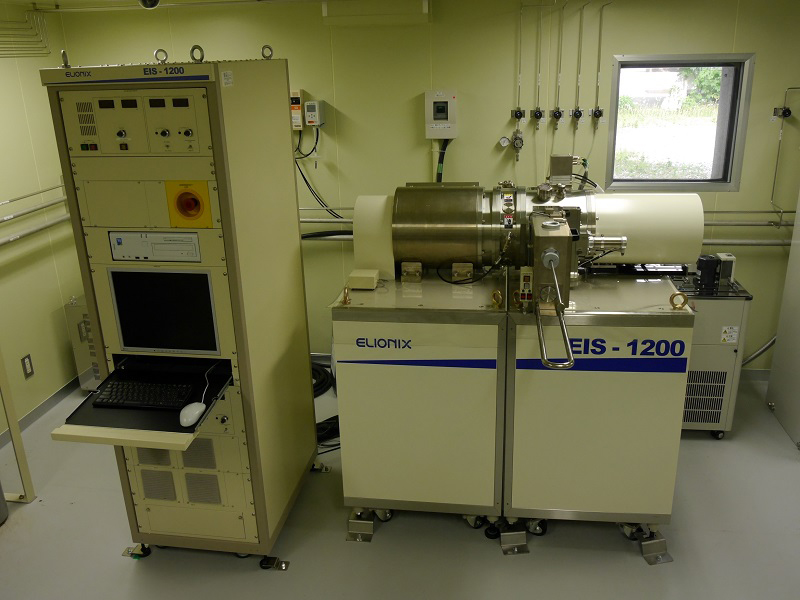
- メーカー名
- (株)エリオニクス (ELIONIX INC.)
- 型番
- EIS-1200
- 仕様・特徴
- ECRプラズマを用いた異方性ドライエッチング装置。(ナノインプリントモールド作成用途に最適)
・基板サイズ:Φ2.5、Φ6、□75×7mm
・加速電圧Vac:30~3,000V
・ビーム電流密度:>1.0mA/cm2@Vac 1,000V/ArまたはO2
・ビーム径:Φ108mm@Vac 700V/ArまたはO2/0,4~0.6mA/cm2
・用途:Si、磁性体 ほか
・ロードロック機構
"京都大学"で検索した結果 108件
- 108件中 21~30件
- <
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 11
- >