共用設備検索結果
レジスト現像装置 ( Photoresist Developer)
- 設備ID
- KT-110
- 設置機関
- 京都大学
- 設備画像
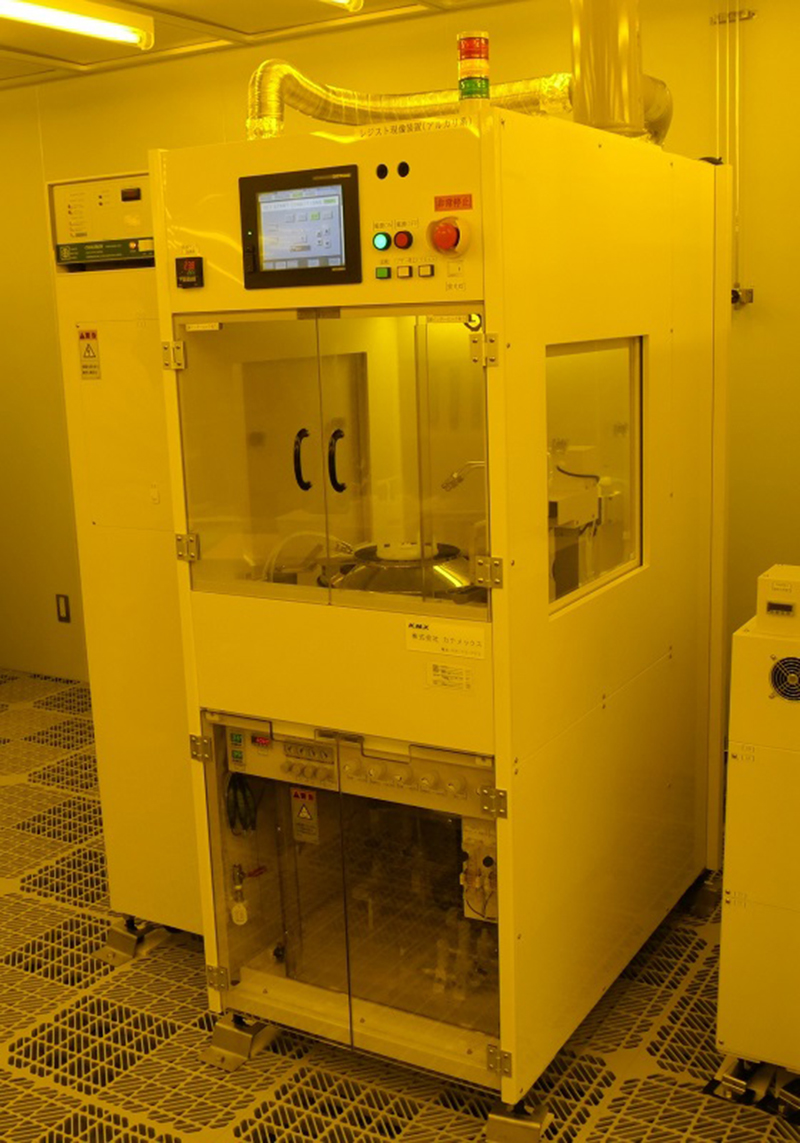
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KD-150CBU
- 仕様・特徴
- 汎用的な枚葉式アルカリ現像装置。
・基板サイズ:Φ2~Φ6、□2.5、□5、不定形
・現像液:アルカリ(TMAH 2.38%)
・現像方式:スプレー、パドル
・対応レジスト:UVレジスト、EBレジスト(NEB22)ほか
ウエハスピン洗浄装置 (Wafer Spin Cleaner )
- 設備ID
- KT-111
- 設置機関
- 京都大学
- 設備画像
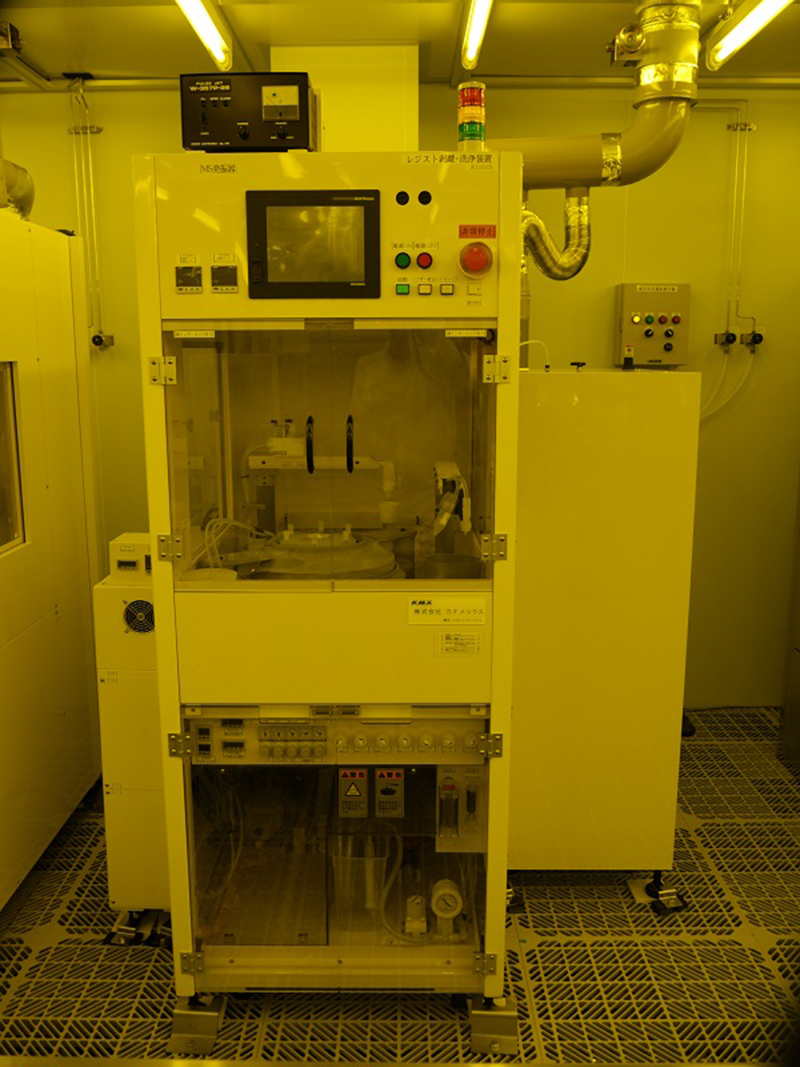
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KSC-150CBU
- 仕様・特徴
- 汎用的な枚葉式ウエハ洗浄装置。
・基板サイズ:Φ2-Φ6、□2.5、□5、□7、不定形
・洗浄方式:ピラニア、メガソニック、2流体、純水
ICP質量分析装置 (Inductively Coupled Plasma Mass Spectrometer)
- 設備ID
- KT-112
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- アジレント・テクノロジー(株) (Agilent Technologies, Inc.)
- 型番
- Agilent7700s
- 仕様・特徴
- Arプラズマでイオン化させたサンプルを四重極質量分析計で測定することで高感度元素分析を実現。
・感度(Mcps/ppm):50@Li(7)、160@Y(89)、80@Tl(205)
・半導体アプリケーション専用設計
超微細インクジェット描画装置 (Super Fine Inkjet Printer)
- 設備ID
- KT-113
- 設置機関
- 京都大学
- 設備画像
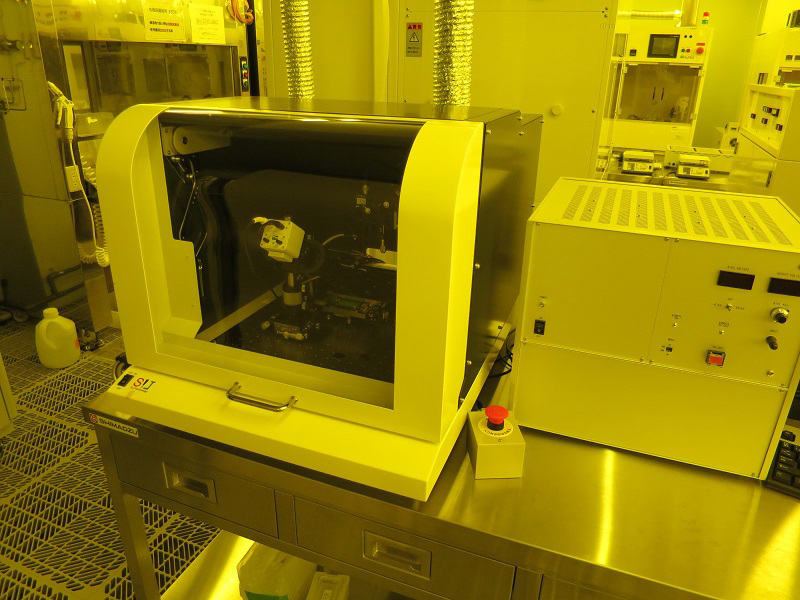
- メーカー名
- (株)SIJテクノロジ (SIJTechnology, Inc.)
- 型番
- ST050
- 仕様・特徴
- 超微量・高粘度吐出のスーパーインクジェットヘッドにより、大気圧・常温下で微細パターンの直接描画が可能。
・最小吐出量:0.1fL
・最小ライン幅:0.6μm
・対応粘度:0.5~10,000cps
・付属ソフトウェア(複雑パターンが可能)
有機現像液型レジスト現像装置 (EB-Resist Developer)
- 設備ID
- KT-114
- 設置機関
- 京都大学
- 設備画像
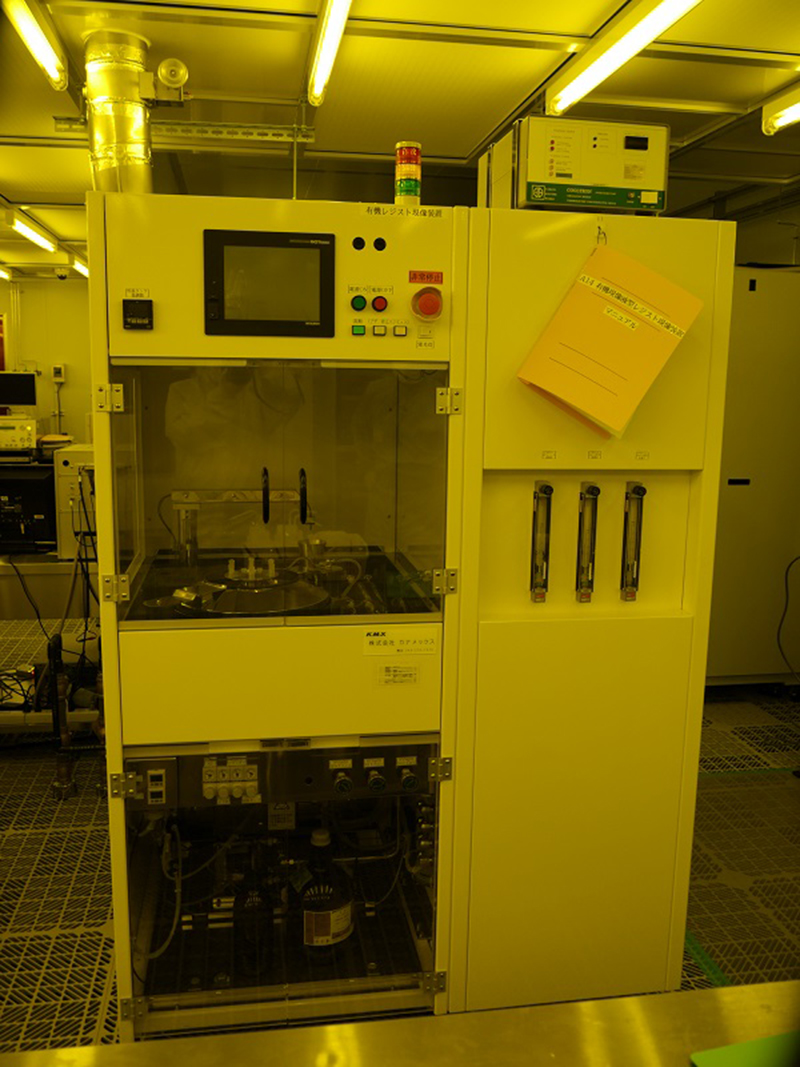
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KD(EB)-150CBU
- 仕様・特徴
- 汎用的な枚葉式有機系現像装置。
・基板サイズ:Φ4、Φ6、□30mm、□40mm
・現像液:有機溶剤系現像液、IPAリンス
大面積超高速電子ビーム描画装置 (Large Area and Ultra-High Speed Electron Beam Lithography)
- 設備ID
- KT-115
- 設置機関
- 京都大学
- 設備画像
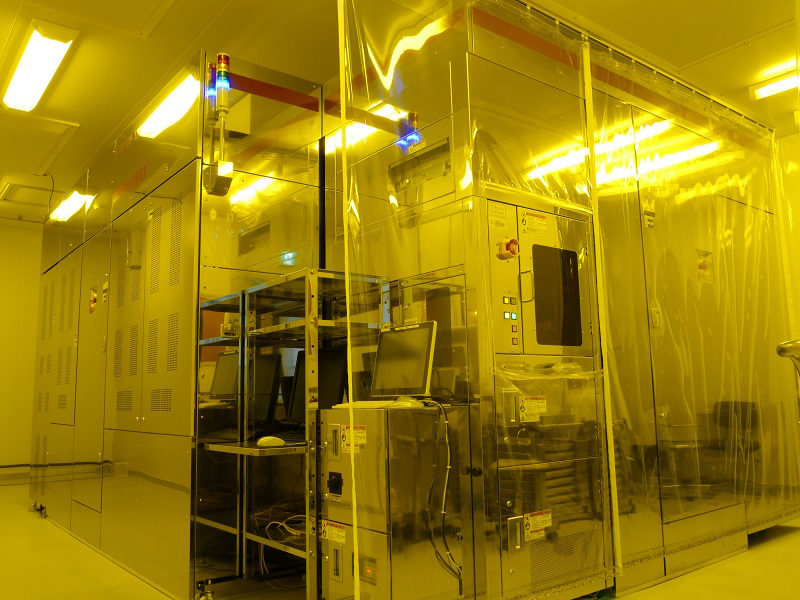
- メーカー名
- (株)アドバンテスト (ADVANTEST CORPORATION)
- 型番
- F7000S-KYT01
- 仕様・特徴
- 1Xnmの解像性能で、研究開発から製造までの幅広い用途に対応。
・加速電圧:50kV(ビーム電流:640A)
・解像度:1Xnm
・基板:□10mm~Φ8
・露光方式:CP、VSB(超高速描画対応)
近接効果補正システム (Proximity Effect Correction System)
- 設備ID
- KT-116
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- GenISys(株) (GenISys Inc.)
- 型番
- BEAMER Full Package
- 仕様・特徴
- 電子線描画装置、レーザー描画装置用の最適露光データ作成のための支援ツール。
・近接効果補正(PEC):2Dドーズ補正、形状補正、3D補正、コーナー補正
・光近接効果補正(OPC):線形補正、コーナー補正、全体形状補正
・グレイスケール露光における補正
・入出力フォーマット:エリオニクス社、アドバンテスト社、ハイデルベルグ社
・モンテカルロ法によるPSF値の導出対応。
超臨界洗浄・乾燥装置 (Supercritical Rinser & Dryer)
- 設備ID
- KT-117
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)レクザム (Rexxam Co., Ltd.)
- 型番
- SCRD401
- 仕様・特徴
- 超臨界CO2により微細構造物を変形・破壊せずに洗浄・乾燥が可能。
・基板サイズ:MAXΦ4
高圧ジェットリフトオフ装置 (High Pressure Jet Lift-off System)
- 設備ID
- KT-118
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KLO-200SV1
- 仕様・特徴
- 高圧ジェット(NMP)を用いた枚葉式スピンリフトオフ装置。
・基板サイズ:Φ4、Φ6、不定形
・高温NMPによるレジスト膨潤(MAX80℃)
・MAX14MPaの高圧ジェットによるバリ&再付着防止
移動マスク紫外線露光装置 (Moving Mask UV Lithography)
- 設備ID
- KT-153
- 設置機関
- 京都大学
- 設備画像
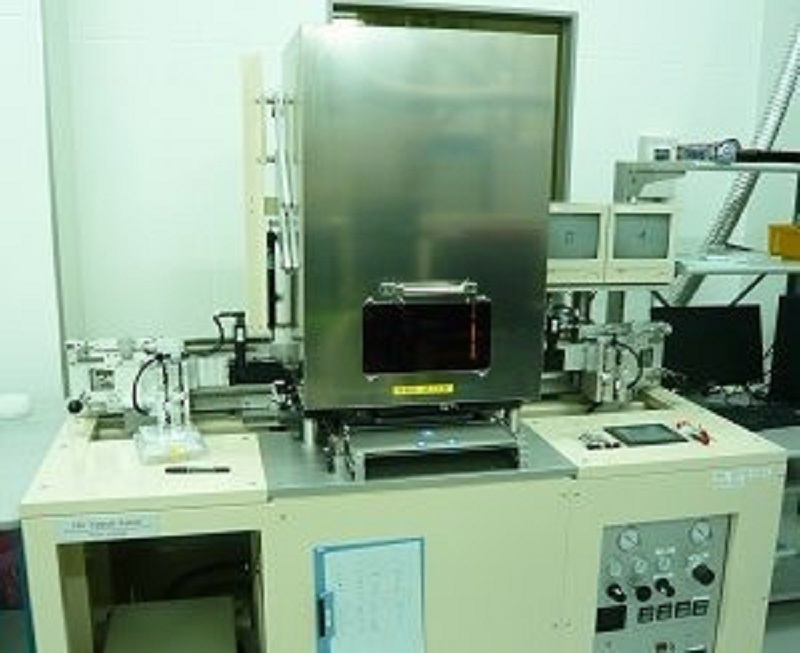
- メーカー名
- (株)大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MUM-0001
- 仕様・特徴
- UV露光中にマスクを周期移動させることで3次元微細構造を実現。
・基板サイズ:Φ4
・3次元微細構造製作可能