共用設備検索結果
回路&レイアウト設計ツール (Ics Design & Layout Editor)
- 設備ID
- KT-120
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- タナーEDA (Tanner EDA)
- 型番
- Tanner Tools Pro
- 仕様・特徴
- ・回路設計:回路図エディタ、SPICEシミュレータほか
・レイアウト設計:全角度マスクエディタ、SDL、対応形式(GDSII、CIF、OASIS、DXF、Gerberほか)
・物理検証:DRC、LVS
両面マスクアライナー (Manual High Precision Double-Sided Mask Aligner)
- 設備ID
- KT-155
- 設置機関
- 京都大学
- 設備画像
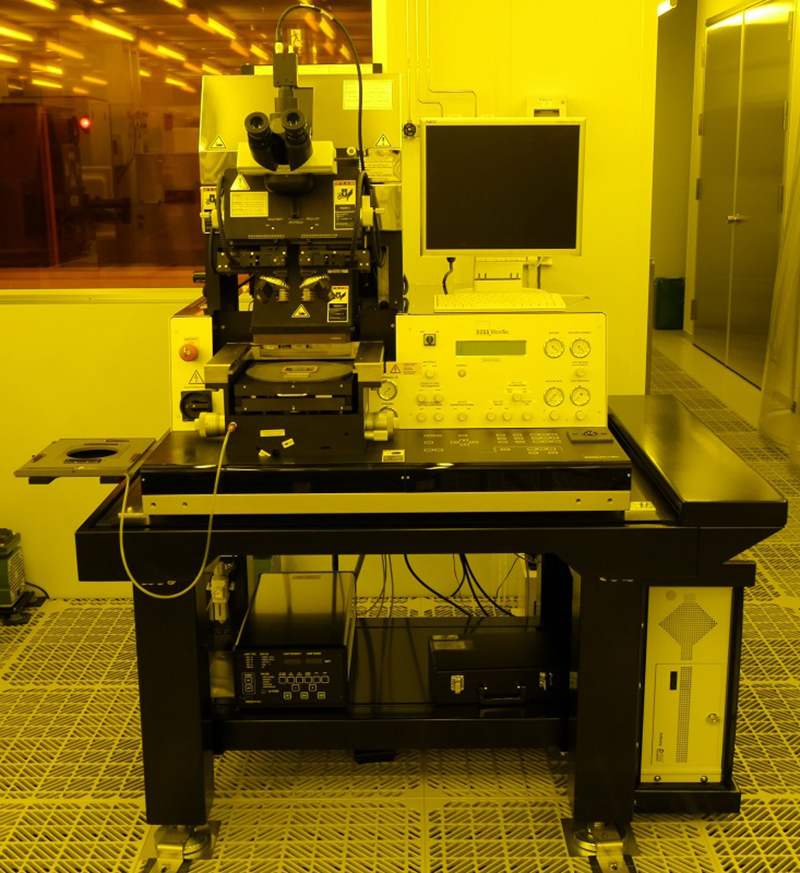
- メーカー名
- ズース・マイクロテック(株) (SUSS MicroTec)
- 型番
- MA6 BSA SPEC-KU/3
- 仕様・特徴
- 高性能手動両面マスクアライナ装置。
・光源:高圧UVランプ350W(h、i線)
・基板サイズ:Φ4"、Φ6"
・露光モード:コンタクト(ソフト、ハード)、プロキシミティ
・アライメント精度 :±0.5um@表面、 ±0.1um@裏面
・厚膜レジスト対応
原子層堆積装置 (Atomic Layer Deposition)
- 設備ID
- KT-238
- 設置機関
- 京都大学
- 設備画像
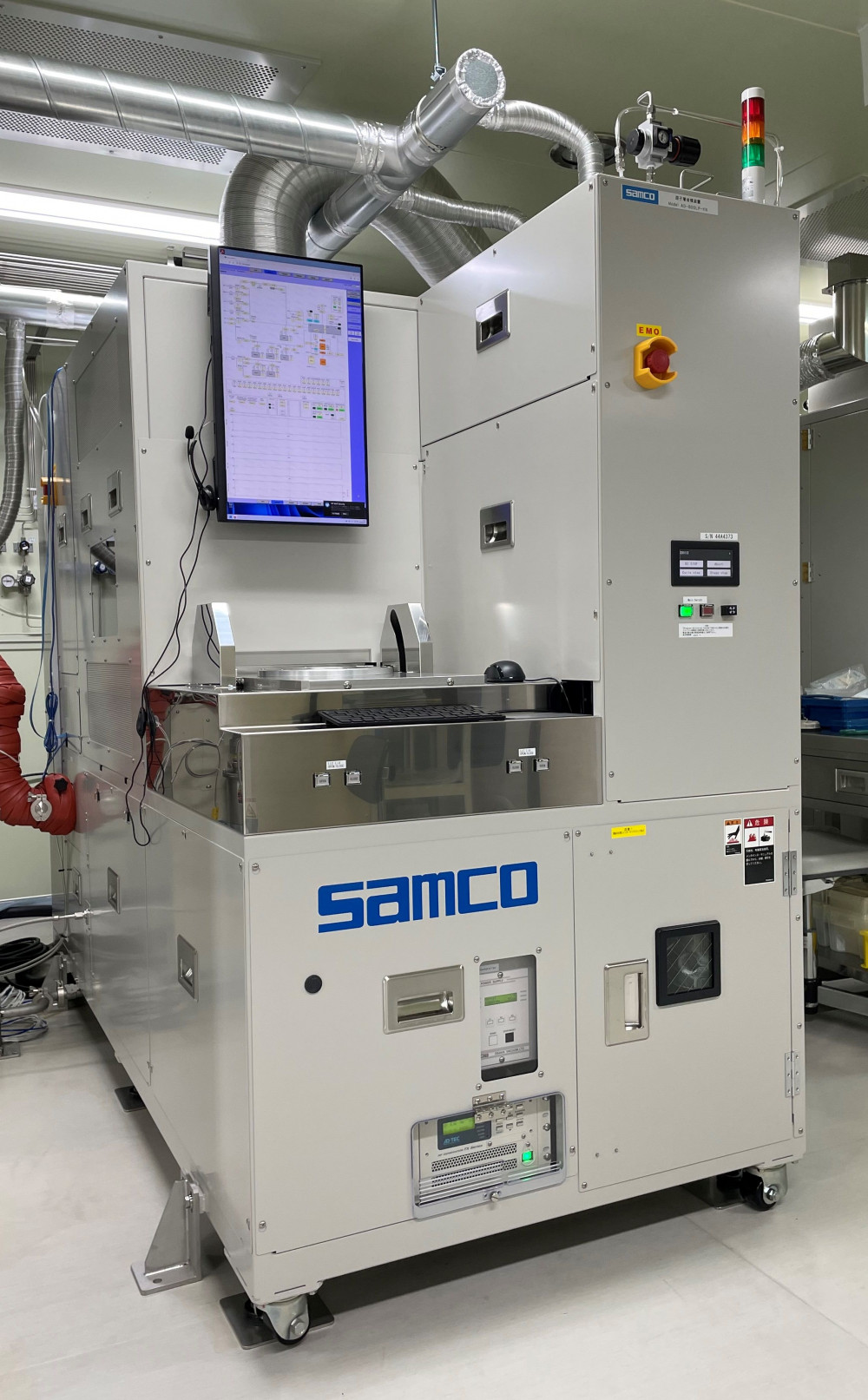
- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- AD-800LP-KN
- 仕様・特徴
- ナノレベルかつコンフォーマルの薄膜を形成するためのALD装置。ゲート酸化膜、バリア膜、透過防止膜などへの利用が可能。
・成膜方式:サーマル/プラズマ
・基板サイズ:小片~Φ8"
・材料ガス:BDEAS(Si系)、TMA(Al系)、TDMAT(Ti系) ほか(要相談)
・反応ガス:H2O、O2、O3、N2、NH3、H2
・キャリアガス:Ar、N2
UVナノインプリント装置 (UV-based Nanoimprint Lithography)
- 設備ID
- KT-239
- 設置機関
- 京都大学
- 設備画像
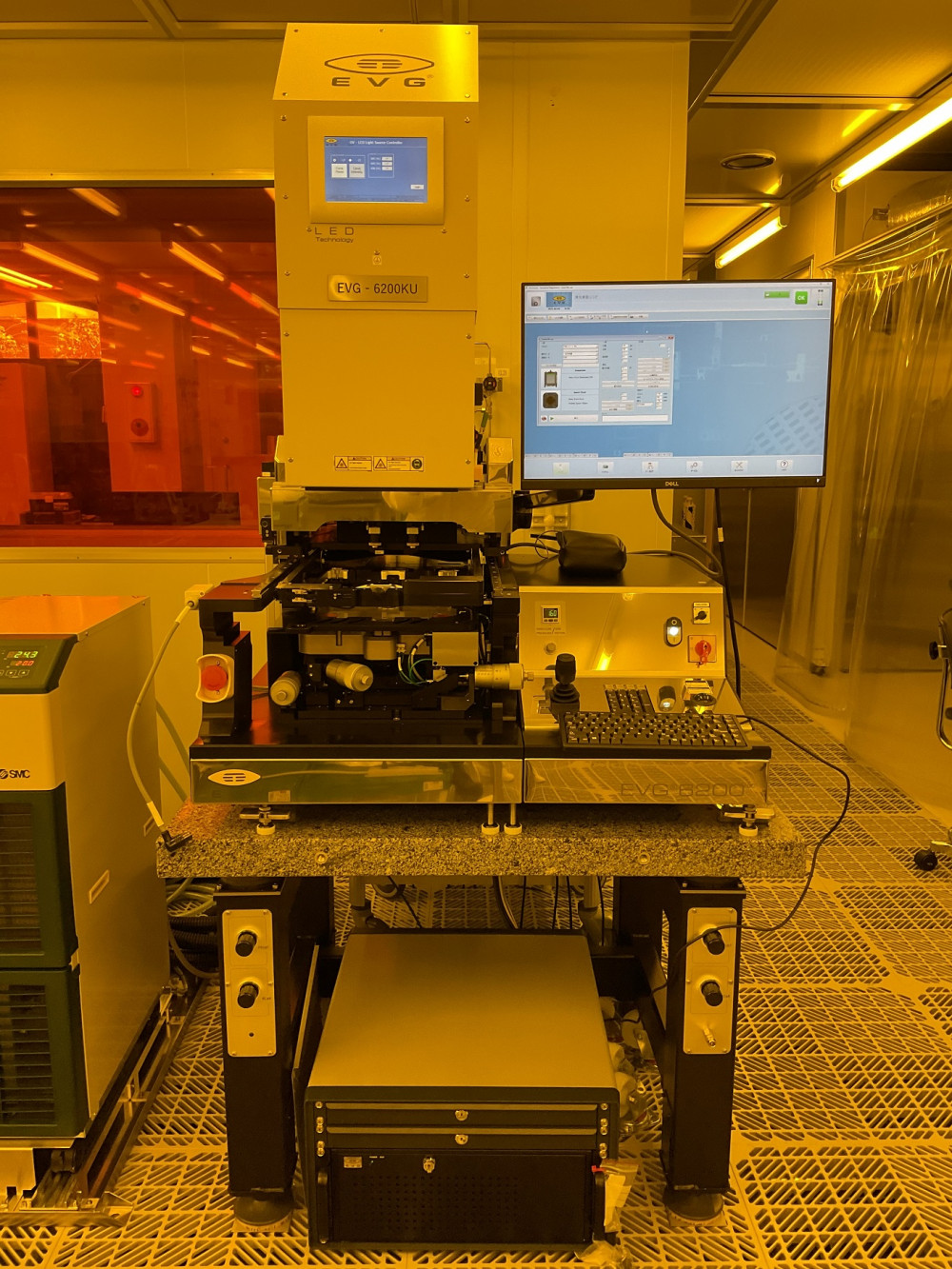
- メーカー名
- イーヴィグループ (EV Group)
- 型番
- EVG6200TBN
- 仕様・特徴
- 光硬化性ポリマーやフォトレジストにナノ・マイクロレベルの構造を形成する光インプリントリソグラフィー装置。
・LED光源:365nm、405nm、436nm
・最大基板サイズ:6インチΦ(不定形対応)
・アライメント:±3.0μm
熱インプリント装置 (Hot Embossing System)
- 設備ID
- KT-240
- 設置機関
- 京都大学
- 設備画像
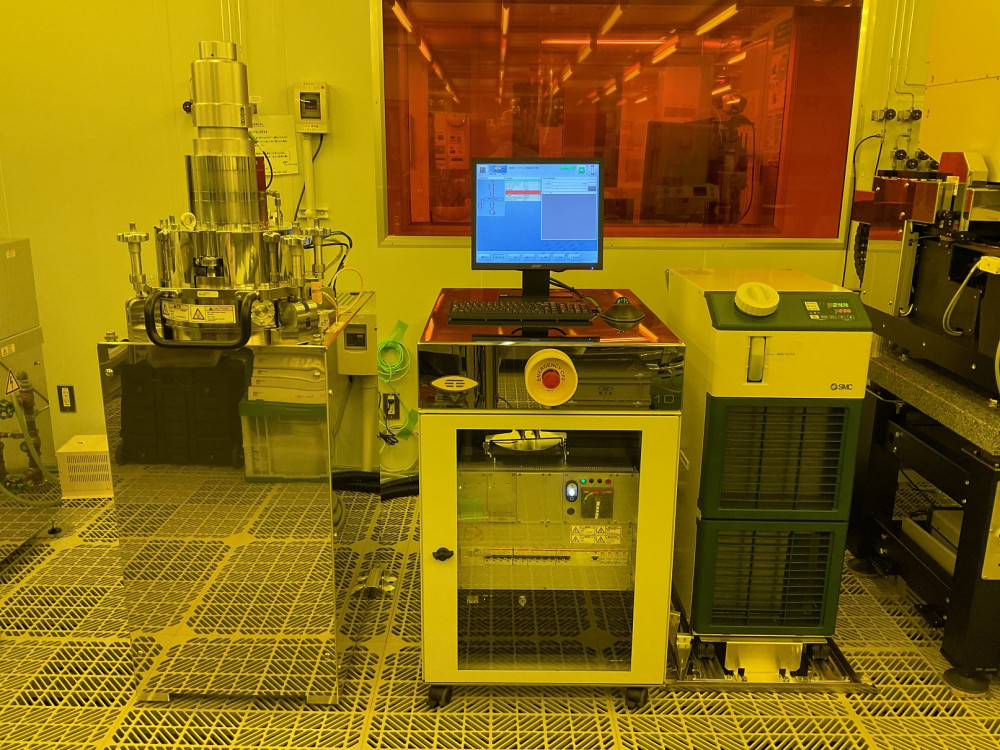
- メーカー名
- イーヴィグループ (EV Group)
- 型番
- EVG510
- 仕様・特徴
- プラスチック基板やポリマーを塗布した半導体ウェハを加熱加圧によりエンボス加工する装置。
・最大基板サイズ:6インチΦ(不定形対応)
・最高プロセス温度/荷重:350℃/20kN
ナノインプリントシステム (Nanoimprint Lithography)
- 設備ID
- KT-257
- 設置機関
- 京都大学
- 設備画像
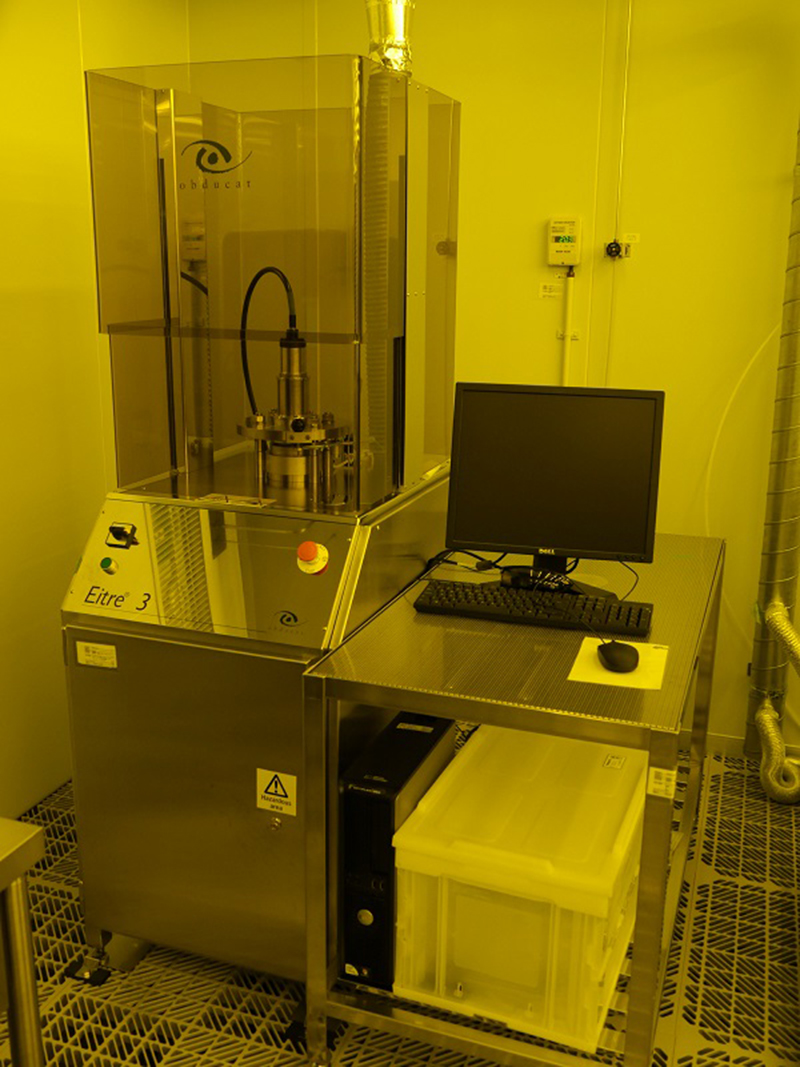
- メーカー名
- Obducat社 (OBDUCAT AB)
- 型番
- Eitre3
- 仕様・特徴
- 最大3インチの基板サイズ対応の一括転写ナノインプリント装置
・基板サイズ φ3
・インプリント方式 STU/熱/UV、全面一括
・最高到達温度(熱インプリント時) 250℃
電子線蒸着装置(2) (Electron Beam Evaporator No.2)
- 設備ID
- KT-258
- 設置機関
- 京都大学
- 設備画像
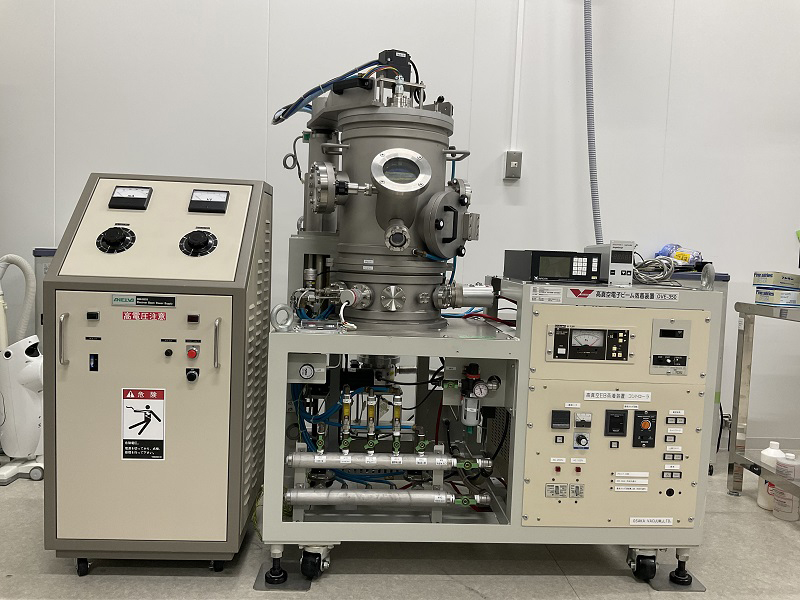
- メーカー名
- (株)大阪真空機器製作所 (Osaka Vacuum, Ltd.)
- 型番
- OVE-350
- 仕様・特徴
- 実験用電子線蒸着装置。
・基板サイズ:MAX Φ3""
・電子銃:2kW3連E型電子銃(1m×3)
・温度:300℃(ハロゲンランプ)
深堀りドライエッチング装置(2) (Reactive Ion Deep Silicon Etcher No.2)
- 設備ID
- KT-259
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- RIE-800iPB-KU
- 仕様・特徴
- ボッシュプロセスを導入したMEMS用高速シリコンエッチング装置
(13.56MHz,400KHz 電源搭載)
・ボッシュプロセス
・基板サイズ Φ6"ウエハ 用途:Si