共用設備検索結果
ウェハ洗浄装置 (Single Wafer Cleaning System)
- 設備ID
- IT-020
- 設置機関
- 東京工業大学
- 設備画像
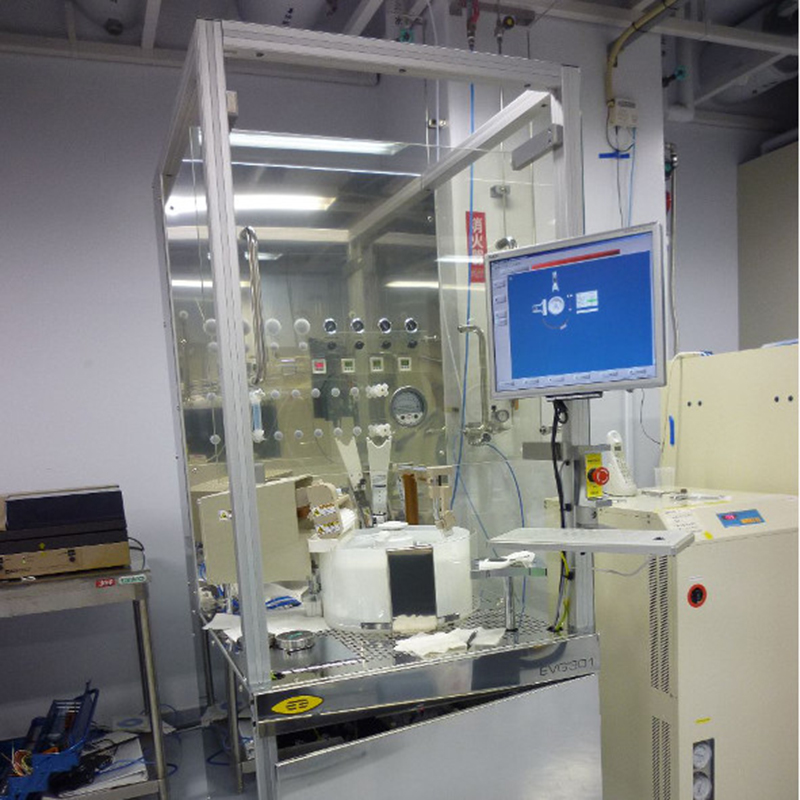
- メーカー名
- EVG (EVG)
- 型番
- EVG301
- 仕様・特徴
- ・PVA製スポンジブラシ洗浄 ・メガソニック洗浄(最大振動子出力:40 W) ・対応基板サイズ:2インチウェハ/2 cm×2 cm角/3 cm×3 cm角
ダイシングソー及びダイシング補助装置 (Dicing saw and dicing support apparatus)
- 設備ID
- IT-027
- 設置機関
- 東京工業大学
- 設備画像
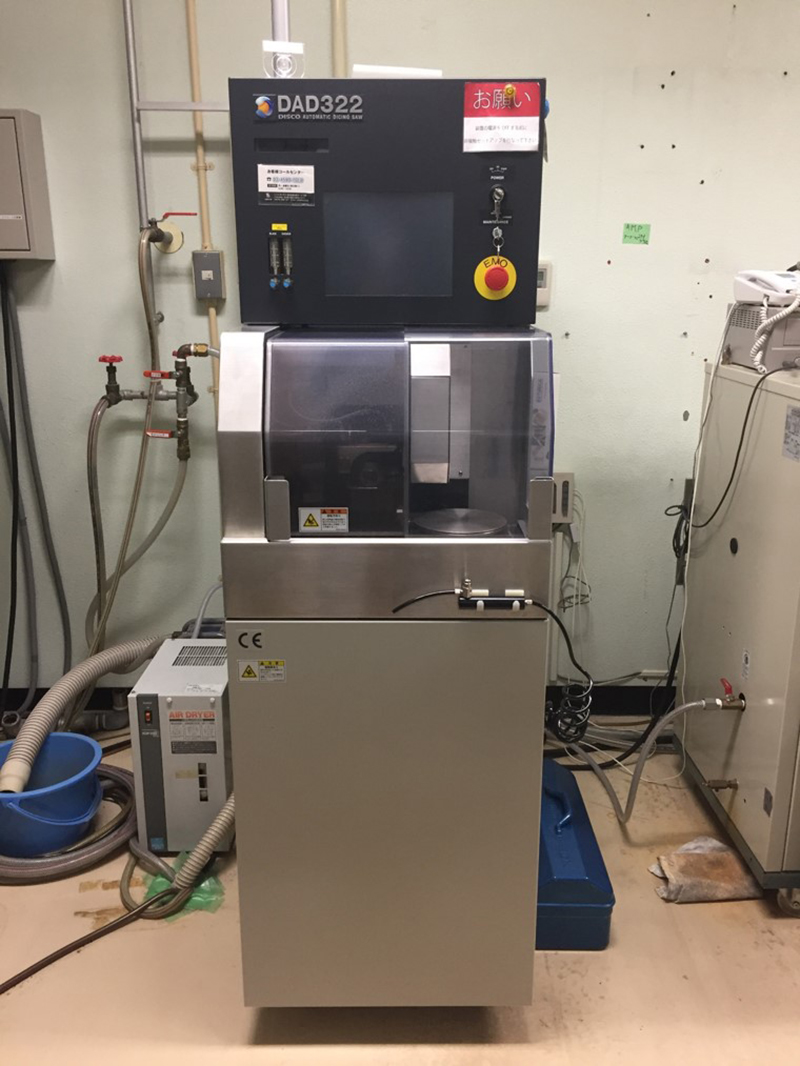
- メーカー名
- ディスコ (Disco)
- 型番
- DAD322
- 仕様・特徴
- φ6インチ 切削可能範囲 x軸160mm y軸162m z軸32.2mm(φ2ブレード時) UV照射装置およびウェハ拡張装置 ヒューグルエレクトロニクス HUV-0608/HS-1840(6インチダイシングフレーム(ディスコDTF2-6-1互換)設置可)によるダイシング前後処理も可能
ダイシング装置 (Dicing equipment)
- 設備ID
- TT-013
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- 岡本工作機械製作所 (okamoto machine tool works,LTD)
- 型番
- ADM-6DBV
- 仕様・特徴
- φ6インチ以下基板のダイシング加工
ダイサー (Dicing Saw)
- 設備ID
- RO-601
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- ディスコ (DISCO Corporation)
- 型番
- DAD322
- 仕様・特徴
- 最大6インチまで対応可。
Si, SiO2, SiCウェハ等のダイシング用。
ダイシングマシン (Dicing system)
- 設備ID
- GA-010
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- DISCO (Disco)
- 型番
- DAD3220
- 仕様・特徴
- 切削方法:ダイヤモンドブレードを用いた切削
切削可能範囲:Φ6インチ、厚さ1mm程度まで対応可能
加工対象:Si、ガラス、半導体パッケージ、セラミックス、石英、水晶等
切削精度:5μm程度
切削速度:0.1~500mm/sec
ダイシングソー [DAD3220] (Dicing Saw [DAD3220])
- 設備ID
- NM-656
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ダイシングソー [DAD3220]](data/facility_item/1687417280_11.jpg)
- メーカー名
- 株式会社ディスコ (DISCO Corporation)
- 型番
- DAD3220
- 仕様・特徴
- ・加工可能材料(例):Si, Al2O3, GaN 他各種半導体/絶縁体
・ウェハサイズ:最大φ6インチ
・切断位置決め精度:5μm以内(CCDカメラによる位置指定)
ワイヤーボンダー [7476D #1] (Wire Bonder [7476D #1])
- 設備ID
- NM-659
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ワイヤーボンダー [7476D #1]](data/facility_item/1687417398_11.jpg)
- メーカー名
- ウェスト・ボンド社 (WEST?BOND Inc.)
- 型番
- 7476D
- 仕様・特徴
- ・ボンディング方式:超音波ウエッジ・ウエッジ技法
・ワイヤ:0.007~0.001インチ径のアルミ又は金ワイヤ
・ワークピースの加熱が可能