共用設備検索結果
ウエーハレベルボンディング装置SB8 Gen2 (Substrate Bonder)
- 設備ID
- UT-917
- 設置機関
- 東京大学
- 設備画像
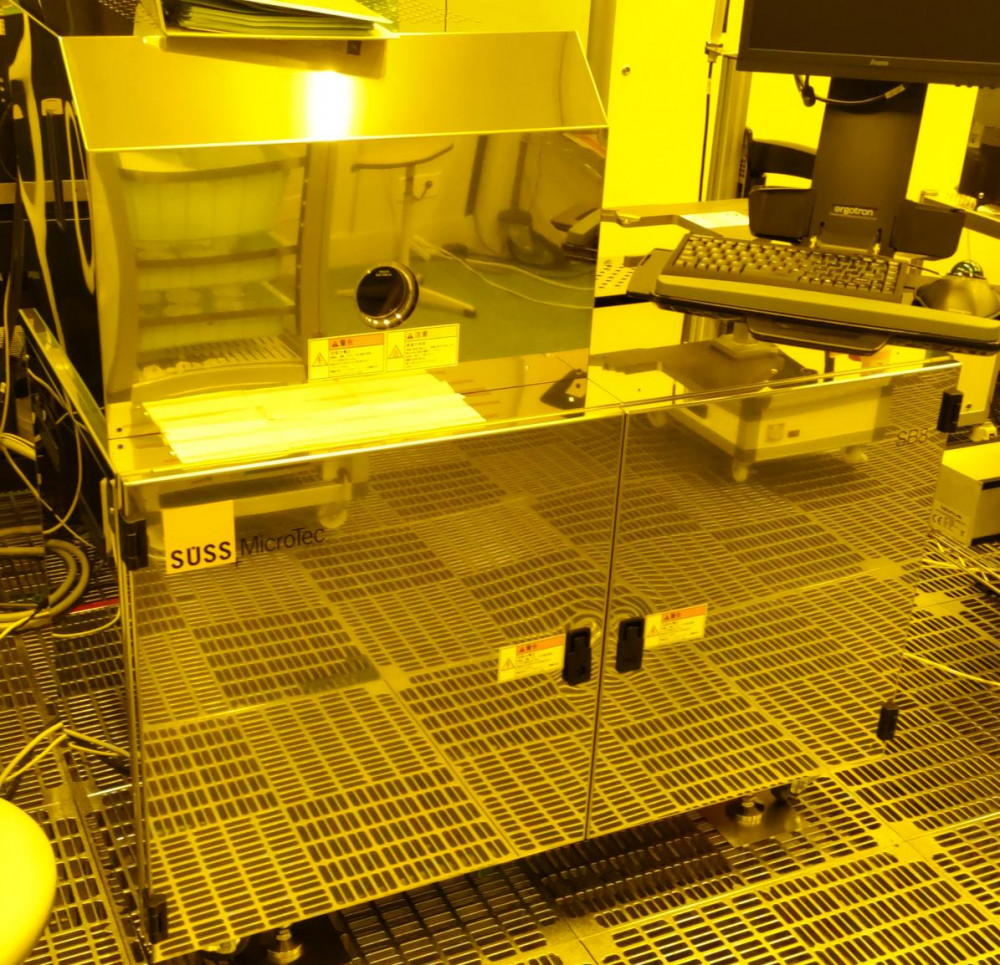
- メーカー名
- ズースマイクロテック (Suss MicroTec)
- 型番
- SB8 Gen2
- 仕様・特徴
- ウエーハ同士を接合する装置。位置合わせはマスクアライナーMA6(UT-504)で行う。MEMSプロセスや三次元配線形成に用いられる装置。
最大加熱温度:550℃、温度均一性:±1.5℃
温度再現性:±3℃、最大加熱速度:30K/分
最大冷却速度:25K/分、最大加圧力:20kN
圧力均一性:±2%
精密研磨装置PM-6 (C.M. Polisher)
- 設備ID
- UT-916
- 設置機関
- 東京大学
- 設備画像
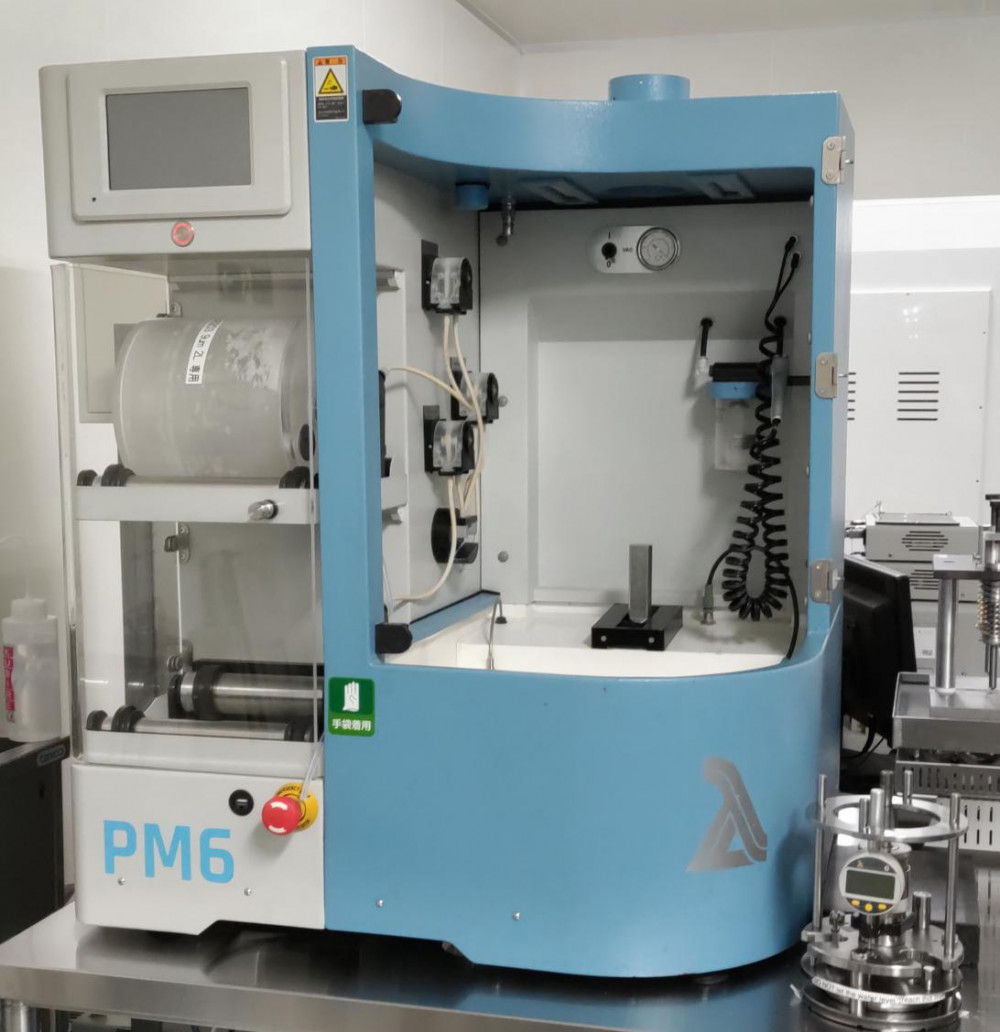
- メーカー名
- ロジテック (Logitec)
- 型番
- PM-6
- 仕様・特徴
- 化学研磨装置
対象物を精密に研磨する装置。研磨剤によって、高速に粗く削る(ラッピング)ことも、低速に平坦性を確保する(ポリッシング)ことも可能。4”丸型ウエーハまで研磨可能。
回転機構:1軸タイプ
最大サンプル径:4インチ
マイクロマニピュレータ (Micromanipulator)
- 設備ID
- TU-269
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- Micro support (Micro support)
- 型番
- -
- 仕様・特徴
- マイクロスコープ一体型
セミオートワイヤボンダ (Semi-automatic wire bonder)
- 設備ID
- TU-266
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- TPT (TPT)
- 型番
- HB16
- 仕様・特徴
- セミオート対応
ダイシングソー [DAD322] (Dicing Saw [DAD322])
- 設備ID
- NM-629
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ダイシングソー [DAD322]](data/facility_item/NM-629.jpg)
- メーカー名
- ディスコ (DISCO)
- 型番
- DAD322
- 仕様・特徴
- ・用途:各種基板の小片化
・切削刃:ダイヤモンドブレード
・切削範囲:XY:162mm以下
・最大試料サイズ:φ6inch
・その他:オート/セミオート/マニュアルアライメント機能
・その他:3Dマッピング機能
ワイヤーボンダー [7476D #2] (Wire Bonder [7476D #2])
- 設備ID
- NM-632
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![ワイヤーボンダー [7476D #2]](data/facility_item/NM-632.jpg)
- メーカー名
- ハイソル(West Bond) (HiSOL (West Bond))
- 型番
- 7476D
- 仕様・特徴
- ・用途:チップキャリアへのボンディング
・ボンディング方式:超音波/熱圧着ウェッジボンド方式
・ボンディングウェッジ:45°,90°
・ワイヤー材質:金線,アルミ線
・ワークホルダー温度:300度以下
・最大試料サイズ:50mm角以下,DIPパッケージ
ブラシスクラバ (Brush scrubber)
- 設備ID
- TU-009
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- 全協化成 (Zenkyo)
- 型番
- 特注
- 仕様・特徴
- サンプルサイズ:20mm角~6インチ
SUSS ウェハ接合装置 (Wafer bonder)
- 設備ID
- TU-251
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- SUSS (SUSS)
- 型番
- SB6e
- 仕様・特徴
- サンプルサイズ:20mm角~6インチ
チャンバ雰囲気:真空~大気圧~+2気圧
到達真空度:5E-3Pa
最大加圧:13kN
陽極接合最大電圧:-2000V
基板温度:室温~500℃
EVG ウェハ接合用アライナ (EVG aligner for wafer bonding)
- 設備ID
- TU-252
- 設置機関
- 東北大学
- 設備画像
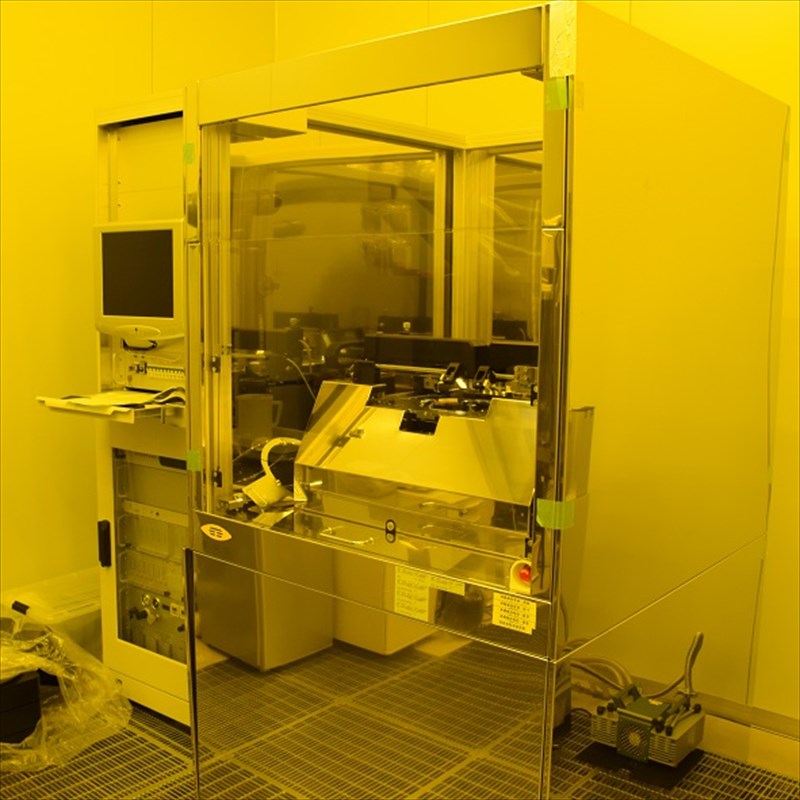
- メーカー名
- EVG (EVG)
- 型番
- Smart View Aligner
- 仕様・特徴
- サンプルサイズ:4、6、8インチ
可視光を用いた接合面どうしのアライメント
赤外光を用いた透過アライメントも可能
EVG ウェハ接合装置 (EVG wafer bonder)
- 設備ID
- TU-253
- 設置機関
- 東北大学
- 設備画像
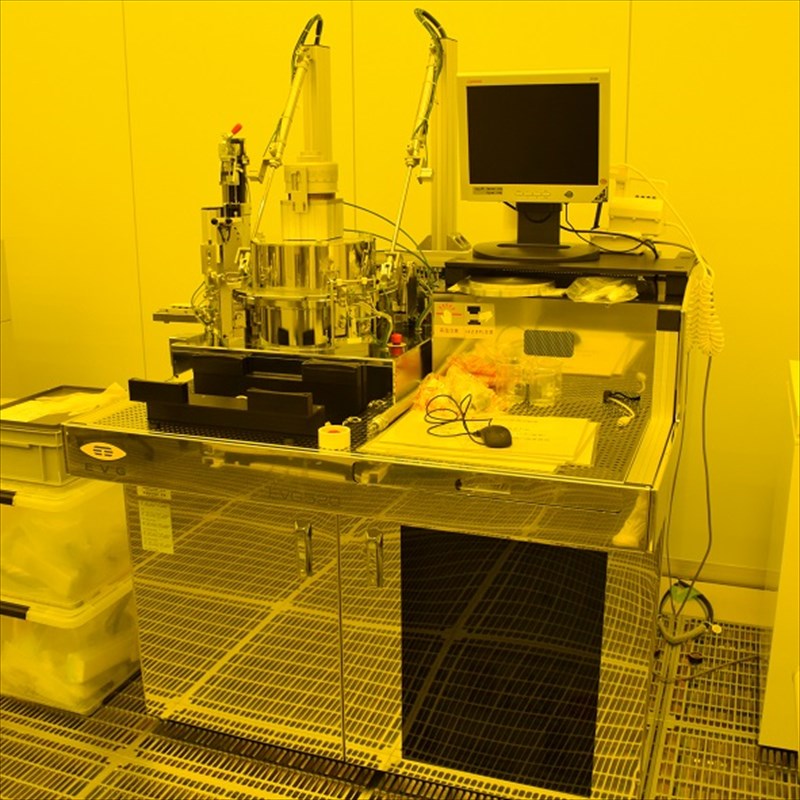
- メーカー名
- EVG (EVG)
- 型番
- 520
- 仕様・特徴
- サンプルサイズ:4、6、8インチ
到達真空度:5E-3Pa
最大加圧:7kN
基板温度:室温~500℃