共用設備検索結果
"接合・接着"で検索した結果 10件
フリーワード検索
ウエーハレベルボンディング装置SB8 Gen2 (Substrate Bonder)
- 設備ID
- UT-917
- 設置機関
- 東京大学
- 設備画像
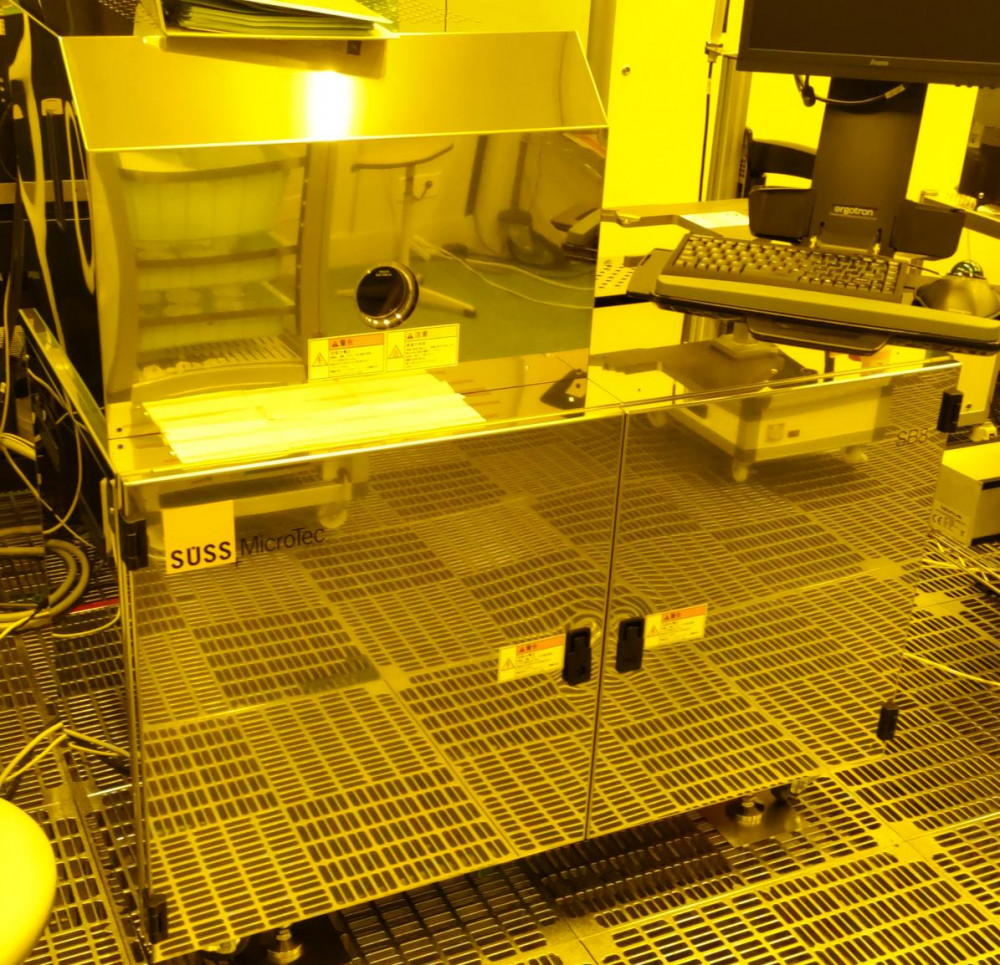
- メーカー名
- ズースマイクロテック (Suss MicroTec)
- 型番
- SB8 Gen2
- 仕様・特徴
- ウエーハ同士を接合する装置。位置合わせはマスクアライナーMA6(UT-504)で行う。MEMSプロセスや三次元配線形成に用いられる装置。
最大加熱温度:550℃、温度均一性:±1.5℃
温度再現性:±3℃、最大加熱速度:30K/分
最大冷却速度:25K/分、最大加圧力:20kN
圧力均一性:±2%
SUSS ウェハ接合装置 (Wafer bonder)
- 設備ID
- TU-251
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- SUSS (SUSS)
- 型番
- SB6e
- 仕様・特徴
- サンプルサイズ:20mm角~6インチ
チャンバ雰囲気:真空~大気圧~+2気圧
到達真空度:5E-3Pa
最大加圧:13kN
陽極接合最大電圧:-2000V
基板温度:室温~500℃
EVG ウェハ接合用アライナ (EVG aligner for wafer bonding)
- 設備ID
- TU-252
- 設置機関
- 東北大学
- 設備画像
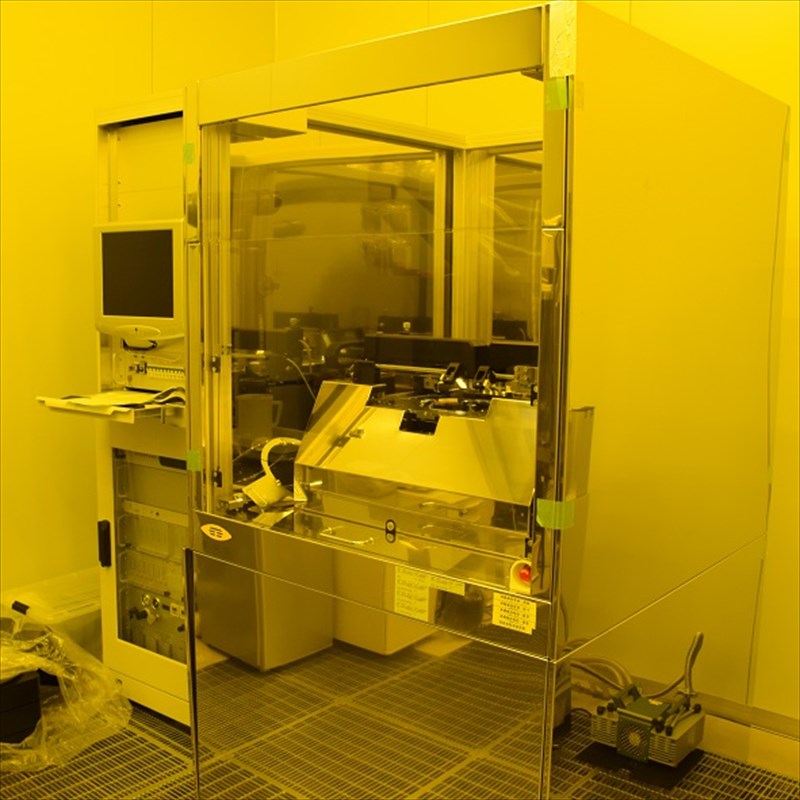
- メーカー名
- EVG (EVG)
- 型番
- Smart View Aligner
- 仕様・特徴
- サンプルサイズ:4、6、8インチ
可視光を用いた接合面どうしのアライメント
赤外光を用いた透過アライメントも可能
EVG ウェハ接合装置 (EVG wafer bonder)
- 設備ID
- TU-253
- 設置機関
- 東北大学
- 設備画像
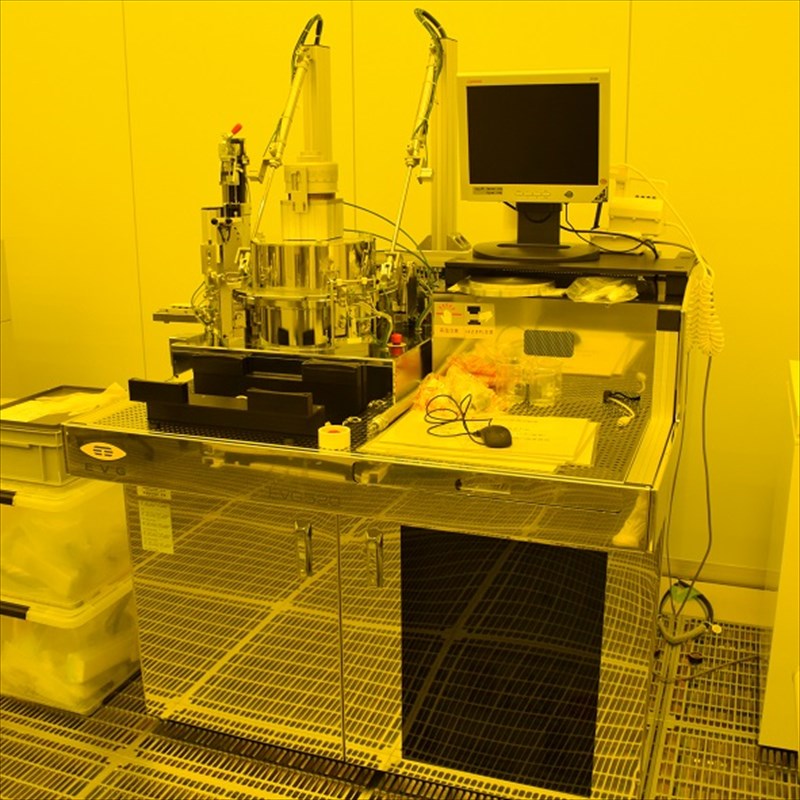
- メーカー名
- EVG (EVG)
- 型番
- 520
- 仕様・特徴
- サンプルサイズ:4、6、8インチ
到達真空度:5E-3Pa
最大加圧:7kN
基板温度:室温~500℃
EVG プラズマ活性化装置 (EVG plasma activation)
- 設備ID
- TU-254
- 設置機関
- 東北大学
- 設備画像
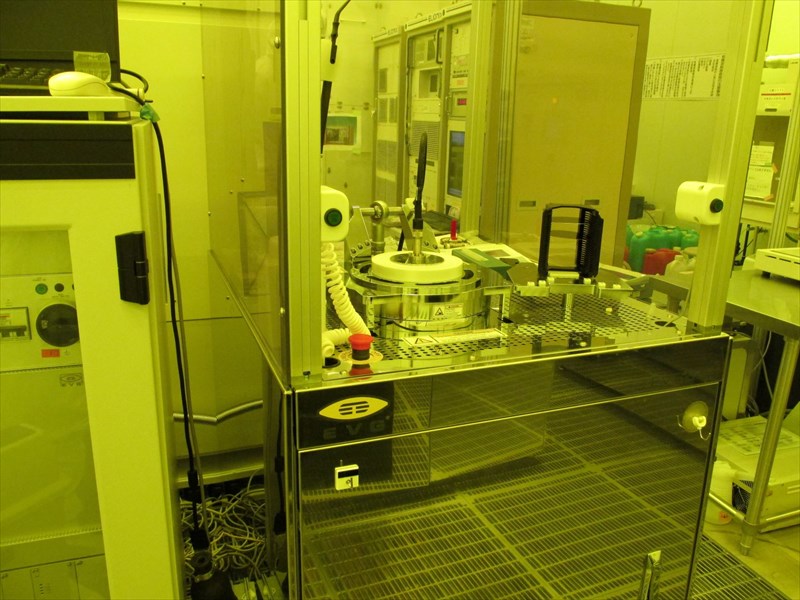
- メーカー名
- EVG (EVG)
- 型番
- 810
- 仕様・特徴
- サンプルサイズ:小片~8インチ
ガス:N2、O2、Ar
赤外線顕微鏡 (Infrared microscope)
- 設備ID
- TU-309
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- オリンパス/浜松ホトニクス (Olympus/Hamamatsu)
- 型番
- -
- 仕様・特徴
- サンプルサイズ:小片~6インチ
超音波顕微鏡 (Ultrasonic microscope)
- 設備ID
- TU-312
- 設置機関
- 東北大学
- 設備画像
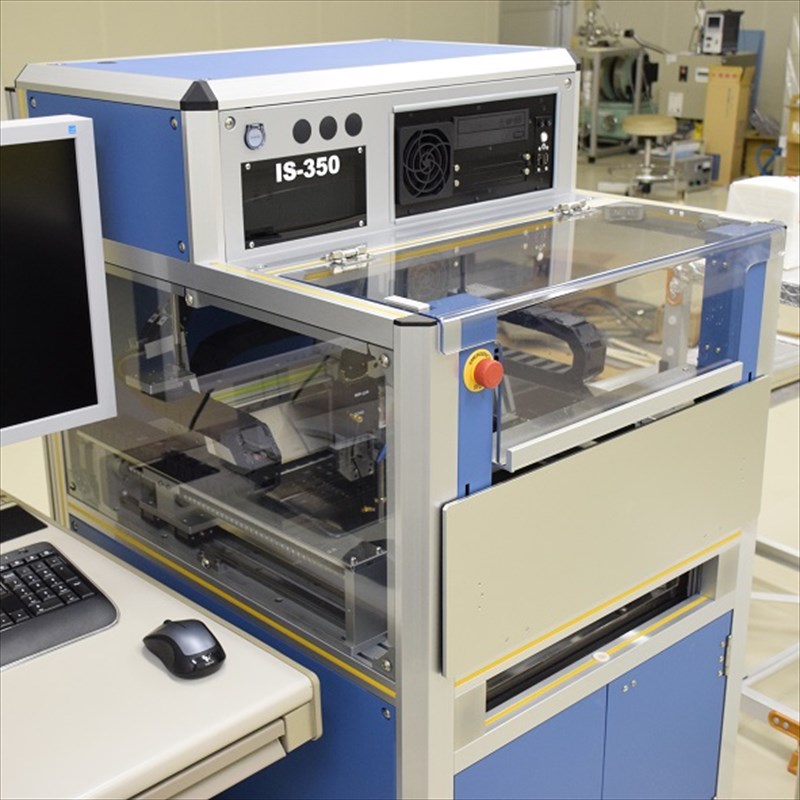
- メーカー名
- インサイト (Insight)
- 型番
- IS-350
- 仕様・特徴
- サンプルサイズ:小片~300mm角
反射測定、透過測定の両方可
超音波周波数:10MHz、15MHz、25MHz、35MHz、50MHz、110MHz、200MHz
ウエハ接合装置 (Surface Activated Wafer Bonder)
- 設備ID
- KT-254
- 設置機関
- 京都大学
- 設備画像
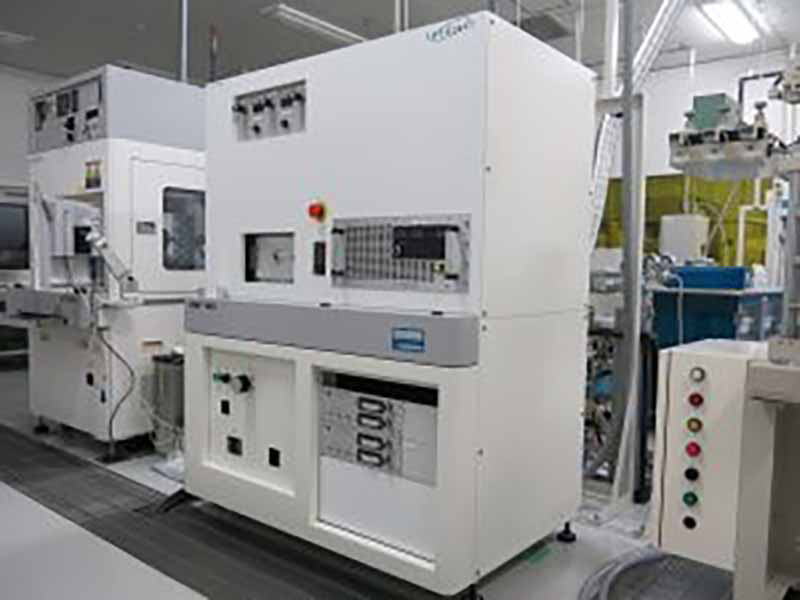
- メーカー名
- ボンドテック(株) (Bondtech Co., Ltd.)
- 型番
- WAP-100
- 仕様・特徴
- 特殊仕様につきアライメント接合不可 プラズマ活性4インチウエハ対応
・4インチウェハ,高精度アライメント
・常温接合・陽極接合
基板貼付け装置 (Wafer bonding equipment)
- 設備ID
- IT-019
- 設置機関
- 東京工業大学
- 設備画像
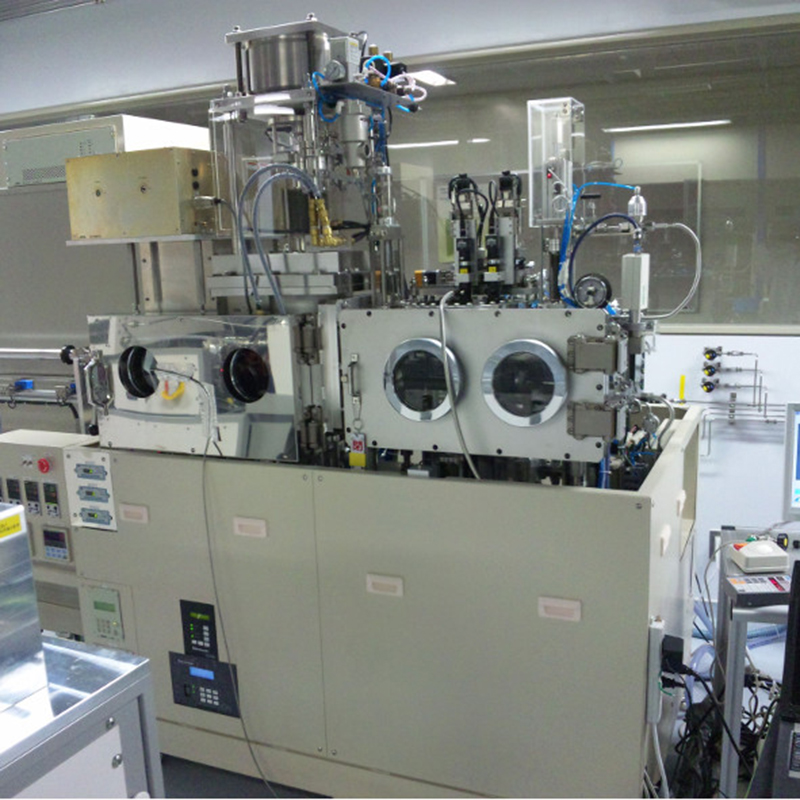
- メーカー名
- アユミ工業 (Ayumi Inc)
- 型番
- VE-07-18
- 仕様・特徴
- ・対応基板サイズ:2インチウェハ,2 cm×2 cm角,3 cm×3 cm角
・プラズマ反応ガス:Ar, N2, O2
・最大プラズマ強度:750W
・アライメント精度<±1.6 μm
・チャンバー真空度:~10-5 Pa
・最大加熱温度:500℃
・アライメント部 加重範囲:5~100 kgf
・加重部 加重範囲:50~1000 kgf
ウェハ洗浄装置 (Single Wafer Cleaning System)
- 設備ID
- IT-020
- 設置機関
- 東京工業大学
- 設備画像
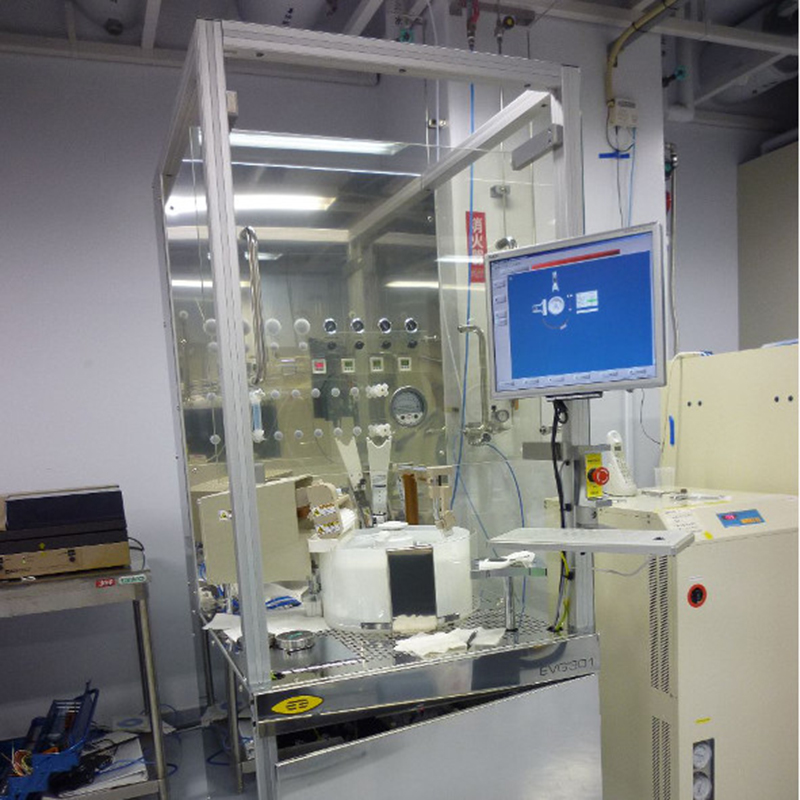
- メーカー名
- EVG (EVG)
- 型番
- EVG301
- 仕様・特徴
- ・PVA製スポンジブラシ洗浄 ・メガソニック洗浄(最大振動子出力:40 W) ・対応基板サイズ:2インチウェハ/2 cm×2 cm角/3 cm×3 cm角
"接合・接着"で検索した結果 10件