共用設備検索結果
中分類から探す
ナノインプリント装置 (Nanoimprint Lithography)
- 設備ID
- KT-255
- 設置機関
- 京都大学
- 設備画像
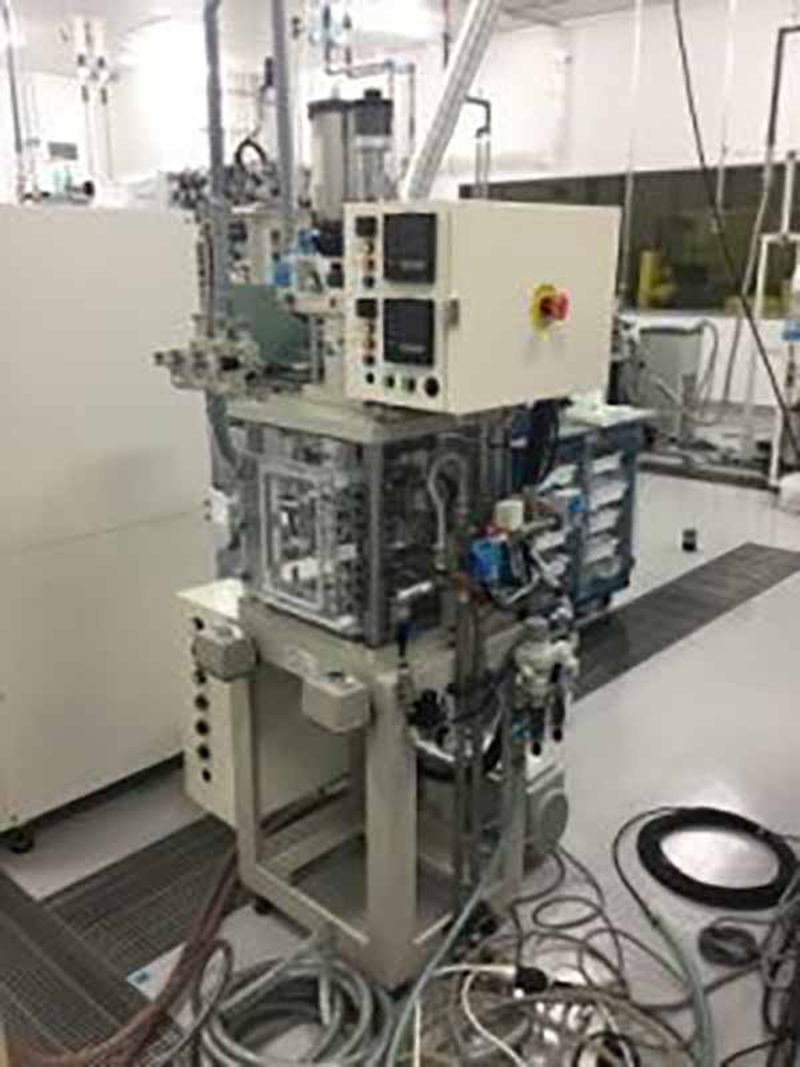
- メーカー名
- (株)マルニ (MARUNI CO., LTD.)
- 型番
- TP-32937
- 仕様・特徴
- 国内で最も多く普及しているエアプレス動きを油圧で制御するハイチェック機構付き4インチウエハ対応
・4インチウェハ
超高精度電子ビーム描画装置(100kV) (Ultra-high precision electron-beam lithography system(100kV))
- 設備ID
- HK-601
- 設置機関
- 北海道大学
- 設備画像
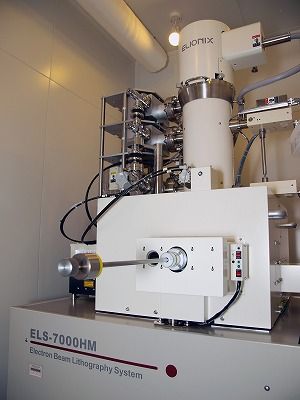
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-7000HM
- 仕様・特徴
- 加速電圧:100kV
試料サイズ:最大6インチ
超高精度電子ビーム描画装置(125kV) (Ultra-high precision electron-beam lithography system(125kV))
- 設備ID
- HK-602
- 設置機関
- 北海道大学
- 設備画像
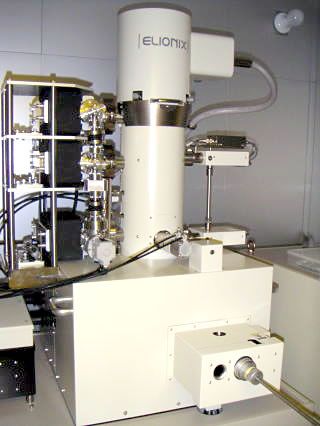
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F125
- 仕様・特徴
- 加速電圧:125kV
試料サイズ:最大6インチ
超高速スキャン電子線描画装置(130kV) (High-speed scanning electron-beam lithography system(130kV))
- 設備ID
- HK-603
- 設置機関
- 北海道大学
- 設備画像
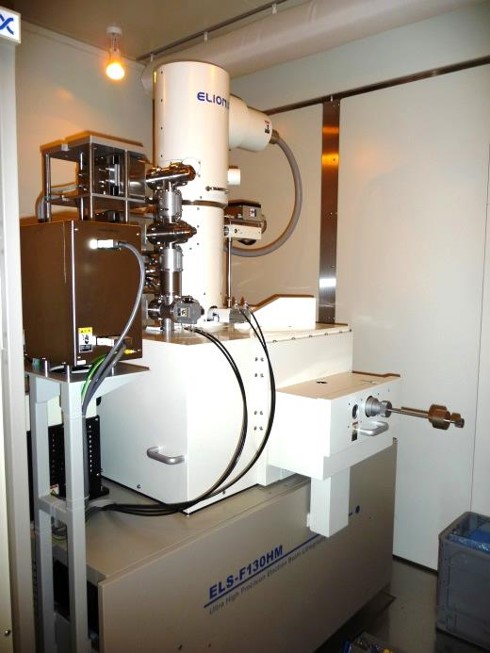
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F130HM
- 仕様・特徴
- 加速電圧:130kV
試料サイズ:最大8インチ
レーザー描画装置 (Laser lithography system)
- 設備ID
- HK-604
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+
- 仕様・特徴
- 光源:405nm半導体レーザー
描画エリア:最大8インチ角
最小描画線幅:0.3ミクロン(HiRes)、0.8ミクロン(WMII)
255階調グレースケールモード搭載
バックアライメント機能
レーザー直接描画装置 (Laser direct lithography system)
- 設備ID
- HK-605
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ネオアーク (NEOARK)
- 型番
- DDB-201
- 仕様・特徴
- 光源:375nm半導体レーザー
描画エリア:最大50mm
試料サイズ:最大6インチ
マスクアライナ (Mask aligner)
- 設備ID
- HK-606
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ミカサ (MIKASA)
- 型番
- MA-20
- 仕様・特徴
- コンタクト露光
試料サイズ:最大4インチ
マスクサイズ:最大5インチ
電子ビーム描画装置(30kV) (Electron-beam lithography system(30kV))
- 設備ID
- HK-701
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-3700
- 仕様・特徴
- 電子銃エミッター:LaB6
加速電圧:1~30kV
最小線幅:100nm
試料サイズ:最大4インチ
円弧スキャン可
両面マスクアライナ (Double-side alignment Mask aligner)
- 設備ID
- HK-702
- 設置機関
- 北海道大学
- 設備画像
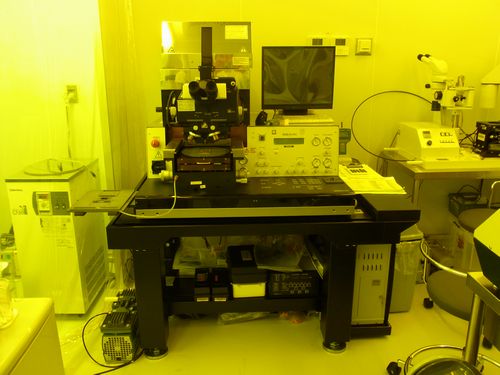
- メーカー名
- ズースマイクロテック (SUSS)
- 型番
- MA-6
- 仕様・特徴
- 両面、露光精度0.6ミクロン
試料サイズ:最大6インチ
基板サイズ:不定形小片~150mm角
スピンコーター (Spin coater)
- 設備ID
- HK-707
- 設置機関
- 北海道大学
- 設備画像
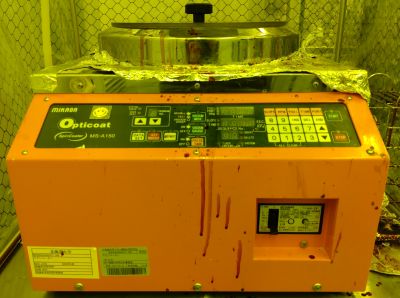
- メーカー名
- ミカサ (MIKASA)
- 型番
- MS-B1000
- 仕様・特徴
- 試料サイズ:最大4インチ
回転数:0-4000rpm