共用設備検索結果
中分類から探す
レジスト現像装置 ( Photoresist Developer)
- 設備ID
- KT-110
- 設置機関
- 京都大学
- 設備画像
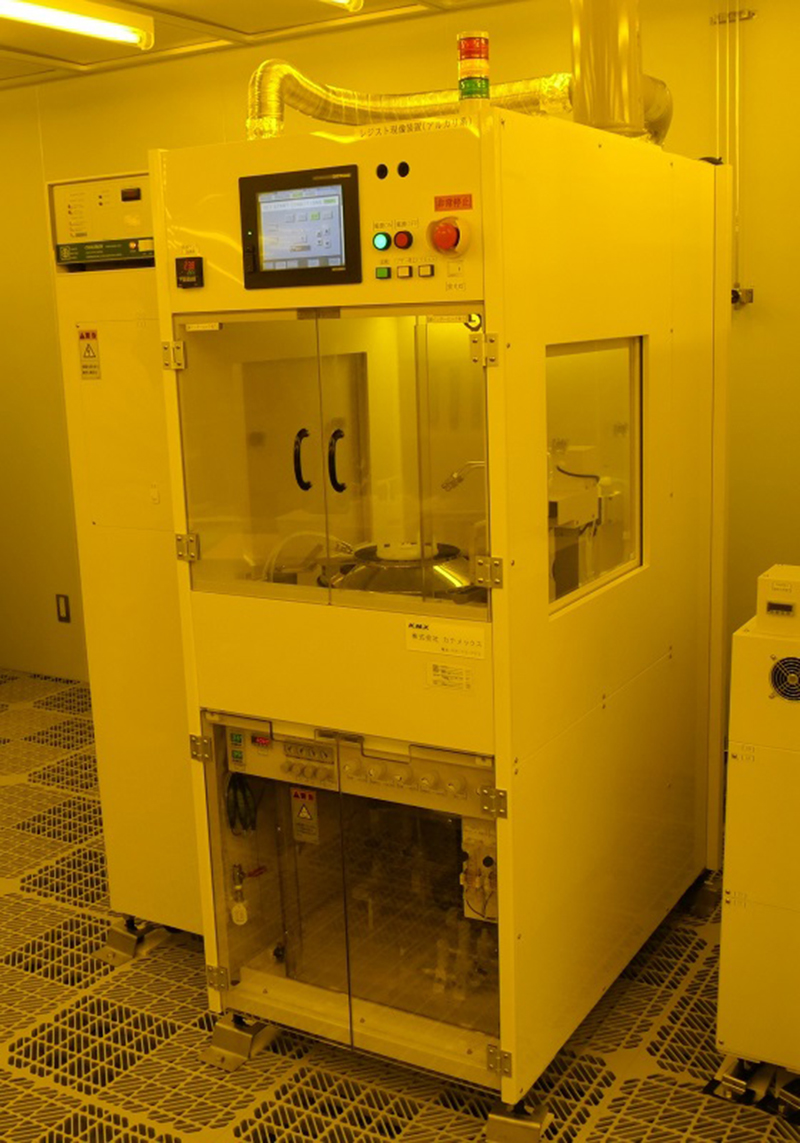
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KD-150CBU
- 仕様・特徴
- 汎用的な枚葉式アルカリ現像装置。
・基板サイズ:Φ2~Φ6、□2.5、□5、不定形
・現像液:アルカリ(TMAH 2.38%)
・現像方式:スプレー、パドル
・対応レジスト:UVレジスト、EBレジスト(NEB22)ほか
ウエハスピン洗浄装置 (Wafer Spin Cleaner )
- 設備ID
- KT-111
- 設置機関
- 京都大学
- 設備画像
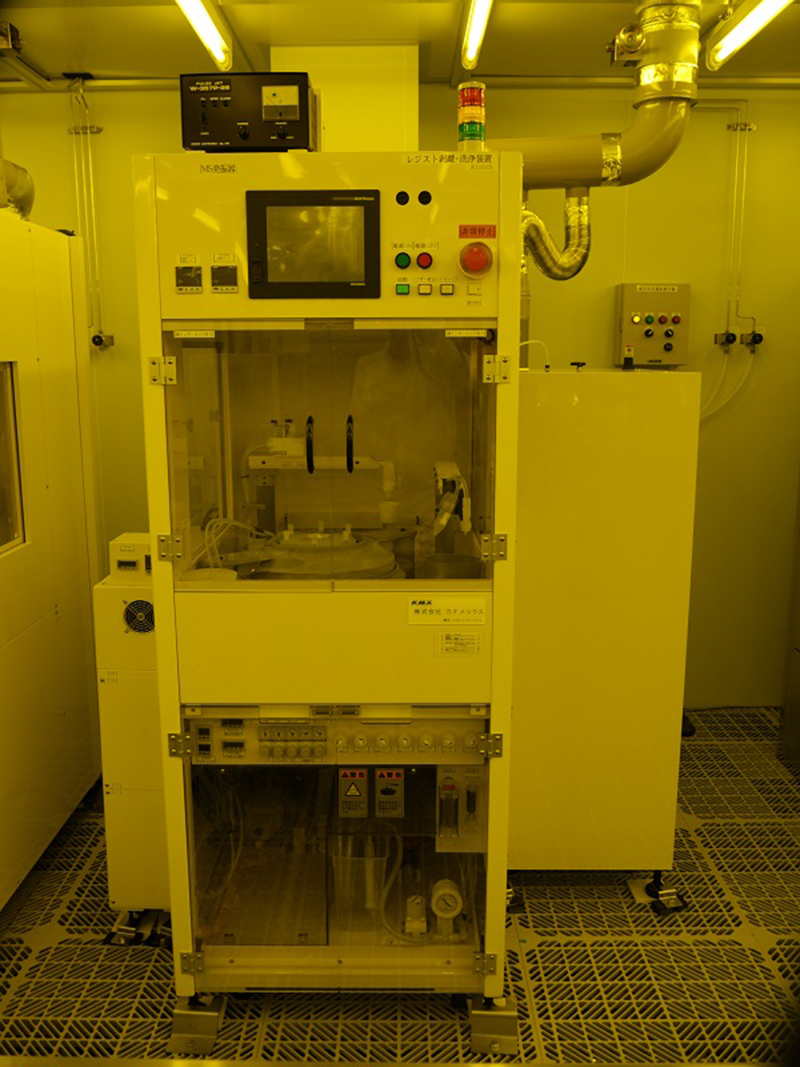
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KSC-150CBU
- 仕様・特徴
- 汎用的な枚葉式ウエハ洗浄装置。
・基板サイズ:Φ2-Φ6、□2.5、□5、□7、不定形
・洗浄方式:ピラニア、メガソニック、2流体、純水
超微細インクジェット描画装置 (Super Fine Inkjet Printer)
- 設備ID
- KT-113
- 設置機関
- 京都大学
- 設備画像
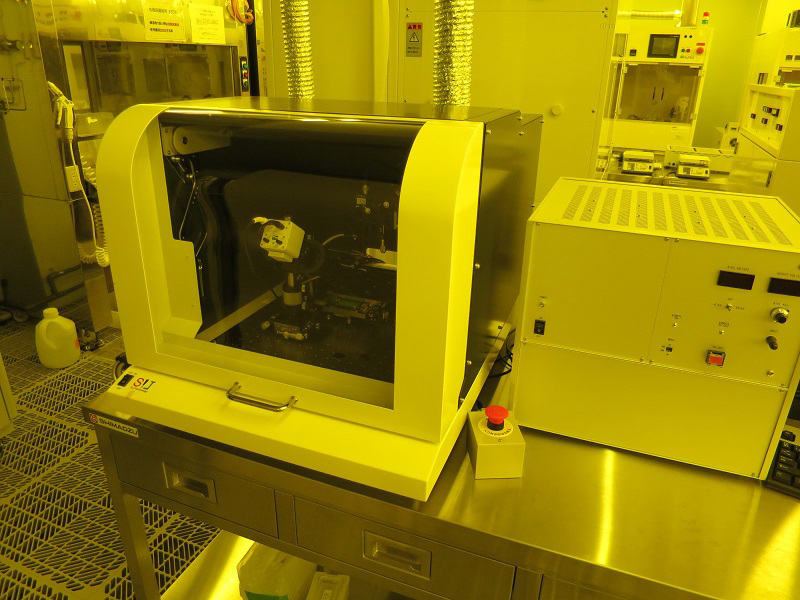
- メーカー名
- (株)SIJテクノロジ (SIJTechnology, Inc.)
- 型番
- ST050
- 仕様・特徴
- 超微量・高粘度吐出のスーパーインクジェットヘッドにより、大気圧・常温下で微細パターンの直接描画が可能。
・最小吐出量:0.1fL
・最小ライン幅:0.6μm
・対応粘度:0.5~10,000cps
・付属ソフトウェア(複雑パターンが可能)
有機現像液型レジスト現像装置 (EB-Resist Developer)
- 設備ID
- KT-114
- 設置機関
- 京都大学
- 設備画像
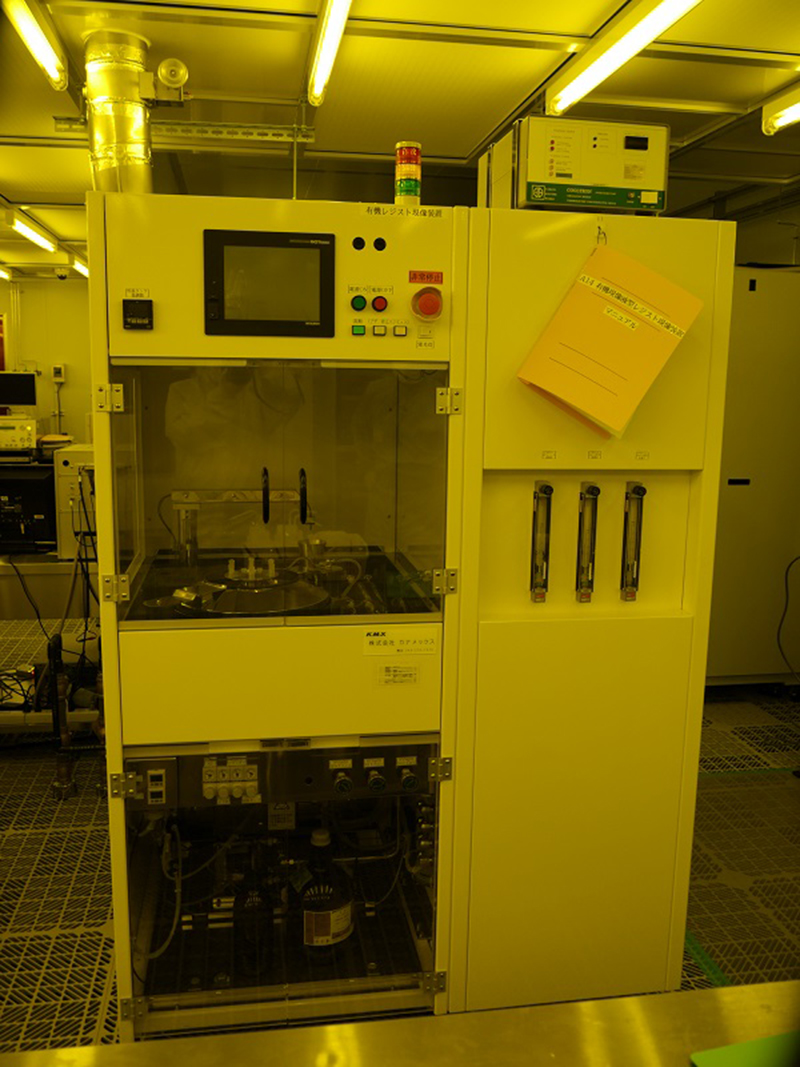
- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KD(EB)-150CBU
- 仕様・特徴
- 汎用的な枚葉式有機系現像装置。
・基板サイズ:Φ4、Φ6、□30mm、□40mm
・現像液:有機溶剤系現像液、IPAリンス
大面積超高速電子ビーム描画装置 (Large Area and Ultra-High Speed Electron Beam Lithography)
- 設備ID
- KT-115
- 設置機関
- 京都大学
- 設備画像
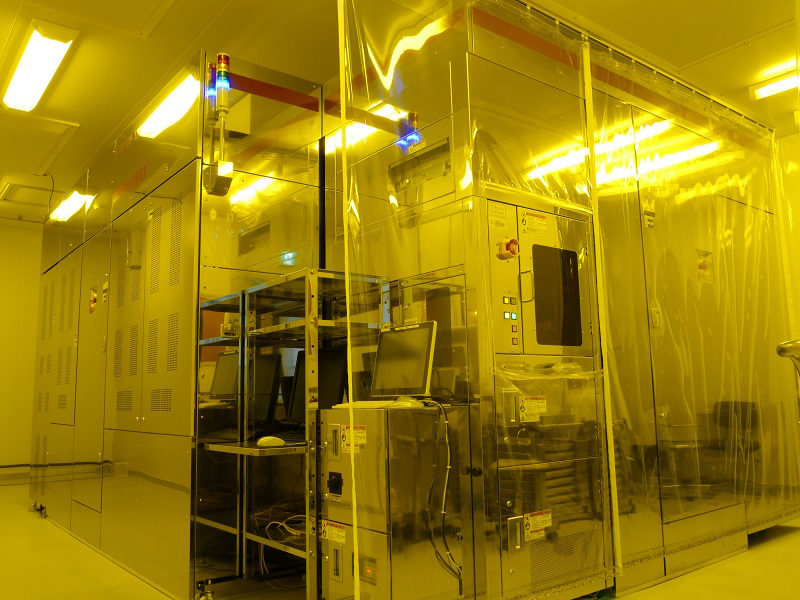
- メーカー名
- (株)アドバンテスト (ADVANTEST CORPORATION)
- 型番
- F7000S-KYT01
- 仕様・特徴
- 1Xnmの解像性能で、研究開発から製造までの幅広い用途に対応。
・加速電圧:50kV(ビーム電流:640A)
・解像度:1Xnm
・基板:□10mm~Φ8
・露光方式:CP、VSB(超高速描画対応)
近接効果補正システム (Proximity Effect Correction System)
- 設備ID
- KT-116
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- GenISys(株) (GenISys Inc.)
- 型番
- BEAMER Full Package
- 仕様・特徴
- 電子線描画装置、レーザー描画装置用の最適露光データ作成のための支援ツール。
・近接効果補正(PEC):2Dドーズ補正、形状補正、3D補正、コーナー補正
・光近接効果補正(OPC):線形補正、コーナー補正、全体形状補正
・グレイスケール露光における補正
・入出力フォーマット:エリオニクス社、アドバンテスト社、ハイデルベルグ社
・モンテカルロ法によるPSF値の導出対応。
高圧ジェットリフトオフ装置 (High Pressure Jet Lift-off System)
- 設備ID
- KT-118
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- (株)カナメックス (KANAMEX Co., Ltd.)
- 型番
- KLO-200SV1
- 仕様・特徴
- 高圧ジェット(NMP)を用いた枚葉式スピンリフトオフ装置。
・基板サイズ:Φ4、Φ6、不定形
・高温NMPによるレジスト膨潤(MAX80℃)
・MAX14MPaの高圧ジェットによるバリ&再付着防止
移動マスク紫外線露光装置 (Moving Mask UV Lithography)
- 設備ID
- KT-153
- 設置機関
- 京都大学
- 設備画像
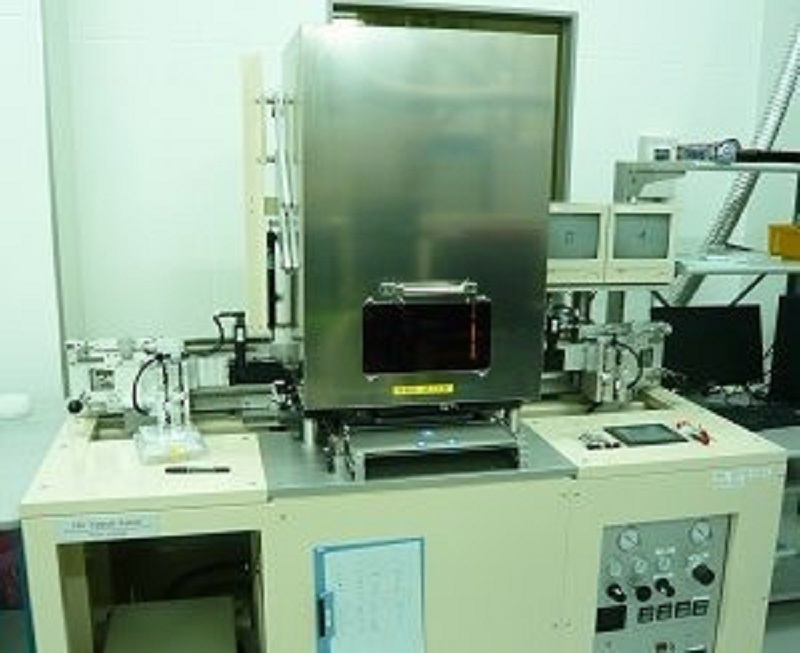
- メーカー名
- (株)大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MUM-0001
- 仕様・特徴
- UV露光中にマスクを周期移動させることで3次元微細構造を実現。
・基板サイズ:Φ4
・3次元微細構造製作可能
両面マスクアライナー露光装置 (Double-Sided Mask Aligner)
- 設備ID
- KT-154
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- ユニオン光学(株) (Union Optical Co., Ltd.)
- 型番
- PEM-800
- 仕様・特徴
- 実験用両面マスクアライナ
・基板サイズ:Φ4
・マスクサイズ:□5
・両面露光、アライメント機能
基板接合装置 (Wafer Bonder)
- 設備ID
- KT-217
- 設置機関
- 京都大学
- 設備画像
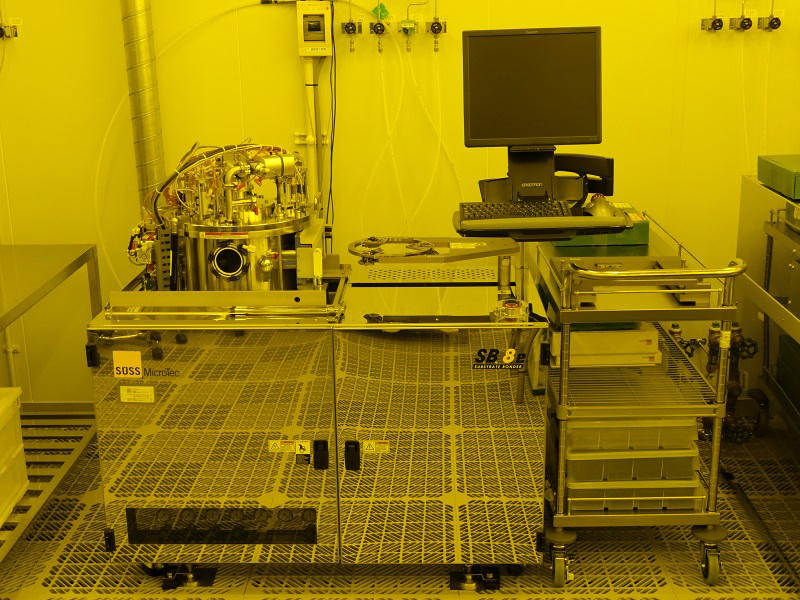
- メーカー名
- ズース・マイクロテック(株) (SUSS MicroTec)
- 型番
- SB8e SPEC-KU
- 仕様・特徴
- プログラマブル接合チャンバを備えた半自動基板接合装置。
・基板サイズ:Φ150mm
・荷重:MAX 20kN
・温度:MAX 550℃
・接合プロセス:陽極接合、拡散接合、熱圧着、接着接合 ほか