共用設備検索結果
中分類から探す
電子線露光装置 (Electron beam lithography)
- 設備ID
- NU-206
- 設置機関
- 名古屋大学
- 設備画像
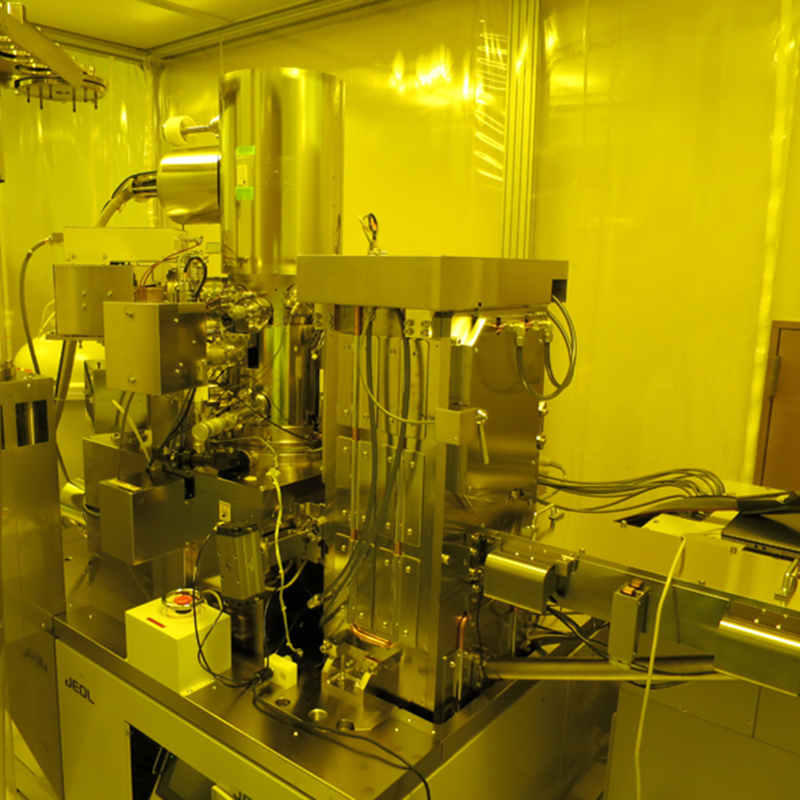
- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX6300FS
- 仕様・特徴
- ・加速電圧:25/50/100kV
・最小ビーム径:2nm
・ビーム電流:100pA-2nA
・重ね合わせ精度:±9nm
・最大試料サイズ:4inchφ
両面露光用マスクアライナ (Mask aligner)
- 設備ID
- NU-208
- 設置機関
- 名古屋大学
- 設備画像
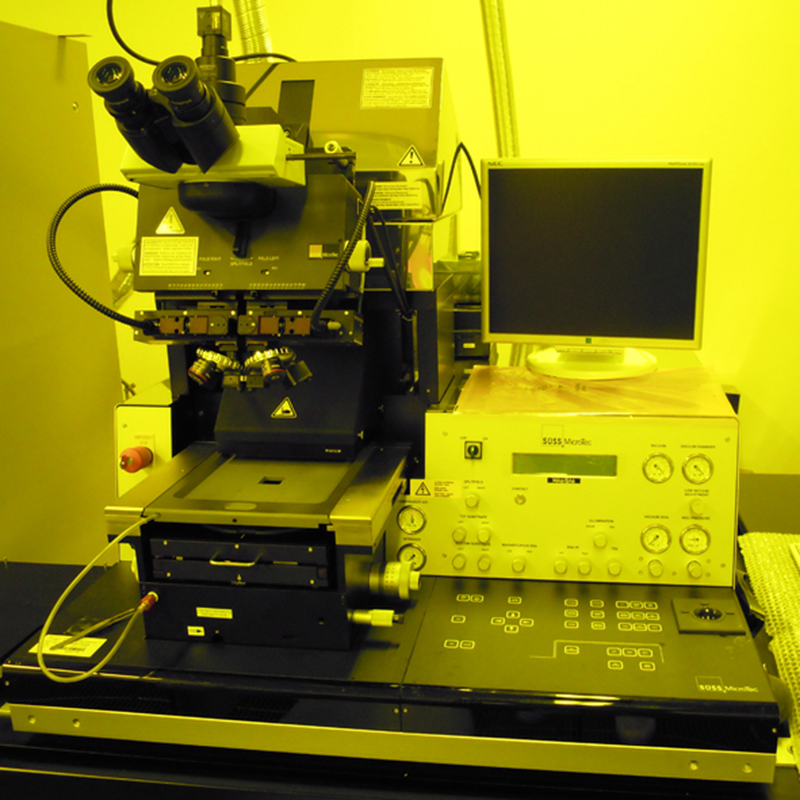
- メーカー名
- Suss MicroTec AG (Suss MicroTec AG)
- 型番
- MA-6
- 仕様・特徴
- ・対応基板サイズ:10mm~最大6インチ径ウェハ
・主波長:350 nm〜450 nm
・裏面アラインメント機能(CCD画像記憶方式)
・アライメント精度:±0.5 µm(表面アラインメント),±0.1 µm(裏面アラインメント)
レーザー描画装置 (Laser lithography)
- 設備ID
- NU-222
- 設置機関
- 名古屋大学
- 設備画像
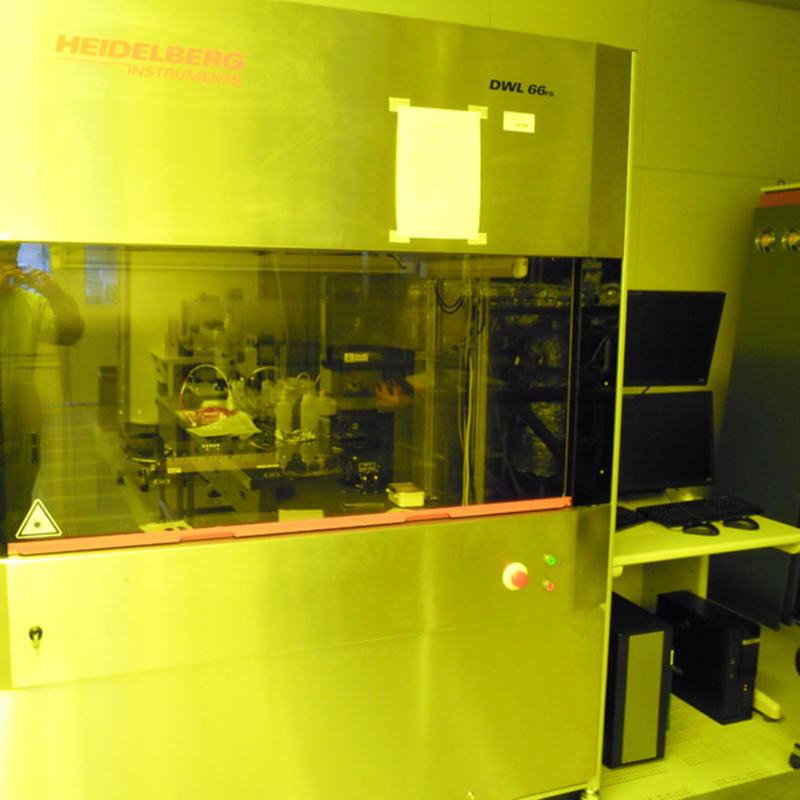
- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- DWL66FS
- 仕様・特徴
- ・最小描画サイズ:0.6 µm
・最大描画サイズ:200mm x 200mm
・直描およびガラスマスク作製
フォトリソグラフィ装置群 (photo lighography system)
- 設備ID
- NU-223
- 設置機関
- 名古屋大学
- 設備画像
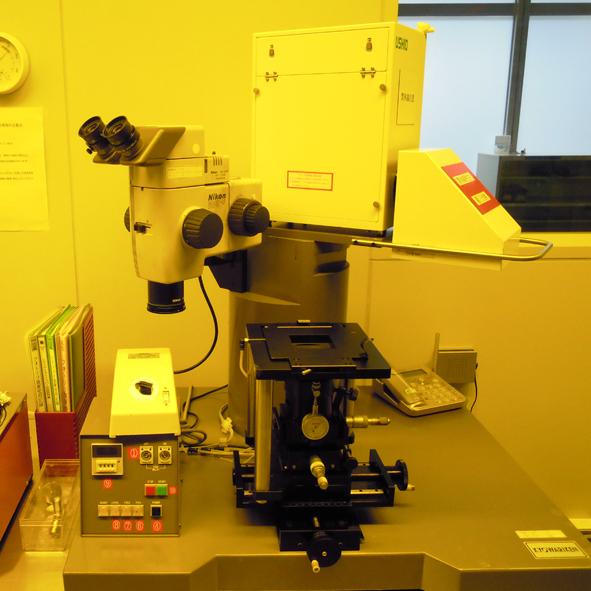
- メーカー名
- 共和理研 (Kyowariken)
- 型番
- K310P100S
- 仕様・特徴
- ・最大2インチ基板
・マスクサイズ:3インチ
・最小パタンサイズ 2µm
・スピンコータ,ベーク炉,ドラフトチャンバー利用可
マスクレス露光装置 (Maskless lithography)
- 設備ID
- NU-231
- 設置機関
- 名古屋大学
- 設備画像
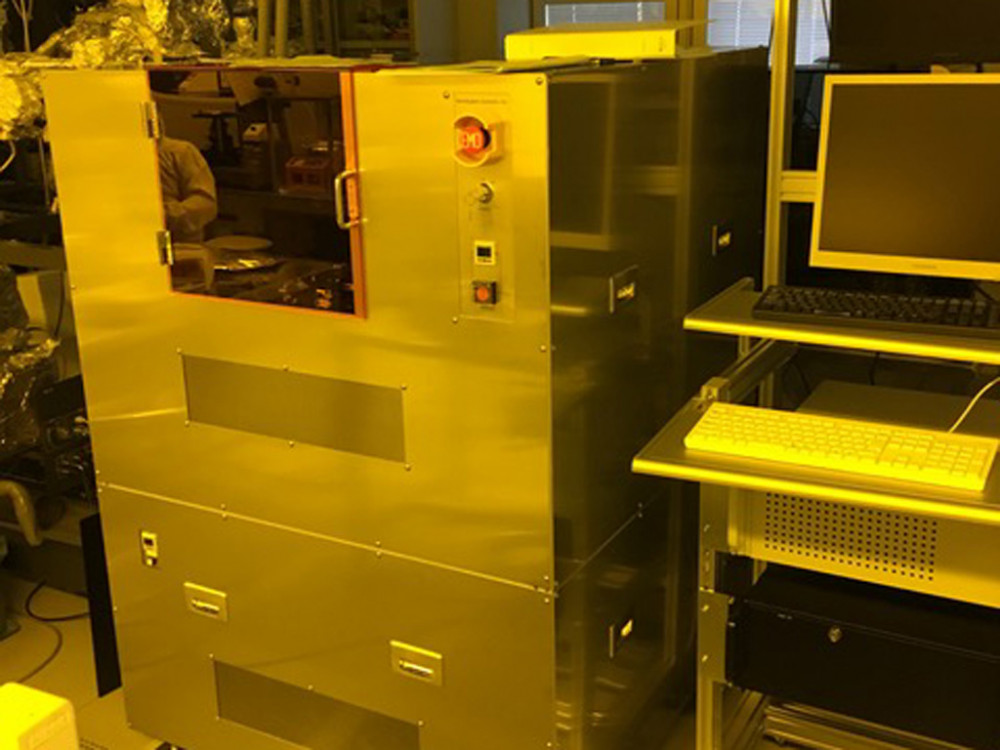
- メーカー名
- ナノシステムソリューションズ (Nanosystem Solutions)
- 型番
- DL-1000
- 仕様・特徴
- ・最大露光面積:200 mm x 200 mm
・最小画素:1 µm(高精細露光機能付)
・つなぎ合わせ精度:0.1 µm
・重ね合わせ精度:±1 µm
・オートフォーカス機能有
レーザ描画装置 (Laser lithography)
- 設備ID
- NU-244
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- mPG101-UV
- 仕様・特徴
- ・対応基板:100 mm ×100 mm
・加工精度:3 µm
・最小アドレスグリッド:100 nm
・対応データ:DXF,CIF,BMP
3次元レーザ・リソグラフィシステム群 (3 dimentional laser lithography system)
- 設備ID
- NU-246
- 設置機関
- 名古屋大学
- 設備画像
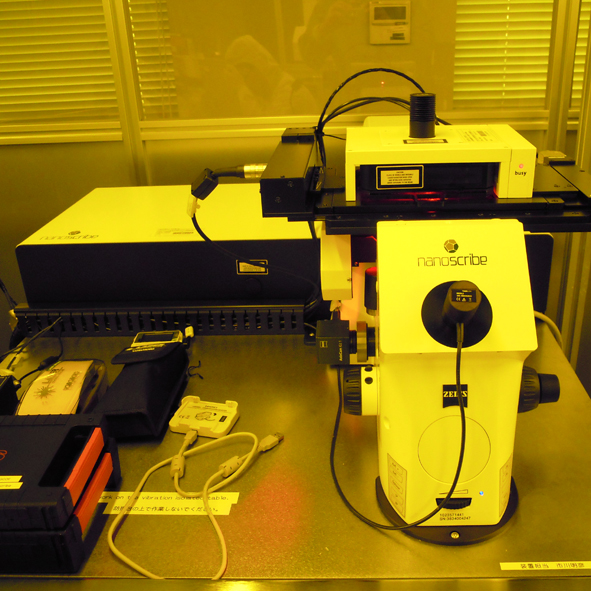
- メーカー名
- Nanoscribe KISCO (Nanoscribe KISCO)
- 型番
- Photonic Professional SCLEAD3CD2000
- 仕様・特徴
- Nanoscribe Photonic Professional
・2次元加工精度:100 nm
・3次元加工精度:150 nm
・対応データ:DXF, STL
KISCO SCLEAD3CD2000
・設計温度:100 ℃
・設計圧力:20 MPa
ナノインプリント装置 (Nanoimprint)
- 設備ID
- NU-247
- 設置機関
- 名古屋大学
- 設備画像
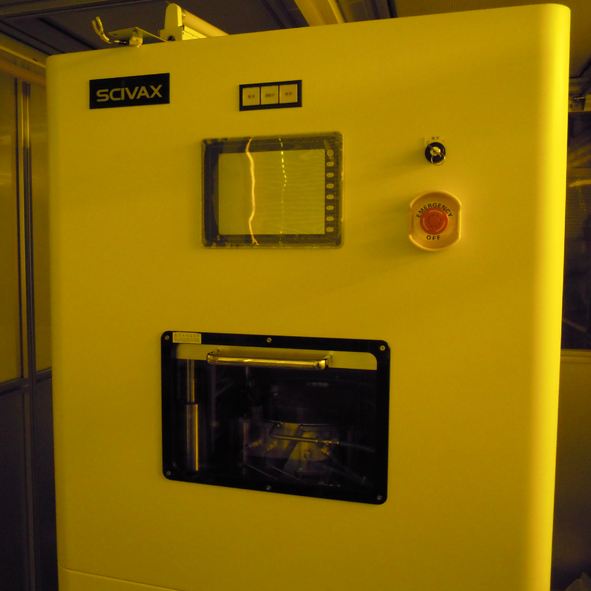
- メーカー名
- SCIVAX (SCIVAX)
- 型番
- X-300 BVU-ND
- 仕様・特徴
- ・形式:熱式,UV式
・最大ワークサイズ:Φ150 mm
・最大荷重:50 kN
・最高仕様温度:250℃,650℃
・UV機能:波長 365 nm/385 nm
・有効照射面積:□100 mm
高精度電子線描画装置 (Scanning electron microscope with add-on lithography system )
- 設備ID
- NU-249
- 設置機関
- 名古屋大学
- 設備画像
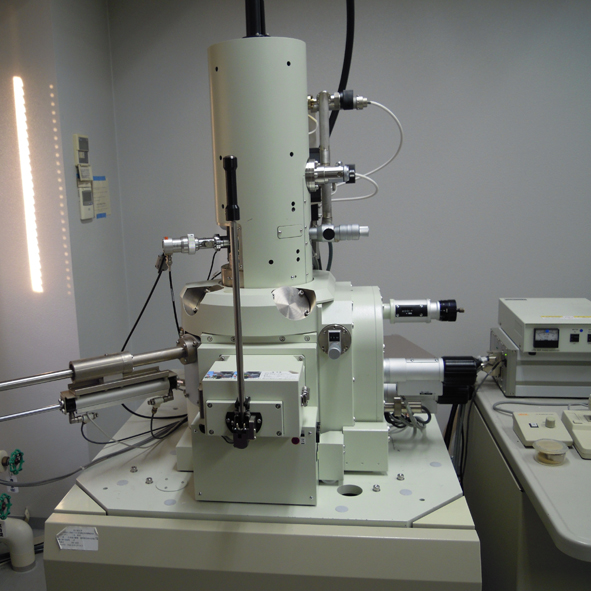
- メーカー名
- 日本電子 サンユー電子 (JEOL Sanyu Electron)
- 型番
- JSM-7000FK SPG-724
- 仕様・特徴
- ・分解能:1.2 nm(30kV)
・倍率:×10~×1,000,000
・試料室:最大200 mm
・描画方式:ラスタースキャン方式/ブロックスキャン方式
・描画フィールド:50 µm□/100 µm□/200 µm□/500 µm□(ラスタースキャン),2,500 µm□,1ブロック=2.5 µm□(ブロックスキャン)
両面露光用マスクアライナ (Mask aligner)
- 設備ID
- NU-250
- 設置機関
- 名古屋大学
- 設備画像
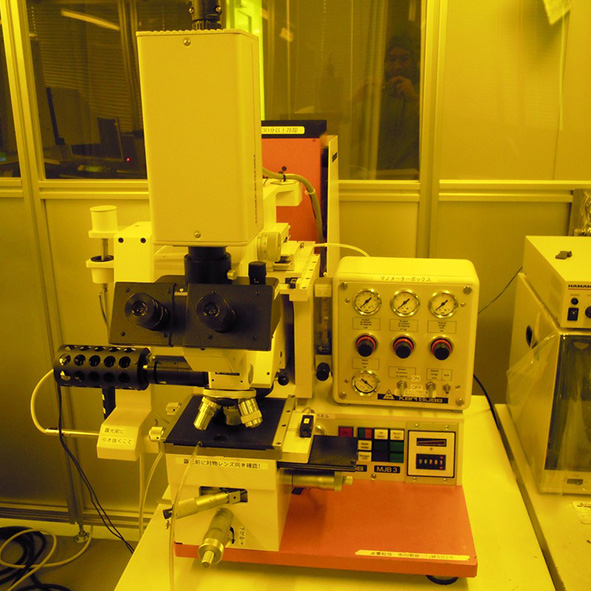
- メーカー名
- Suss MicroTec AG (Suss MicroTec AG)
- 型番
- MJB-3
- 仕様・特徴
- ・最大ウェーハサイズ:3 inch(吸引モード),4 inch(ソフトコンタクト)
・照射範囲:3×3 inch
・対応基板厚さ:4.5 mm
両面露光:可能(赤外線照明)