共用設備検索結果
中分類から探す
マスクレス露光装置 [DL-1000] (Maskless Lithography [DL-1000])
- 設備ID
- NM-636
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![マスクレス露光装置 [DL-1000]](data/facility_item/1687416253_11.jpg)
- メーカー名
- 株式会社ナノシステムソリューションズ (Nano System Solutions Inc.)
- 型番
- DL-1000
- 仕様・特徴
- ・露光方式:DMD
・露光モード:ステップ&リピート描画
・光源 405nm半導体レーザー(h線)
・照度 300mW/cm2
・位置決め精度 ±1um以下
・重ね合わせ精度 ±1um以下
・試料サイズ 最大4インチ角
マスクアライナー [MA-6] (Mask Aligner [MA-6])
- 設備ID
- NM-637
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![マスクアライナー [MA-6]](data/facility_item/1687416307_11.jpg)
- メーカー名
- ズース・マイクロテック株式会社 (SUSS MicroTec SE)
- 型番
- MA-6
- 仕様・特徴
- ・露光方式:フォトマスク(等倍)
・光源:i線、h線、g線
・マスク寸法:102mm角~152mm角、
・基板寸法:76mm径以下
・露光最小線幅:0.75μm
・位置決め精度:0.5μm(表面側)
マスクレス露光装置 [MLA150] (Maskless Lithography [MLA 150])
- 設備ID
- NM-660
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![マスクレス露光装置 [MLA150]](data/facility_item/1687417453_11.jpg)
- メーカー名
- ハイデルベルグ・インスツルメンツ (HEIDELBERG INSTRUMENT)
- 型番
- MLA 150
- 仕様・特徴
- ・露光方式:DMD
・露光モード:スキャニング露光
・光源 375nm半導体レーザー
・照度 7.2W/cm2
・位置決め精度 ±1um以下
・重ね合わせ精度 ±1um以下
・試料サイズ 最大8インチ角
電子ビーム描画装置 (Electron beam drawing equipment)
- 設備ID
- TT-031
- 設置機関
- 豊田工業大学
- 設備画像
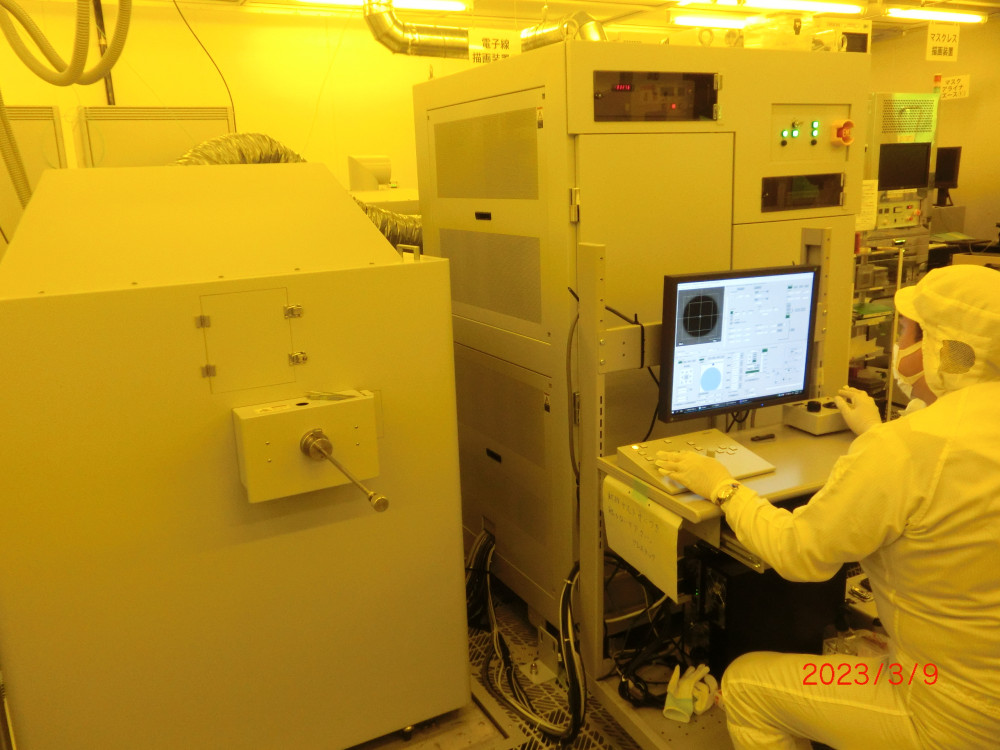
- メーカー名
- クレステック (Crestec)
- 型番
- CABL-AP50S/RD
- 仕様・特徴
- 描画最小径10nm
つなぎ精度50nm/最大1000μm□
グラデーション歪補正可能
両面アライナ(8") (Double-side aligner)
- 設備ID
- TU-069
- 設置機関
- 東北大学
- 設備画像
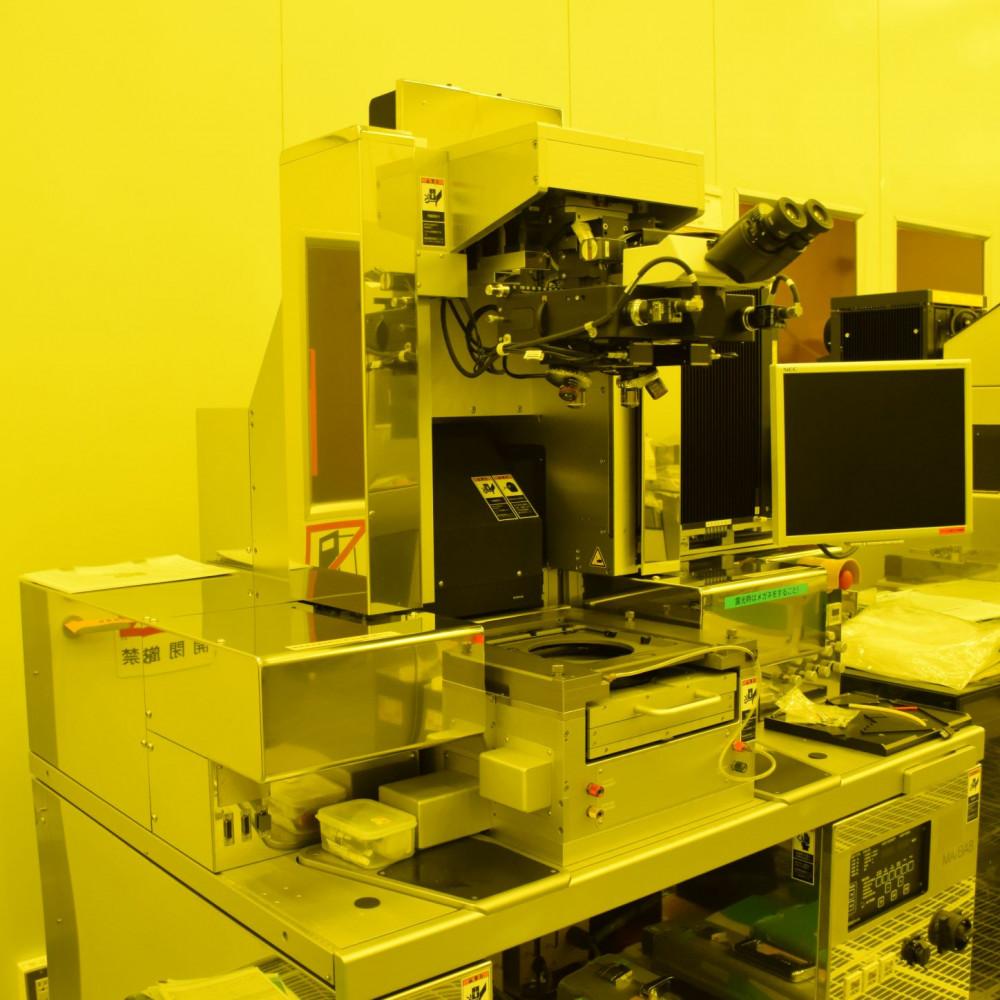
- メーカー名
- SUSS (SUSS)
- 型番
- MA8/BA8 Gen3
- 仕様・特徴
- サンプルサイズ:小片~6インチ
露光波長:ブロードバンド、i線
最小露光線幅:~0.7um
アライメント精度(片面):~1um
アライメント精度(両面):~3um