共用設備検索結果
中分類から探す
電子線描画装置 (Electron beam lithography system)
- 設備ID
- GA-001
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-7500EX
- 仕様・特徴
- 加速電圧:50kV、30kV、20kV
描画可能な最小線幅10nm
フィールドつなぎ精度50nm 以下
描画対象:6インチまで対応可能
所要時間:線幅1μm/2インチウエハ;5~6時間
線幅10nm/2インチウエハ;4日間
マスクレス露光装置 (Mask-less exposure system)
- 設備ID
- GA-002
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- 大日本科研 (Jpn.Sci.Eng.)
- 型番
- MX-1204
- 仕様・特徴
- DMDによるパターン生成露光、
光源:LD(波長375±5nm)
描画方法:直接描画
描画対象:150mm角、
最小描画精度:最小線幅1μm程度、
アライメント精度±0.15μm
スピンコータ- (Spin-coater)
- 設備ID
- GA-003
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- ミカサ (MIKASA)
- 型番
- MS-B150
- 仕様・特徴
- 回転塗布式 1ヘッド
真空吸着方式
試料サイズ:最大154mmφ1mmt
回転数:300–7000r.p.m
回転精度:±1r.p.m
回転時間:最大999.9sec(合計)
回転制御:プログラム方式・最大100段入力可
電子ビーム露光装置 (Electron beam lithograph system)
- 設備ID
- IT-038
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX-8100
- 仕様・特徴
- スポットビーム、ベクタースキャン方式。 ビーム径3nm以下(100kV)、最小線幅8nm。つなぎ精度:仕様20nm/実測7.6nm(フィールドサイズ1000um)、重ね合わせ精度:仕様20nm/9.8nm(フィールドサイズ1000um)試料最大150㎜φウエーハまで 不定形も可能
JEOL01,51,52などの日本電子製電子ビーム露光用パターンデータファイルが入出力可能。
各露光基板形状に基づいたモンテカルロシミュレーションによって点拡がり関数(PSF)を導出でき、得られたPSFに基づく近接効果補正が可能なソフトウェア(GenISys Beamer)を含む。
両面マスク露光&ボンドアライメント装置 (Double-Sided/Infrared Mask Lithography & Bond Aligner )
- 設備ID
- KT-119
- 設置機関
- 京都大学
- 設備画像
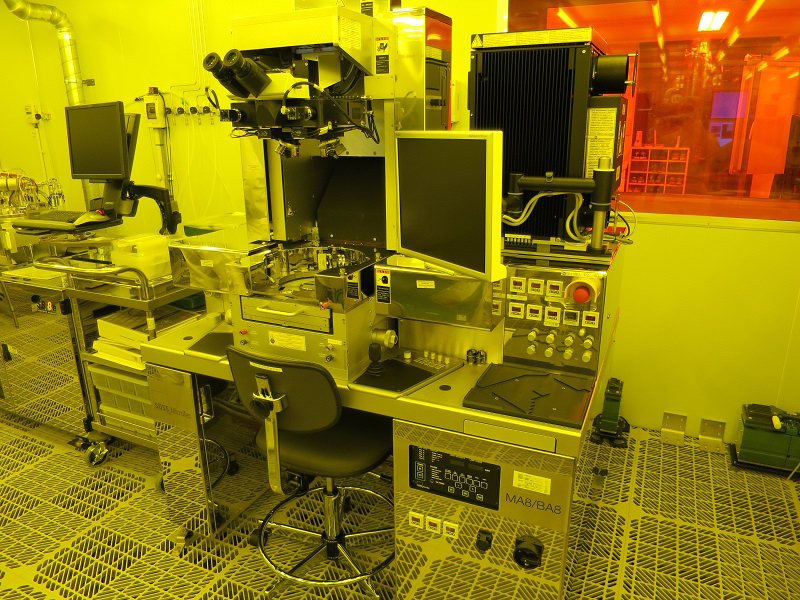
- メーカー名
- ズース・マイクロテック(株) (SUSS MicroTec)
- 型番
- MA/BA8 Gen3 SPEC-KU
- 仕様・特徴
- 接合用アライメントとUVナノインプリント機能を兼備した複合装置。(マスクアライナー機能を兼備)
・基板サイズ:小片~Φ8"
・ウエハ厚さ:MAX 5mm
・マスクサイズ:MAX □9"
・アライメント精度:±0.25um@表面、±1.0um@裏面、±2.0um@接合
両面マスクアライナー (Manual High Precision Double-Sided Mask Aligner)
- 設備ID
- KT-155
- 設置機関
- 京都大学
- 設備画像
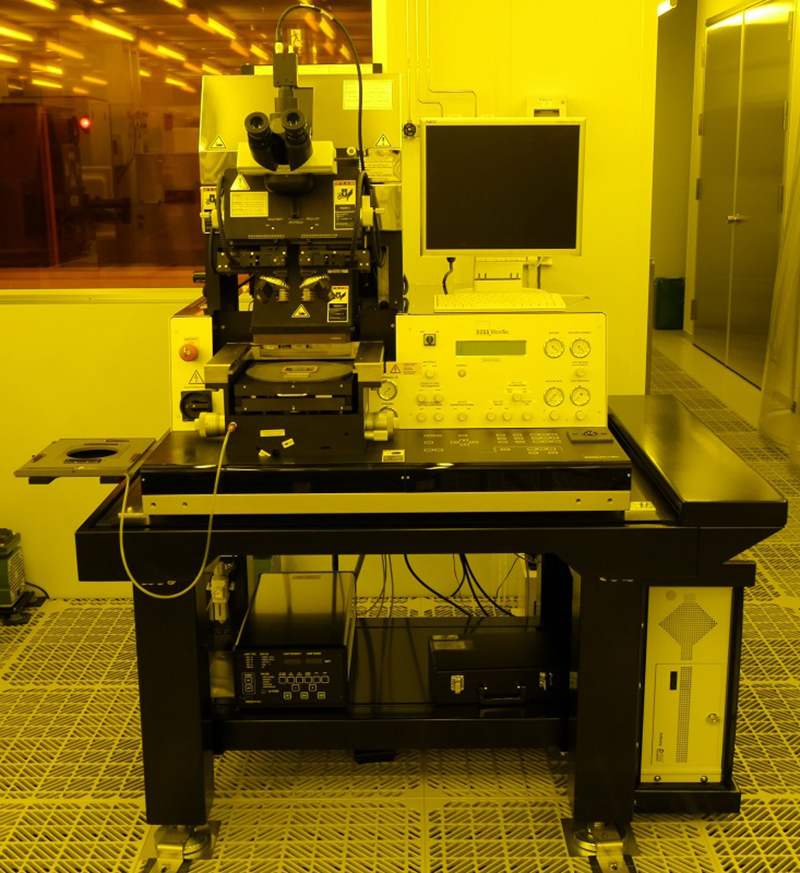
- メーカー名
- ズース・マイクロテック(株) (SUSS MicroTec)
- 型番
- MA6 BSA SPEC-KU/3
- 仕様・特徴
- 高性能手動両面マスクアライナ装置。
・光源:高圧UVランプ350W(h、i線)
・基板サイズ:Φ4"、Φ6"
・露光モード:コンタクト(ソフト、ハード)、プロキシミティ
・アライメント精度 :±0.5um@表面、 ±0.1um@裏面
・厚膜レジスト対応
UVナノインプリント装置 (UV-based Nanoimprint Lithography)
- 設備ID
- KT-239
- 設置機関
- 京都大学
- 設備画像
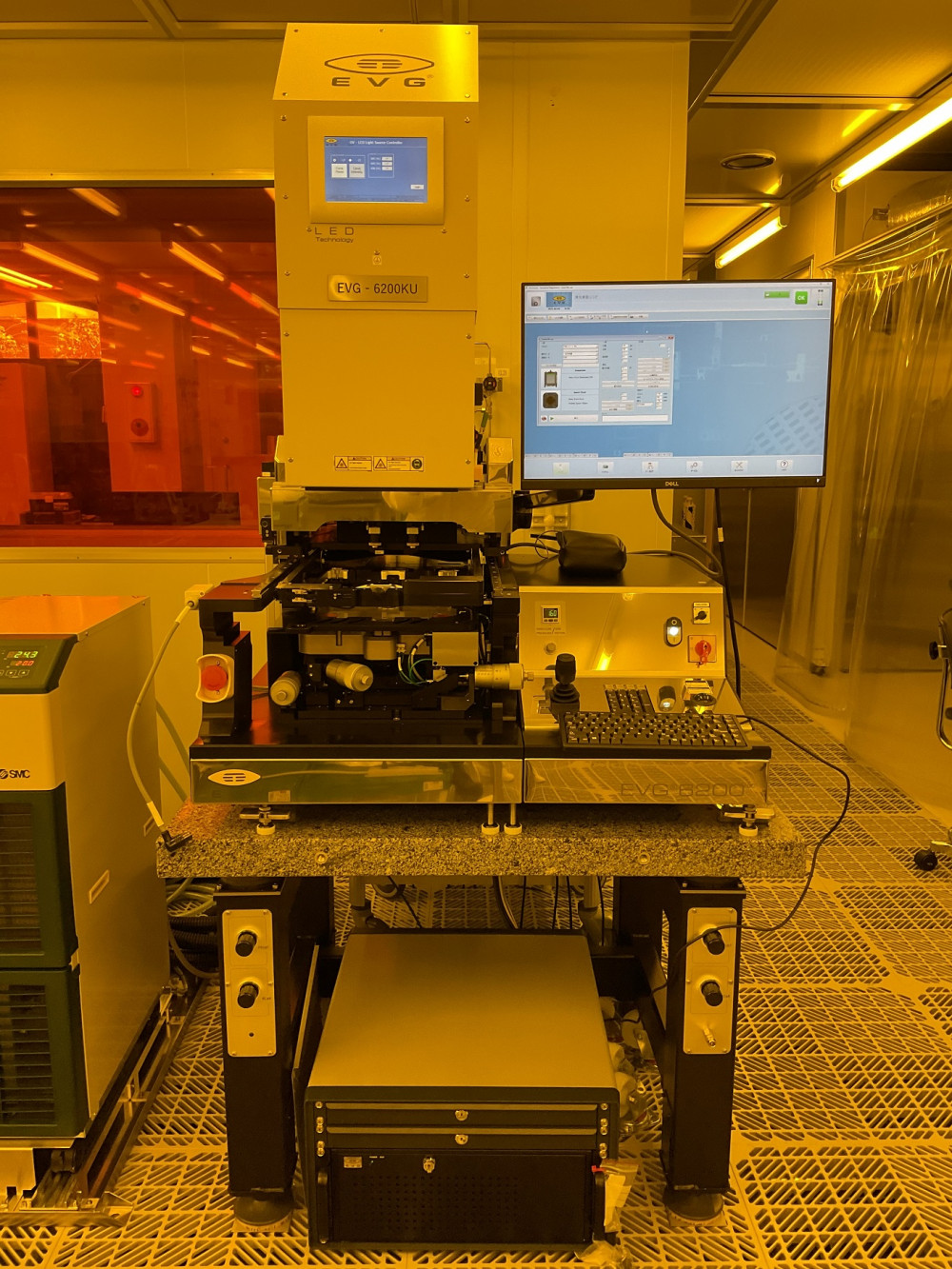
- メーカー名
- イーヴィグループ (EV Group)
- 型番
- EVG6200TBN
- 仕様・特徴
- 光硬化性ポリマーやフォトレジストにナノ・マイクロレベルの構造を形成する光インプリントリソグラフィー装置。
・LED光源:365nm、405nm、436nm
・最大基板サイズ:6インチΦ(不定形対応)
・アライメント:±3.0μm
熱インプリント装置 (Hot Embossing System)
- 設備ID
- KT-240
- 設置機関
- 京都大学
- 設備画像
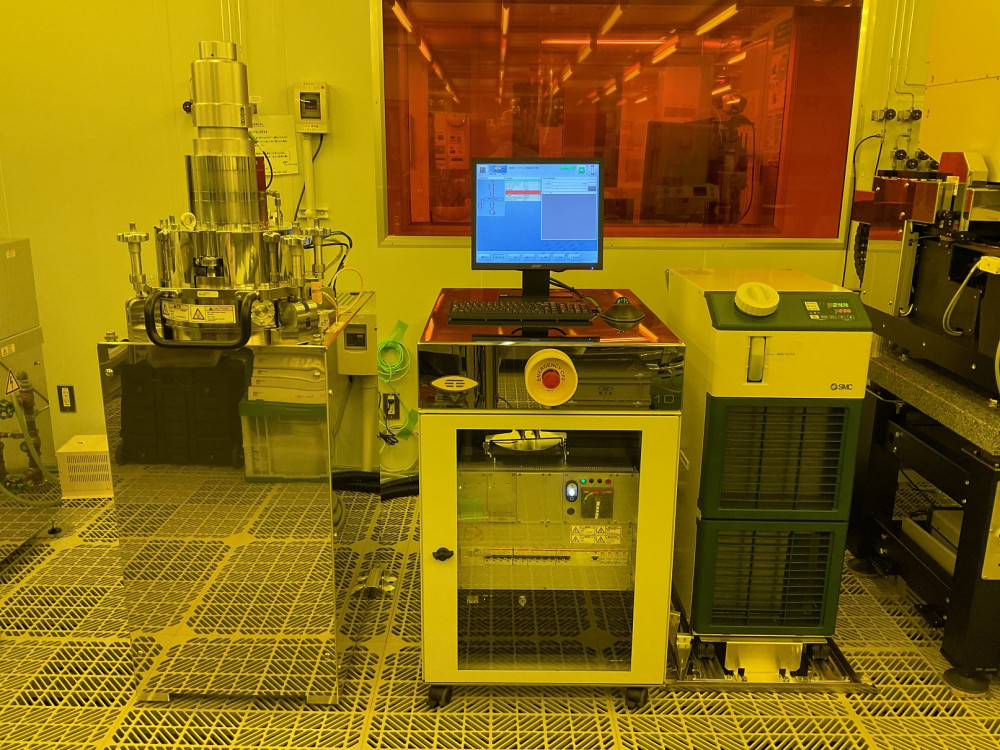
- メーカー名
- イーヴィグループ (EV Group)
- 型番
- EVG510
- 仕様・特徴
- プラスチック基板やポリマーを塗布した半導体ウェハを加熱加圧によりエンボス加工する装置。
・最大基板サイズ:6インチΦ(不定形対応)
・最高プロセス温度/荷重:350℃/20kN
ナノインプリントシステム (Nanoimprint Lithography)
- 設備ID
- KT-257
- 設置機関
- 京都大学
- 設備画像
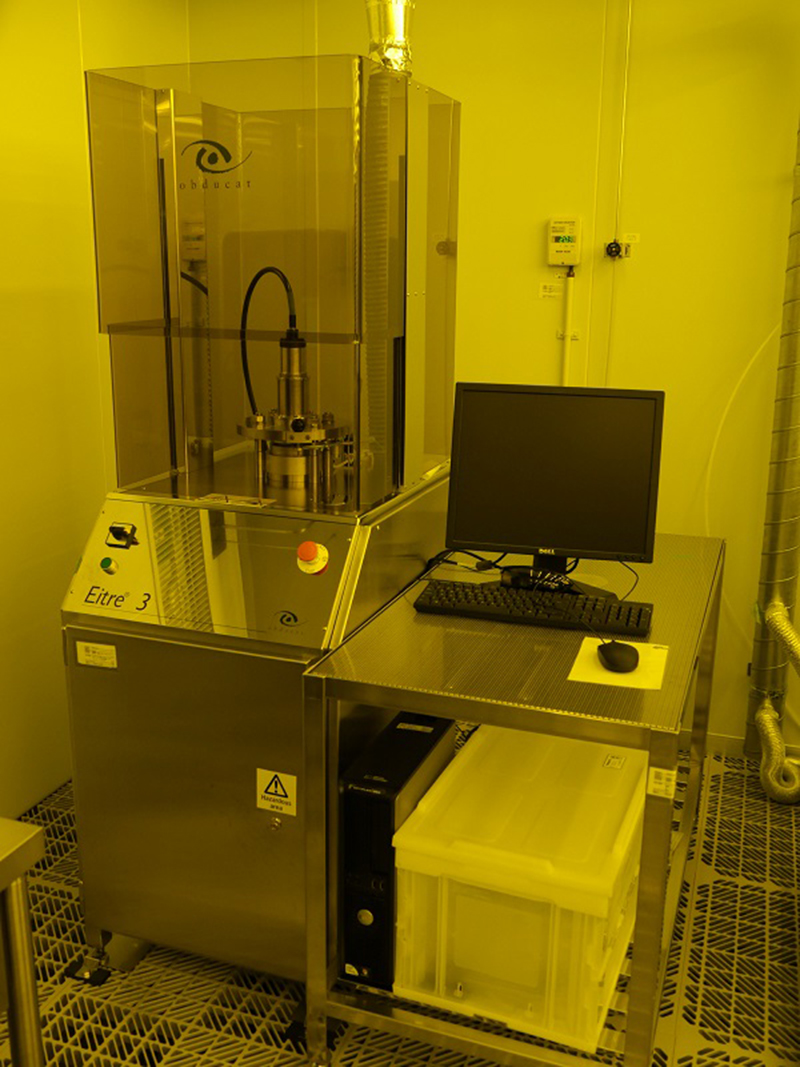
- メーカー名
- Obducat社 (OBDUCAT AB)
- 型番
- Eitre3
- 仕様・特徴
- 最大3インチの基板サイズ対応の一括転写ナノインプリント装置
・基板サイズ φ3
・インプリント方式 STU/熱/UV、全面一括
・最高到達温度(熱インプリント時) 250℃
電子ビーム描画装置 [ELS-BODEN100] (EB Lithography [ELS-BODEN100])
- 設備ID
- NM-635
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子ビーム描画装置 [ELS-BODEN100]](data/facility_item/1687416131_11.jpg)
- メーカー名
- 株式会社エリオニクス (ELIONIX INC.)
- 型番
- ELS-BODEN100
- 仕様・特徴
- 【遠隔利用可】
加速電圧:100kV
電流値:100pA~20nA
フィールドサイズ:100, 250, 500, 1000mm(デフォルト)
最小ドットピッチ:0.2nm
最小ショットタイム:10 nsec/dot(分解能:0.1nsec)
フィールドつなぎ精度:(30nm以下)
重ね合わせ精度:(35nm以下)
最大試料サイズ:~8インチΦ
対応CADフォーマット:GDSII, DXF、他
画像検出器:SE、BSE
自動/手動アライメント機能