共用設備検索結果
中分類から探す
超高精細電子ビームリソグラフィー装置 (Ultra high definition electron beam lithography system)
- 設備ID
- OS-103
- 設置機関
- 大阪大学
- 設備画像
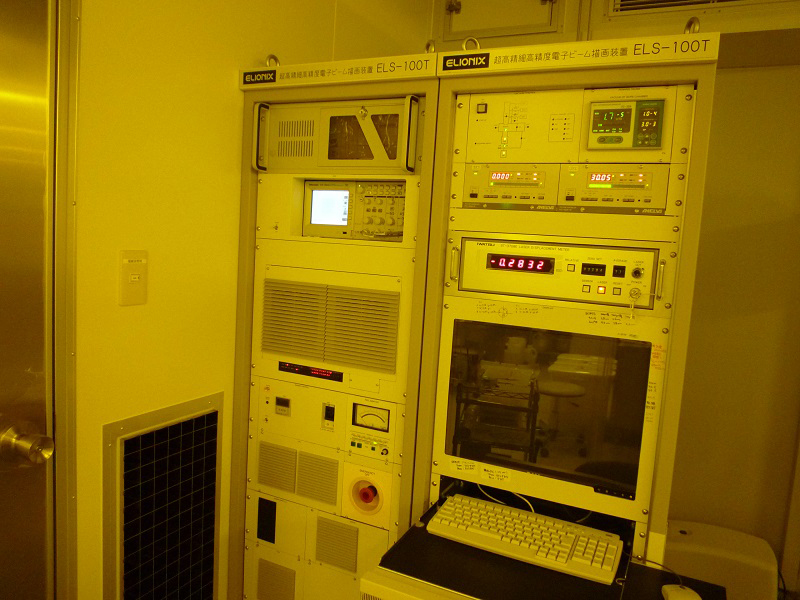
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-100T
- 仕様・特徴
- 【特徴】
最小ビーム径φ1.7nmにて線幅10nm以下の細線描画が可能。
【仕様】
描画最小線幅:5nm
繋ぎ重ね精度:15nm以下
電子銃:ZrO/W熱電界放射型
描画方式:ベクタースキャン方式
加速電圧:125kV, 100kV, 75kV, 50kV
描画フィールド:75µm□~2400µm□
最大試料サイズ:6inch
自動搬送電子ビーム描画装置 (Automatic Transport Electron Beam Lithography System)
- 設備ID
- OS-104
- 設置機関
- 大阪大学
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-BODEN-OU4801
- 仕様・特徴
- 【特徴】
ZnO/W熱電解放射型電子銃の採用により、最小ビーム径1.5nmφの極細線用ビームを長時間安定して使用することができます。また最高150kVの加速電圧を採用し、最小線幅4nmの描画が可能です。
【仕様】
加速電圧:150kV
最小電子ビーム径:φ1.5nm
最小描画線幅:4nm
ビーム電流可変域:5pA-100nA
描画フィールドサイズ:□100μm、□250μm、□500μm
高速大面積電子ビームリソグラフィー装置 (High speed and large area electron beam lithography system)
- 設備ID
- OS-105
- 設置機関
- 大阪大学
- 設備画像
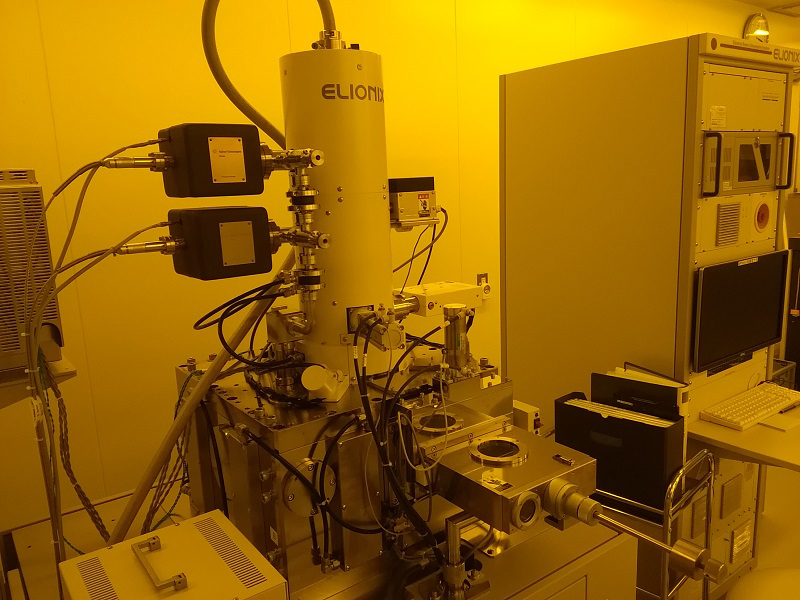
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-S50LBC
- 仕様・特徴
- 【特徴】
加速電圧50kVで1µAのビーム電流が得られる。最高クロック周波数100MHzの高速ビーム変更システムを搭載し、大面積を高スループットで描画することに特化。
【仕様】
電子銃:ZrO/W熱電界放出型(TFE)
描画方式:ベクタースキャン方式
加速電圧:20, 30, 50kV
ビーム電流:100pA~1µA
描画フィールド:100µm□~3000µm□
試料サイズ:10~25mm□、3インチ□、4インチ・6インチφウエハ
マスクアライナー (Mask aligner)
- 設備ID
- OS-107
- 設置機関
- 大阪大学
- 設備画像
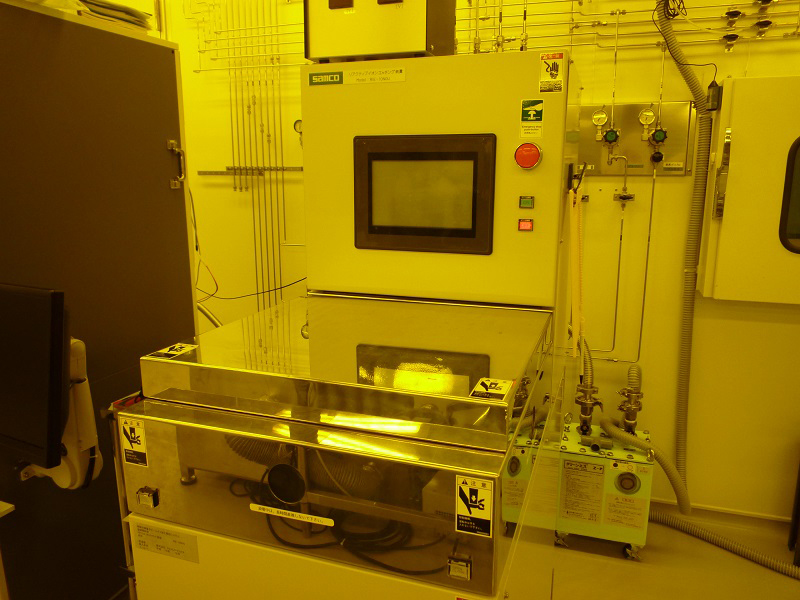
- メーカー名
- ミカサ (Mikasa)
- 型番
- MA-10
- 仕様・特徴
- 【特徴】
UV露光、マニュアルタイプ、コンタクト露光機。二視野顕微鏡採用によるスピーディで正確なアライメント。
【仕様】
試料は 2 inch φ、マスクは 3 inch角まで対応
水銀灯250W光源(ブロード波長)
二視野顕微鏡採用
ナノインプリント装置 (Nanoimprint system)
- 設備ID
- OS-108
- 設置機関
- 大阪大学
- 設備画像
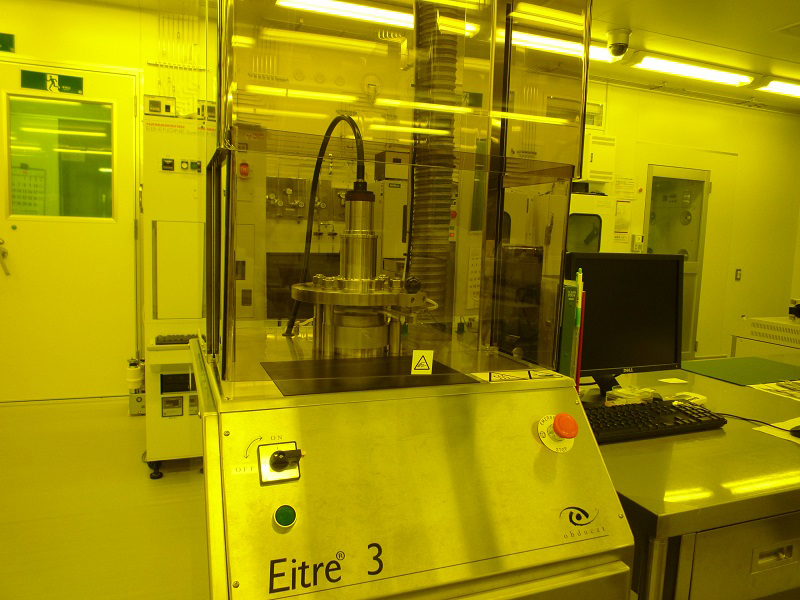
- メーカー名
- オブデュキャット (Obducat)
- 型番
- Eitre 3
- 仕様・特徴
- 【特徴】
UV(波長 365, 405, 436nm)と熱(室温~200℃)を使って、最大3インチの微細パターンを転写可能。エア加圧(最大50bar)なので基板全面に均一に転写でき、異物によるモールドの破損が少ない。鋳型準備が必要だが同じパターンを複数作製したいユーザーに最適。
【仕様】
熱・UVの両方式に対応
試料サイズ:3 inch
超高精度電子ビーム描画装置 (Ultra high precision electron beam lithography system)
- 設備ID
- RO-111
- 設置機関
- 広島大学
- 設備画像
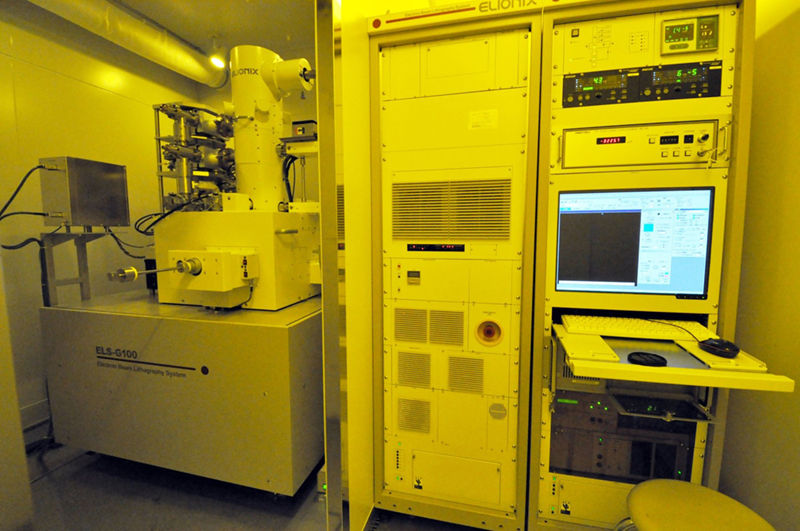
- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-G100
- 仕様・特徴
- 試料サイズ:2~6インチ直径の定型ウエハ
加速電圧:100kV,50kV, 25kV
電子ビームの最小スポットサイズ:ビーム電流1nAにおいて2.0nm以下
最小線幅:6nm
マスクレス露光装置 (Maskless photolithography system)
- 設備ID
- RO-112
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 株式会社ナノシステムソリューションズ (NanoSystem Solutions, Inc.)
- 型番
- DL-1000
- 仕様・特徴
- 対応wafer:2~4inch、cut wafer他
DMDを用いたレーザー露光装置
最小画素:1μm
マスクレス露光装置 (Maskless photolithography system)
- 設備ID
- RO-113
- 設置機関
- 広島大学
- 設備画像
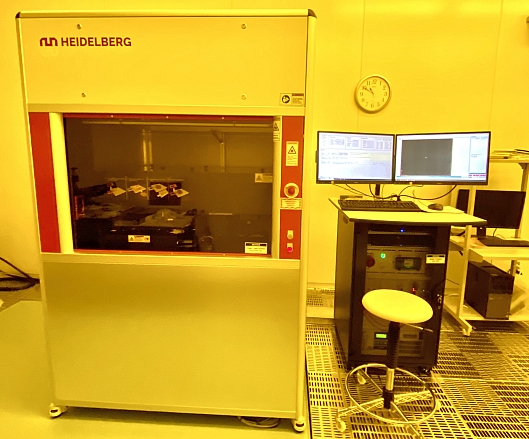
- メーカー名
- ハイデルベルグ・インストルメンツ (Heidelberg Instruments)
- 型番
- MLA150
- 仕様・特徴
- 対応wafer:2~6inch、cut wafer他
DMDを用いたレーザー露光装置
レーザ光源:375nm 7.2W 最小画素:1μm
スピンコータ (Spin Coater)
- 設備ID
- RO-121
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- タツモ(株) (TAZMO)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
レジスト塗布
レイアウト設計ツール (Mask layout design tool)
- 設備ID
- RO-131
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- Tanner (Tanner)
- 型番
- L-Edit
- 仕様・特徴
- リソグラフィマスク設計用レイアウトエディター
IC,MEMSデバイス設計用ソフト。Tanner社L-Edit