共用設備検索結果
中分類から探す
電子ビーム描画装置 (Electron Beam Lithography Exposure)
- 設備ID
- WS-015
- 設置機関
- 早稲田大学
- 設備画像
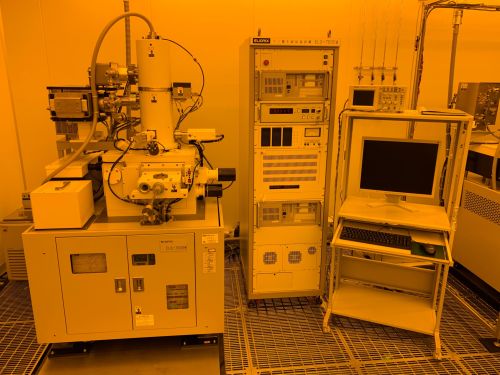
- メーカー名
- 株式会社エリオニクス (ELIONIX INC.)
- 型番
- ELS-7500
- 仕様・特徴
- 最小線幅:10 nm
基板サイズ10mm角~4インチ
加速電圧:5~50 kV
レーザー直接描画装置 (Advanced Maskless Aligner )
- 設備ID
- WS-016
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- ハイデルベルグ・ジャパン株式会社 (Heidelberger Druckmaschinen AG)
- 型番
- MLA150
- 仕様・特徴
- (375nm Diode、SU-8対応)
マスクレス露光装置 (Maskless exposure system)
- 設備ID
- IT-003
- 設置機関
- 東京工業大学
- 設備画像
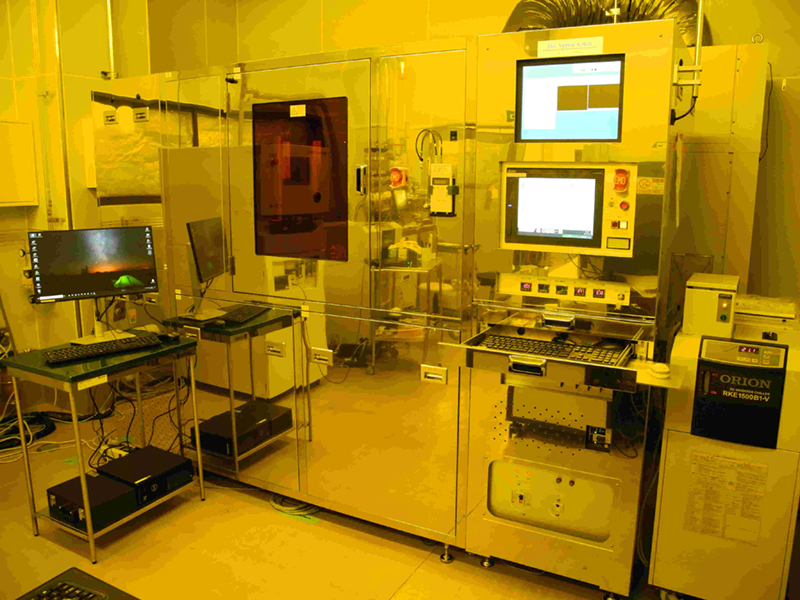
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1205
- 仕様・特徴
- DMDによるパターン生成露光、100mm角露光サイズ、最小描画画素1μm、アライメント精度±0.15μm データ取り込み機能
マスクレス露光装置 (Maskless exposure system)
- 設備ID
- IT-004
- 設置機関
- 東京工業大学
- 設備画像
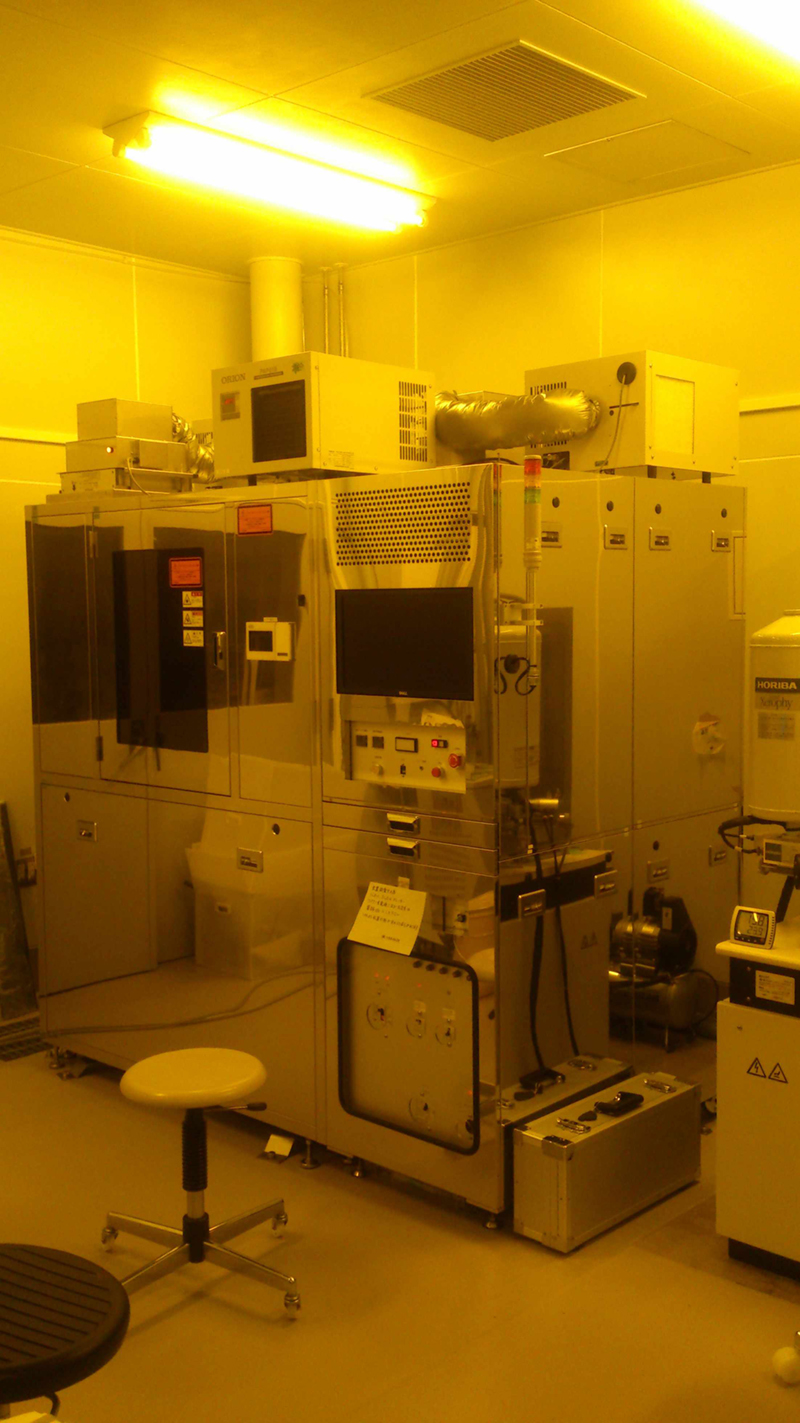
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1204
- 仕様・特徴
- DMDによるパターン生成露光、150mm角露光サイズ、最小描画画素2μm、アライメント精度±0.15μm
コンタクト光学露光装置 (Contact optical exposure)
- 設備ID
- IT-005
- 設置機関
- 東京工業大学
- 設備画像
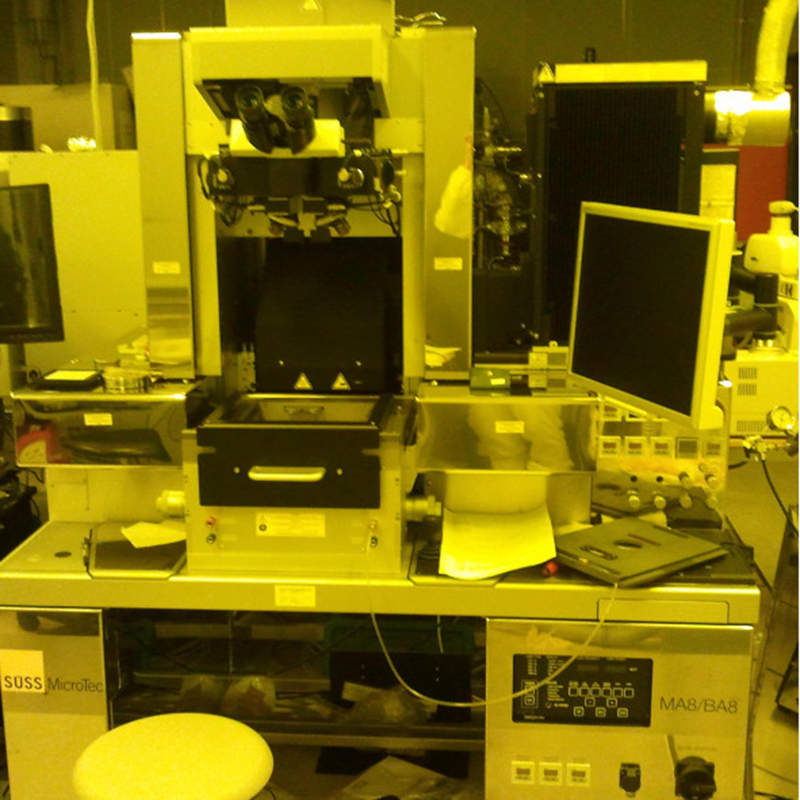
- メーカー名
- ズース ( Süss)
- 型番
- MA-8
- 仕様・特徴
- ・アシスト機能装備、TSA/BSA装備
・表面アライメント制度 TSA:±0.25μm以下 BSA:±1.00μm以下
・露光解像度 0.5μm
・対応基板 小片~直径2inch ウェハ
クリーンルーム微細加工装置群 (clean room facility)
- 設備ID
- JI-017
- 設置機関
- 北陸先端科学技術大学院大学(JAIST)
- 設備画像
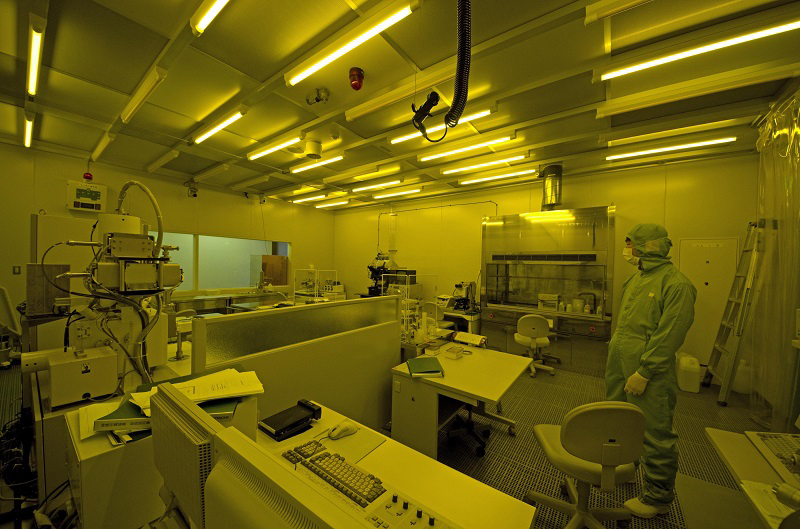
- メーカー名
- ()
- 型番
- 仕様・特徴
- EBL(30kV, 50kV)、マスクレス露光機(405nm, 375nm)、抵抗加熱蒸着、EB蒸着、RFスパッタ、ECRスパッタ、ALD、MBE、RIE、イオン注入、赤外ランプアニールなど
マスクレス露光装置 (Maskless exposure equipment)
- 設備ID
- TT-005
- 設置機関
- 豊田工業大学
- 設備画像
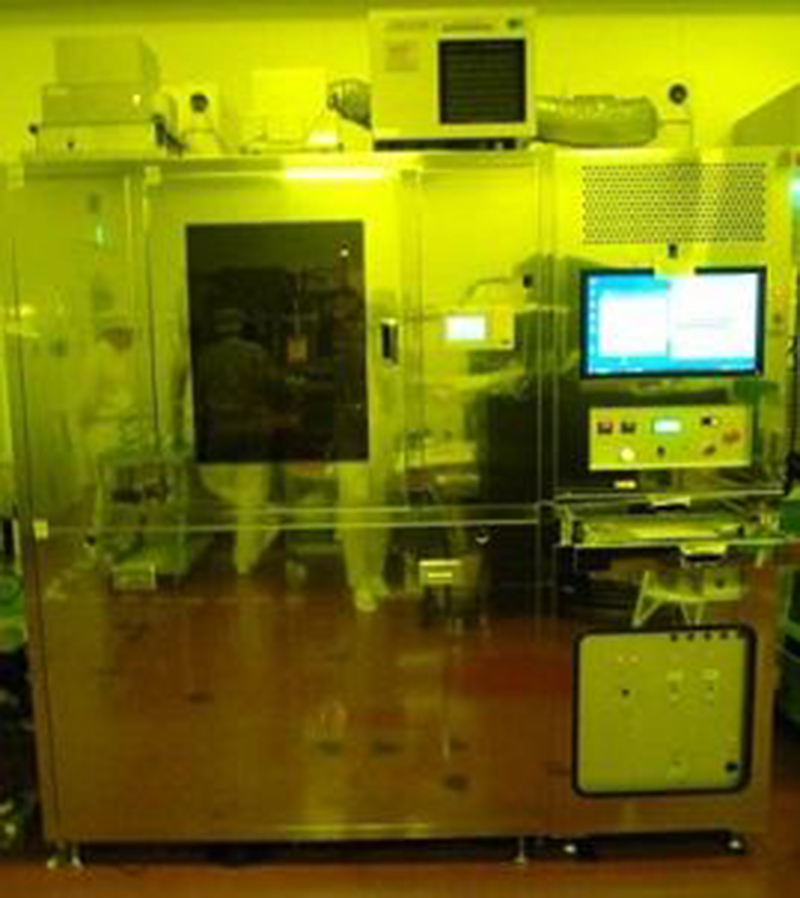
- メーカー名
- 大日本科研 (Japan Science Engineering Co., Ltd.)
- 型番
- MX-1204
- 仕様・特徴
- φ4インチにポジ型フォトレジスト(膜厚1μm以上)に、2μm幅のラインアンドスペースを全面(外周3mm除く)に描いたときに、描画時間が30分程度。
露光パターン幅のバラツキが100 nm(1σ)以下。
マスクアライナ装置 (Mask aligner)
- 設備ID
- TT-006
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- ズース・マイクロテック (SUSS MicroTec)
- 型番
- MA6
- 仕様・特徴
- ・裏面アライメント可能、i線フィルタ付き
・付帯装置:レジストのスピンコータ共和理研K-359SDなど
マスクレス露光装置 (Maskless Lithography System)
- 設備ID
- MS-101
- 設置機関
- 自然科学研究機構 分子科学研究所
- 設備画像
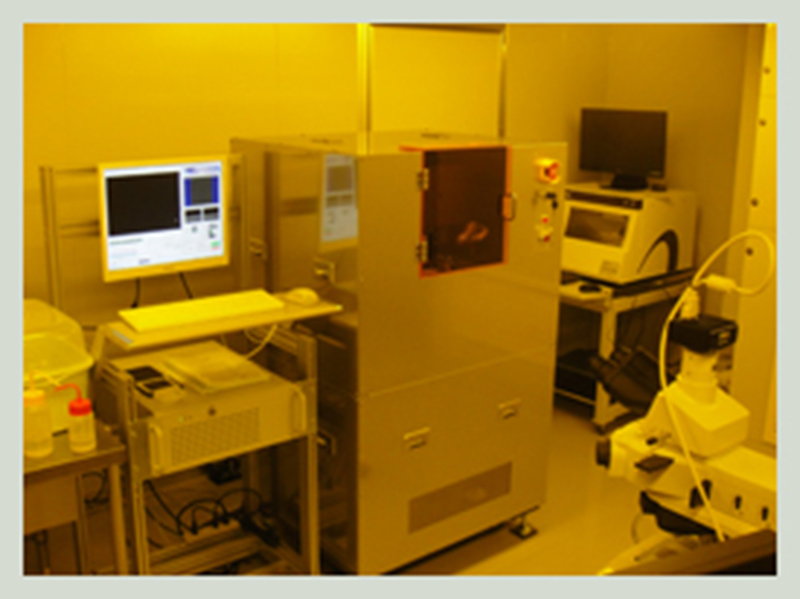
- メーカー名
- ナノシステムソリューションズ (NanoSystem Solutions)
- 型番
- DL-1000
- 仕様・特徴
- 【付帯設備】
精密温度調整機能付クリーンブース
マスクアライナー(ミカサ社製MA-10)
スピンコーター(ミカサ社製MS-A100)
電子ビーム描画装置 (Electron Beam Lithgraphy System)
- 設備ID
- MS-103
- 設置機関
- 自然科学研究機構 分子科学研究所
- 設備画像
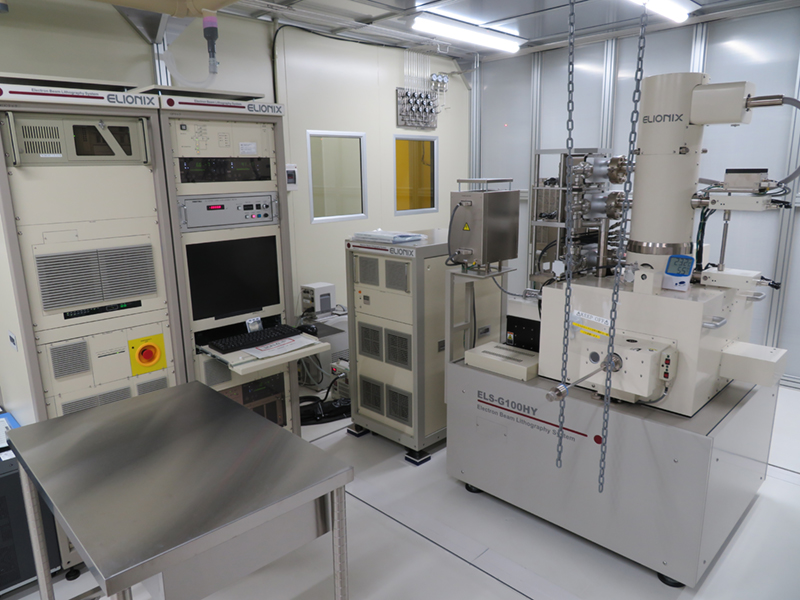
- メーカー名
- エリオニクス (Elionix Inc.)
- 型番
- ELS-G100
- 仕様・特徴
- 最大加速電圧100kV, 最小ビーム径1.8nm, 最小描画線幅6nm