共用設備検索
共用設備検索結果
- 設備ID
- BA-005
- 設置機関
- 筑波大学
- 設備画像
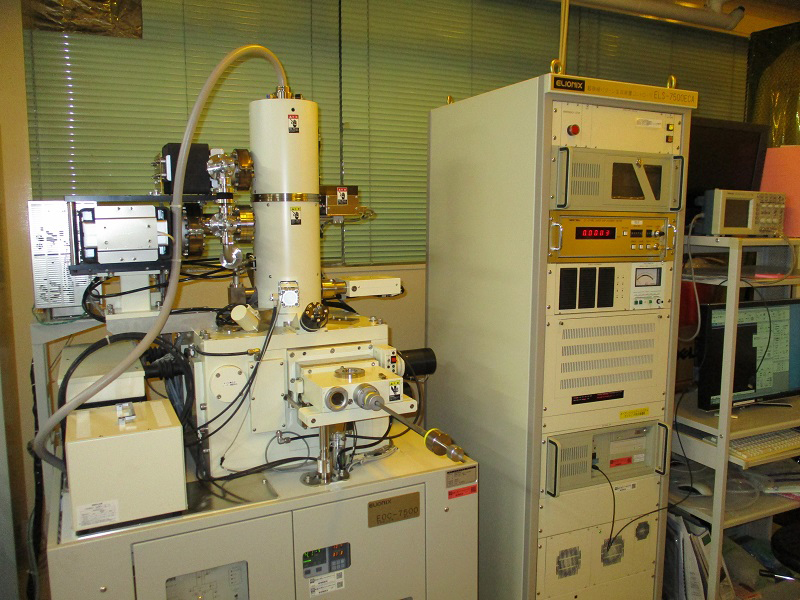
- メーカー名
- ELIONIX (ELIONIX)
- 型番
- ELS-7500EX
- 仕様・特徴
- 電子銃エミッター:ZrO/W熱電界放射型
加速電圧:5~50 kV
最小線幅:10 nm
試料サイズ:最大4インチ
ステージ移動範囲: X:100 mm以上 Y:110 mm以上
重ねあわせ精度:40 nm
フィールド継ぎ精度:40 nm
- 設備ID
- BA-009
- 設置機関
- 筑波大学
- 設備画像
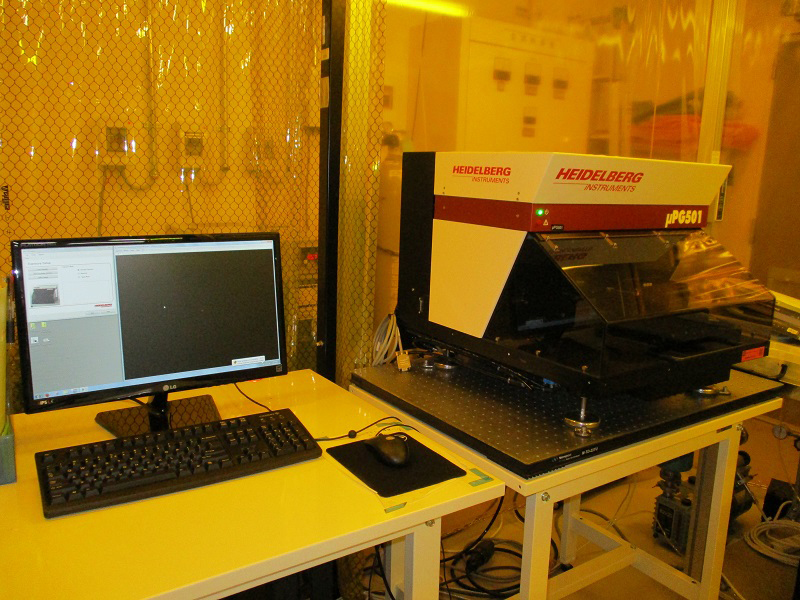
- メーカー名
- Heidelberg instruments (Heidelberg instruments)
- 型番
- μPG501
- 仕様・特徴
- 描画エリア;125×125mm2
最小描画サイズ;1.0μm
最小アドレッシンググリッド;50nm@1μm
描画スピード;50mm2/min@1μm,100mm2/min@2μm
- 設備ID
- BA-011
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- Neutronix-Quintel/ミカサ ( Neutronix-Quintel/Mikasa)
- 型番
- Q 2001CT/MS-A100
- 仕様・特徴
- Neutronix-Quintel社製Q 2001CT(2.5インチマスク用コンタクトアライナー)
マスク-ウエハ間隔;0-180μm
基板;1cm角~4インチφ マスク;2.5インチ角、5インチ角
光源;200W水銀ランプ(350~450nm)
解像度;0.6~1.0μm
マニュアルアライメント;1.0μm
照度分布;≤5%@3.5インチφ
ミカサ社製MS-A100(スピンコーター)
基板: 5mm角から4インチφまで
- 設備ID
- AT-001
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
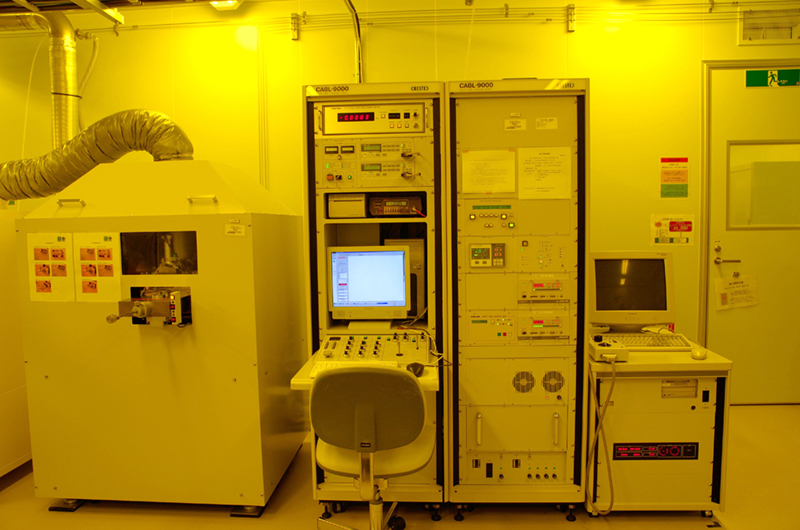
- メーカー名
- クレステック (CRESTEC)
- 型番
- CABL_9410TFNA
- 仕様・特徴
- ・型式:CABL-9410TFNA
・試料サイズ:6インチφ×4.6 mm(高さ)
・電子銃:熱電界放射型ZrO/Wエミッタ
・最小スポット:2 nmφ(加速電圧50 kV)
・描画可能な最小線幅:10 nm(レジスト膜厚100 nm)
・走査方式:ベクター走査、ラスター走査
・走査領域:最大1 mm□
・つなぎ合わせ描画領域:最大150 mm□
・つなぎ合わせ精度:50 nm以下
・重ね合わせ精度:50 nm以下
- 設備ID
- AT-006
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ナノシステムソリューション (Nano System-Solutions)
- 型番
- DL1000
- 仕様・特徴
- ・型式:DL1000
・試料サイズ:4インチφ、100mm□
・光源:波長405nm(LED)
・露光最小画素:1μm□
・最大露光領域:100mm□
・重ね合わせ精度:±1μm
- 設備ID
- AT-009
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![コンタクトマスクアライナー[MJB4]](data/facility_item/AT-009.jpg)
- メーカー名
- ズース (SUSS MicroTec)
- 型番
- MJB4
- 仕様・特徴
- ・型式:MJB4
・基板サイズ:2インチφ~4インチφ、不定形小片~100mm
・解像度:約800nm (バキュームコンタクト使用時)
・波長:g線(436nm)、h線(405nm)、i線(365nm)
・ 照度 :約25mW/cm2
・露光モード:プロキシミティ、ソフトコンタクト、 ハードコンタクト、ソフトバキュームコンタクト、 バキュームコンタクト
・露光領域:2.5~5インチ対応マスクホルダー(最大40mm□)
4インチ, 5インチ対応マスクホルダー 最大110mmφ
- 設備ID
- AT-011
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
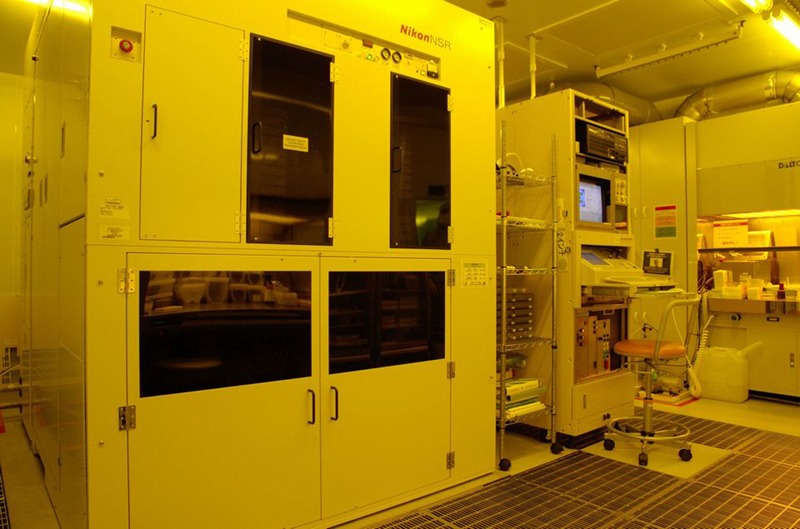
- メーカー名
- ニコン (Nikon)
- 型番
- NSR-2205i12D
- 仕様・特徴
- ・形式:NSR-2205i12D
・試料サイズ:2インチφ~8インチφ
20 mm, 18mm, 15 mm, 10 mm□クーポン
・露光光源:i線(波長365 nm)
・解像度:350 nm以下
・最大N.A.:0.63
・縮小倍率:5分の1倍
・露光範囲:22 mm□(ウェハー上)
・レチクル:6インチ石英ガラス(6025)
・総合アライメント精度:55 nm以下
- 設備ID
- AT-093
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F130AN
- 仕様・特徴
- ・型式:LS-F130AN
・試料サイズ:~12インチφ、9インチ□のマスクブランクス
・電子銃:ZrO/W熱電界放射型
・加速電圧:130kV, 100kV, 50kV, 25kV
・最小ビーム径:1.7nm (@ 130kV)
・最小描画線幅:5nm (@ 130kV)
・最大スキャンクロック:100MHz
・ビーム電流強度:5pA~100nA
・フィールドサイズ:100μm □、250μm□、500μm□、1000μm□(100kV以下)、1500μm□(50kV以下)、3000μm□ (25kV以下)
・ビームポジション:1,000,000×1,000,000 (20bit DAC)
・位置決め分解能:0.1nm
・つなぎ精度:±10nm
・重ねあわせ精度:±15nm
・描画可能エリア:210mm×210mm
- 設備ID
- AT-110
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
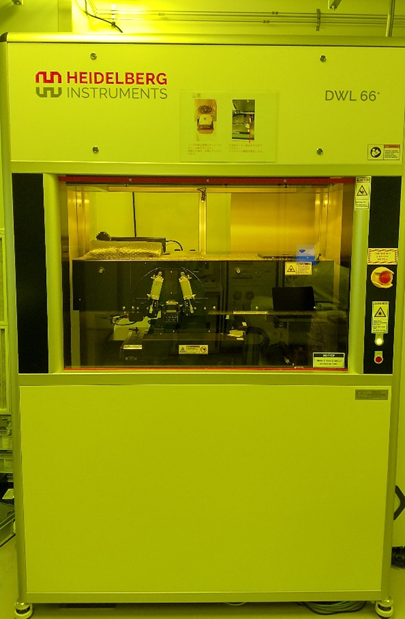
- メーカー名
- ハイデルベルグ (Heidelberg Instruments)
- 型番
- DWL66+
- 仕様・特徴
- ・型式:DWL66+
・試料サイズ:8インチφ、200mm×200mm×12mmt
・最小角型試料サイズ: 5mm×5mm
・描画エリア:200mm×200mm
・レーザー光源:405nm
・最小描画パターン:0.5μm (L&S)、0.3μm(孤立パターン)
・重ね合わせ描精度:0.25μm(5mm×5mm以内)、0.5μm(100mm×100mm以内)
・裏面パターンとの重ね合わせ精度:1μm
・グレースケール露光:1000階調
- 設備ID
- WS-014
- 設置機関
- 早稲田大学
- 設備画像
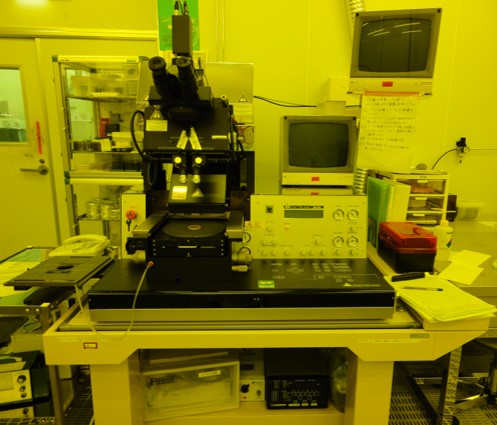
- メーカー名
- ズース マイクロテック グループ (SUSS MicroTec Group)
- 型番
- MA6/BA6
- 仕様・特徴
- ズースマイクロテック社製MA6
小片~4インチまで露光可能
最小線幅1μm
UV両面マスクアライナー
"リソグラフィ"で検索した結果 135件
- 135件中 91~100件
- <
- 1
- ...
- 7
- 8
- 9
- 10
- 11
- 12
- 13
- 14
- ...
- 14
- >
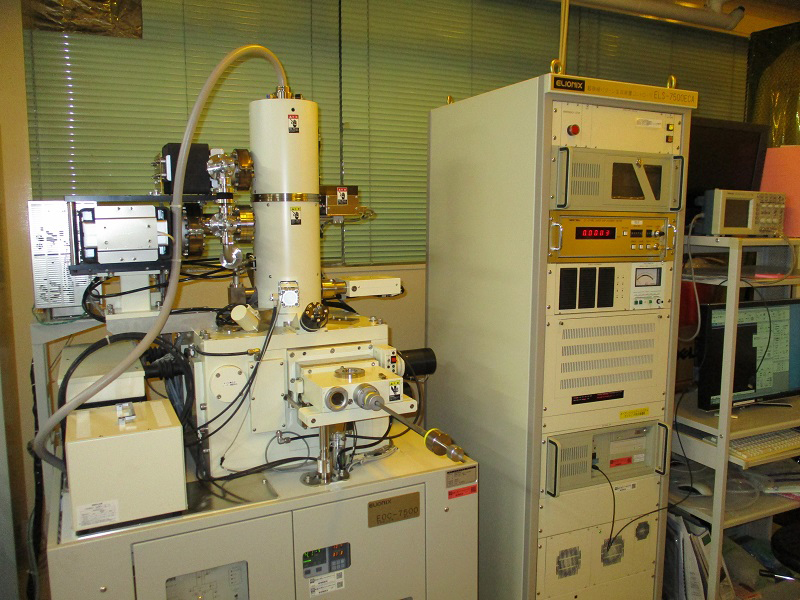
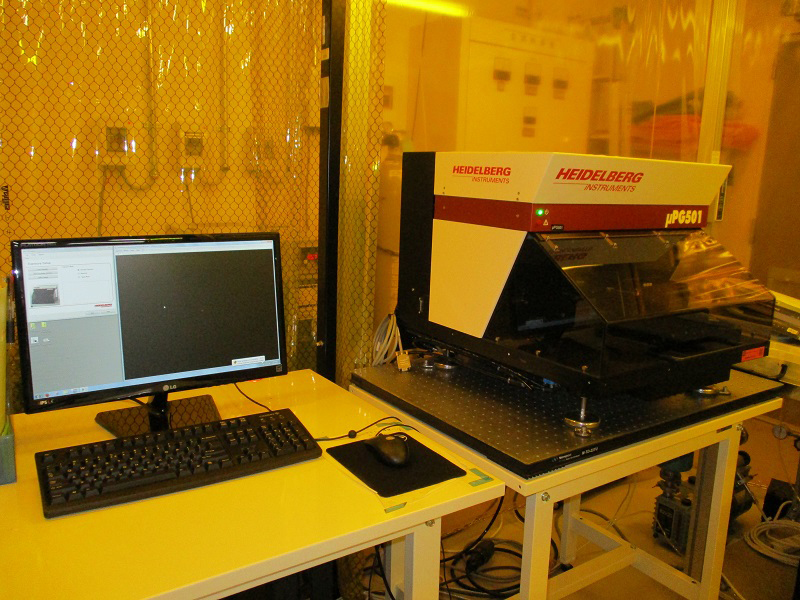

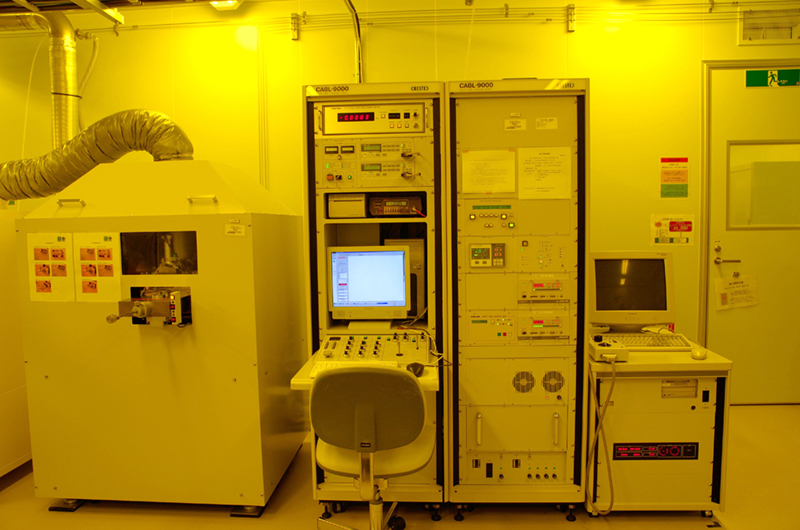

![コンタクトマスクアライナー[MJB4]](data/facility_item/AT-009.jpg)