共用設備検索結果
中分類から探す
ウエハスピン現像装置 (Wafer spin developer )
- 設備ID
- GA-015
- 設置機関
- 香川大学
- 設備画像
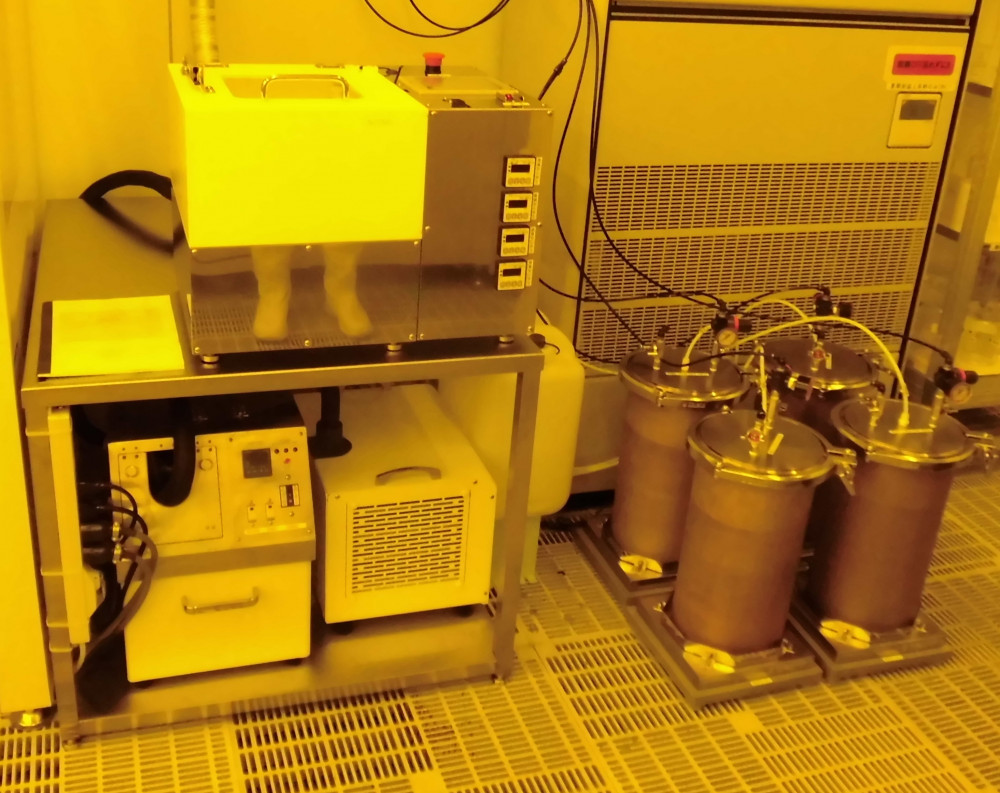
- メーカー名
- 滝沢産業 (TAKIZAWA SANGYO)
- 型番
- AD-1200(無機用),AD-1200(有機用)
- 仕様・特徴
- 基板サイズ:φ4"以下
基板ホルダー:真空吸着式
基板回転数:0~3000rpm 可変式
処理時間:999sec/stop(1sec単位)
使用薬液:無機系アルカリ液対応と有機溶剤対応
処理方法:スプレースイングアーム式
電子線描画用データ処理ソフトウェア (Data analysis software for electron beam lithography)
- 設備ID
- NU-268
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- GenISys (GenISys)
- 型番
- BEAMER
- 仕様・特徴
- ・レイアウトエディタ
・パターンデータ変換
・近接効果補正(PEC)
・グレースケール露光補正
枚様式HMDS処理装置APPS-30 (Single-wafer type HMDS surface treatment machine)
- 設備ID
- UT-512
- 設置機関
- 東京大学
- 設備画像
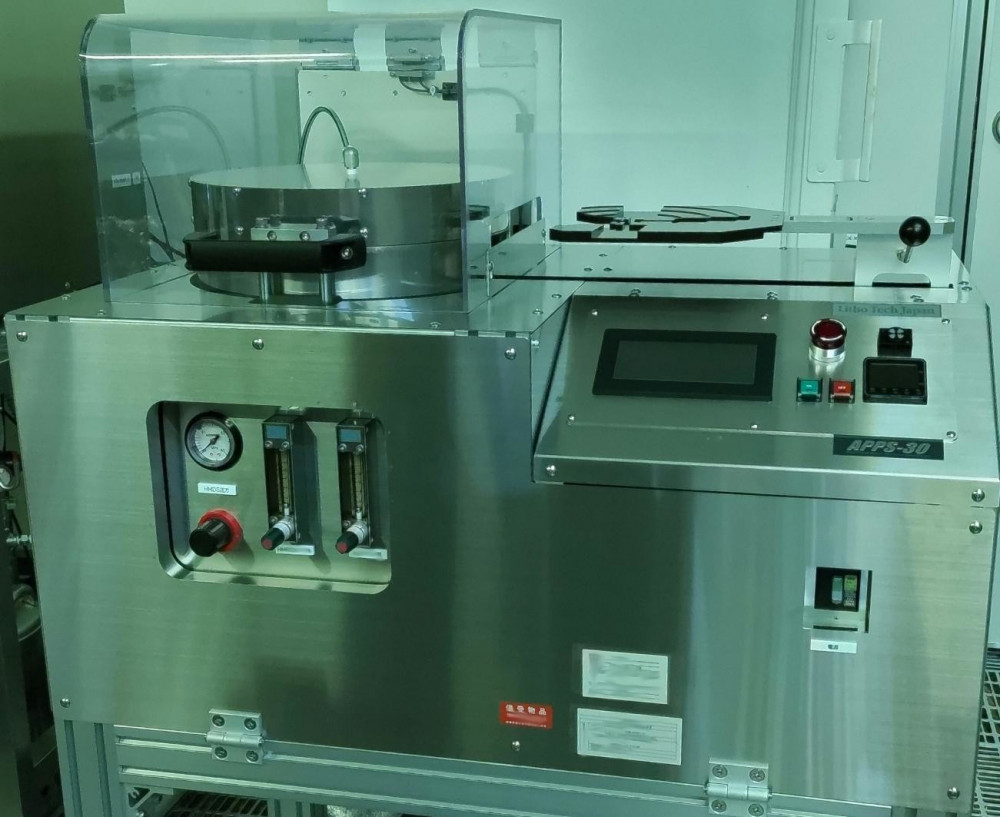
- メーカー名
- リソテックジャパン (Litho Tech Japan)
- 型番
- APPS-30
- 仕様・特徴
- シリコン表面(シラノールSi-O基)をHMDSでメチル基に置換疎水化し、レジスト現像時の密着性を改善する表面処理。スピンコーターを共用してHMDSを塗布すると、発生するアンモニアによって、レジストによっては悪影響が出る。本装置はHMDS塗布専用装置なので悪影響の心配が無い。
基板サイズ:2インチ~300mmウエハ
ベーク温度:60~150℃
HMDS供給:内臓バブリングシステム
レーザー直接描画装置DWL66+2024 (Laser Drawing System DWL66+2024)
- 設備ID
- UT-511
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+ (2024,375nm)
- 仕様・特徴
- 波長375nm(半導体レーサー 70mW) 小片アライメントオプション、両面アライメント機能付き。最小リソグラフィサイズ 0.3μm、重ねリソグラフィ精度±3σで500 nm以下(解像度による)、 128階調の「グレイスケールリソグラフィー」により,フォトレジストの立体形状段差をある程度自由に作れる。また、GenISys社の変換ソフトウェア「BEAMER」を使うと、形状を得るために、近接効果の影響を計算して露光補正が可能。
自動フォトマスクエッチング装置AEP-3000S (Auto Photomask Etching Machine)
- 設備ID
- UT-510
- 設置機関
- 東京大学
- 設備画像
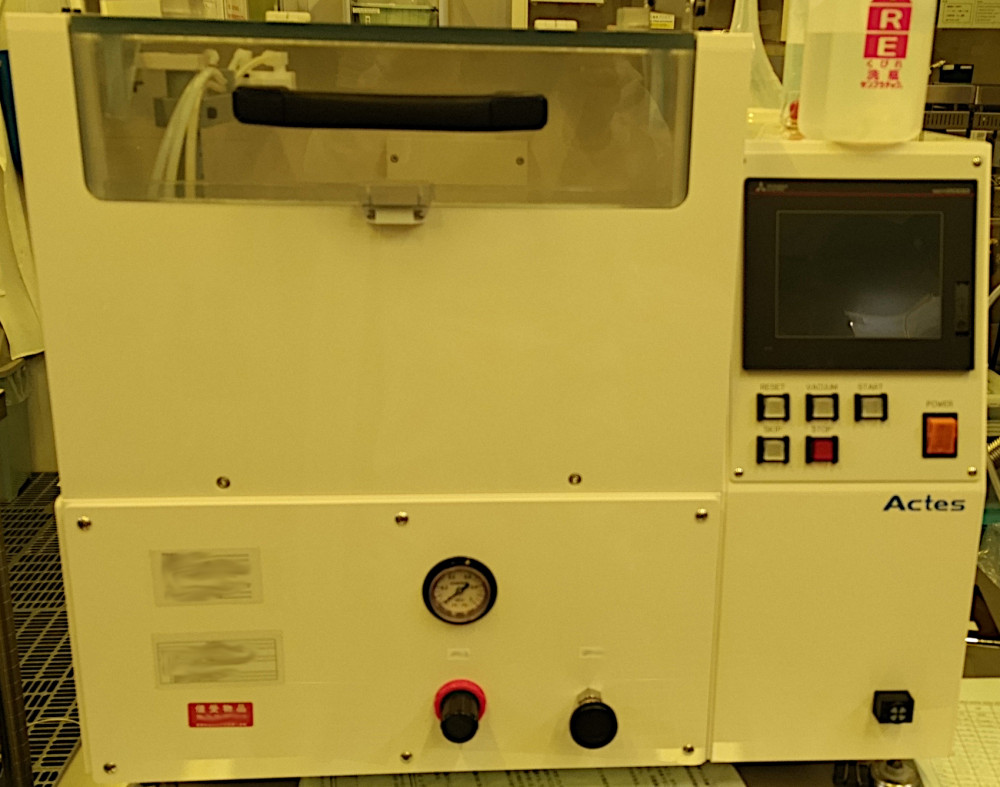
- メーカー名
- アクテス京三(株) (ActesKyosan Inc)
- 型番
- AEP-3000S
- 仕様・特徴
- 東京大学の電子線描画装置を用いて5009サイズのフォトマスクを作製するために使用する自動クロムエッチング装置。
試料サイズ:Φ2ーΦ6インチ、または100x100mm
プログラム設定:1プログラム最大99ステップ、50プログラム保存可能
回転数: 0-3000rpm
開店時間: 0-999sec
ノズル:薬液 2系等、リンス 1系統
UVナノインプリント露光装置 (UV Nanoimprint Lithography System)
- 設備ID
- IT-039
- 設置機関
- 東京工業大学
- 設備画像
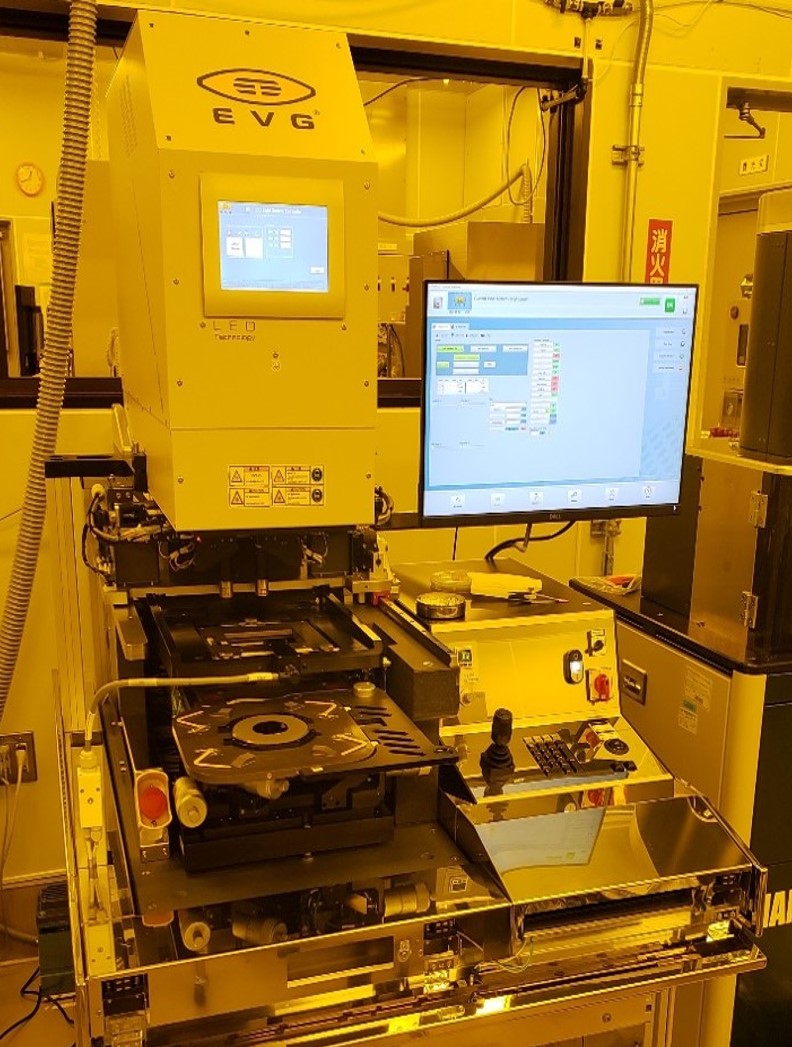
- メーカー名
- EVG (EVG)
- 型番
- EVG620NT
- 仕様・特徴
- UVによるナノインプリント露光装置。4inchまで対応。解像度限界 L/S 50nm。
プログラム・ホットプレート (Program hot plate)
- 設備ID
- RO-122
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アズワン株式会社 (AS ONE)
- 型番
- EC-1200NP
- 仕様・特徴
- ・16ステップ以内のプログラムを4パターン記憶
・制御可能温度範囲:室温+50 ~ 300℃
・プレート面積:412*312mm
電子ビーム描画装置 [JBX-8100FS] (EB Lithography [JBX-8100FS])
- 設備ID
- NM-661
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子ビーム描画装置 [JBX-8100FS]](data/facility_item/1701398235_11.jpg)
- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX-8100FS
- 仕様・特徴
- 1. 最高加速電圧200kV
2. クロック周波数125MHz
3. 12カセット自動搬送
4. 最大8インチウェハ対応
マスクレス露光装置 (Maskless lithography)
- 設備ID
- NU-260
- 設置機関
- 名古屋大学
- 設備画像
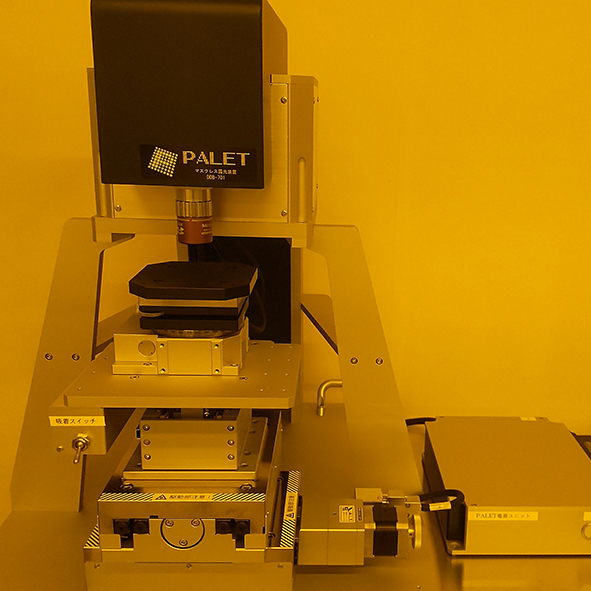
- メーカー名
- ネオアーク (NEOARK)
- 型番
- PALET DDB-701-DL4
- 仕様・特徴
- ・露光領域:100mm x 100mm
・最大ワークサイズ:Φ150mm x 10mm
・光源:365nm LED
・最小画素:3µm(対物レンズx10),15µm(対物レンズx2)
エリオニクス 50kV EB描画装置 (Elionix 50kV EB lithography)
- 設備ID
- TU-065
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-7500X
- 仕様・特徴
- 最大加速電圧:50kV