共用設備検索結果
"その他"で検索した結果 5件
フリーワード検索
中分類から探す
電子線描画用データ処理ソフトウェア (Data analysis software for electron beam lithography)
- 設備ID
- NU-268
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- GenISys (GenISys)
- 型番
- BEAMER
- 仕様・特徴
- ・レイアウトエディタ
・パターンデータ変換
・近接効果補正(PEC)
・グレースケール露光補正
電子線描画用近接効果補正ソフト (Procxymity effect correction for electron beam lithography)
- 設備ID
- UT-508
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- GenISys (GenISys GmbH)
- 型番
- Beamer
- 仕様・特徴
- 電子線描画時に生じる近接効果を補正して設計通りのレズストパターンを電子線で描画するためのパターン補正システム。グレースケール露光用のデータ生成が可能。
超微細インクジェット描画装置 (Super Fine Inkjet Printer)
- 設備ID
- KT-113
- 設置機関
- 京都大学
- 設備画像
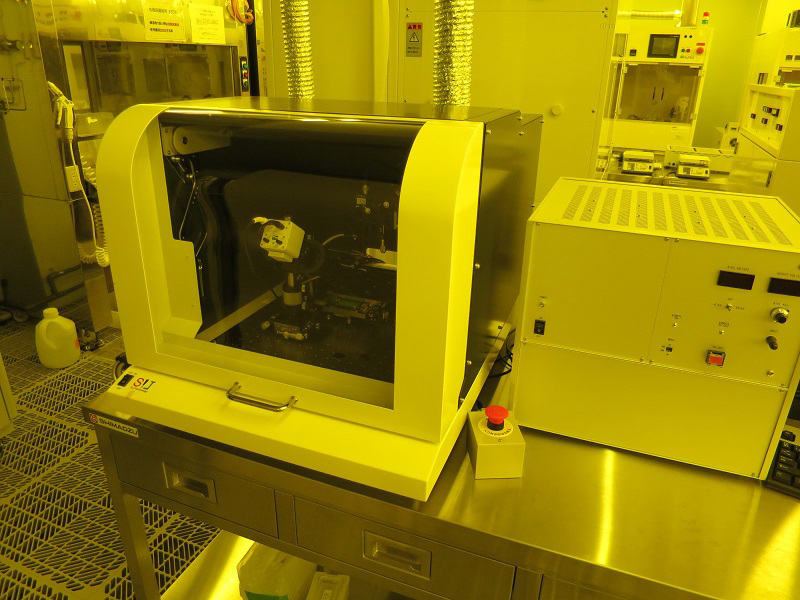
- メーカー名
- (株)SIJテクノロジ (SIJTechnology, Inc.)
- 型番
- ST050
- 仕様・特徴
- 超微量・高粘度吐出のスーパーインクジェットヘッドにより、大気圧・常温下で微細パターンの直接描画が可能。
・最小吐出量:0.1fL
・最小ライン幅:0.6μm
・対応粘度:0.5~10,000cps
・付属ソフトウェア(複雑パターンが可能)
近接効果補正システム (Proximity Effect Correction System)
- 設備ID
- KT-116
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- GenISys(株) (GenISys Inc.)
- 型番
- BEAMER Full Package
- 仕様・特徴
- 電子線描画装置、レーザー描画装置用の最適露光データ作成のための支援ツール。
・近接効果補正(PEC):2Dドーズ補正、形状補正、3D補正、コーナー補正
・光近接効果補正(OPC):線形補正、コーナー補正、全体形状補正
・グレイスケール露光における補正
・入出力フォーマット:エリオニクス社、アドバンテスト社、ハイデルベルグ社
・モンテカルロ法によるPSF値の導出対応。
レイアウト設計ツール (Mask layout design tool)
- 設備ID
- RO-131
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- Tanner (Tanner)
- 型番
- L-Edit
- 仕様・特徴
- リソグラフィマスク設計用レイアウトエディター
IC,MEMSデバイス設計用ソフト。Tanner社L-Edit
"その他"で検索した結果 5件