共用設備検索結果
中分類から探す
電子ビーム描画装置 [JBX-8100FS] (EB Lithography [JBX-8100FS])
- 設備ID
- NM-661
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子ビーム描画装置 [JBX-8100FS]](data/facility_item/1701398235_11.jpg)
- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX-8100FS
- 仕様・特徴
- 1. 最高加速電圧200kV
2. クロック周波数125MHz
3. 12カセット自動搬送
4. 最大8インチウェハ対応
エリオニクス 50kV EB描画装置 (Elionix 50kV EB lithography)
- 設備ID
- TU-065
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-7500X
- 仕様・特徴
- 最大加速電圧:50kV
電子ビーム描画装置 [ELS-F125] ( EB Lithography [ELS-F125])
- 設備ID
- NM-601
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子ビーム描画装置 [ELS-F125]](data/facility_item/NM-601.jpg)
- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-F125
- 仕様・特徴
- ・用途:高精細ナノパターニング
・電子銃:ZrO/W 熱電界放射型
・最大加速電圧:125kV (25kV ステップで可変)
・フィールドつなぎ精度:25nm 以下(500μm フィールド)
・重ね合わせ精度:30nm 以下(500μm フィールド)
・最大試料サイズ:6 inch
・走査クロック周波数:100MHz
エリオニクス 130kV EB描画装置 (Elionix 130kV EB lithography)
- 設備ID
- TU-064
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- エリオニクス (Elionix)
- 型番
- ELS-G125S
- 仕様・特徴
- 最大加速電圧:130kV
最小描画線幅:10nm以下
高速大面積電子線描画装置 (Ultrarapid Electron Beam Direct Writing and Photo Mask Fabrication Machine)
- 設備ID
- UT-500
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アドバンテスト (ADVANTEST)
- 型番
- F5112+VD01
- 仕様・特徴
- ・長方形・矩形の大きさを任意に変更してショットする(可変整形)ことのできる高速電子線描画装置。
・カケラ基板から8インチ丸基板までの任意形状に対応
・加速電圧50kV
超高速大面積電子線描画装置 (Ultrarapid Electron Beam Direct Writing and Photo Mask Fabrication Machine)
- 設備ID
- UT-503
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アドバンテスト (ADVANTEST)
- 型番
- F7000S-VD02
- 仕様・特徴
- カケラから8インチ丸基板までの任意形状に対応。R2年度補正予算改造により、更に高速性がアップしました。
(厚みに制限あり。ご相談ください)
可変整形ビーム(VSBモード)による、高速描画が可能
内蔵ステンシル(CPモード)による、階段近似の無い滑らかな曲線等の高速描画が可能。
データはGDS-IIストリームフォーマットから変換
電子線露光装置 (Electron beam lithography)
- 設備ID
- NU-206
- 設置機関
- 名古屋大学
- 設備画像
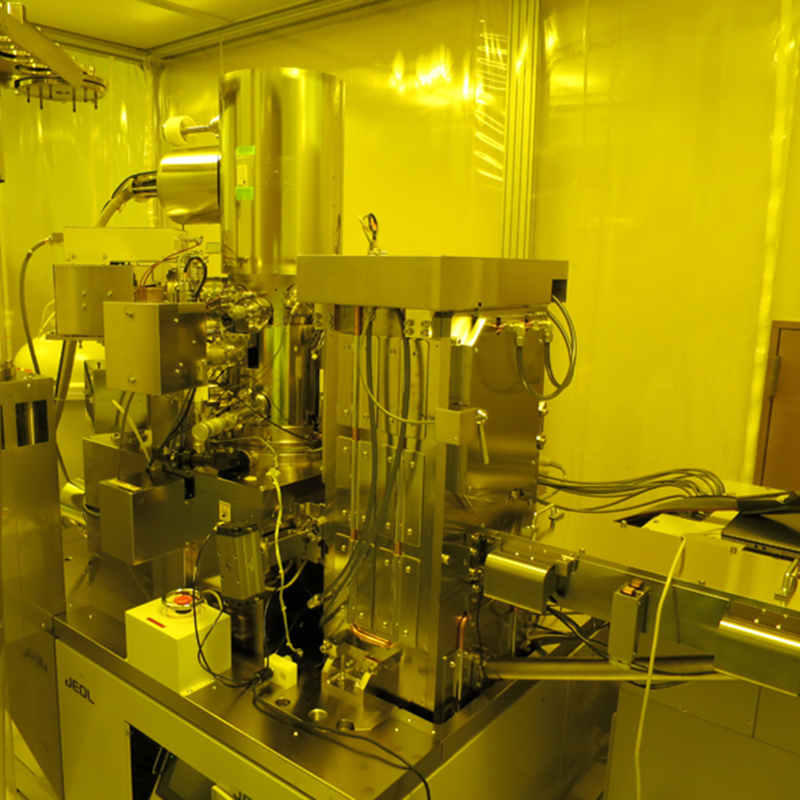
- メーカー名
- 日本電子 (JEOL)
- 型番
- JBX6300FS
- 仕様・特徴
- ・加速電圧:25/50/100kV
・最小ビーム径:2nm
・ビーム電流:100pA-2nA
・重ね合わせ精度:±9nm
・最大試料サイズ:4inchφ
高精度電子線描画装置 (Scanning electron microscope with add-on lithography system )
- 設備ID
- NU-249
- 設置機関
- 名古屋大学
- 設備画像
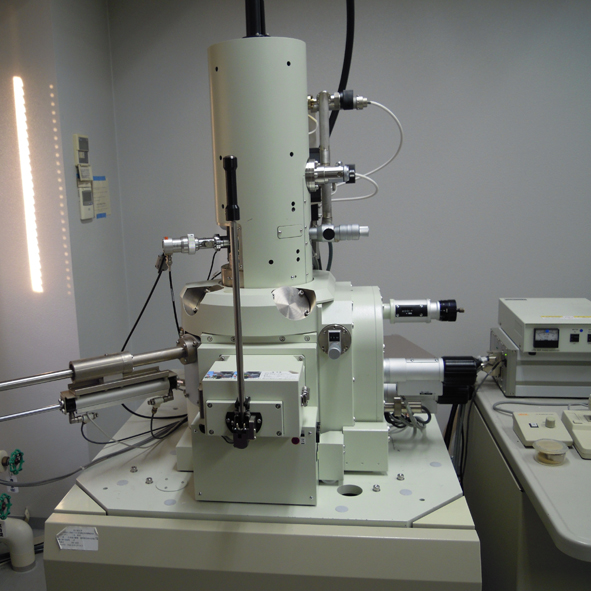
- メーカー名
- 日本電子 サンユー電子 (JEOL Sanyu Electron)
- 型番
- JSM-7000FK SPG-724
- 仕様・特徴
- ・分解能:1.2 nm(30kV)
・倍率:×10~×1,000,000
・試料室:最大200 mm
・描画方式:ラスタースキャン方式/ブロックスキャン方式
・描画フィールド:50 µm□/100 µm□/200 µm□/500 µm□(ラスタースキャン),2,500 µm□,1ブロック=2.5 µm□(ブロックスキャン)
高速高精度電子ビーム描画装置 (Ultra-High Precision Electron Beam Lithography)
- 設備ID
- KT-101
- 設置機関
- 京都大学
- 設備画像
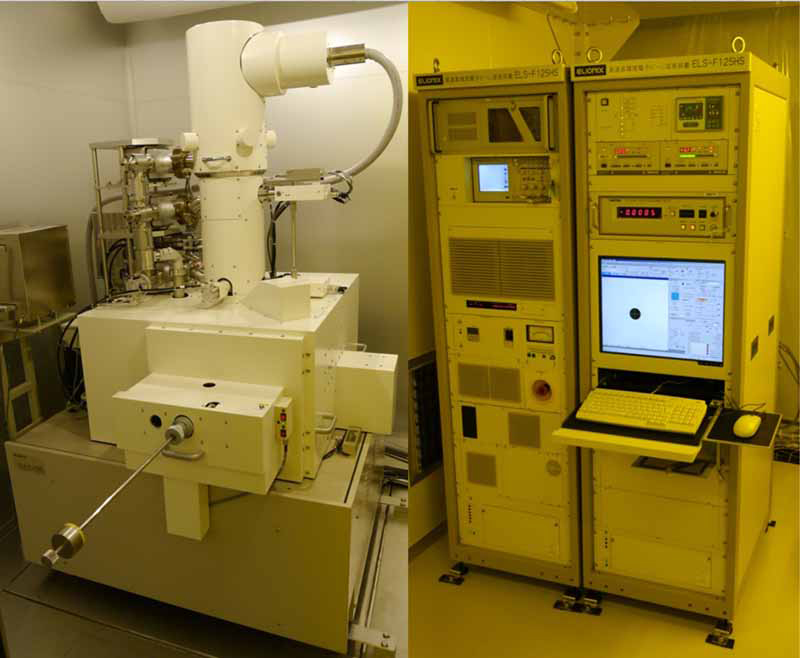
- メーカー名
- (株)エリオニクス (ELIONIX INC.)
- 型番
- ELS-F125HS
- 仕様・特徴
- 加速電圧125kVを採用した電子線描画装置。最小ビーム径をΦ1.7nmにすることにより最小加工線幅5nmが可能。
・加速電圧:125kV、100kV、75kV、50kV、25kV
・最小ビーム径:1.7nm@125kV
・描画最小線幅:5nm@125kV
大面積超高速電子ビーム描画装置 (Large Area and Ultra-High Speed Electron Beam Lithography)
- 設備ID
- KT-115
- 設置機関
- 京都大学
- 設備画像
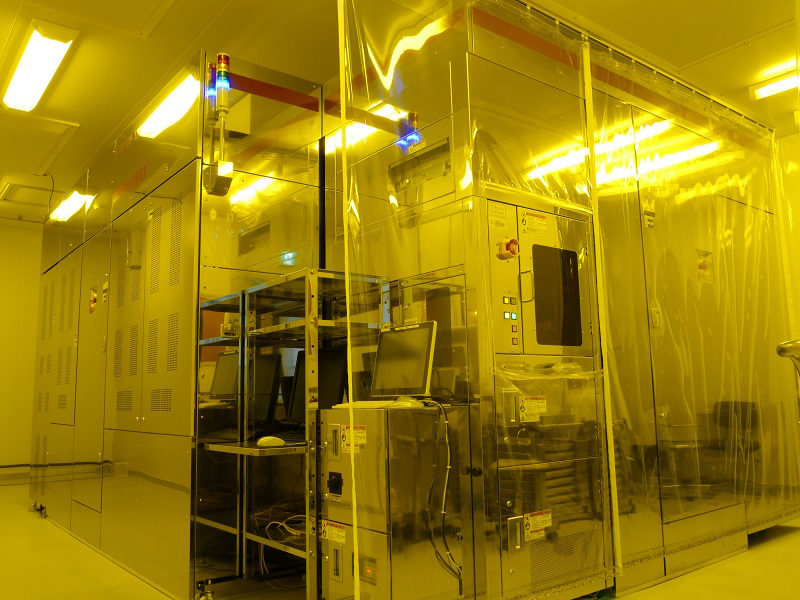
- メーカー名
- (株)アドバンテスト (ADVANTEST CORPORATION)
- 型番
- F7000S-KYT01
- 仕様・特徴
- 1Xnmの解像性能で、研究開発から製造までの幅広い用途に対応。
・加速電圧:50kV(ビーム電流:640A)
・解像度:1Xnm
・基板:□10mm~Φ8
・露光方式:CP、VSB(超高速描画対応)