共用設備検索結果
中分類から探す
レーザ描画装置 (Laser lithography)
- 設備ID
- NU-244
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- mPG101-UV
- 仕様・特徴
- ・対応基板:100 mm ×100 mm
・加工精度:3 µm
・最小アドレスグリッド:100 nm
・対応データ:DXF,CIF,BMP
3次元レーザ・リソグラフィシステム群 (3 dimentional laser lithography system)
- 設備ID
- NU-246
- 設置機関
- 名古屋大学
- 設備画像
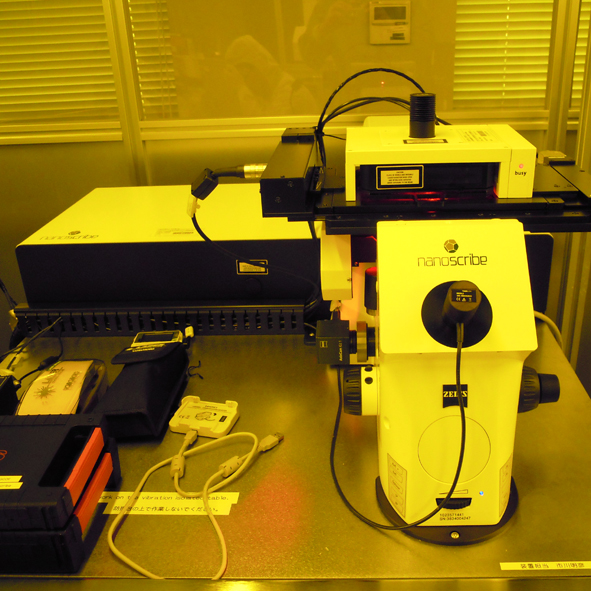
- メーカー名
- Nanoscribe KISCO (Nanoscribe KISCO)
- 型番
- Photonic Professional SCLEAD3CD2000
- 仕様・特徴
- Nanoscribe Photonic Professional
・2次元加工精度:100 nm
・3次元加工精度:150 nm
・対応データ:DXF, STL
KISCO SCLEAD3CD2000
・設計温度:100 ℃
・設計圧力:20 MPa
レーザー直接描画装置 (Laser Pattern Generator )
- 設備ID
- KT-103
- 設置機関
- 京都大学
- 設備画像
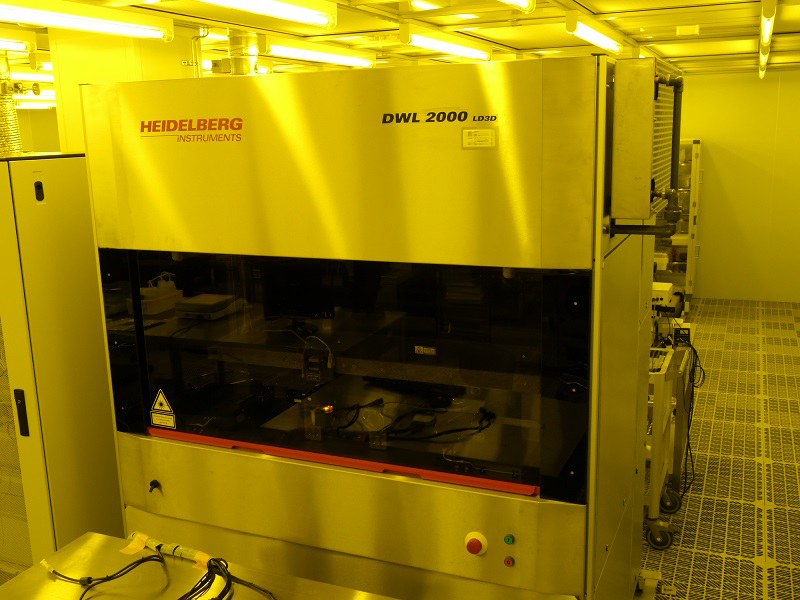
- メーカー名
- ハイデルベルグ・インストルメンツ(株) (Heidelberg Instruments)
- 型番
- DWL2000
- 仕様・特徴
- 偏向変調されたΦ1umのLDビーム、高精度制御のステージとの組み合わせにより微細パターンを描画。
・光源:h線LD(405nm)
・基板サイズ:MAX □200mm
・描画サイズ:min0.7μm
・グレースケール露光対応
高速マスクレス露光装置 (High Speed Maskless Laser Lithography )
- 設備ID
- KT-104
- 設置機関
- 京都大学
- 設備画像
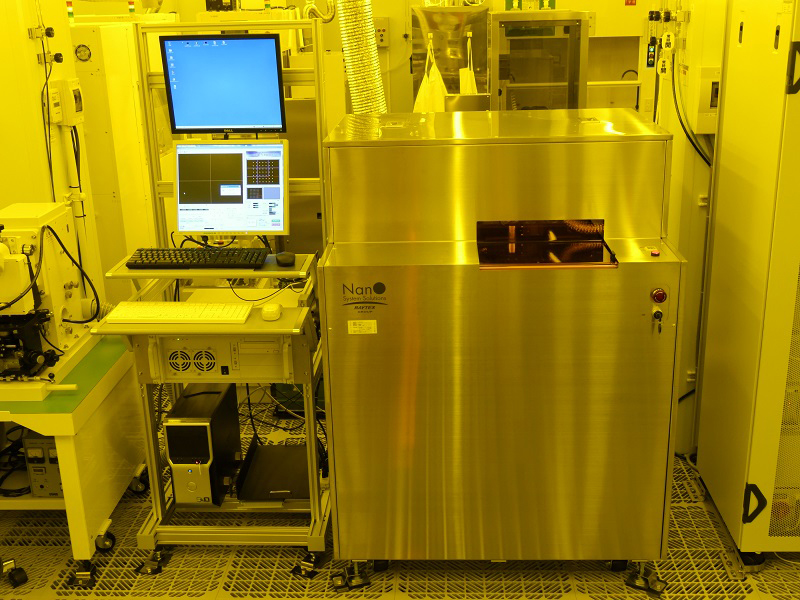
- メーカー名
- (株)ナノシステムソリューションズ (NanoSystem Solutions, Inc.)
- 型番
- D-light DL-1000GS/KCH
- 仕様・特徴
- グレースケール露光機能を備えたDMD方式の高速マスクレス露光装置。
・光源:h線LED(405nm)>1W/cm2
・基板サイズ:MAXΦ6インチ
・最小画素:1μm
・グレースケール露光機能(最大256階調)
・厚膜レジスト対応(>100μm以上)
レーザー描画装置 (Laser lithography system)
- 設備ID
- HK-604
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+
- 仕様・特徴
- 光源:405nm半導体レーザー
描画エリア:最大8インチ角
最小描画線幅:0.3ミクロン(HiRes)、0.8ミクロン(WMII)
255階調グレースケールモード搭載
バックアライメント機能
レーザー直接描画装置 (Laser direct lithography system)
- 設備ID
- HK-605
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- ネオアーク (NEOARK)
- 型番
- DDB-201
- 仕様・特徴
- 光源:375nm半導体レーザー
描画エリア:最大50mm
試料サイズ:最大6インチ
パターン投影リソグラフィシステム (Maskless Lithography System)
- 設備ID
- BA-009
- 設置機関
- 筑波大学
- 設備画像
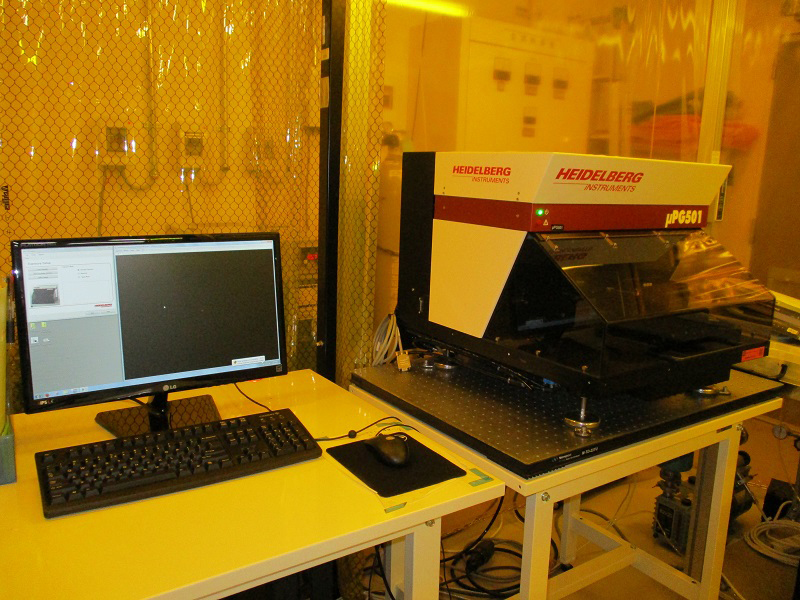
- メーカー名
- Heidelberg instruments (Heidelberg instruments)
- 型番
- μPG501
- 仕様・特徴
- 描画エリア;125×125mm2
最小描画サイズ;1.0μm
最小アドレッシンググリッド;50nm@1μm
描画スピード;50mm2/min@1μm,100mm2/min@2μm
マスクレス露光装置 (Maskless Lithography System)
- 設備ID
- AT-006
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ナノシステムソリューション (Nano System-Solutions)
- 型番
- DL1000
- 仕様・特徴
- ・型式:DL1000
・試料サイズ:4インチφ、100mm□
・光源:波長405nm(LED)
・露光最小画素:1μm□
・最大露光領域:100mm□
・重ね合わせ精度:±1μm
レーザー描画装置〔DWL66+〕 (Laser Beam Lithography)
- 設備ID
- AT-110
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
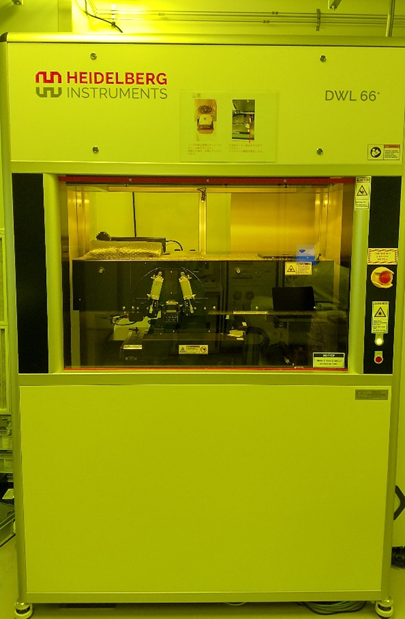
- メーカー名
- ハイデルベルグ (Heidelberg Instruments)
- 型番
- DWL66+
- 仕様・特徴
- ・型式:DWL66+
・試料サイズ:8インチφ、200mm×200mm×12mmt
・最小角型試料サイズ: 5mm×5mm
・描画エリア:200mm×200mm
・レーザー光源:405nm
・最小描画パターン:0.5μm (L&S)、0.3μm(孤立パターン)
・重ね合わせ描精度:0.25μm(5mm×5mm以内)、0.5μm(100mm×100mm以内)
・裏面パターンとの重ね合わせ精度:1μm
・グレースケール露光:1000階調
レーザー直接描画装置 (Advanced Maskless Aligner )
- 設備ID
- WS-016
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- ハイデルベルグ・ジャパン株式会社 (Heidelberger Druckmaschinen AG)
- 型番
- MLA150
- 仕様・特徴
- (375nm Diode、SU-8対応)