共用設備検索結果
中分類から探す
レーザー直接描画装置DWL66+2024 (Laser Drawing System DWL66+2024)
- 設備ID
- UT-511
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+ (2024,375nm)
- 仕様・特徴
- 波長375nm(半導体レーサー 70mW) 小片アライメントオプション、両面アライメント機能付き。最小リソグラフィサイズ 0.3μm、重ねリソグラフィ精度±3σで500 nm以下(解像度による)、 128階調の「グレイスケールリソグラフィー」により,フォトレジストの立体形状段差をある程度自由に作れる。また、GenISys社の変換ソフトウェア「BEAMER」を使うと、形状を得るために、近接効果の影響を計算して露光補正が可能。
マスクレス露光装置 (Maskless lithography)
- 設備ID
- NU-260
- 設置機関
- 名古屋大学
- 設備画像
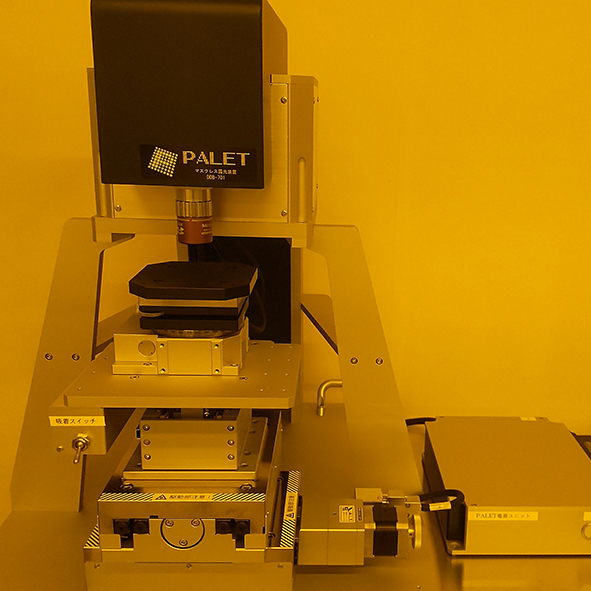
- メーカー名
- ネオアーク (NEOARK)
- 型番
- PALET DDB-701-DL4
- 仕様・特徴
- ・露光領域:100mm x 100mm
・最大ワークサイズ:Φ150mm x 10mm
・光源:365nm LED
・最小画素:3µm(対物レンズx10),15µm(対物レンズx2)
レーザー描画装置 [DWL66+] (Laser Lithography [DWL66+])
- 設備ID
- NM-603
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![レーザー描画装置 [DWL66+]](data/facility_item/NM-603.jpg)
- メーカー名
- ハイデルベルグ・インストルメンツ (HEIDELBERG INSTRUMENT)
- 型番
- DWL66+
- 仕様・特徴
- ・光源:375nm 半導体レーザー (70mW)
・描画モード:ラスタースキャン描画、ベクターモード描画
・解像モード:0.3μm, 0.6μm, 0.8μm, 1.0μm
・最大試料サイズ:8インチ角
・その他:グレースケール描画、重ね合わせ描画
マスクレス露光装置 [DL-1000/NC2P] (Maskless Lithography [DL-1000/NC2P])
- 設備ID
- NM-604
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![マスクレス露光装置 [DL-1000/NC2P]](data/facility_item/1651463479_14.jpg)
- メーカー名
- ナノシステムソリューションズ (Nanosystem Solutions)
- 型番
- DL-1000 / NC2P
- 仕様・特徴
- ・用途:高速マスクレスパターニング
・光源:405nm 半導体レーザー(h線)
・照度:10W/cm2
・位置決め精度:500nm 以下
・重ね合わせ精度:500nm 以下
・最大試料サイズ:8インチ角
・その他:グレースケール露光,スキャニング露光,自動/手動アライメント機能
レーザ描画装置 (Laser writer)
- 設備ID
- TU-057
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- DWL2000CE
- 仕様・特徴
- サンプルサイズ:小片~9インチ
波長:405nm
最小描画線幅:0.7µm
マスクレスアライナ (Maskless aligner)
- 設備ID
- TU-058
- 設置機関
- 東北大学
- 設備画像
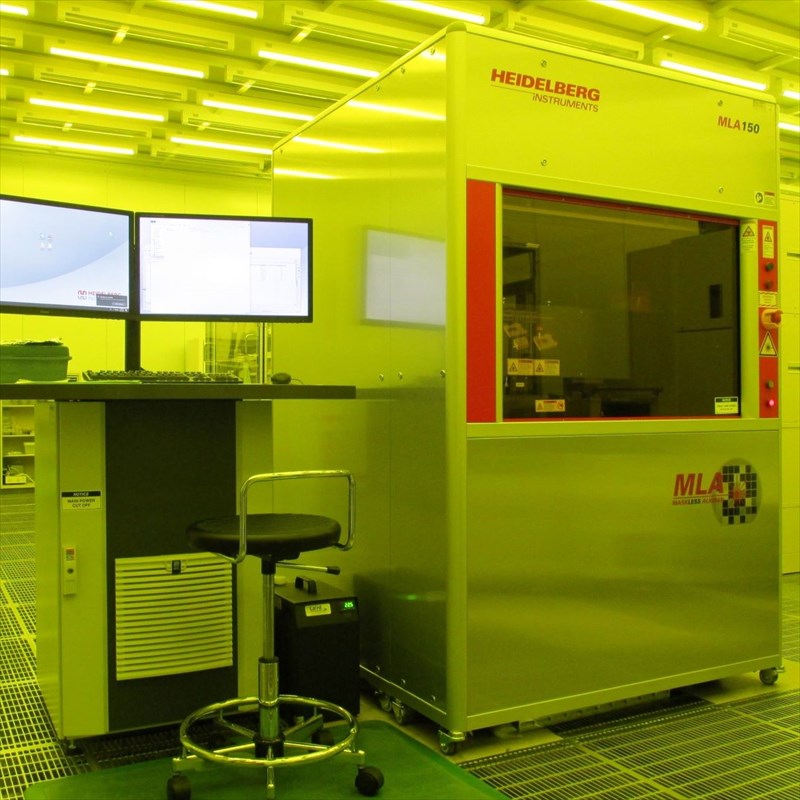
- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- MLA150
- 仕様・特徴
- サンプルサイズ:小片~8インチ
波長:405nm 、375nm
最小描画線幅:1µm
球面露光装置 (Maskless exposure system for ball)
- 設備ID
- TU-068
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- 東栄科学産業 (Toei Scientific Instruments)
- 型番
- -
- 仕様・特徴
- サンプル:球体(直径1.0、3.3mm)
最小パターン:1.5µmハーフピッチ
アライメント精度:±5µm
レーザー直接描画装置 DWL66+2018 (Laser Drawing System DWL66+2018)
- 設備ID
- UT-505
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ハイデルベルグ (Heidelberg)
- 型番
- DWL66+ (2018,405nm)
- 仕様・特徴
- 波長406nm 小片アライメントオプション、両面アライメント機能付き。1024階調の「グレイスケールリソグラフィー」により,フォトレジストの立体形状段差をある程度自由に作れる。また、GenISys社の変換ソフトウェア「BEAMER」を使うと、形状を得るために、近接効果の影響を計算して露光補正が可能。
レーザー描画装置 (Laser lithography)
- 設備ID
- NU-222
- 設置機関
- 名古屋大学
- 設備画像
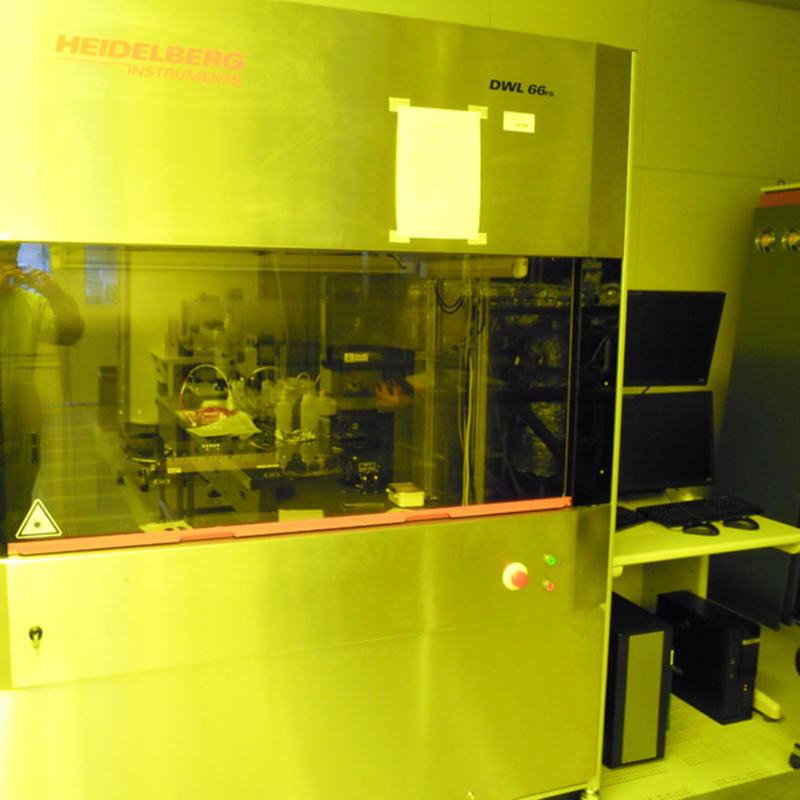
- メーカー名
- Heidelberg Instruments (Heidelberg Instruments)
- 型番
- DWL66FS
- 仕様・特徴
- ・最小描画サイズ:0.6 µm
・最大描画サイズ:200mm x 200mm
・直描およびガラスマスク作製
マスクレス露光装置 (Maskless lithography)
- 設備ID
- NU-231
- 設置機関
- 名古屋大学
- 設備画像
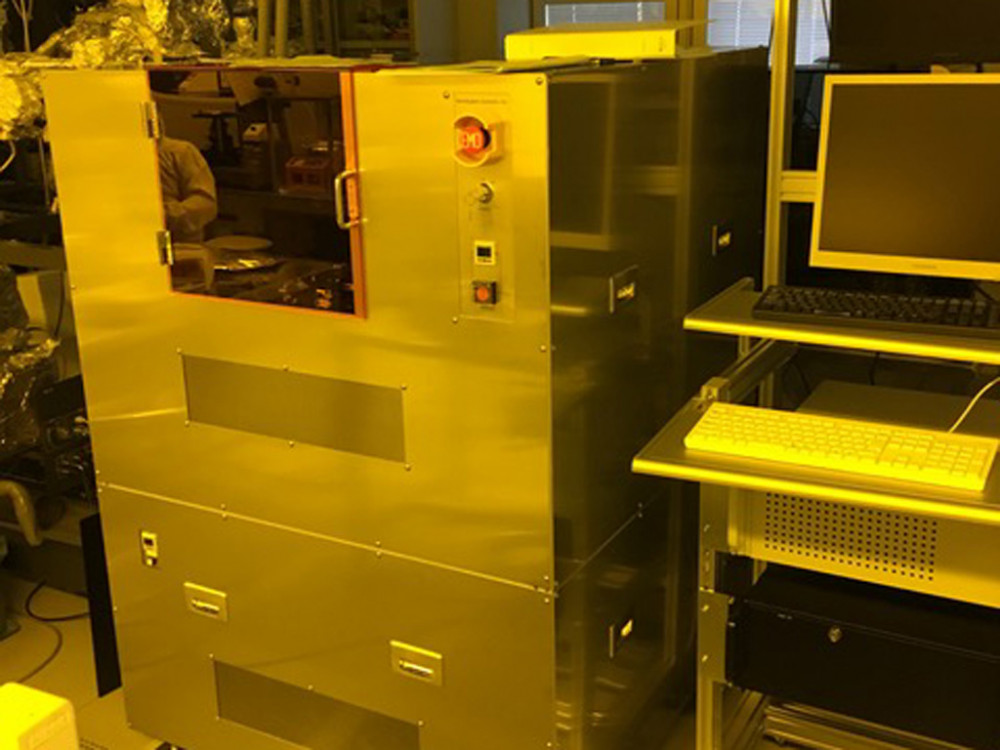
- メーカー名
- ナノシステムソリューションズ (Nanosystem Solutions)
- 型番
- DL-1000
- 仕様・特徴
- ・最大露光面積:200 mm x 200 mm
・最小画素:1 µm(高精細露光機能付)
・つなぎ合わせ精度:0.1 µm
・重ね合わせ精度:±1 µm
・オートフォーカス機能有