共用設備検索結果
中分類から探す
パリレン成膜装置 (Parylene Coater)
- 設備ID
- KT-251
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 日本パリレン合同会社 (Specialty Coating Systems Inc.)
- 型番
- LABCOTER PDS-2010
- 仕様・特徴
- 全面に均一な極薄コーティングが可能であり、微細な隙間中なども均一にカバーする。
・蒸着室有効内容積:215mm(径)×270mm(高さ)
コーティング装置群 (Coating machine for nonconductive specimens)
- 設備ID
- KU-015
- 設置機関
- 九州大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JEOL JFC-1600、JEOL EC-32010CC
- 仕様・特徴
- 電子顕微鏡試料の調製
EB蒸着装置 (EB vacuume evaporation system)
- 設備ID
- HK-607
- 設置機関
- 北海道大学
- 設備画像
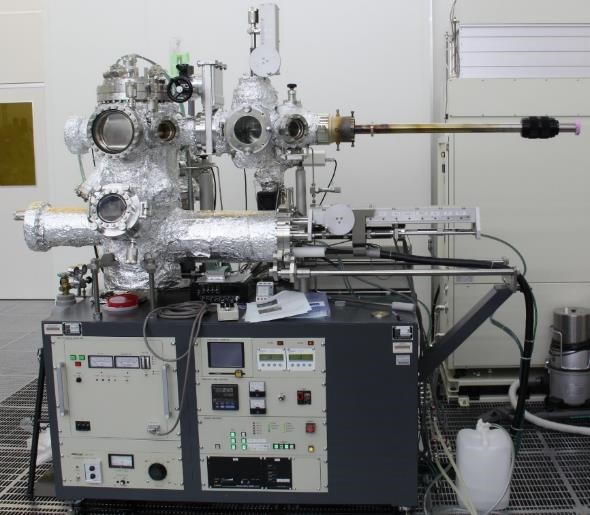
- メーカー名
- エイコー (Eiko)
- 型番
- EB-580S
- 仕様・特徴
- 蒸着源:Au,Ti,Al,Cu,Nb
基板加熱可(600℃程度まで)
水晶振動式膜厚計
真空蒸着装置 (Vacuume evaporation system)
- 設備ID
- HK-608
- 設置機関
- 北海道大学
- 設備画像
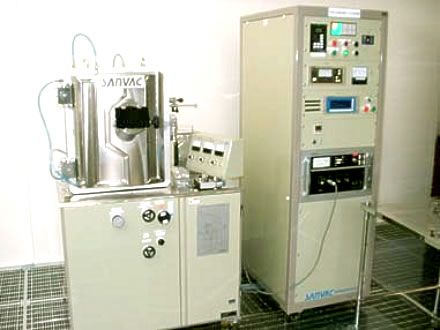
- メーカー名
- サンバック (SANVAC)
- 型番
- ED-1500R
- 仕様・特徴
- 蒸着源:抵抗加熱3元、EB3元
基板加熱可
水晶振動式膜厚計
ヘリコンスパッタリング装置 (Helicon sputtering system)
- 設備ID
- HK-609
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- MPS-4000C1/HC1
- 仕様・特徴
- カソード:3元(マグネトロン4インチ、ヘリコンDC2インチ、ヘリコンRF2インチ)
成膜材料:Au,Cr,Ti
試料サイズ:最大4インチ
コンパクトスパッタ装置 (Compact Sputter)
- 設備ID
- HK-610
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- ACS-4000-C3-HS
- 仕様・特徴
- カソード4元(DC3元、RF1元)
成膜材料:SiO2、Au,Cr、Mo等
基板サイズ:10mm~4インチ(リフトオフ仕様では25mm角まで)
基板加熱機構有り(~550℃)
多元スパッタ装置 (Multi-target Sputtering sysutem)
- 設備ID
- HK-611
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- アルバック (Ulvac)
- 型番
- QAM-4-STS
- 仕様・特徴
- カソード7元(ヘリコン2台含む)
試料:小片~最大Φ100㎜
垂直成膜可能(25mm角まで)
コスパッタ(DC/RF)、逆スパッタ
ターゲット:Au、Cr、Pt、Ag他
700度加熱可能
ラジカルイオンガン搭載(N,O)
イオンビームスパッタ装置 (Ion beam sputtering system)
- 設備ID
- HK-612
- 設置機関
- 北海道大学
- 設備画像
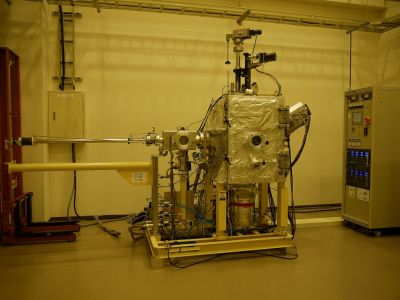
- メーカー名
- アルバック (Ulvac)
- 型番
- IBS-6000
- 仕様・特徴
- 成膜材料:4元、Ni、Cr、SiO2、W-Si他
試料サイズ:最大3インチ
プラズマCVD装置 (Plasma Enhanced CVD system)
- 設備ID
- HK-613
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- サムコ (samco)
- 型番
- PD-220ESN
- 仕様・特徴
- 成膜材料:SiO2、SiN
試料サイズ:最大8インチ
液体ソースプラズマCVD装置 (Liquid Source CVD Systems)
- 設備ID
- HK-614
- 設置機関
- 北海道大学
- 設備画像

- メーカー名
- サムコ (samco)
- 型番
- PD-10C1
- 仕様・特徴
- 成膜材料:SiO2他(原料持ち込み可)
キャリアガス:N2、He、Ar、H2
試料サイズ:最大3インチ