共用設備検索結果
中分類から探す
スパッタ絶縁膜作製装置 (Insulator sputtering system)
- 設備ID
- NU-229
- 設置機関
- 名古屋大学
- 設備画像
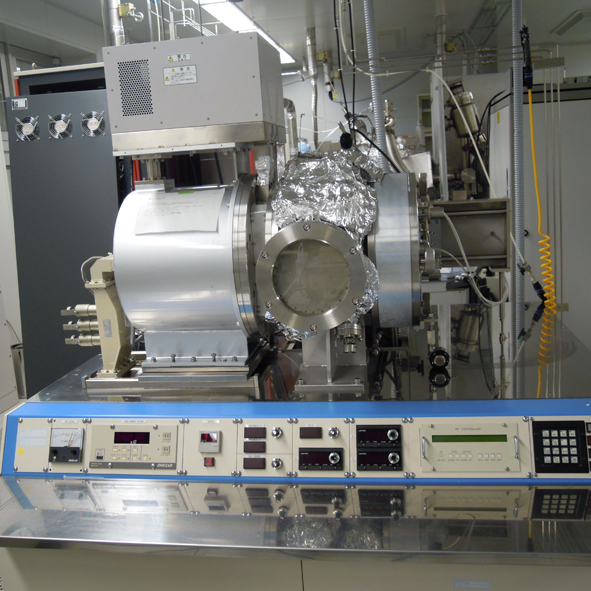
- メーカー名
- MESアフティ (MES Afty)
- 型番
- AFTEX-3420
- 仕様・特徴
- ・対応基板サイズ:最大3インチ
・酸化膜,窒化膜用
原子層堆積装置 (Atomic layer deposition)
- 設備ID
- NU-232
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- AD-100LE
- 仕様・特徴
- ・Al2O3, SiO2, AlOxNy, SiOxNy成膜用
・基板サイズ:212 mmΦ
・加熱温度:最大500℃
・ガス導入系:有機金属系2系統,H2O,O2,N2
スパッタリング装置 (Sputtering system)
- 設備ID
- NU-245
- 設置機関
- 名古屋大学
- 設備画像
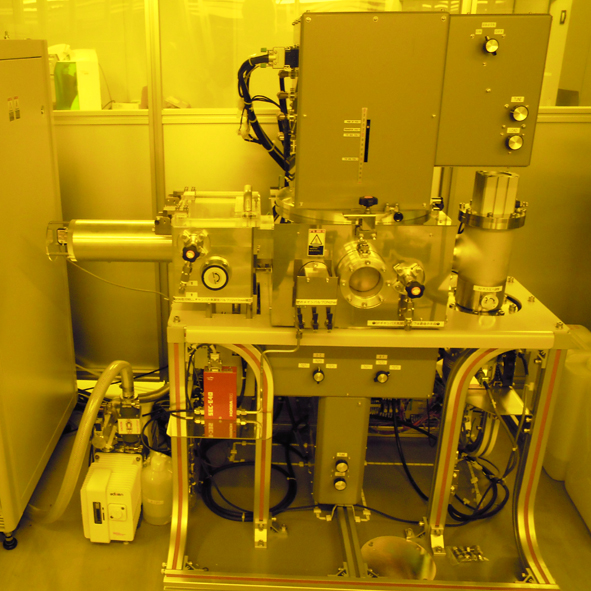
- メーカー名
- キャノンアネルバ (Canon Anelva)
- 型番
- E-200S
- 仕様・特徴
- ・ターゲット:SiO2,Cr,Au
・膜厚分布:Φ100 mm内±3%
・基板ホルダー:Φ200 mm
・基板加熱:Max 300℃(水冷付)
パリレンコーティング装置 (Parylene coating system)
- 設備ID
- NU-248
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- KISCO (KISCO)
- 型番
- DACS-LAB
- 仕様・特徴
- ・蒸着チャンバー寸法:ID300×H350 mm
・回転:0.5~10rpm
多元スパッタ装置(仕様A) (RF Magnetron Multi-Sputter Type-A )
- 設備ID
- KT-201
- 設置機関
- 京都大学
- 設備画像
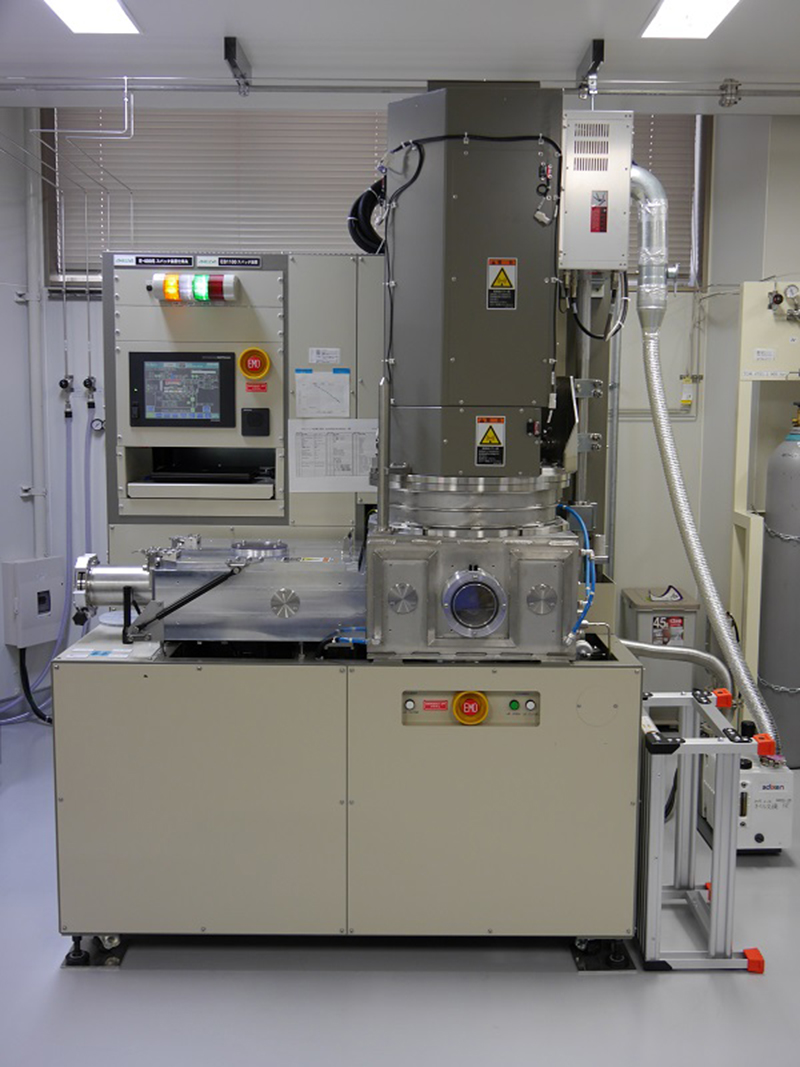
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1100
- 仕様・特徴
- 研究開発~小規模生産用の高性能RFマグネトロンスパッタリング装置(高温対応)。
・基板サイズ:Φ4、Φ6、不定形
・カソード:非磁性体Φ4PMC×4(RF電源:1,000W×2)
・TS距離:100~200mm
・温度:RT~800℃(ハロゲンランプ)
・ガス:Ar、O2
・ターゲット:Ti、Pt、PZT、PLT ほか
・ロードロック機構
多元スパッタ装置(仕様B) (RF Magnetron Multi-Sputter Type-B )
- 設備ID
- KT-202
- 設置機関
- 京都大学
- 設備画像
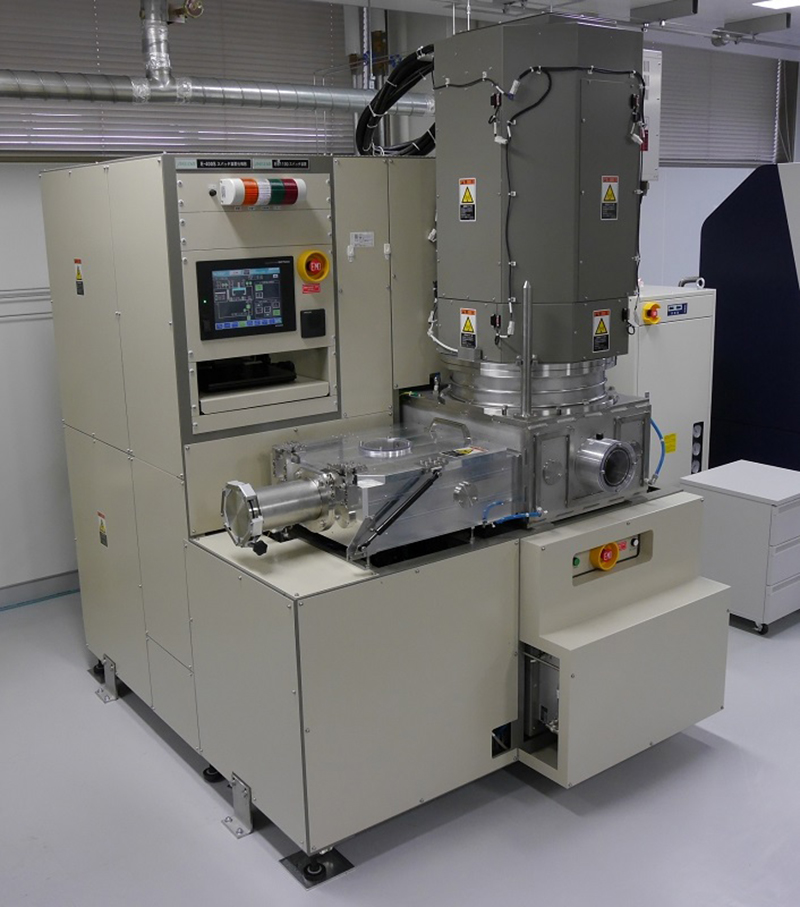
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1100
- 仕様・特徴
- 研究開発~小規模生産用の高性能RFマグネトロンスパッタリング装置(高温対応)。
・基板サイズ:Φ4、Φ6、不定形
・カソード:非磁性体Φ4PMC×3(RF電源:1,000W×3)
・TS距離:100~200mm
・温度:RT~800℃(ハロゲンランプ)
・ガス:Ar、O2、N2
・ターゲット: 各種メタル、各種金属酸化物 ほか
・ロードロック機構
電子線蒸着装置 (Electron Beam Evaporator)
- 設備ID
- KT-203
- 設置機関
- 京都大学
- 設備画像
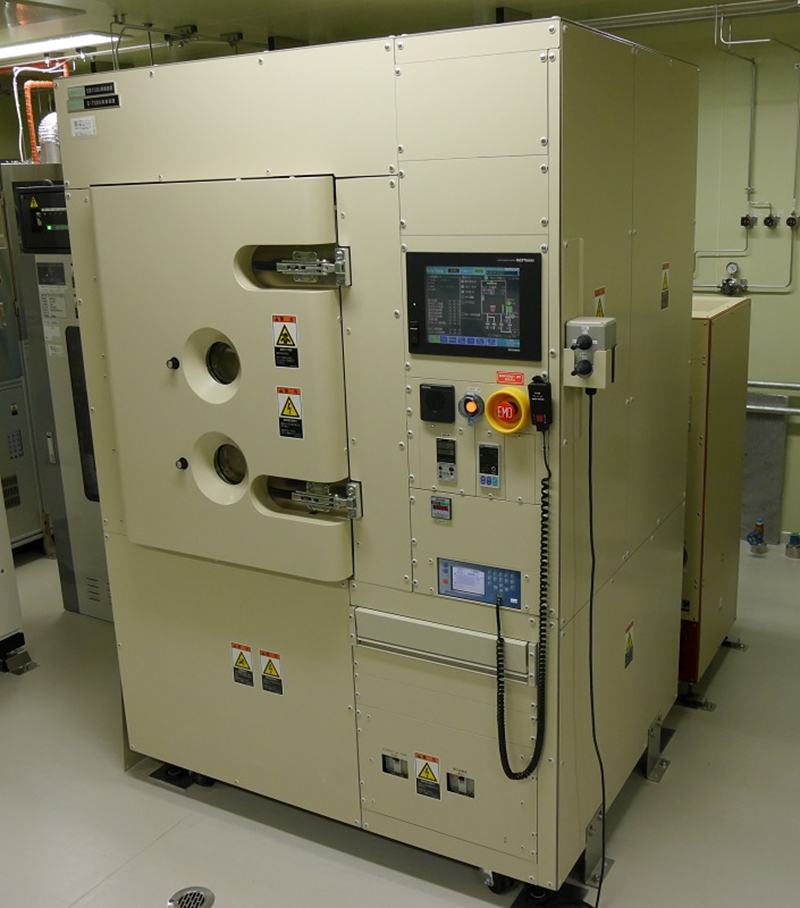
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1200
- 仕様・特徴
- リフトオフ対応の電子線蒸着装置
・基板サイズ:MAX Φ6×3枚
・電子銃:10kW 4連E型電子銃(22ml x 4)
・温度:RT~300℃(ハロゲンランプ)
・蒸着源-基板間距離:300mm(リフトオフ対応)
・蒸着材料:Al、Ti、Cr、Ni、Au、Pt、Ag、Pd ほか
プラズマCVD装置 (Plasma-Enhanced Chemical Vapor Deposition System)
- 設備ID
- KT-205
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 住友精密工業(株) (Sumitomo Precision Products CO., LTD.)
- 型番
- MPX-CVD
- 仕様・特徴
- 液体ソース(酸化膜/窒化膜用)を用いたプラズマCVD装置。
・基板サイズ:MAX Φ6
・RF電源:500W@上部(13.56MHz)、500W@下部(380kHz)
・プロセスガス:C4F8、H2 ほか
・液体ソース:TEOS(テトラエトキシシラン)、TSA(トリシリルアミン)
・温度:150~350℃
真空蒸着装置(1) (Thermal Evaporator No.1)
- 設備ID
- KT-232
- 設置機関
- 京都大学
- 設備画像
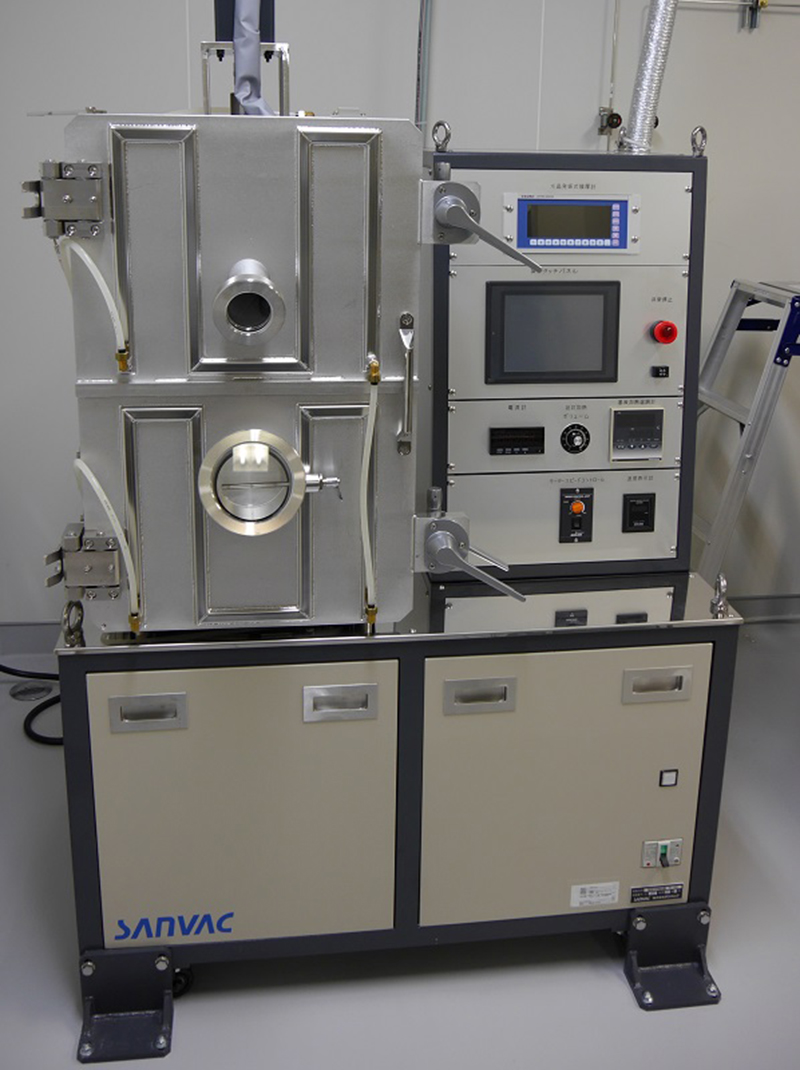
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃
真空蒸着装置(2) (Thermal Evaporator No.2)
- 設備ID
- KT-233
- 設置機関
- 京都大学
- 設備画像
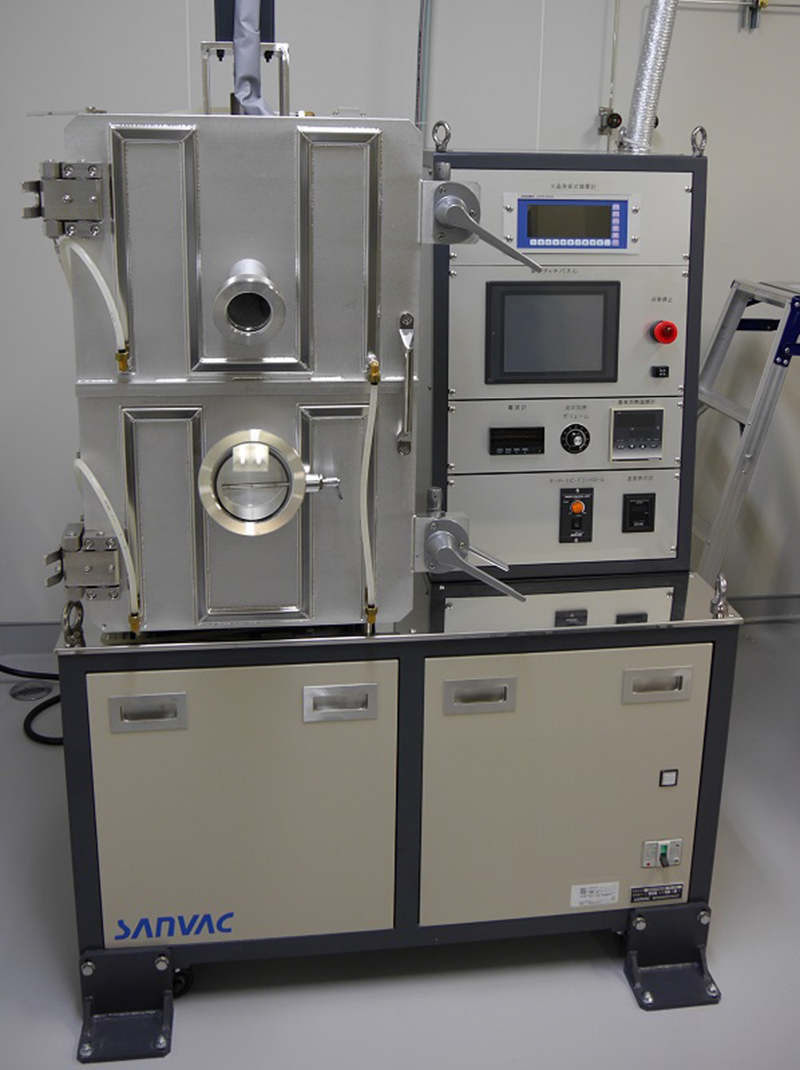
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃