共用設備検索結果
中分類から探す
LL式高密度汎用スパッタリング装置(2019) (LL-type High-density General Purpose Sputtering System)
- 設備ID
- UT-711
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL !-Miller (2019)
- 仕様・特徴
- 真空引きが速く、通常10分程度でスパッタリング開始が可能。また、膜質の安定も期待できる。ターゲットはCFS-4ESと共通。 デフォルトはPt/Au/Cr/Tiを装着。それ以外のターゲットは支援員の技術補助で交換を行う。UT-716と互換。
8元電子線蒸着装置 (Electron Beam Evaporator)
- 設備ID
- UT-712
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- エイコー (EIKO)
- 型番
- EB-380
- 仕様・特徴
- 蒸着材料を一度に8種類装填できる多様な実験を支援する電子ビーム蒸着。
カーボンコーター (Carbon coater )
- 設備ID
- UT-713
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 明和フォーシス (Meiwafosis )
- 型番
- CADE-4T
- 仕様・特徴
- 帯電しやすい試料をカーボンでコーティングして鮮明な走査電子顕微鏡増が得られます。
電子線顕微鏡観察用コーター (Coater for SEM analysis)
- 設備ID
- UT-714
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- Gatan (Gatan)
- 型番
- PECS
- 仕様・特徴
- スパッタによりカーボン膜など観察用の薄膜を堆積できます
3元マグネトロンスパッタ装置 (3 sources magnetron sputtering)
- 設備ID
- NU-205
- 設置機関
- 名古屋大学
- 設備画像
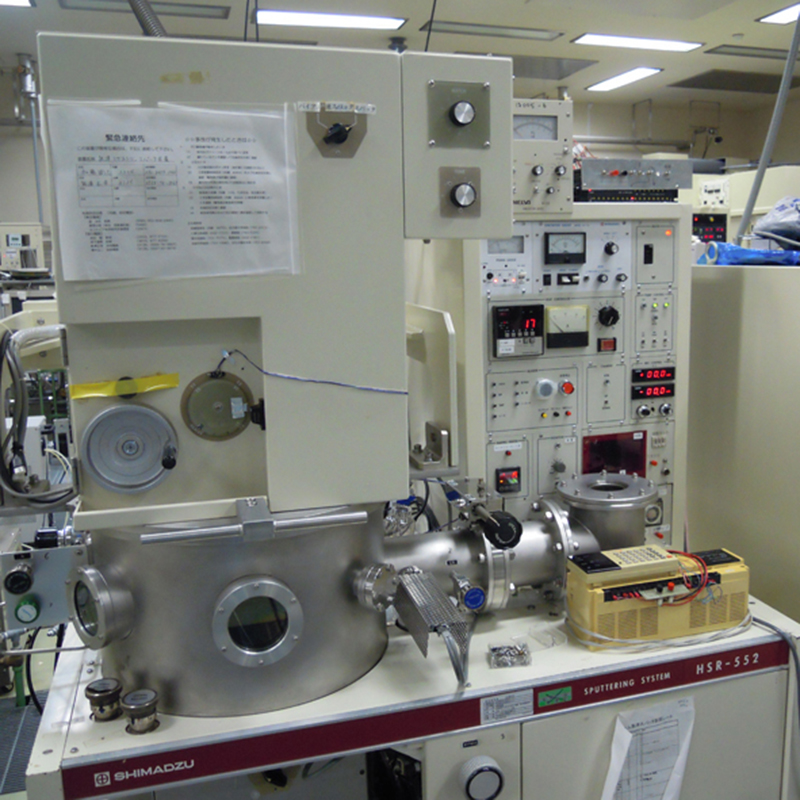
- メーカー名
- 島津製作所 (SHIMADZU)
- 型番
- HSR-522
- 仕様・特徴
- ・4インチカソード3本
・RF電源500 W 2台
・逆スパッタ機構
・基盤回転
・シャッター開閉機構による多層膜成長可能
8元マグネトロンスパッタ装置 (8 sources magnetron sputtering)
- 設備ID
- NU-213
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- 自作 (Lab made)
- 型番
- 仕様・特徴
- ・2インチカソード8本
・試料サイズ30 mm角
・RF電源 500 W 2台
・1 kV Arイオンエッチング機構
・試料交換室に8サンプルバンク可
8元MBE装置 (8 sources molecular beam epitaxy)
- 設備ID
- NU-214
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- 自作 (Lab made)
- 型番
- 仕様・特徴
- ・蒸着源:4cc蒸着源4個、2cc蒸着源2個
・試料サイズ30 mm角
・高圧電源3台
・基板加熱:1000℃
・1kV Arイオンエッチング機構
・20 kV RHEED表面観察機能
スプレーコーター (Spray coater)
- 設備ID
- NU-216
- 設置機関
- 名古屋大学
- 設備画像
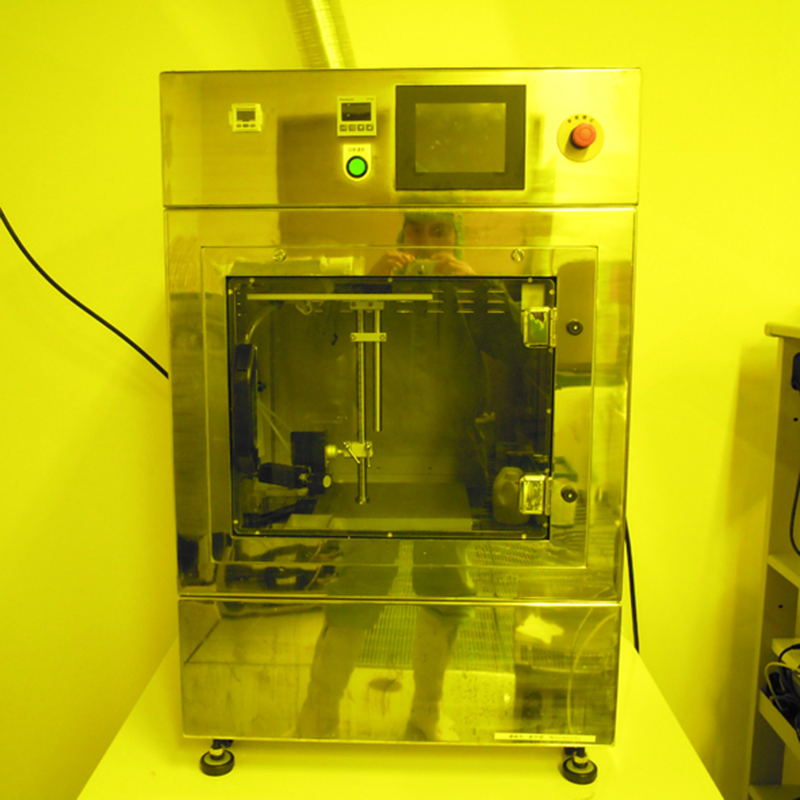
- メーカー名
- サンメイ (Sunmay)
- 型番
- DC110
- 仕様・特徴
- ・対応サイズ:最大 □220 mm
・移動範囲:縦横300 mm
・移動速度:10~200 mm/秒
・粒子径:約5~15 µm
プラズマCVD装置 (Plasma CVD)
- 設備ID
- NU-221
- 設置機関
- 名古屋大学
- 設備画像
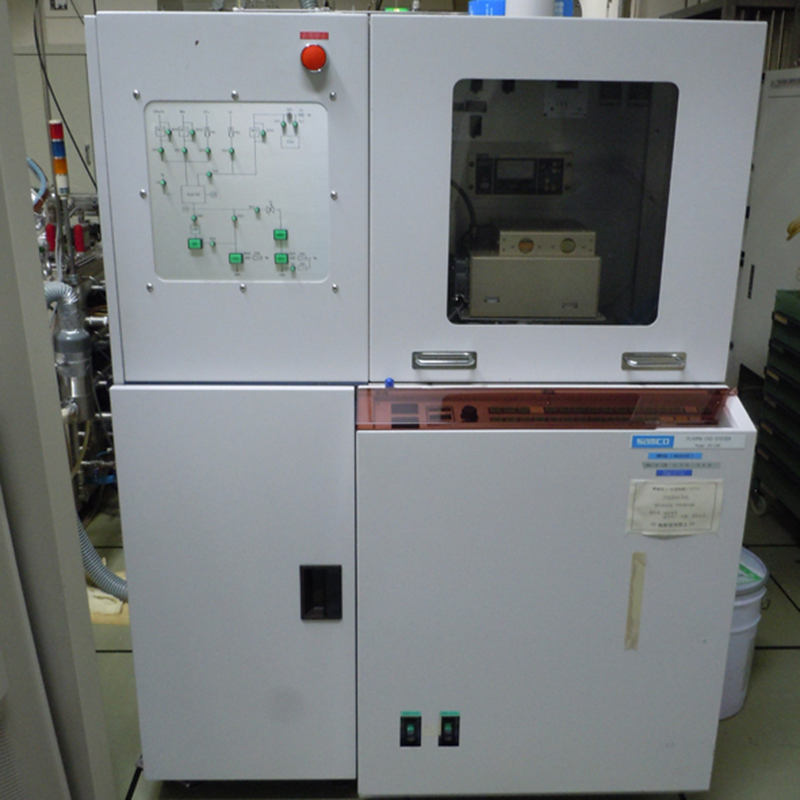
- メーカー名
- サムコ (Samco)
- 型番
- PD-240
- 仕様・特徴
- ・基板加熱:抵抗加熱式 (~400℃)
・適正ウェハ寸法:不定形~3インチ径
・供給ガス:TEOS, O2
電子ビーム蒸着装置 (Electron beam evaporation)
- 設備ID
- NU-224
- 設置機関
- 名古屋大学
- 設備画像
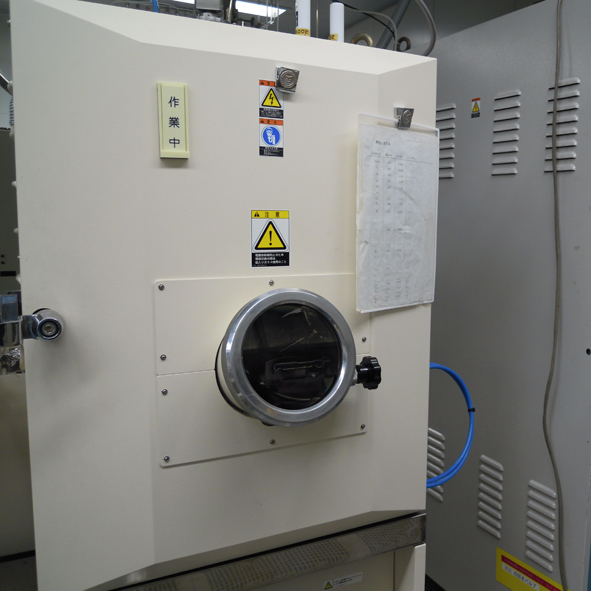
- メーカー名
- アルバック (ULVAC)
- 型番
- EBX-10D
- 仕様・特徴
- ・最大投入電力:5kW
・るつぼ数4
・ハースライナー使用