共用設備検索
共用設備検索結果
- 設備ID
- RO-331
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- アルパック (ULVAC, Inc.)
- 型番
- 仕様・特徴
- 対応wafer:2inch以下
抵抗加熱型の蒸着装置。
2種類の材料をセットして多層膜を作成することも可能。
Al、Au等。
- 設備ID
- GA-004
- 設置機関
- 香川大学
- 設備画像
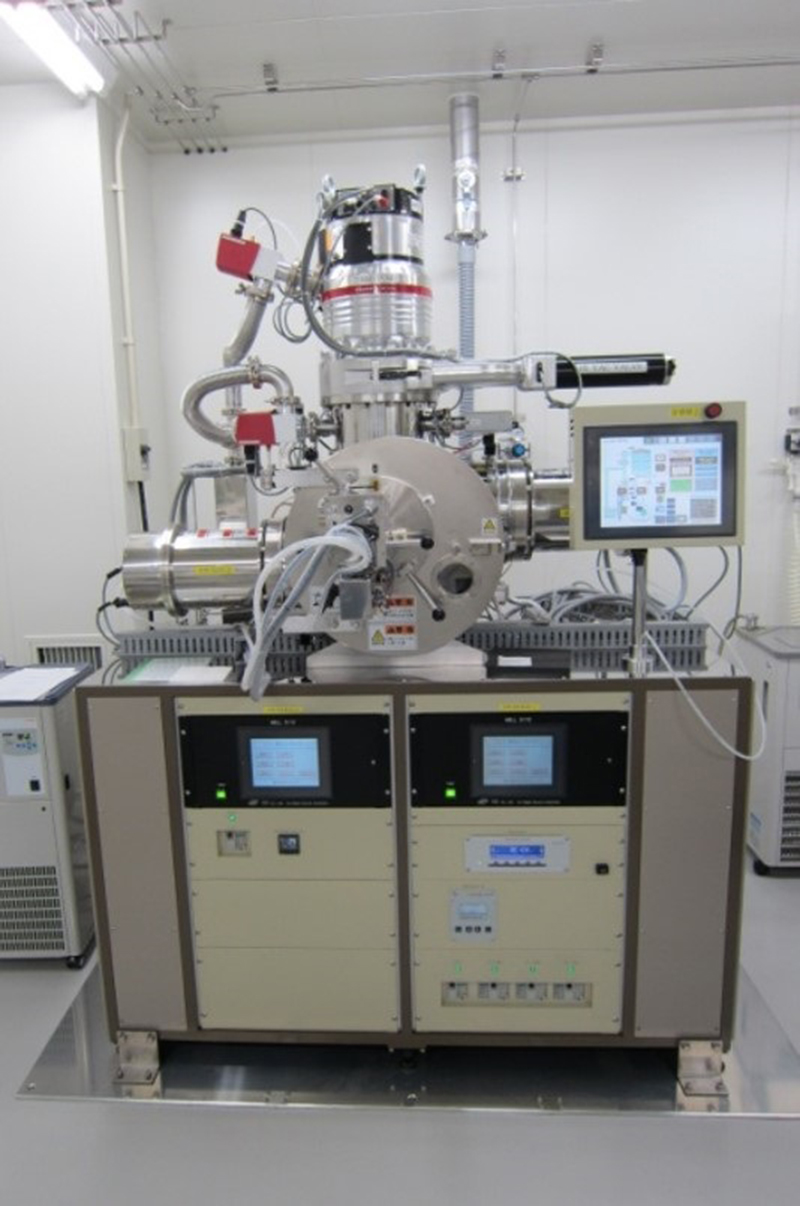
- メーカー名
- ハシノッテク (Hashino-tech)
- 型番
- 10W-IBS
- 仕様・特徴
- 4in-IBS
熱陰極型イオン源:2基(:50~1000eV)
基板加熱温度:最大700゜C
膜形成中のイオン同時照射機能
イオンビ-ムエッチング機能
【ビームガン1:エッチング用】
イオン銃:熱陰極型
イオン化ガス:Ar
ビーム電圧:100~1200V
ビーム電流:50~300mA
加速電圧:75~500V
イオン流密度:0.3~0.6mA/cm2 (500V加速時)
ビーム有効径:φ4インチ(分布測定可能)
真空度:~8x10-5Pa
試料寸法:φ4インチまで
【ビームガン2:デポジション用】
イオン銃:熱陰極型
イオン化ガス:Ar
ビーム電圧:100~1200V
ビーム電流:50~300mA
加速電圧:75~500V
ターゲット:Au、Cr、Tiほか
ステージ角度:ターゲットに対し-90~+90℃設定可
ステージ位置:上下50mm調整可
真空度:~8x10-5Pa
試料寸法:φ4インチまで
- 設備ID
- GA-013
- 設置機関
- 香川大学
- 設備画像

- メーカー名
- 日本電子, 日本電子, 日本電子, ディエナー (JEOL, JEOL, JEOL, diener)
- 型番
- JSM-IT800SHL, JCM-7000, JFC-3000FC, Femto
- 仕様・特徴
- ・JSM-IT800SHL
サンプルサイズ:~φ100mm
分解能:0.7nm(20kV)1.3nm(1kV)
倍率:×27~5,480,000(表示倍率)
加速電圧:0.01~30kV
分析機能:EDS
・JCM-7000
サンプルサイズ:~φ25mm(傾斜回転有)~φ80mm(傾斜回転無)
倍率:×10~100,000
加速電圧:5kV、10kV、15kV(3段)
- 設備ID
- KT-238
- 設置機関
- 京都大学
- 設備画像
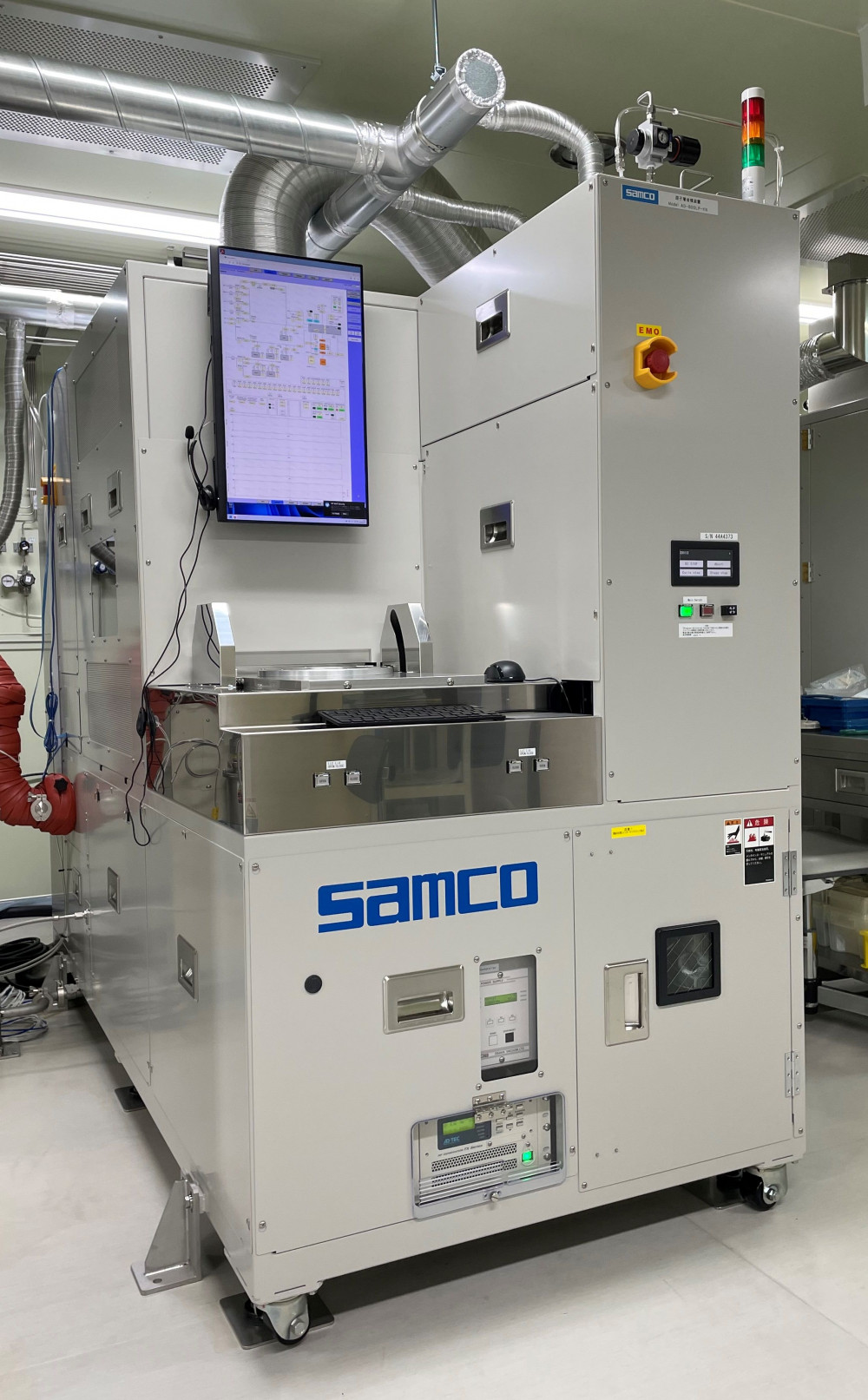
- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- AD-800LP-KN
- 仕様・特徴
- ナノレベルかつコンフォーマルの薄膜を形成するためのALD装置。ゲート酸化膜、バリア膜、透過防止膜などへの利用が可能。
・成膜方式:サーマル/プラズマ
・基板サイズ:小片~Φ8"
・材料ガス:BDEAS(Si系)、TMA(Al系)、TDMAT(Ti系) ほか(要相談)
・反応ガス:H2O、O2、O3、N2、NH3、H2
・キャリアガス:Ar、N2
- 設備ID
- KT-258
- 設置機関
- 京都大学
- 設備画像
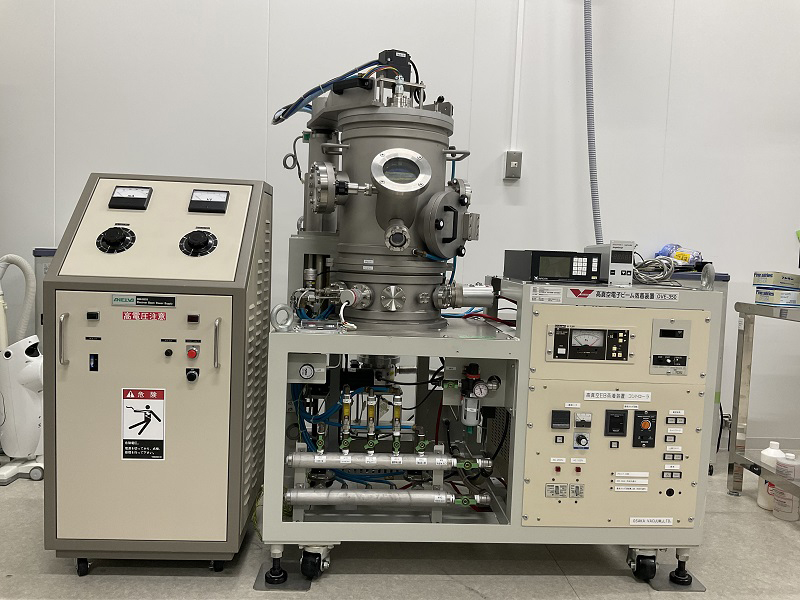
- メーカー名
- (株)大阪真空機器製作所 (Osaka Vacuum, Ltd.)
- 型番
- OVE-350
- 仕様・特徴
- 実験用電子線蒸着装置。
・基板サイズ:MAX Φ3""
・電子銃:2kW3連E型電子銃(1m×3)
・温度:300℃(ハロゲンランプ)
- 設備ID
- NM-641
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [CFS-4EP-LL #2]](data/facility_item/1687416500_11.jpg)
- メーカー名
- 芝浦メカトロニクス株式会社 (SHIBAURA MECHATRONICS CORPORATION)
- 型番
- CFS-4EP-LL
- 仕様・特徴
- ・電源:DC×2、RF×1
・電源出力:500W
・カソード:φ3インチ×4式(強磁性用1)
・基板サイズ:最大6inchφ
・プロセスガス:Ar、O2、N2
・基板加熱:設定300℃
・逆スパッタ可
- 設備ID
- NM-642
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子銃型蒸着装置 [MB-501010]](data/facility_item/1687416539_11.jpg)
- メーカー名
- 株式会社エイコー・エンジニアリング (EIKO ENGINEERING, LTD.)
- 型番
- MB-501010
- 仕様・特徴
- ・電子ビーム加速電圧:10kV
・最大エミッション:500mA
・蒸発源:材料ハース10cc×10個
・到達真空度:10-5 Pa
・T-S距離:700mm
・基板サイズ:最大φ6インチ
- 設備ID
- NM-644
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![原子層堆積装置 [SUNALE R-150]](data/facility_item/1687416682_11.jpg)
- メーカー名
- PICOSUN JAPAN株式会社 (Picosun Oy)
- 型番
- SUNALE R-150
- 仕様・特徴
- ・成膜方式:サーマルまたはプラズマALD
・原料ソース:3源
・基板サイズ:最大6inchφ
・基板温度:室温~300℃
- 設備ID
- TU-161
- 設置機関
- 東北大学
- 設備画像
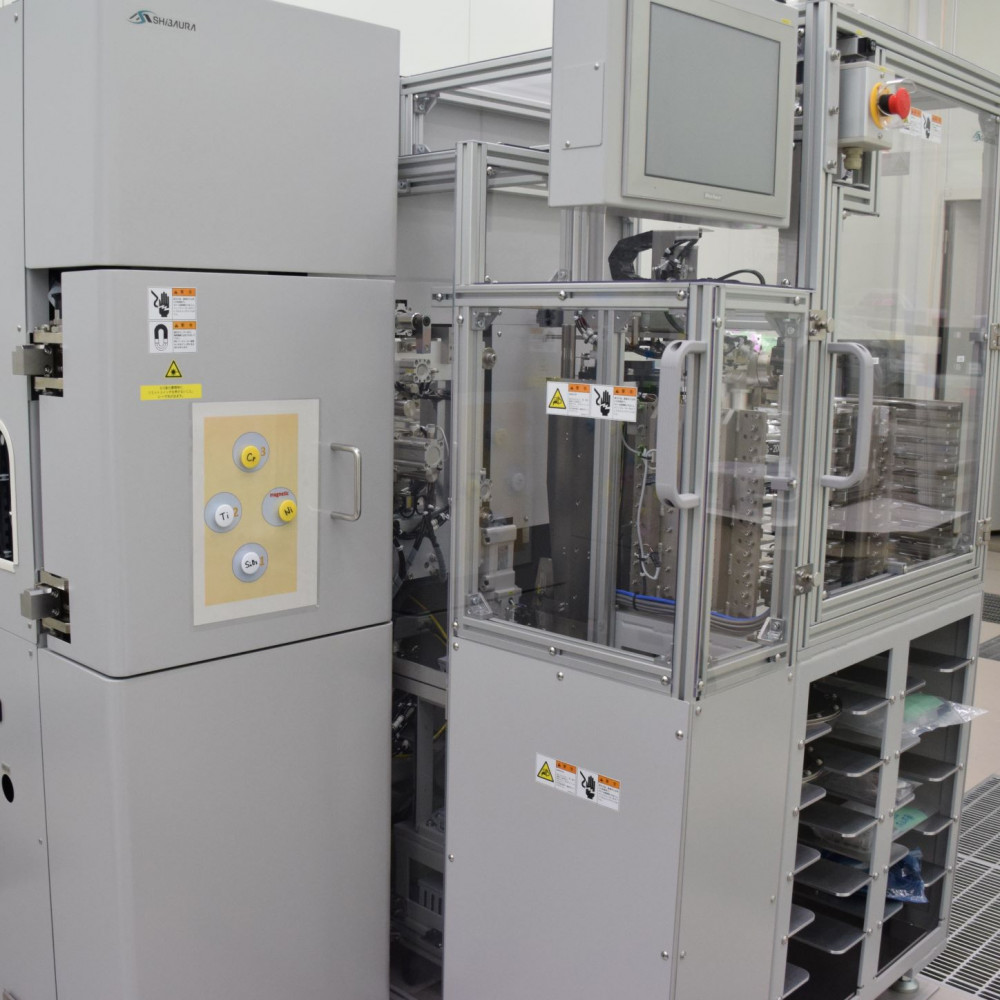
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- !-Miller CFS-4EP-LL
- 仕様・特徴
- サンプルサイズ:小片~8インチ
サンプルステージ:直径220mm
基板温度:約20℃
電源:RF×1
ターゲット:3インチ×4
方式:スパッタSIDE
到達真空度:8E-5Pa
- 設備ID
- TU-172
- 設置機関
- 東北大学
- 設備画像
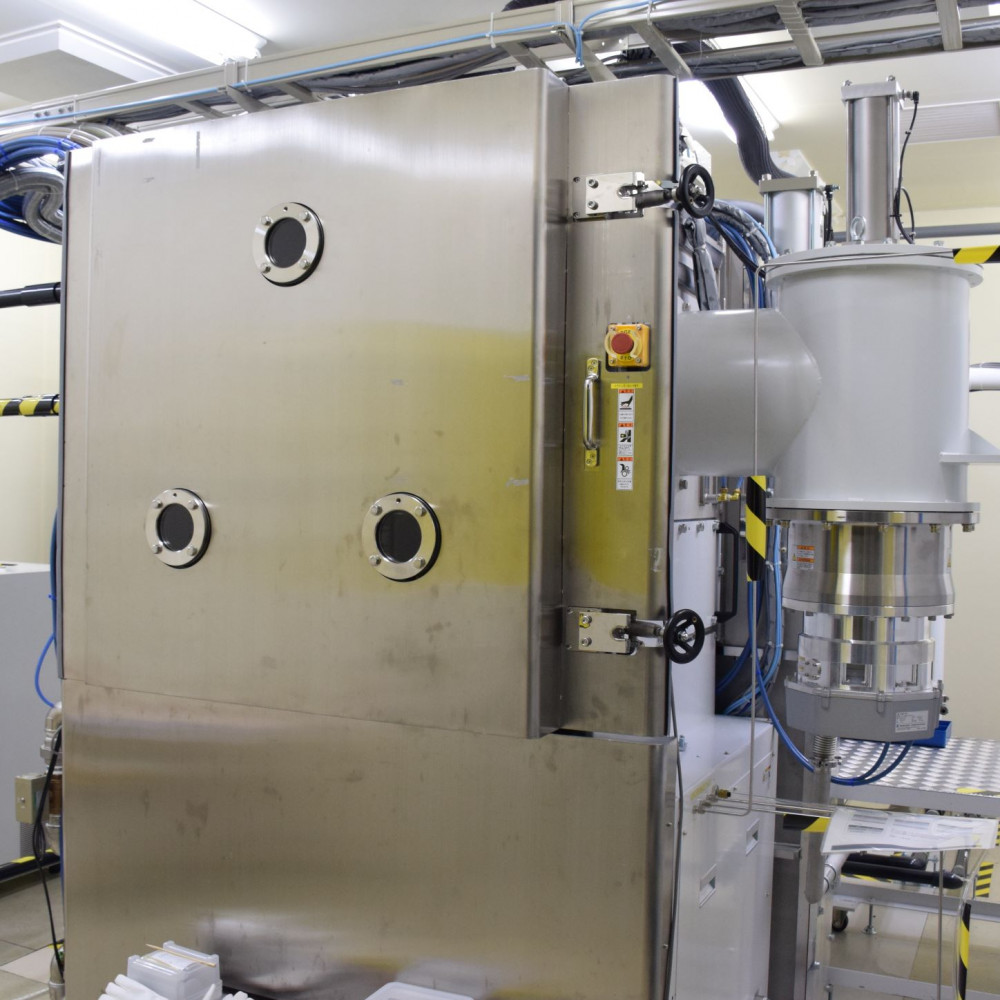
- メーカー名
- シンクロン (Shincron)
- 型番
- RAS-1100BII
- 仕様・特徴
- サンプルサイズ:4インチ
ラジカルアシストにより、緻密な酸化、窒化が可能
基板RFバイアス付
"成膜装置"で検索した結果 160件
- 160件中 151~160件
- <
- 1
- ...
- 9
- 10
- 11
- 12
- 13
- 14
- 15
- 16

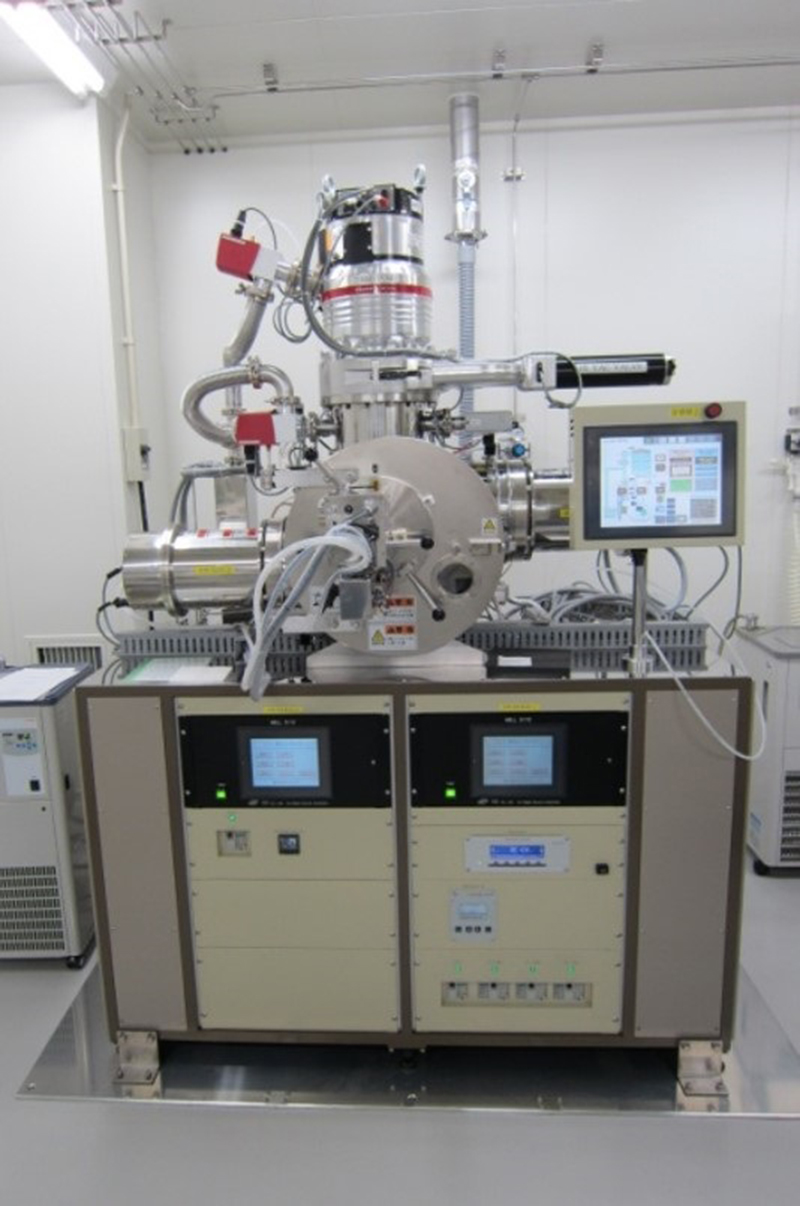

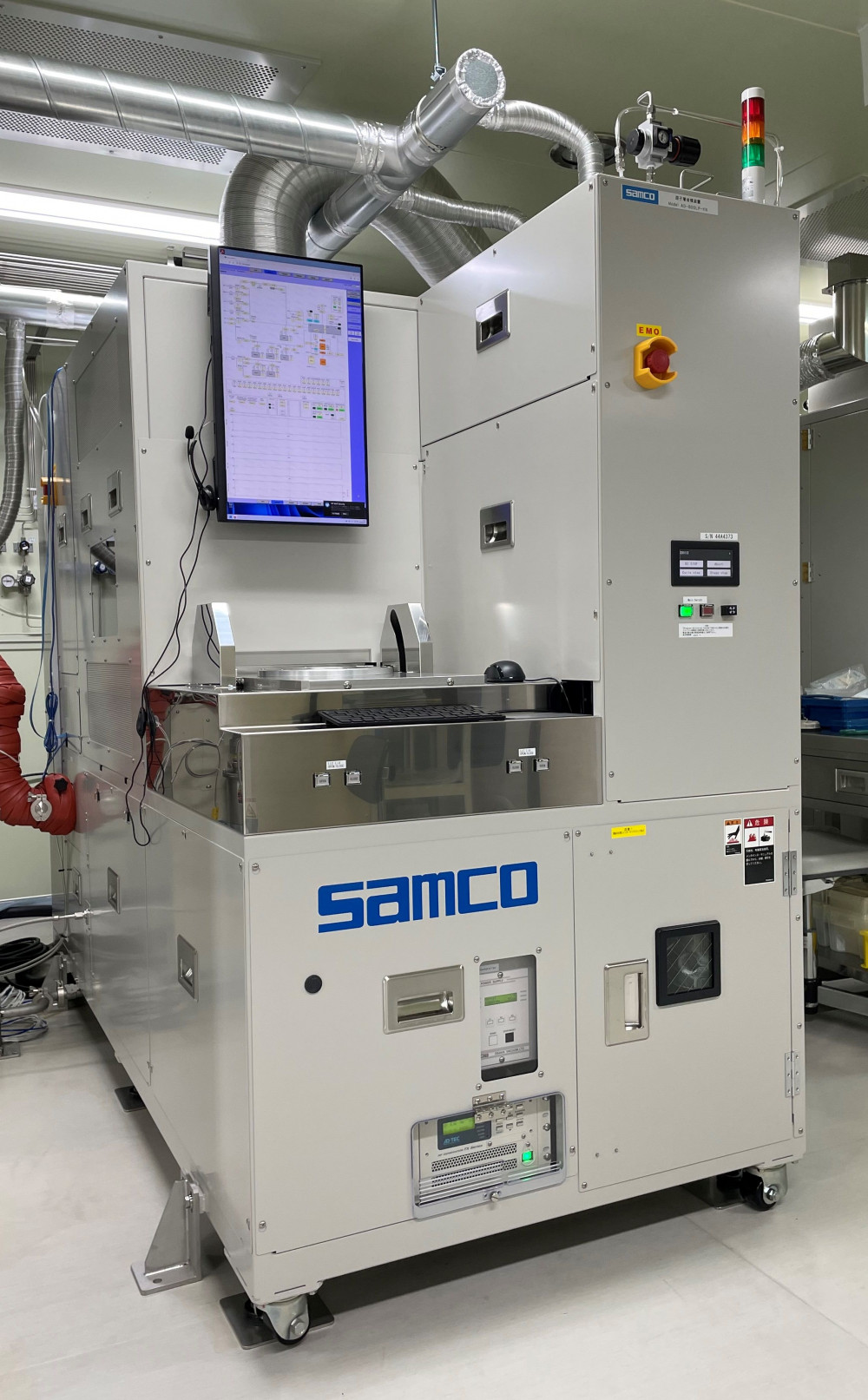
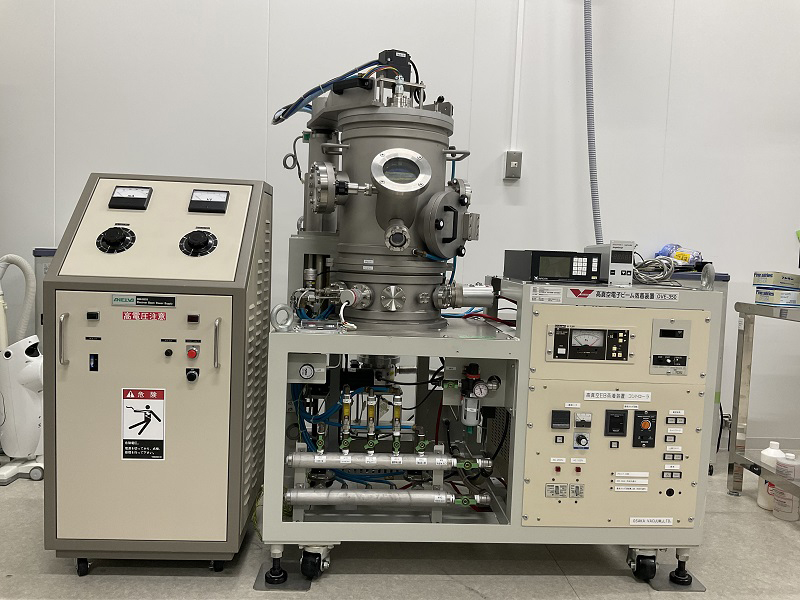
![スパッタ装置 [CFS-4EP-LL #2]](data/facility_item/1687416500_11.jpg)
![電子銃型蒸着装置 [MB-501010]](data/facility_item/1687416539_11.jpg)
![原子層堆積装置 [SUNALE R-150]](data/facility_item/1687416682_11.jpg)