共用設備検索
共用設備検索結果
- 設備ID
- OS-113
- 設置機関
- 大阪大学
- 設備画像
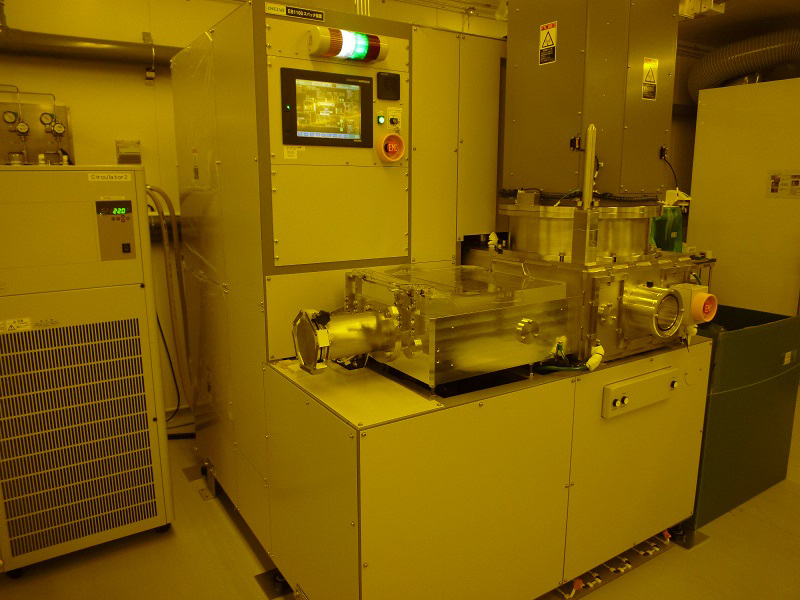
- メーカー名
- キャノンアネルバ (CANON ANELVA)
- 型番
- EB1100
- 仕様・特徴
- 【特徴】
スパッタチャンバー室、ロードロック室を備えた2室構造の平行平板型スパッタ装置。10nm以下の成膜が可能。真空を破らずに基板-ターゲット間距離を100~300mmの範囲で変更でき、搬送から成膜まで自動制御できるシステムを備える。
【仕様】
Au, Pt, Cr成膜用
ターゲット基板間距離100~300mm可変
全自動(排気、搬送、成膜)
最大200mm基板対応可能
- 設備ID
- OS-114
- 設置機関
- 大阪大学
- 設備画像
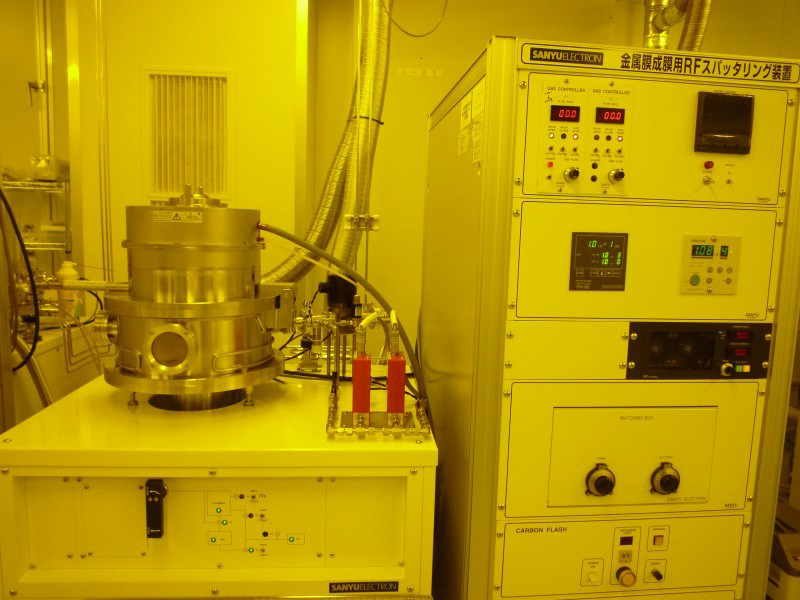
- メーカー名
- サンユー電子 (Sanyu Electron)
- 型番
- SVC-700LRF
- 仕様・特徴
- 【特徴】
Ti, Cr, W, Au, Pt等の金属のスパッタリングによる成膜が可能。TS間距離が400mmあるので、サンプル表面を均一にスパッタ加工したいユーザーに最適。
【仕様】
試料サイズ:max 4 inch
- 設備ID
- OS-115
- 設置機関
- 大阪大学
- 設備画像
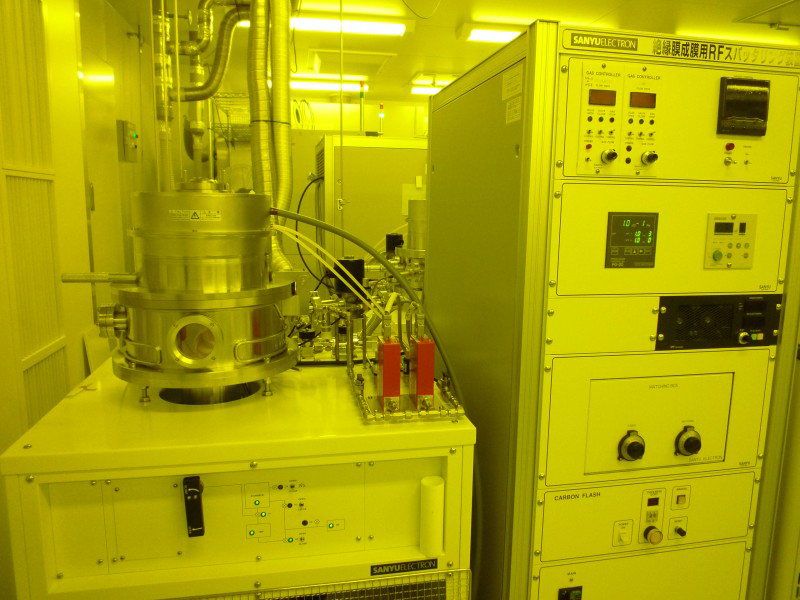
- メーカー名
- サンユー電子 (Sanyu Electron)
- 型番
- SVC-700LRF
- 仕様・特徴
- 【特徴】
SiO2, Al2O3等の絶縁体のスパッタリングによる成膜が可能
【仕様】
試料サイズ:max 4 inch
- 設備ID
- OS-116
- 設置機関
- 大阪大学
- 設備画像
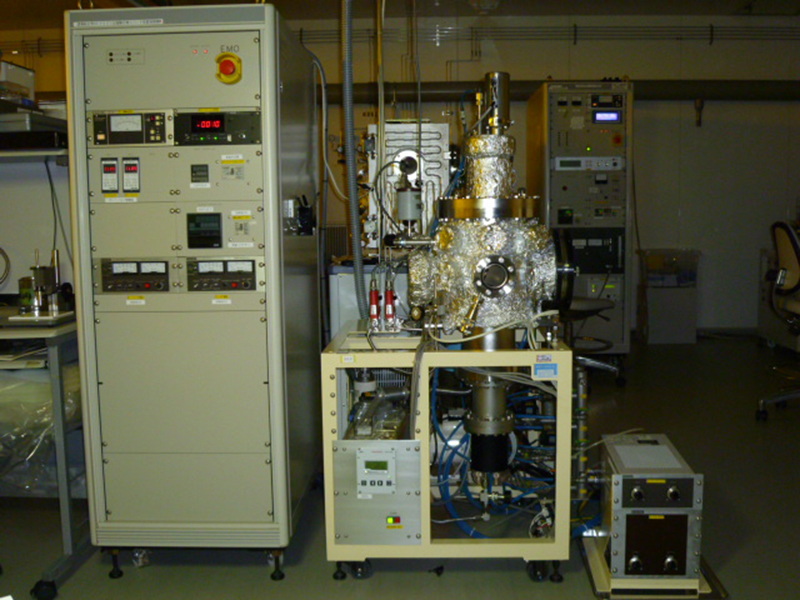
- メーカー名
- 株式会社アルバック (ULVAC, Inc.)
- 型番
- MB02-5002
- 仕様・特徴
- 【特徴】
誘導結合型RFプラズマ支援ヘリコン型スパッタ装置です。
隔膜式真空計を備えており、プロセスガス圧の高度な制御が可能です。
【仕様】
ターゲットサイズ:2inch
利用可能なターゲット:Au,Pt,Al2O3,SiO2,ITOなど(使用ごとに交換必要)
プロセスガス:Ar,O2
基板加熱温度:800℃
ターゲット基板間距離:200mm
- 設備ID
- OS-117
- 設置機関
- 大阪大学
- 設備画像
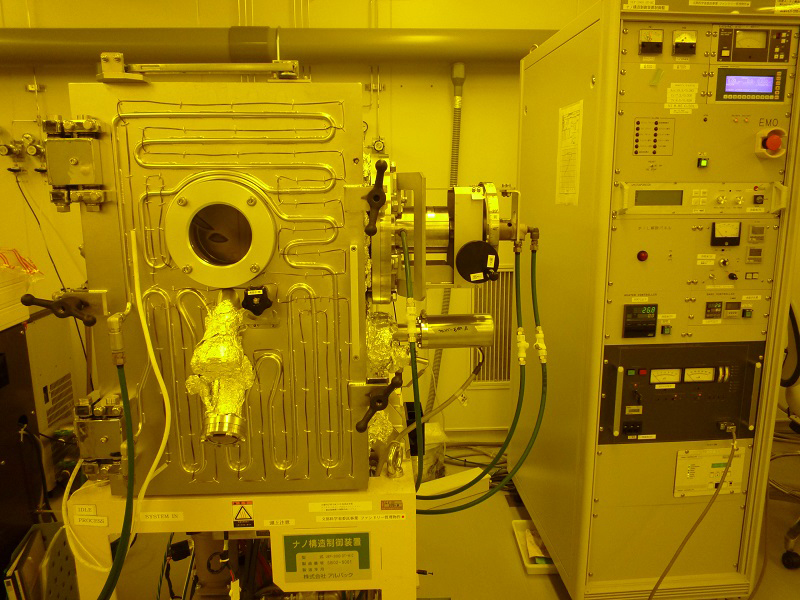
- メーカー名
- アルバック (ULVAC)
- 型番
- UEP-2000 OT-H/C
- 仕様・特徴
- 【特徴】
蒸発源として電子ビームを用いることで、蒸発させにくいPt, Au, Ni, Tiなどの金属薄膜の形成が可能。微細構造作製のため基板への斜入射蒸着が可能で、基板の冷却および加熱機能を備える。
【仕様】
高真空中で一度に4種類の金属薄膜形成が可能
試料サイズ:max 4 inch
- 設備ID
- OS-119
- 設置機関
- 大阪大学
- 設備画像
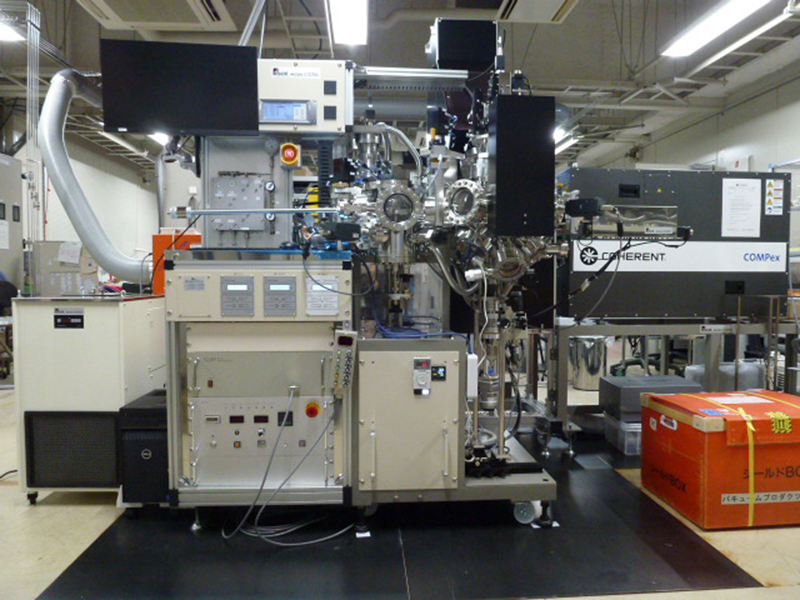
- メーカー名
- 株式会社パスカル (Pascal Co.,Lid.)
- 型番
- MC-LMBE
- 仕様・特徴
- 【特徴】
スキャニングRHEEDと2つのコンビナトリアルマスクを用いて、成長を原子レベルで制御しながら、一枚の基板上に異なる条件の試料を一括作製することが可能です。
【仕様】
レーザー波長:193nm(ArF)
レーザー周波数、エネルギー:1~20Hz、最大240mJ
試料サイズ:10mm×10mm
真空度:10-7Pa台
雰囲気ガス:O2(0.02~20Pa)
基板加熱温度:1200℃
RHEED最大加速電圧:30kV
- 設備ID
- QS-113
- 設置機関
- 量子科学技術研究開発機構(QST)
- 設備画像

- メーカー名
- 神津精機(株)ほか (Kohzu Precision Co., Ltd., etc.)
- 型番
- なし(特別仕様)
- 仕様・特徴
- ・半導体ヘテロ構造や多層膜、半導体量子ドット結晶やナノワイヤなどの成長過程について、原子が一層づつ積み上がってゆく様子を、表面X線回折法によってリアルタイム観察できる装置。
・原子状窒素を利用する分子線エピタキシー法により、GaNやInNなどの窒化物半導体の成長を行うことができる。
・良質な電子材料の作成をサポート。
- 設備ID
- RO-121
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- タツモ(株) (TAZMO)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
レジスト塗布
- 設備ID
- RO-311
- 設置機関
- 広島大学
- 設備画像
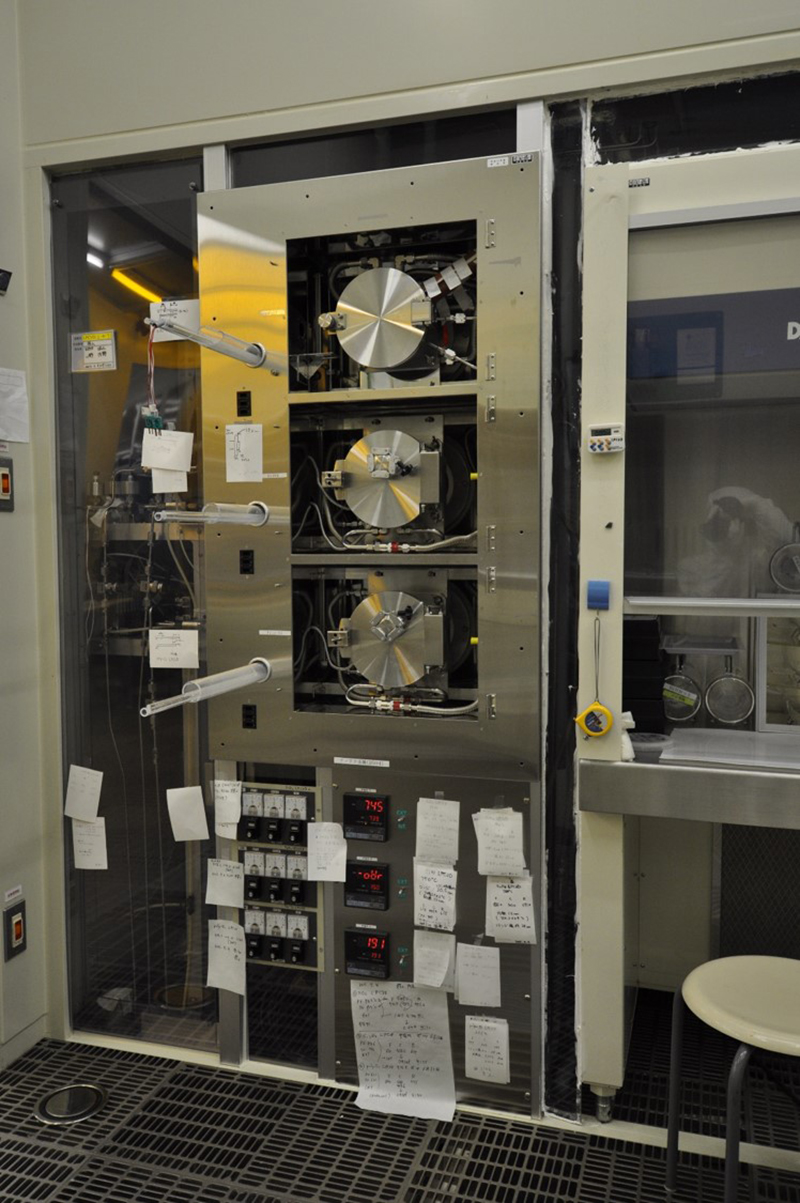
- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
モノシランの熱分解、650℃
- 設備ID
- RO-312
- 設置機関
- 広島大学
- 設備画像

- メーカー名
- 東京エレクトロン (Tokyo Electron)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
ジクロルシランとアンモニアの反応、基板温度750℃
"成膜装置"で検索した結果 160件
- 160件中 131~140件
- <
- 1
- ...
- 9
- 10
- 11
- 12
- 13
- 14
- 15
- 16
- >