共用設備検索
共用設備検索結果
- 設備ID
- IT-009
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- エイコーエンジニアリング ( Eiko-engineering)
- 型番
- 特注品
- 仕様・特徴
- ロードロックチャンバ付 6連E-gun 6kW 3連EBガン×2 到達真空度: 5e-8Torr以下 基板サイズ: 20mm角まで 蒸着原材料: Ti,Pd,Ni,Cr,Au
- 設備ID
- IT-010
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 日本酸素 ( Nippon Sanso)
- 型番
- HR-3246
- 仕様・特徴
- InP用 ・ウェハトレイ:石英製2インチウェハトレイ ・III族材料:TEG,TMG,TMA,TMI,CBr4 ・V族材料:AsH3(100%),AsH3(1%),PH3(100%),Si2H6,C2H6Zn
- 設備ID
- IT-011
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- Ultratech/CamnbridgeNanotech (Ultratech/CamnbridgeNanotech)
- 型番
- FijiF20
- 仕様・特徴
- ロードロック機構付
プラズマ式/サーマル式の両方のモードでの原子層堆積が可能。化合物半導体等のMIS構造での低界面準位密度などに実績あり。(成膜温度で揮発し、装置を汚染する可能性のある材料は禁止) 酸素源:オゾンおよび水の両方の利用が可能
- 設備ID
- IT-015
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- PD-100ST
- 仕様・特徴
- PD-100ST 使用ガス: TEOS、O2、CF4 最大3インチまで
- 設備ID
- IT-016
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- 住友精密工業 (STS)
- 型番
- Multiplex-CVD
- 仕様・特徴
- シリコン窒化膜/アモルファスシリコンの成膜
- 設備ID
- IT-017
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702-KM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備 ・膜厚計装備 ・スパッタコントローラ装備 ・Ti, W, TiW ロードロック付き装置
- 設備ID
- IT-018
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702KAM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備
・膜厚計装備
・スパッタコントローラ装備
・SiN、Ta2O3、SiO2 最大2インチ程度まで
- 設備ID
- IT-028
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- エフ・ティ・エスコーポレーション (FTS corp)
- 型番
- 特注品
- 仕様・特徴
- 対向ターゲット式RFスパッタリング(2元) 最大3インチまで (ただし堆積は中央の2インチ程度)
- 設備ID
- IT-033
- 設置機関
- 東京工業大学
- 設備画像
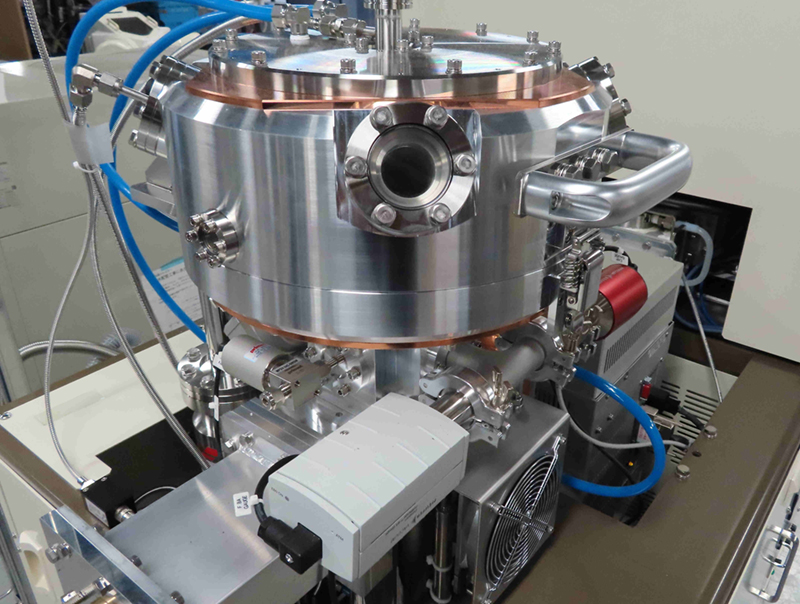
- メーカー名
- アリオス (Arios)
- 型番
- DCVD-601BTG
- 仕様・特徴
- マイクロ波周波数 2.45 GHz、マイクロ波パワー 最大6 kW、水素・メタンガスによるダイヤモンド合成、窒素ガスによる不純物ドーピング、基板サイズ 50mmΦまで 窒素を添加することで、現在注目されている量子センサである窒素-空孔(NV)センタを作ることも可能です。
- 設備ID
- JI-017
- 設置機関
- 北陸先端科学技術大学院大学(JAIST)
- 設備画像
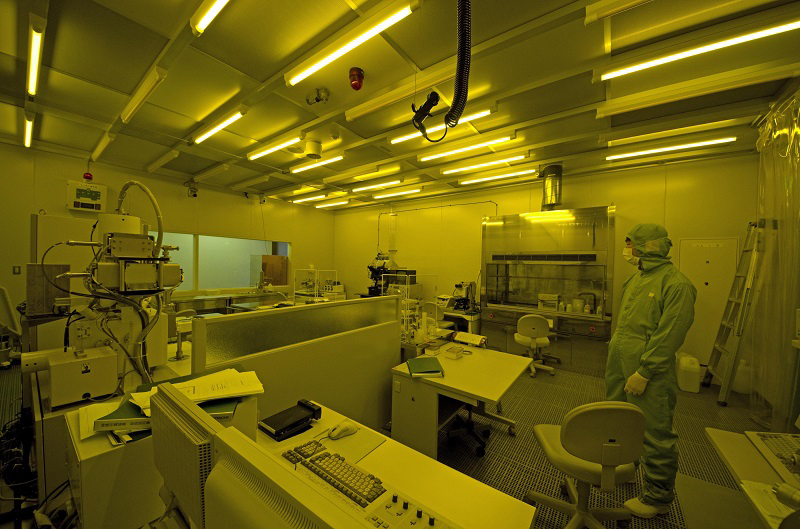
- メーカー名
- ()
- 型番
- 仕様・特徴
- EBL(30kV, 50kV)、マスクレス露光機(405nm, 375nm)、抵抗加熱蒸着、EB蒸着、RFスパッタ、ECRスパッタ、ALD、MBE、RIE、イオン注入、赤外ランプアニールなど
"成膜装置"で検索した結果 160件
- 160件中 111~120件
- <
- 1
- ...
- 9
- 10
- 11
- 12
- 13
- 14
- 15
- 16
- ...
- 16
- >