共用設備検索
共用設備検索結果
- 設備ID
- AT-102
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
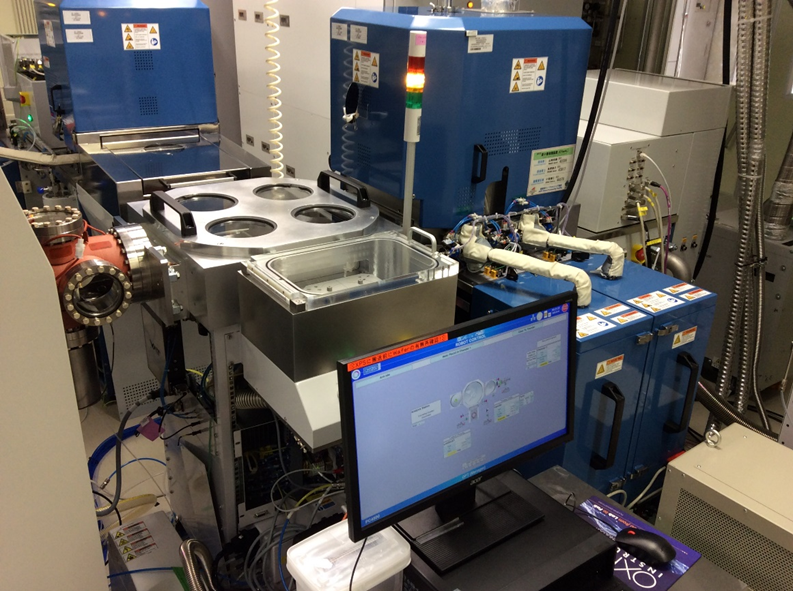
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- FlexAL
- 仕様・特徴
- ・型式:FlexAL
・試料サイズ:4インチφ
・基板温度:100-550℃
・プラズマALD:600W(誘導結合型)
・基板バイアス:100W
・反応ガス:重水, O2, ピュアオゾン, N2, H2, D2, NH3, ND3
・材料ポート:8ポート
・キャリアガス:Ar
・表面分析用 in-situ XPS
・膜厚計測用 in-situ 分光エリプソ
- 設備ID
- AT-103
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
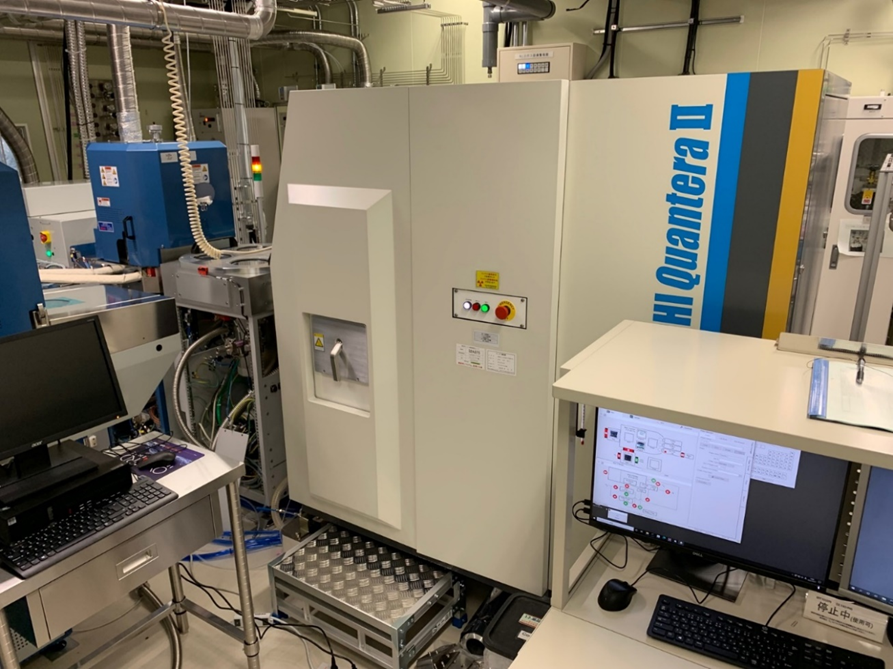
- メーカー名
- アルバック・ファイ (ULVAC-PHI,)
- 型番
- Quantera II
- 仕様・特徴
- ・型式:Quantera II
・試料サイズ:4インチφ
・X線源:単色化Al kα(ローランド直径 200 mm)
・光電子分光器:静電半球型(軌道直径279.4 mm)
・検出器:マルチチャネル検出器 (32 ch)
・スペクトル分析:0~1467 eV
・イメージング:最小ビーム径7.5μm, 最大走査範囲1.4 mmx1.4 mmのSXIイメージング
・最小スペクトル分析面積:7.5μmφ (20% - 80% knife edge法)
・エネルギ分解能:0.48 eV(Ag 3d5/2光電子ピーク半値幅)
・帯電中和:10 eV以下電子と5~10 eV Arイオン同時照射
・光電子取り出し角度:45°(標準)
- 設備ID
- AT-104
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
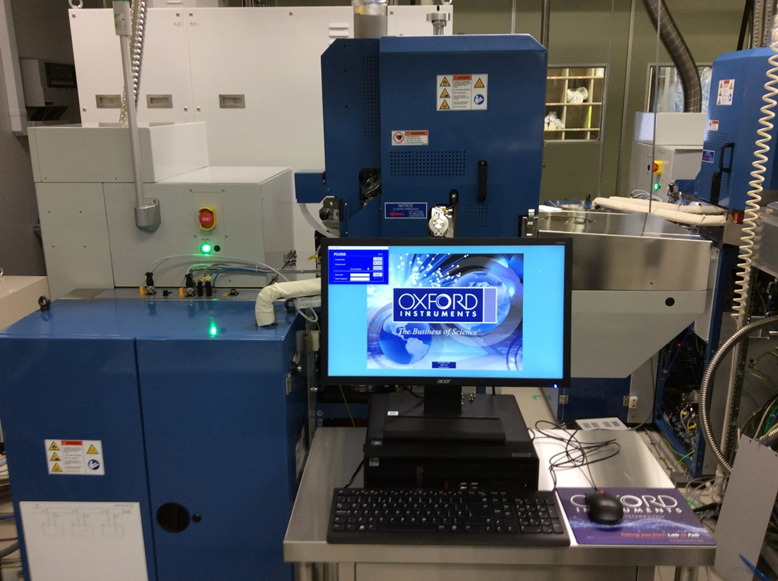
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- FlexAL
- 仕様・特徴
- ・型式:FlexAL
・試料サイズ:4インチφ
・基板温度:100-550℃
・プラズマALD:600W(誘導結合型)
・基板バイアス:100W
・反応ガス:H2O,O2,N2,H2,D2, NH3, ND3
・材料ポート:3ポート
・キャリアガス:Ar
・膜厚計測用 in-situ 分光エリプソ
- 設備ID
- AT-109
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
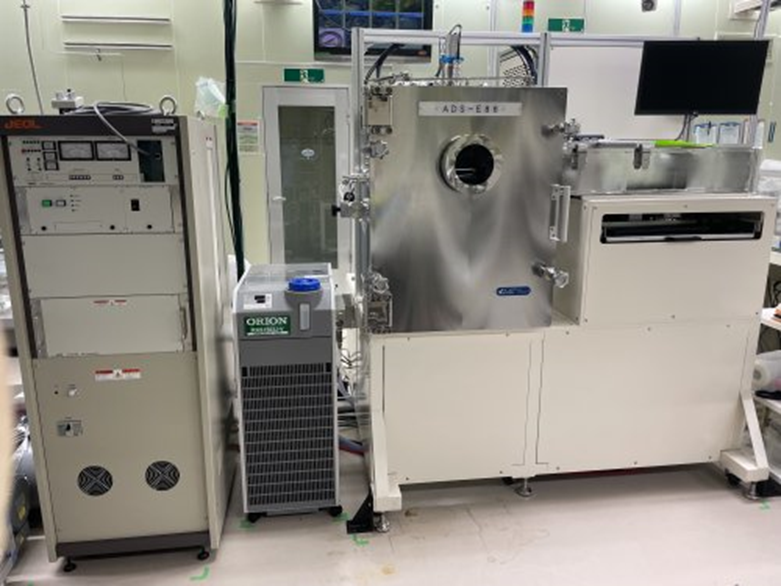
- メーカー名
- アールデック (R-DEC)
- 型番
- ADS-E86
- 仕様・特徴
- ・型式:ADS-E86
・試料サイズ:8インチφ
・蒸着方式:電子ビーム加熱蒸発
・蒸発源:6連装(6 kW)
・クルーシブル容量:12 ml
・基板ホルダ:冷却機構付(水冷)
・蒸発源―基板間:500 mm
・試料導入:ロードロック自動搬送
・真空排気システム:到達圧力1×10-5 Pa以下、オイルフリー、自動排気
・成膜:水晶振動子膜厚モニタによる自動制御
・膜厚分布:10 %以内@200mm
・常設ソース材料: Al, Al, Cu, Ti,
- 設備ID
- WS-001
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 伯東株式会社 (Hakuto Co., Ltd.)
- 型番
- MILLATRON 820
- 仕様・特徴
- デュアルイオンビームスパッタ装置
試料サイズ 4インチ以下
4ターゲット
基板昇温可能(約400℃)
- 設備ID
- WS-002
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- キヤノンアネルバ株式会社 (CANON ANELVA CORPORATION)
- 型番
- EVC-1501
- 仕様・特徴
- 試料サイズ 4インチ以下
Au, Cr, Ti専用
4インチウエハ18枚同時成膜可能(プラネタリーホルダー)
- 設備ID
- WS-003
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 株式会社アルバック (ULVAC, Inc.)
- 型番
- EBX-6D
- 仕様・特徴
- 試料サイズ 4インチ以下(プラネタリーホルダーにより、複数枚成膜可能)
金属(Cu, Cr, Ni, Al, Au, Ag等)および絶縁膜(SiO2, ZnO等)の成膜
- 設備ID
- WS-004
- 設置機関
- 早稲田大学
- 設備画像
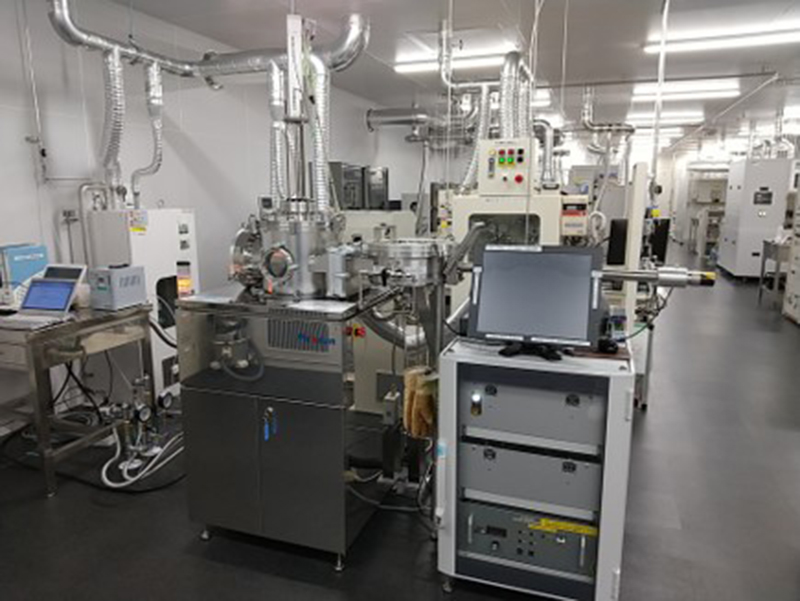
- メーカー名
- PICOSUN JAPAN株式会社 (Picosun Japan Co. Ltd.)
- 型番
- SUNALE R-150
- 仕様・特徴
- Al2O3膜を原子一層レベルで成膜可能
H2O及びO3使用可
基板サイズ小片~4インチ
4”, 6”ウエハ, 及び20×20mm試料対応
基板材料は原則としてダイヤモンドまたはSi
- 設備ID
- WS-005
- 設置機関
- 早稲田大学
- 設備画像
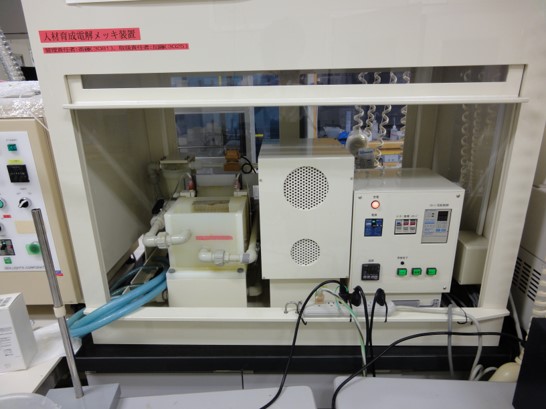
- メーカー名
- 特注品 (Custom-made products)
- 型番
- 特注品
- 仕様・特徴
- 各種無電解、電解めっきに対応、Auめっき、合金めっきに対応、基板サイズ4インチまで
- 設備ID
- IT-008
- 設置機関
- 東京工業大学
- 設備画像
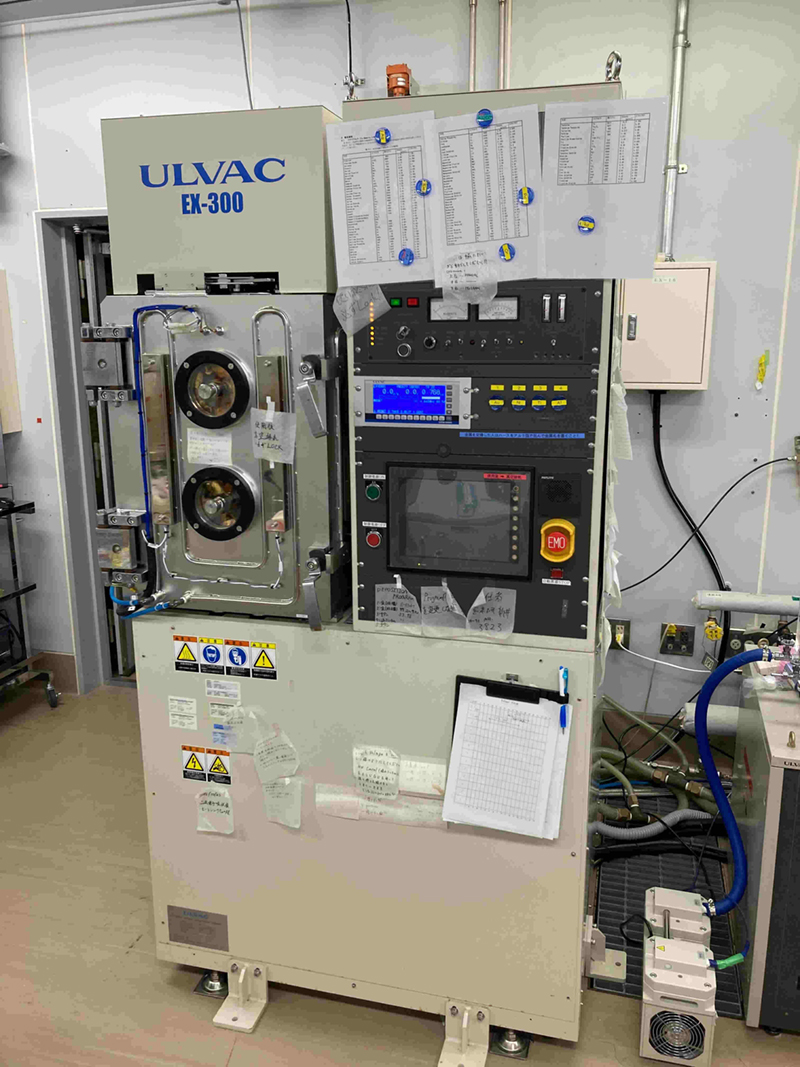
- メーカー名
- アルバック ( Ulvac)
- 型番
- EX-300
- 仕様・特徴
- 300mm対応 高速排気
"成膜装置"で検索した結果 160件
- 160件中 101~110件
- <
- 1
- ...
- 8
- 9
- 10
- 11
- 12
- 13
- 14
- 15
- ...
- 16
- >