共用設備検索
共用設備検索結果
- 設備ID
- AT-023
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
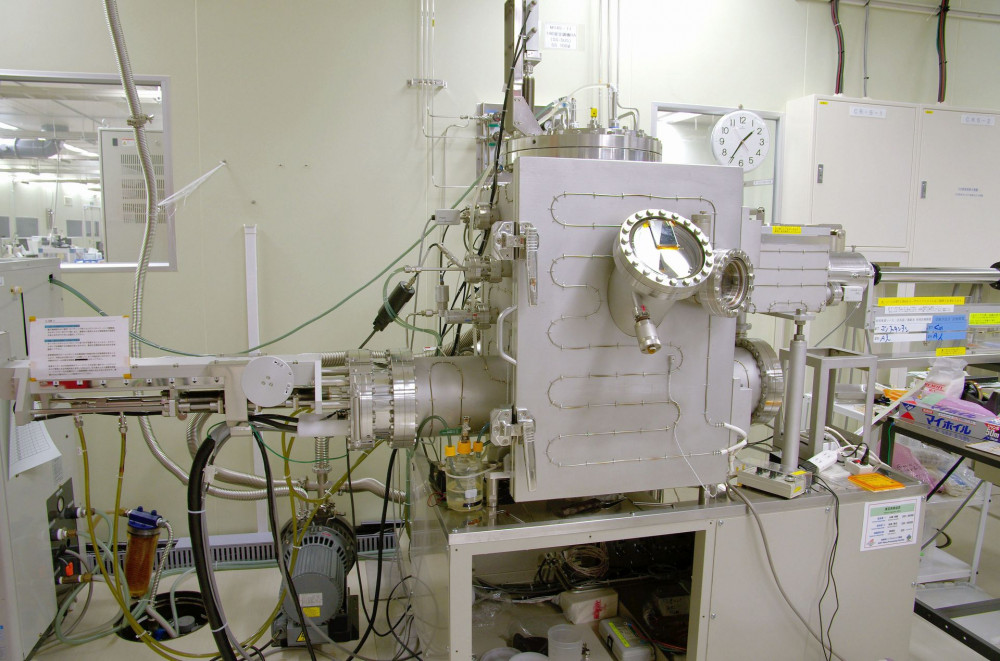
- メーカー名
- エイコーエンジニアリング (EIKO ENGINEERING)
- 型番
- 仕様・特徴
- ・試料サイズ:100 mm×100 mm×20 mm
・蒸着方式:電子ビーム加熱蒸発、180°配向型
・蒸発源:8連装(6 kW電子銃)
・クルーシブル容量:10 ml
・基板ホルダ:傾斜ホルダ、冷却機構付(マイナス10℃)
・蒸発源―基板間:300 mm
・試料導入:ロードロック自動搬送
・真空排気システム:到達圧力3×10-6 Pa以下、オイルフリー、自動排気
・成膜:水晶振動子膜厚モニタによる自動制御
・膜厚分布:10 %以内@Φ75mm
・ソース材料: Al, Al2O3, Ag, Au, Cr, Cu, Mo, Pt, Ru, SiO2, Ta, Ti, TiN, TiO2, W
- 設備ID
- AT-024
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ビームトロン (Biemtron)
- 型番
- KIS_3
- 仕様・特徴
- ・型式:KIS_3
・試料サイズ:3インチφ以下
・蒸着方式:抵抗加熱蒸発
・蒸発源:3ポート
・加熱抵抗体:平板ボート、コイル、バスケット
・傾斜基板ホルダ:±15°
・蒸発源―基板間:250 mm
・試料導入:手動
・真空排気:手動、到達圧力5×10-5 Pa以下
・成膜制御:手動( 基板シャッター開閉及びヒーター電力調整)
・膜厚モニター:水晶振動子膜厚モニタ付
・ソース材料: Al, Ag, Au, Fe, Ni, Cr, Cu, Ti
- 設備ID
- AT-025
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
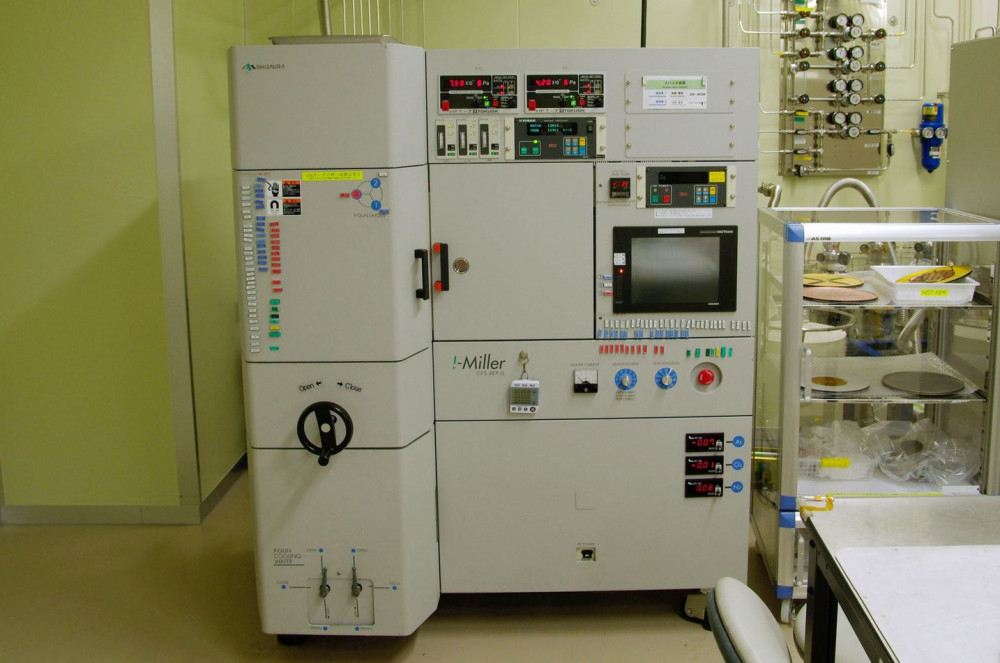
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチφ, 5mmt
・スパッタ源:3インチマグネトロン方式×3式
・高周波電源:最大出力500 W(使用最大200 W)
・RF制御:自動制御
・逆スパッタリング:200W
・試料搬送:ロードロック室付
・基板テーブル:回転機構付
・ターゲット-基板間:85 mm
・加熱温度:最大300 ℃
・膜厚分布:±5%以内@膜厚2~3 kÅ、SiO2成膜時、170 mmφ内
・到達真空度:2×10-4 Pa
・反応ガス:Ar, O2, N2
・成膜時ガス圧:0.2~1 Pa
・常備ターゲット:金属・酸化物・窒化物等、60種
- 設備ID
- AT-029
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 山本鍍金試験器 (Yamamoto-ms)
- 型番
- 仕様・特徴
- ・試料サイズ:2インチ、4インチφ
・水槽:4インチウエハ用 アクリル製二重底タイプ、浴容量 4L
・ヒーター:ウエハ水槽用ヒーター 100V,100W
・陽極板:含燐銅
・濾過器:ミニフィルター20APFA型(PTFEチューブ/4.8 (dm3/min.)/0.5μmカートリッジタイプ)
・揺動装置:4インチ用パドル撹拌装置(回転数表示式)
・電源:入力電圧 AC100~200V±10%(50/60Hz±5%)
・出力電圧 DC 0~15V
・出力電流 0~10A
・最小分解能 10mV,1mA,0.1mC
・温度調整機能 1KW(ON/OFF PID制御)
・めっき液:微細配線、パンプ用無光沢硫酸銅(XP-CS)
・その他:筆めっき用にリード線付き筆具(筆先カーボン)あり
- 設備ID
- AT-030
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- PD-20SS
- 仕様・特徴
- ・型式:PD-20SS
・試料サイズ8インチ
・有効成膜範囲:220mmφ
・排気系:ロータリーポンプ+メカニカルブースターポンプ
・圧力制御:オートプレッシャーコントローラー(コンダクタンス可変型)
・高周波電源:300W(13.56MHz)
・電極間隔:25mm(上部電極:Al製、下部電極:SUS製)
・ガス噴出口:上部電極一体式シャワー状マニホールド
・ステージ加熱機構:抵抗加熱方式(400℃)
・導入ガス:C2F6, O2, TEOS
- 設備ID
- AT-031
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![原子層堆積装置_1[FlexAL]](data/facility_item/AT-031.jpg)
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- FlexAL
- 仕様・特徴
- ・型式:FlexAL
・試料サイズ:8インチφ
・基板温度:100-550℃
・プラズマALD:600W(誘導結合型)
・基板バイアス:100W
・反応ガス:H2O, O2, N2, H2, NH3
・材料ポート:8ポート
・常備材料ガス:TMA, DEZn, 3DMAS, TTIP, TDMATi, TBTDMTa, TEMAHf, Ru(EtCp)2, TBTDEN, TEMAZr, TDMAHf
・キャリアガス:Ar
・膜厚計測用 in-situ 分光エリプソ
- 設備ID
- AT-081
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
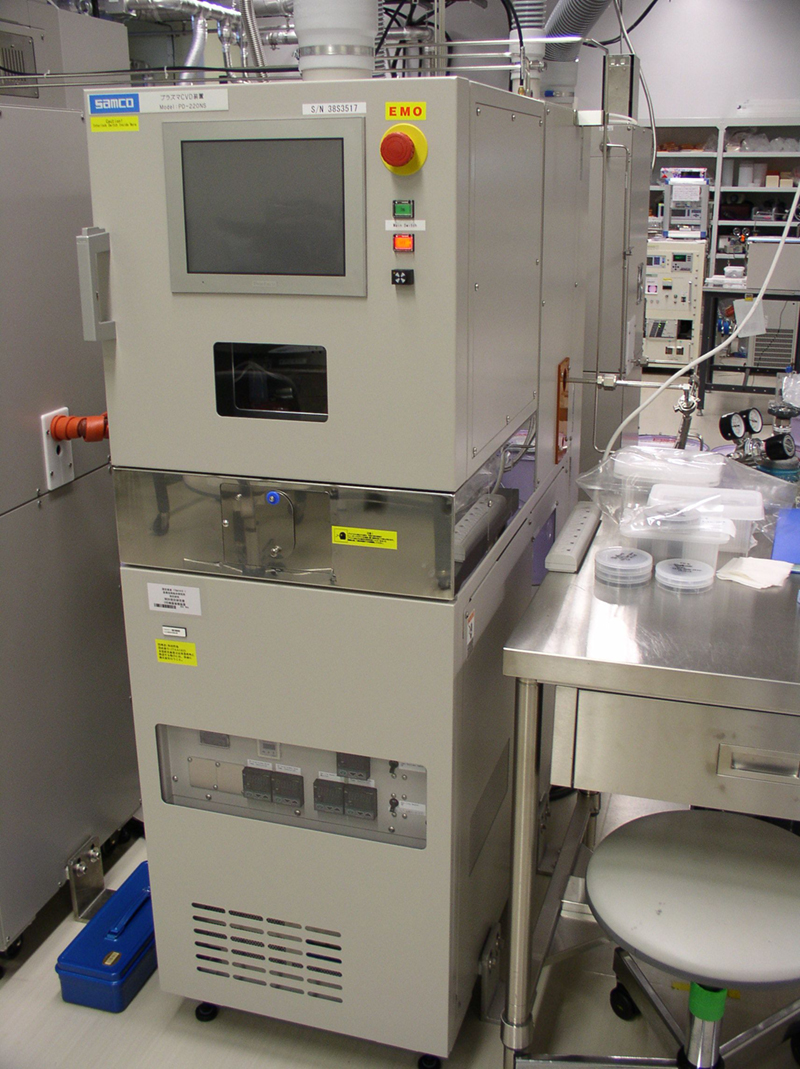
- メーカー名
- サムコ (Samco)
- 型番
- PD-220SN
- 仕様・特徴
- ・型式:PD-220NS
・試料サイズ:8インチ
・成膜種:SiO2, Si3N4
・電極間隔:25mm (上部電極:Al製、下部電極:SUS製)
・高周波電源:300W(13.5MHz)
・ステージ加熱:350℃(抵抗加熱方式 )
- 設備ID
- AT-095
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
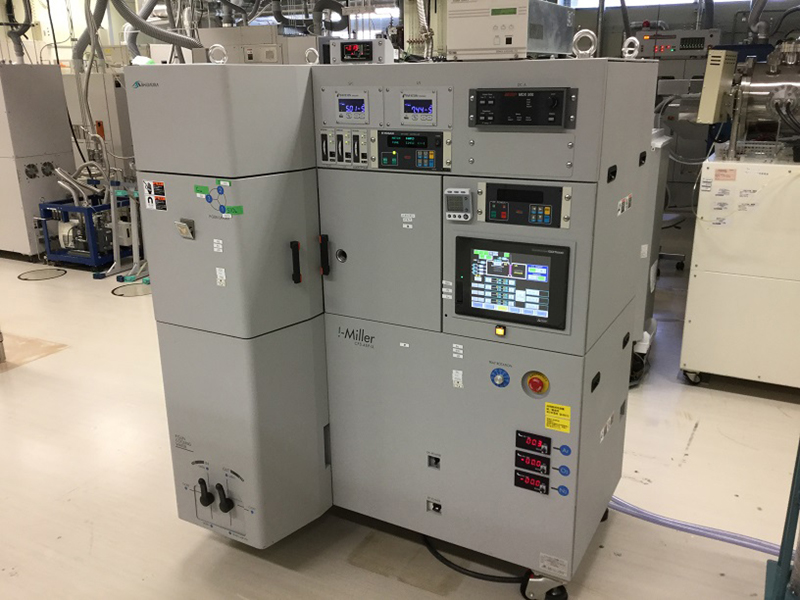
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチ
・スパッタ源:3インチマグネトロン×3式
・スパッタ方式:直流スパッタ、高周波スパッタ
・基板テーブル:回転機構付
・逆スパッタ:200W
・ターゲット-基板間距離:82 mm
・基板加熱:なし
・膜厚分布:±5%以内@膜厚~600nm(SiO2、170 mmφ)
・到達真空度:10-5 Pa台
・スパッタガス:Ar、O2、N2
・成膜時ガス圧(標準):0.5Pa
・常備ターゲット:Al, Al2O3, Au, Cr, Cu, Nb, Pt, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W
- 設備ID
- AT-098
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
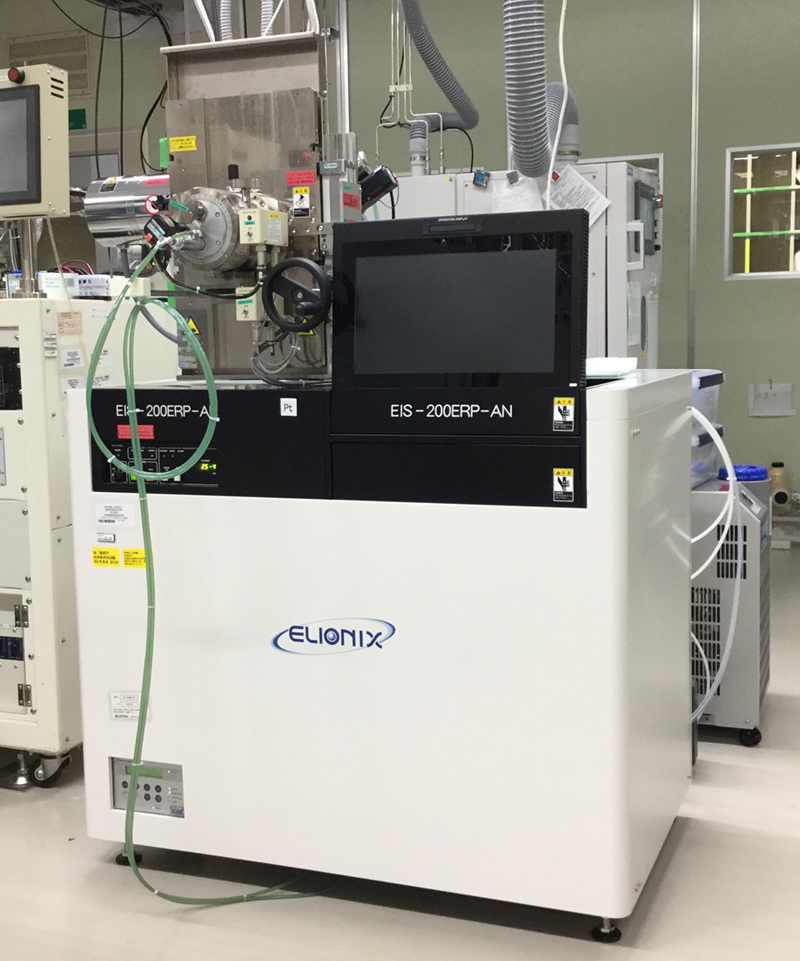
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-200ERP
- 仕様・特徴
- ・型式:EIS-200ERP
・試料サイズ:75 mmφ
・イオンソース:ECR方式
・ガス種:Ar (最大流量5sccm)
・圧力:0.01 Pa
・加速電圧:30~3000 V
・マイクロ波:最大100 W
・材料ターゲットサイズ:100 mmφ
- 設備ID
- AT-099
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
![サムコ原子層堆積装置_2[AD-100LP]](data/facility_item/AT-099.jpg)
- メーカー名
- サムコ (Samco)
- 型番
- AD-100LP
- 仕様・特徴
- ・型式: AD100-LP (サムコ株式会社)
・試料サイズ:4インチ(2インチは3枚まで搭載可能)
・ステージ温度:50 ~ 500℃
・放電方式: 誘導結合式ICPプラズマ(ダウンフロー型、リモート型)
・ICP高周波電源: 300W(13.56MHz)
・試料導入方式: ロードロック式
・キャリアガス:N2
・反応ガス:H2O, O2、ピュアオゾン, N2、NH3、H2、Ar
・材料ガス:TMA,BDEAS
"成膜装置"で検索した結果 160件
- 160件中 91~100件
- <
- 1
- ...
- 7
- 8
- 9
- 10
- 11
- 12
- 13
- 14
- ...
- 16
- >
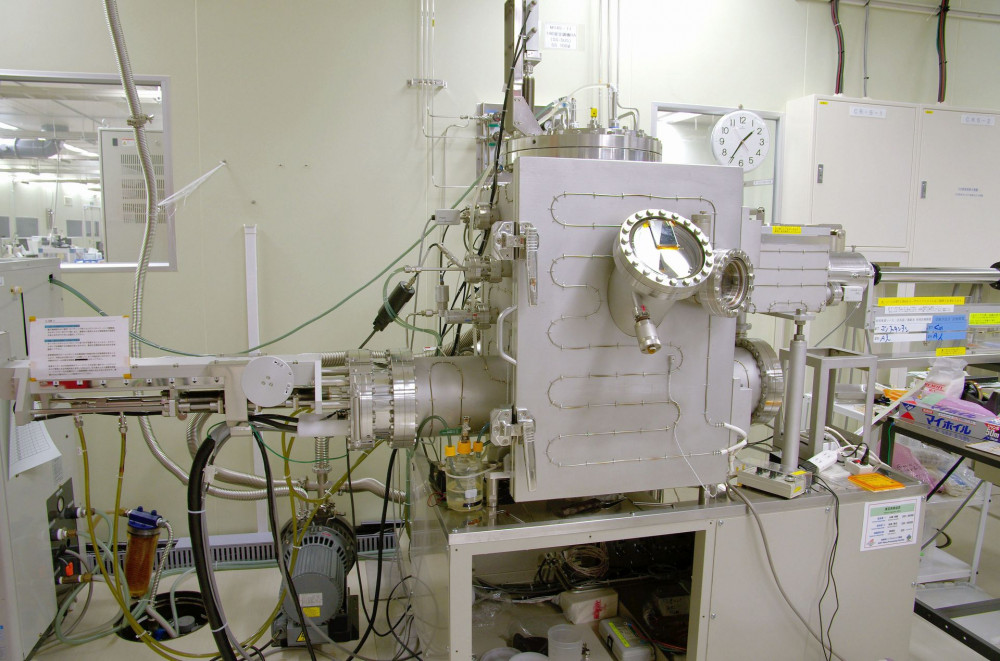

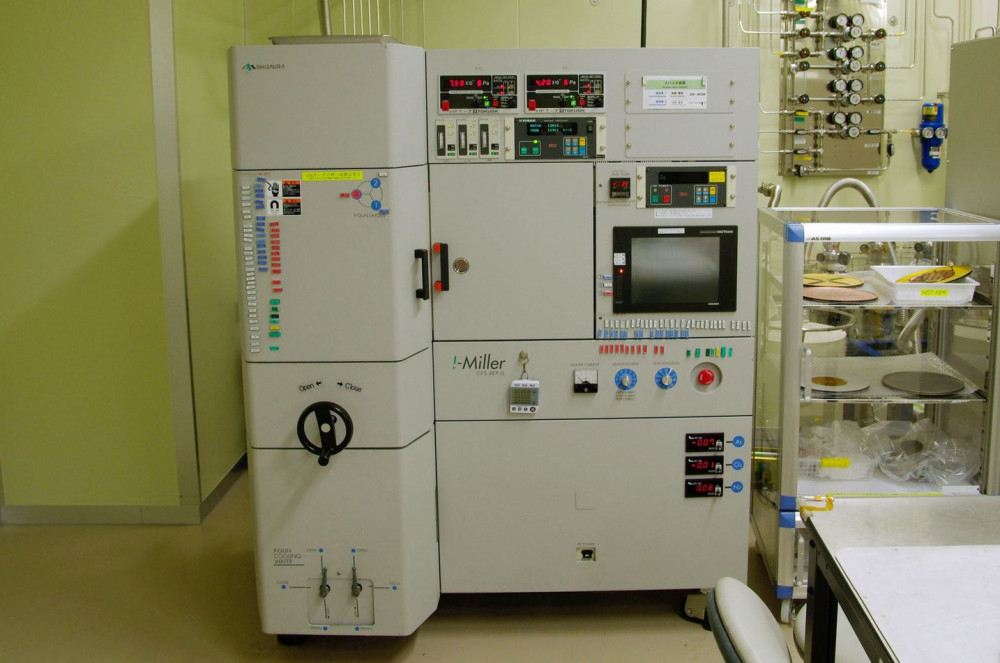


![原子層堆積装置_1[FlexAL]](data/facility_item/AT-031.jpg)
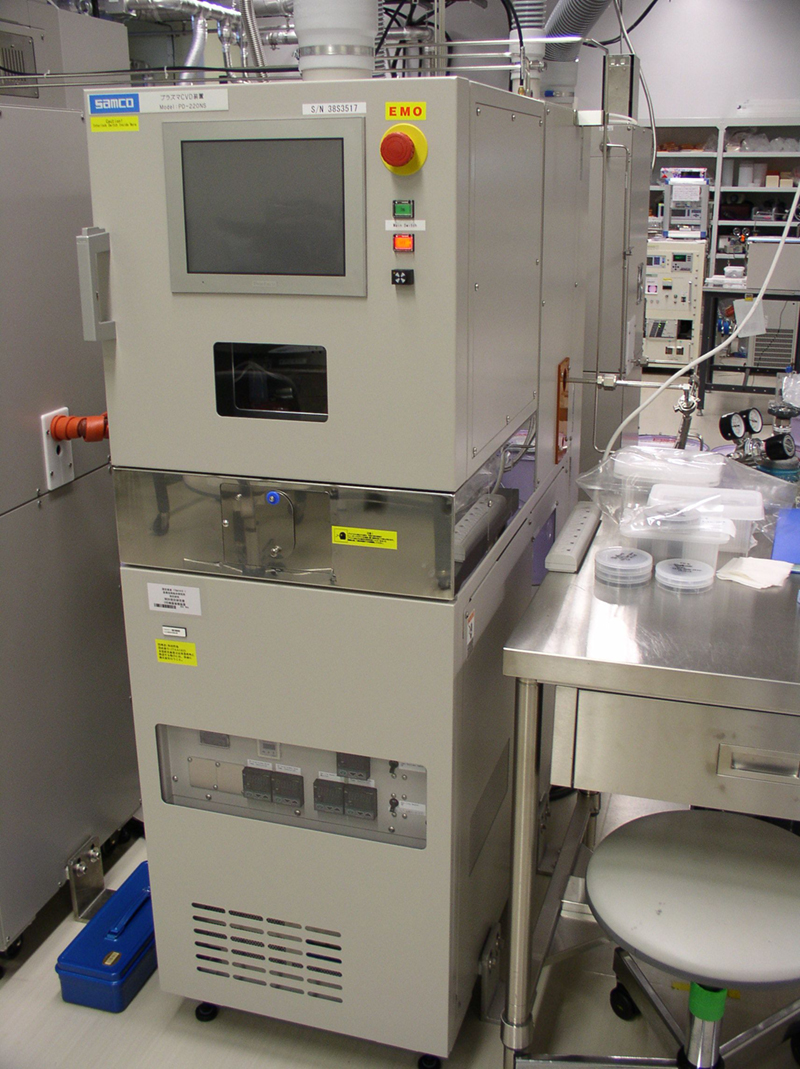
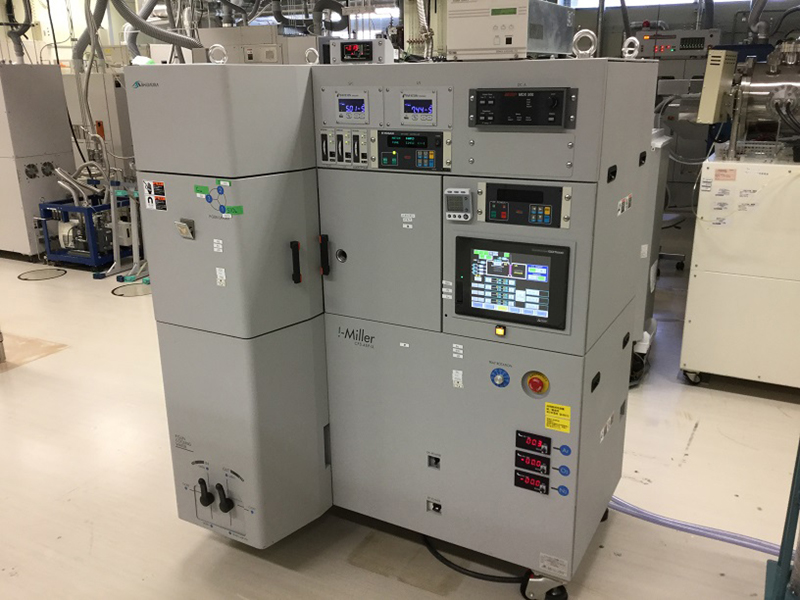
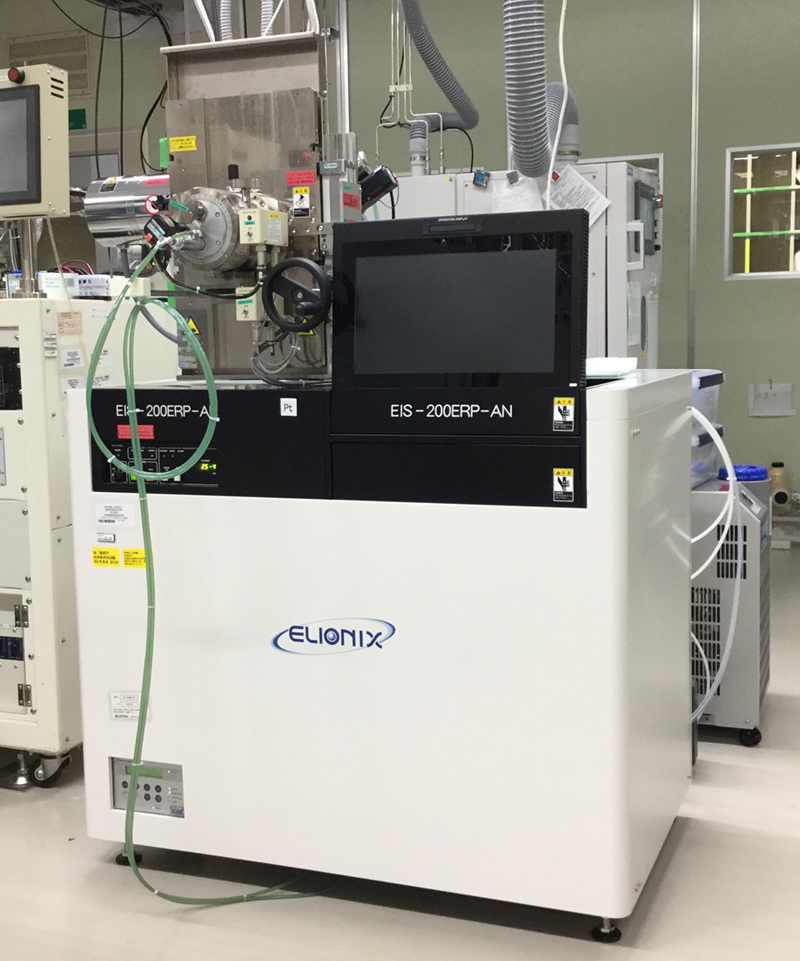
![サムコ原子層堆積装置_2[AD-100LP]](data/facility_item/AT-099.jpg)