共用設備検索
共用設備検索結果
"成膜装置"で検索した結果 160件
- 160件中 1~10件
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 16
- >
- 設備ID
- NU-262
- 設置機関
- 名古屋大学
- 設備画像
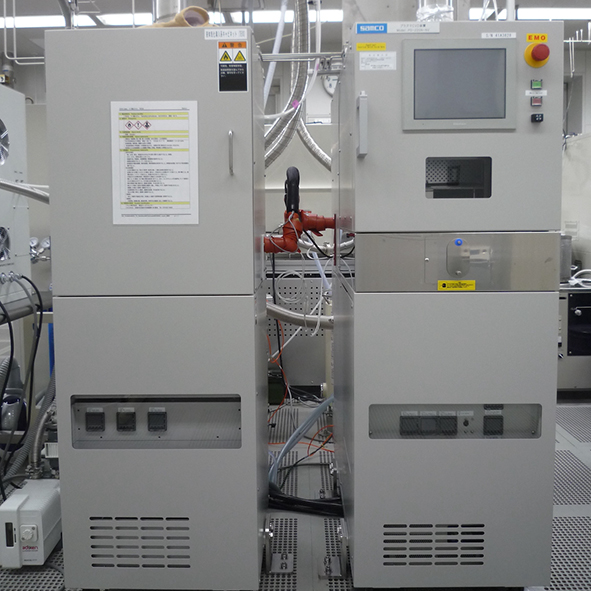
- メーカー名
- サムコ (Samco)
- 型番
- PD-220N
- 仕様・特徴
- ・基板加熱:抵抗加熱式 (常用300℃)
・適正ウェハ寸法:最大8インチ径
・供給ガス:TEOS
- 設備ID
- UT-716
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL !-Miller (2024)
- 仕様・特徴
- 真空引きが速く、通常10分程度でスパッタリング開始が可能。また、膜質の安定も期待できる。ターゲットはCFS-4ESと共通。 デフォルトはPt/Au/Cr/Tiを装着。それ以外のターゲットは支援員の技術補助で交換を行う。UT-711と互換。
サイドスパッタ方式、スパッタターゲット:3inchx3、ホルダーサイズ:Φ220mm、到達圧力:5x10E-4 Pa以下、RF50W(DC)、加熱温度:最大300℃
- 設備ID
- UT-715
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- BB7873
- 仕様・特徴
- ウエーハサイズ2インチもしくはそれ以下のチップサンプルに対応可能。一般的なEB蒸着装置です。ロードロックを備えており、試料交換時間が短い。到達真空度は10E-5 Pa台。膜厚計、試料加熱ランプあり。
- 設備ID
- TT-034
- 設置機関
- 豊田工業大学
- 設備画像
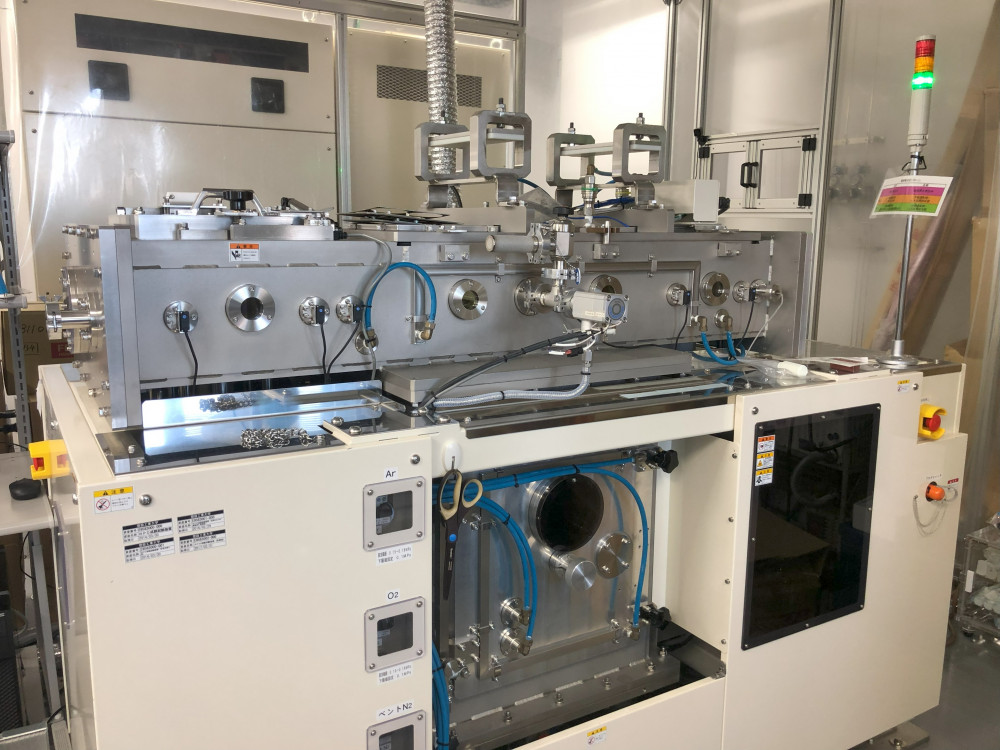
- メーカー名
- 住友重機械工業 (Sumitomo Heavy Industries, Ltd.)
- 型番
- RPD-PCS4/LC
- 仕様・特徴
- ITO透明導電膜成膜
基板サイズ 156×156mm
基板温度 max200℃
- 設備ID
- NM-665
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![電子銃型蒸着装置 [ADS-E810]](data/facility_item/1711340460_11.jpg)
- メーカー名
- アールデック (R-DEC)
- 型番
- ADS-E810
- 仕様・特徴
- ・蒸着方式:電子銃型
・ターゲット:Al, Ti, Ni, AuGe, Pt, Au, Pd, Ag, Cr, 他
・到達真空度:10-5 Pa
・TS間距離:500 mm
・最大試料サイズ:φ8inch
・その他:ロードロック式、水冷式試料ステージ
- 設備ID
- NM-664
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [CFS-4EP-LL #4]](data/facility_item/1711340420_11.jpg)
- メーカー名
- 芝浦メカトロニクス株式会社 (SHIBAURA MECHATRONICS CORPORATION)
- 型番
- CFS-4EP-LL
- 仕様・特徴
- ・電源:DC×2、RF×1
・電源出力:500W(最大)
・カソード:φ3インチ×4式
・基板サイズ:最大8inchφ
・プロセスガス:Ar、O2、N2
・基板加熱:設定300℃
・逆スパッタ可
- 設備ID
- WS-030
- 設置機関
- 早稲田大学
- 設備画像
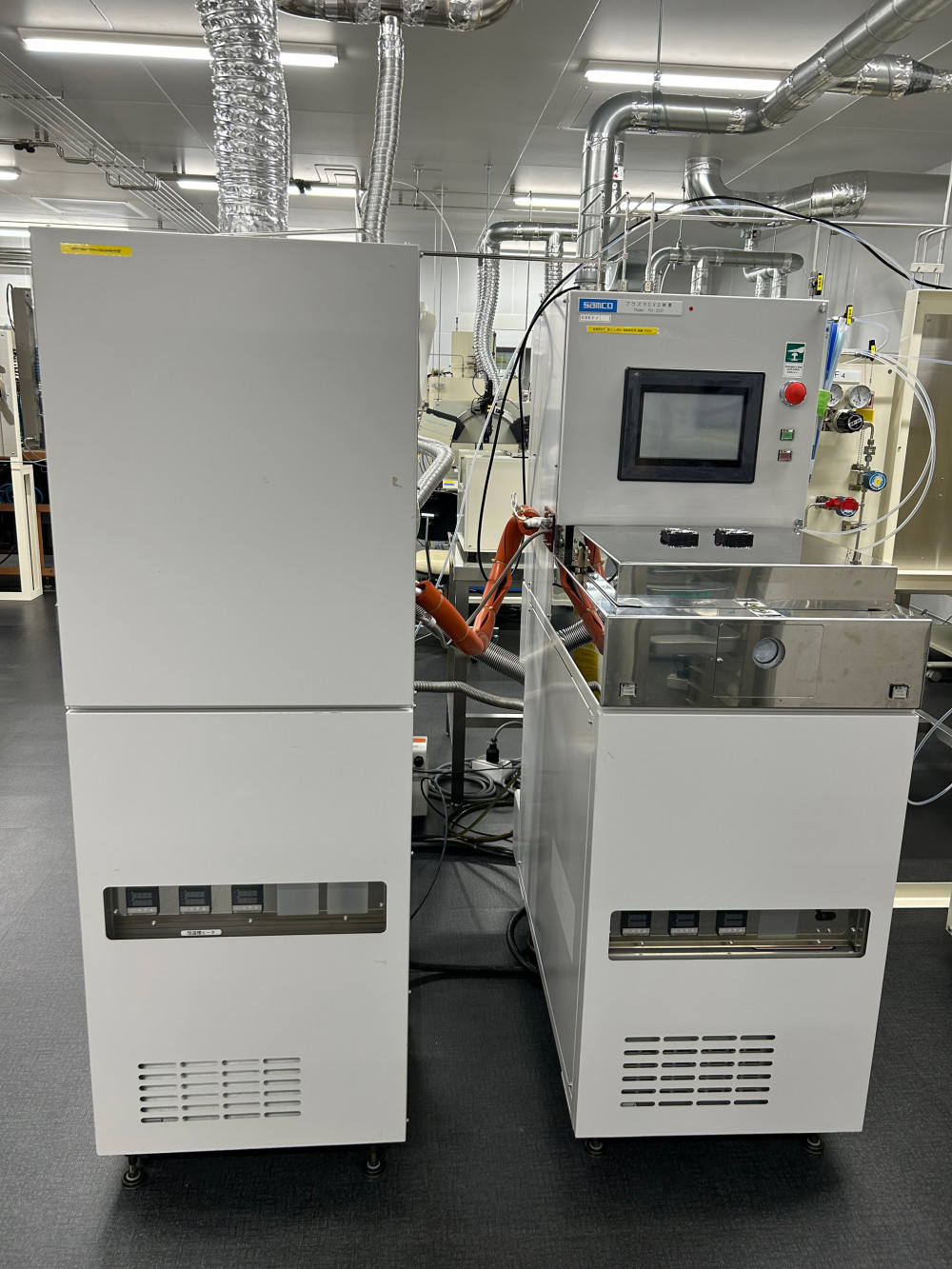
- メーカー名
- サムコ株式会社 (Samco Inc.)
- 型番
- PD-220
- 仕様・特徴
- プラズマCVDの原理による成膜
高いカバレッジ成形
基板サイズ6インチ以下
面内分布 5%以内(仕様)
標準条件での基板温度300℃
- 設備ID
- NM-633
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![SiO2プラズマCVD装置 [PD-220NL]](data/facility_item/1673319140_10.jpg)
- メーカー名
- サムコ (samco)
- 型番
- PD-220NL
- 仕様・特徴
- ・プラズマ方式:平行平板型
・電源出力:30-300W
・原料:TEOS (SiO2)
・成膜温度:400度以下
・最大試料サイズ:φ8inch
- 設備ID
- NM-607
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [CFS-4EP-LL #3]](data/facility_item/NM-607.jpg)
- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL (i-Miller)
- 仕様・特徴
- ・用途:金属・絶縁薄膜形成
・スパッタ方式:DC/RFマグネトロンスパッタ,反応性/2元同時/逆スパッタ/バイアススパッタ可能
・電源出力:Max 500W
・カソード:φ3インチ×4式
・プロセスガス:Ar,O2,N2
・最大試料サイズ:φ8inch(水冷ステージ)
・現有ターゲット:Ti, Au, Al, Si, Cu, W, Ta, Ag, Ni, Cr, ITO, ZnO, SiO2(2020年4月時点)
- 設備ID
- NM-608
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [JSP-8000]](data/facility_item/NM-608.jpg)
- メーカー名
- アルバック (ULVAC)
- 型番
- j-Sputter
- 仕様・特徴
- ・用途:金属・絶縁薄膜形成
・スパッタ方式:DC/RFマグネトロンスパッタ,反応性/3元同時/逆スパッタ可能
・電源出力:Max 500W
・カソード:φ4インチ×4式
・プロセスガス:Ar,O2,N2
・最大試料サイズ:φ6inch
・その他:試料ステージ水冷/加熱可 (最大300度)
・現有ターゲット:Al, Ag, Au, Al2O3, Cr, Cu, ITO, Mo, Ni, Pt, Si, Si3N4, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W, Zn, ZnO
"成膜装置"で検索した結果 160件
- 160件中 1~10件
- 1
- 2
- 3
- 4
- 5
- 6
- 7
- 8
- ...
- 16
- >
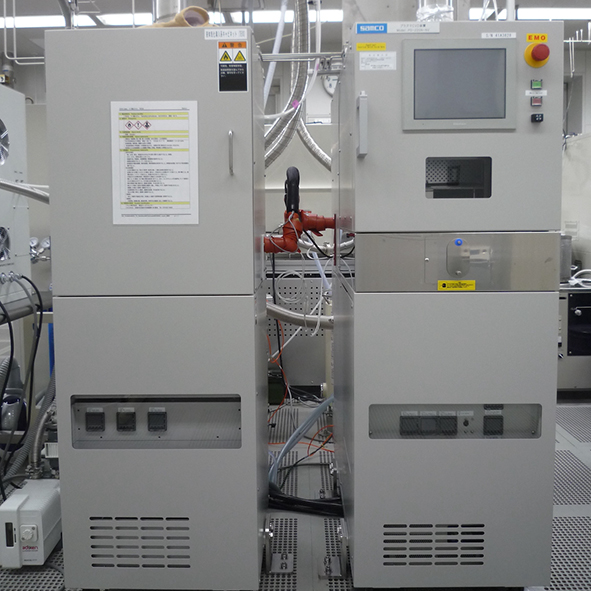


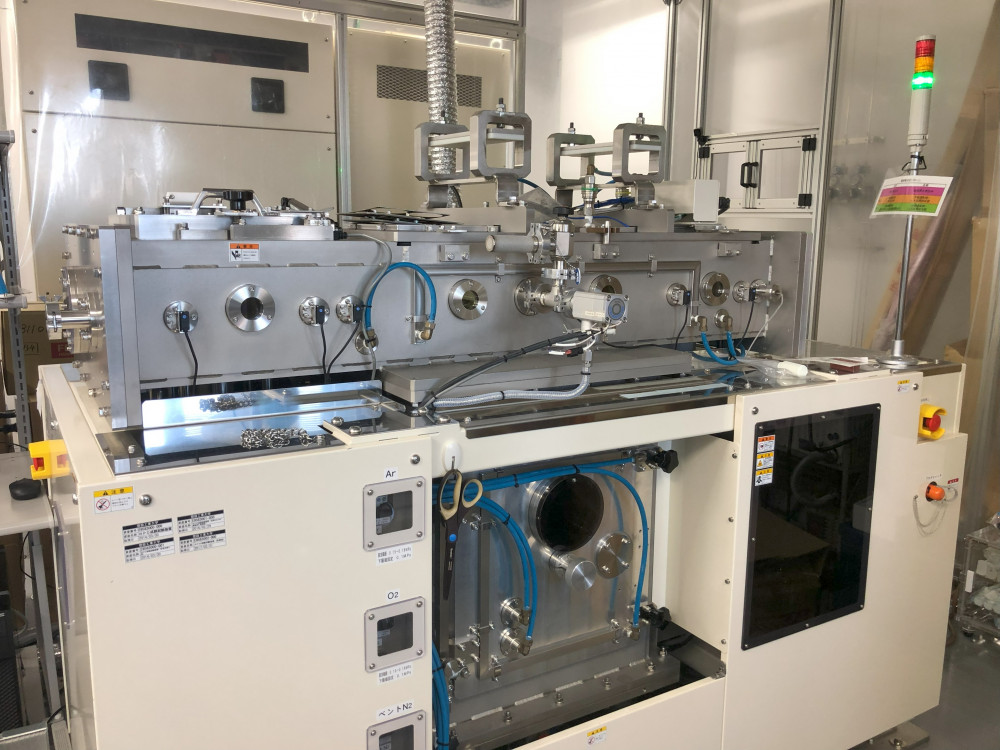
![電子銃型蒸着装置 [ADS-E810]](data/facility_item/1711340460_11.jpg)
![スパッタ装置 [CFS-4EP-LL #4]](data/facility_item/1711340420_11.jpg)
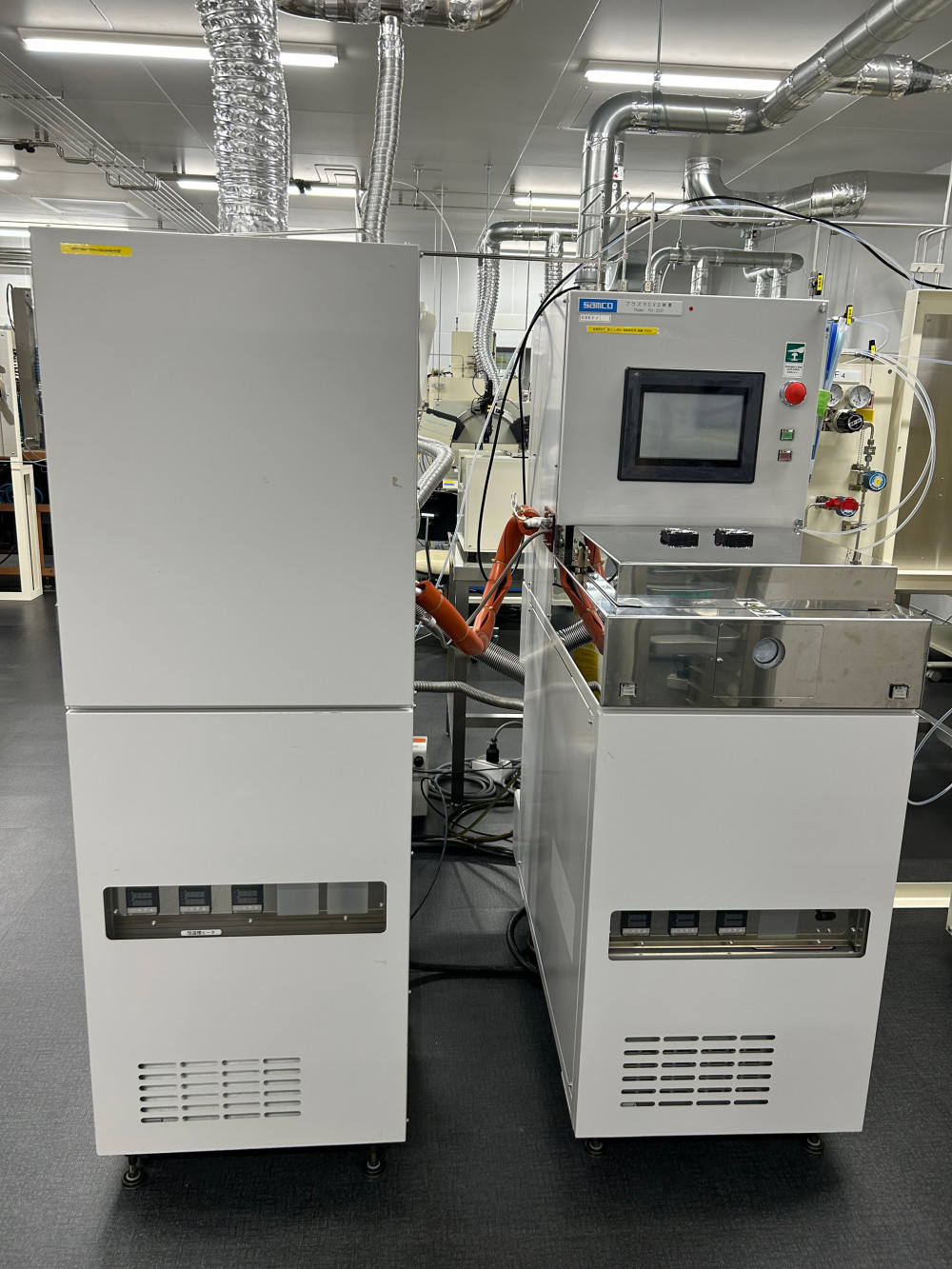
![SiO2プラズマCVD装置 [PD-220NL]](data/facility_item/1673319140_10.jpg)
![スパッタ装置 [CFS-4EP-LL #3]](data/facility_item/NM-607.jpg)
![スパッタ装置 [JSP-8000]](data/facility_item/NM-608.jpg)