共用設備検索結果
"その他"で検索した結果 7件
フリーワード検索
中分類から探す
反応性プラズマ蒸着(RPD)装置 (Reactive plasma deposition: RPD)
- 設備ID
- TT-034
- 設置機関
- 豊田工業大学
- 設備画像
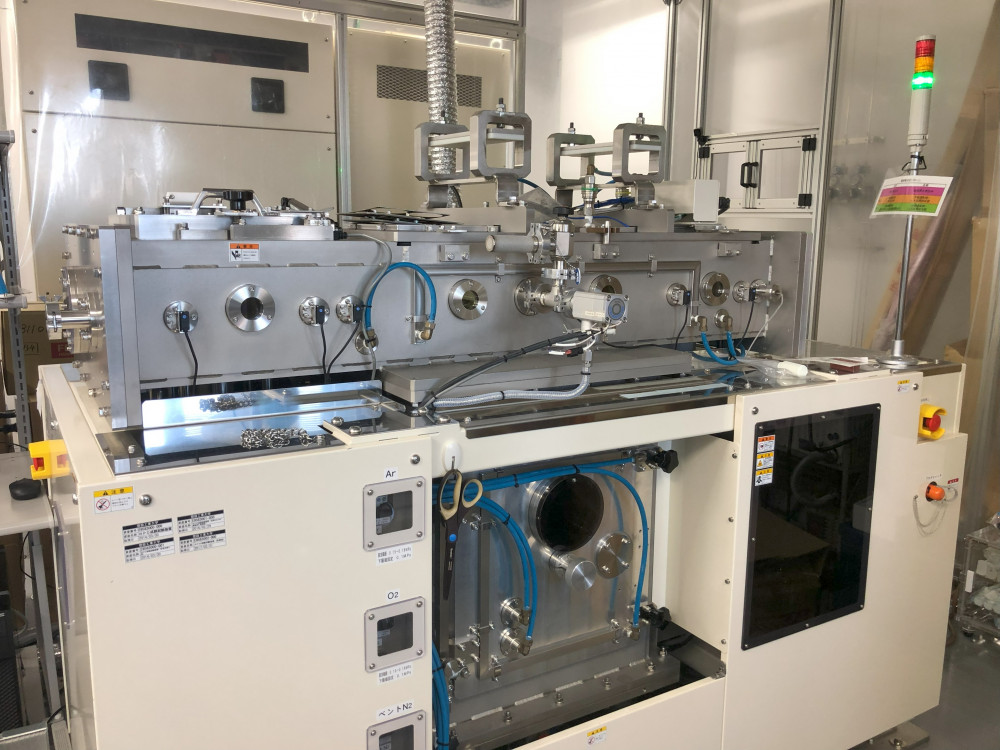
- メーカー名
- 住友重機械工業 (Sumitomo Heavy Industries, Ltd.)
- 型番
- RPD-PCS4/LC
- 仕様・特徴
- ITO透明導電膜成膜
基板サイズ 156×156mm
基板温度 max200℃
薄膜応力測定装置 [FLX-2000-A] (Thin-Film Stress Tester [FLX-2000-A])
- 設備ID
- NM-628
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![薄膜応力測定装置 [FLX-2000-A]](data/facility_item/NM-628.jpg)
- メーカー名
- 東朋テクノロジー (Toho Technology)
- 型番
- FLX-2000-A
- 仕様・特徴
- ・用途:薄膜応力測定
・測定方式:レーザースキャン方式(670nm&750nm半導体レーザー)
・測定範囲:1~4000MPa
・測定再現性:1.3MPa(1σ)
・試料サイズ:φ3inch, φ6inch, φ8inch
・その他:3Dマッピング機能
パリレン成膜装置 (Parylene Coater)
- 設備ID
- KT-251
- 設置機関
- 京都大学
- 設備画像

- メーカー名
- 日本パリレン合同会社 (Specialty Coating Systems Inc.)
- 型番
- LABCOTER PDS-2010
- 仕様・特徴
- 全面に均一な極薄コーティングが可能であり、微細な隙間中なども均一にカバーする。
・蒸着室有効内容積:215mm(径)×270mm(高さ)
パルスレーザー堆積装置 (Pulse Laser Deposition system)
- 設備ID
- HK-615
- 設置機関
- 北海道大学
- 設備画像
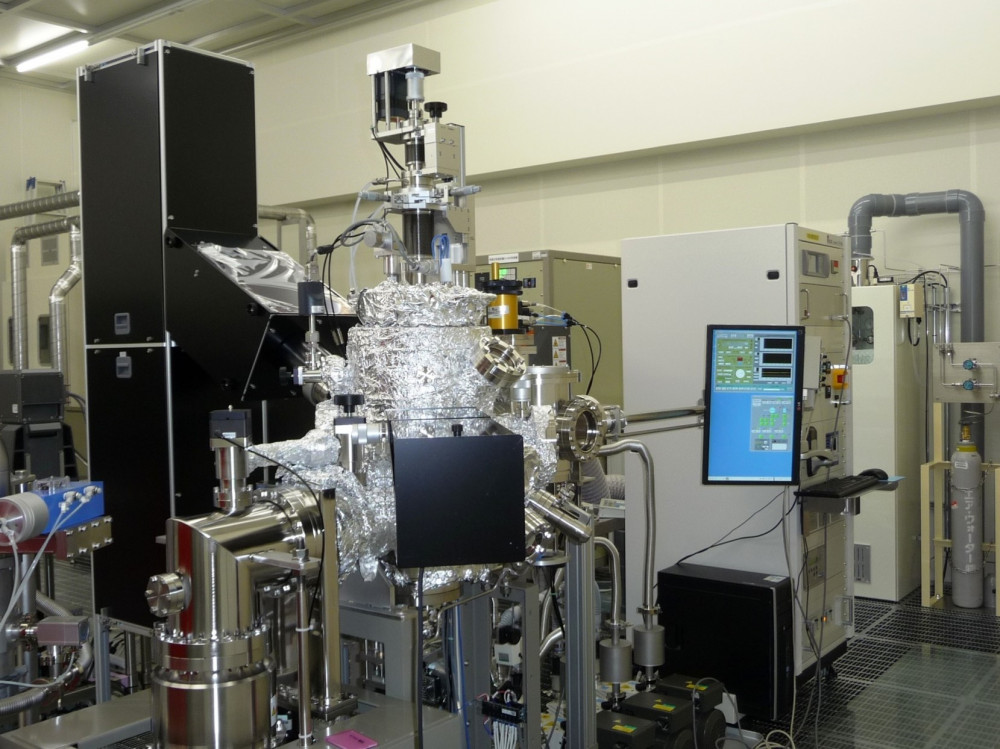
- メーカー名
- パスカル (Pascal)
- 型番
- PAC-LMBE
- 仕様・特徴
- レーザー光源:248nm
基板サイズ:
成膜材料:TiO2、STOなど
液晶配向膜ラビング装置 (Rubbing device for liquid crystal alignment films)
- 設備ID
- CT-018
- 設置機関
- 公立千歳科学技術大学
- 設備画像

- メーカー名
- 日本文化精工 (Nippon Bunkaseiko)
- 型番
- 仕様・特徴
- ・真空吸着テーブルサイズ(50 x 50 mm)
・ラビングローラー回転速度可変<1,000 rpm
・テーブル移動速度調節可
・真空吸着テーブルθ調整機構付き
プラズマ・ガス凝縮クラスター堆積装置 (Plasma-Gas-Condensation Cluster Deposition Apparatus)
- 設備ID
- NI-101
- 設置機関
- 名古屋工業大学
- 設備画像

- メーカー名
- 日本ビーテック (Vieetech Japan)
- 型番
- 特型
- 仕様・特徴
- クラスターサイズ 直径3~15nm
直流マグネトロンスパッタリング方式
スパッタ電力 最大500W
基板サイズ 最大2cmX2cm
磁性薄膜作成評価 (Magnetic thin film creation evaluation)
- 設備ID
- MS-303
- 設置機関
- 自然科学研究機構 分子科学研究所
- 設備画像

- メーカー名
- ()
- 型番
- 仕様・特徴
- 超高真空下での磁性薄膜作成・磁気光学Kerr効果によるその場観察評価。
"その他"で検索した結果 7件