共用設備検索結果
中分類から探す
パリレンコーティング装置 (Parylene coating system)
- 設備ID
- NU-248
- 設置機関
- 名古屋大学
- 設備画像

- メーカー名
- KISCO (KISCO)
- 型番
- DACS-LAB
- 仕様・特徴
- ・蒸着チャンバー寸法:ID300×H350 mm
・回転:0.5~10rpm
電子線蒸着装置 (Electron Beam Evaporator)
- 設備ID
- KT-203
- 設置機関
- 京都大学
- 設備画像
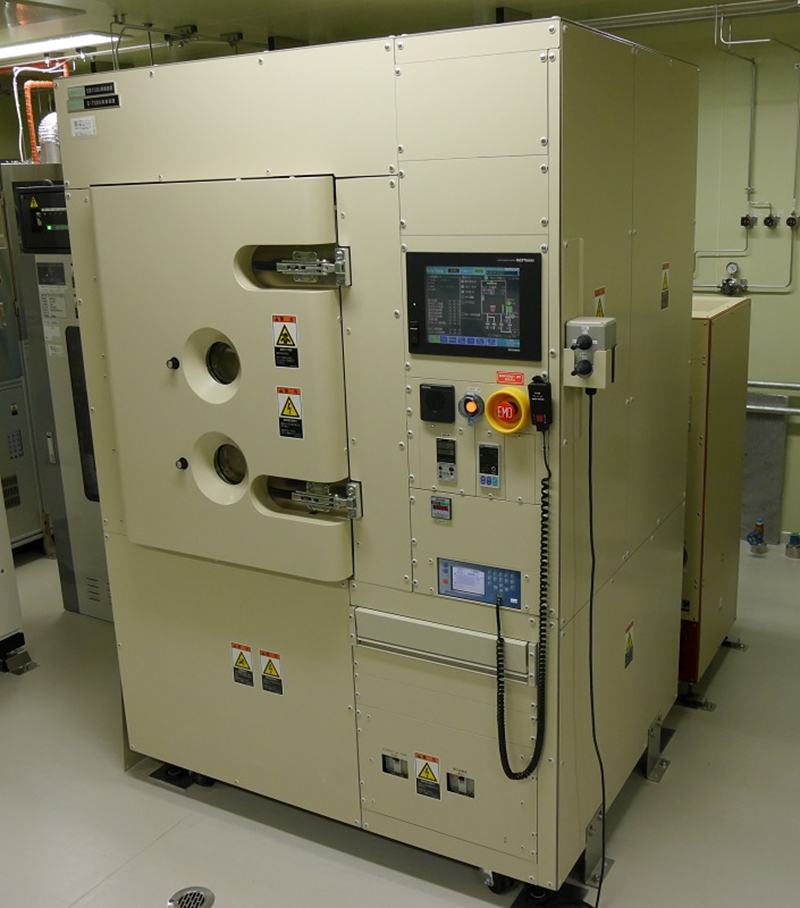
- メーカー名
- キャノンアネルバ(株) (CANON ANELVA CORPORATION)
- 型番
- EB-1200
- 仕様・特徴
- リフトオフ対応の電子線蒸着装置
・基板サイズ:MAX Φ6×3枚
・電子銃:10kW 4連E型電子銃(22ml x 4)
・温度:RT~300℃(ハロゲンランプ)
・蒸着源-基板間距離:300mm(リフトオフ対応)
・蒸着材料:Al、Ti、Cr、Ni、Au、Pt、Ag、Pd ほか
真空蒸着装置(1) (Thermal Evaporator No.1)
- 設備ID
- KT-232
- 設置機関
- 京都大学
- 設備画像
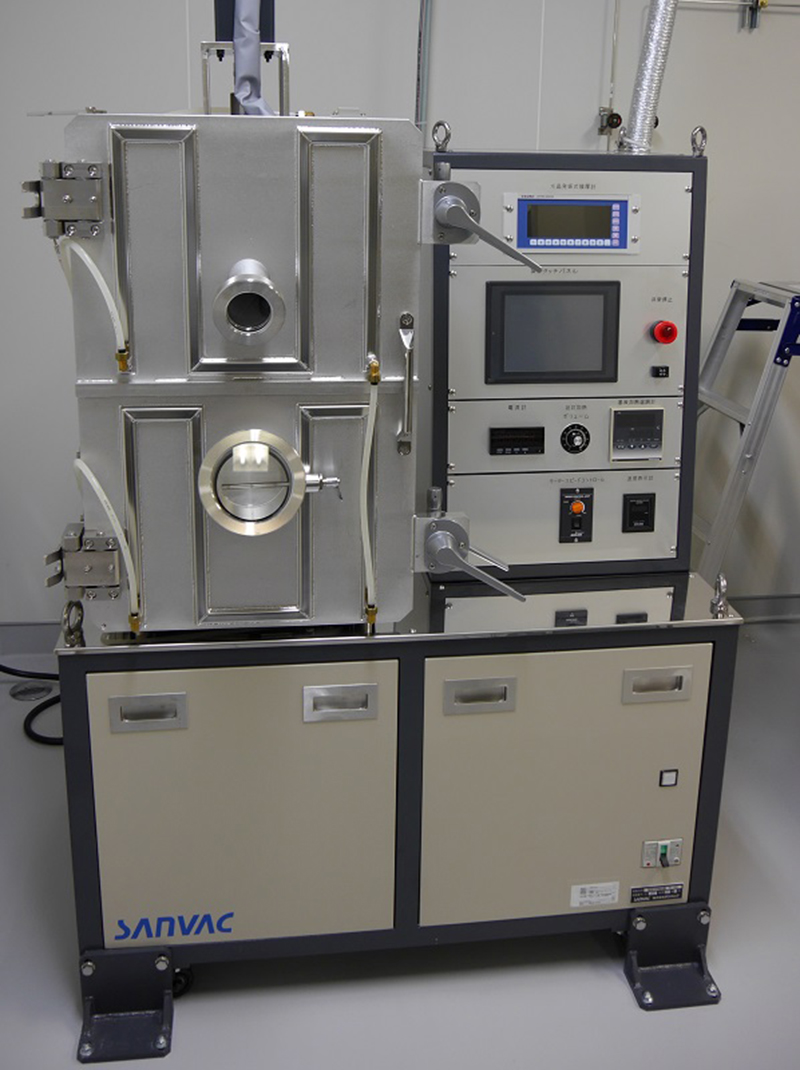
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃
真空蒸着装置(2) (Thermal Evaporator No.2)
- 設備ID
- KT-233
- 設置機関
- 京都大学
- 設備画像
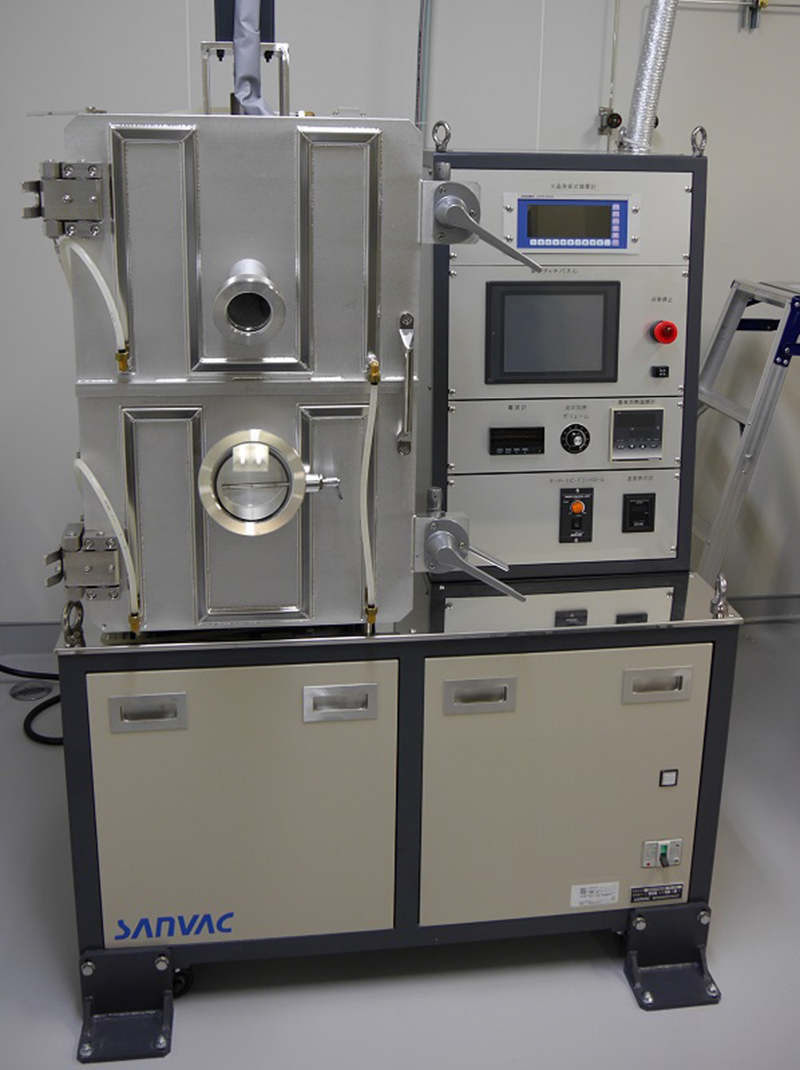
- メーカー名
- (株)サンバック (SANVAC CO., LTD.)
- 型番
- RD-1400
- 仕様・特徴
- 真空中で抵抗加熱蒸発源により物質を蒸発させ、電極・マスク材等の金属膜を作製することができます。
・抵抗加熱方式 電極数量 3式(切り替え方式)
・基板 Φ4インチおよびΦ6インチウェハ
・基板加熱温度 最高350℃
コーティング装置群 (Coating machine for nonconductive specimens)
- 設備ID
- KU-015
- 設置機関
- 九州大学
- 設備画像

- メーカー名
- 日本電子 (JEOL)
- 型番
- JEOL JFC-1600、JEOL EC-32010CC
- 仕様・特徴
- 電子顕微鏡試料の調製
EB蒸着装置 (EB vacuume evaporation system)
- 設備ID
- HK-607
- 設置機関
- 北海道大学
- 設備画像
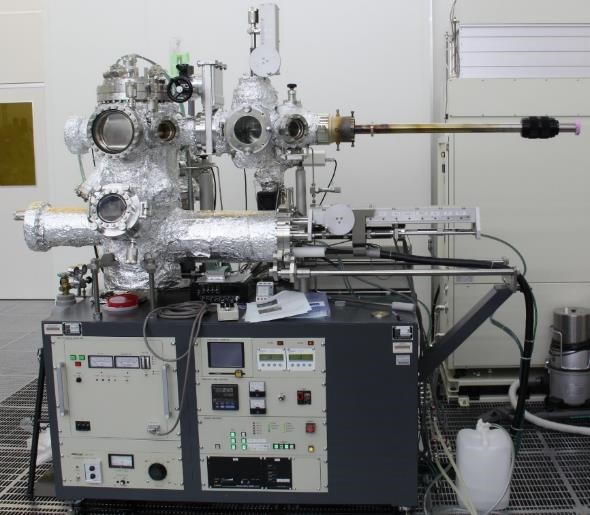
- メーカー名
- エイコー (Eiko)
- 型番
- EB-580S
- 仕様・特徴
- 蒸着源:Au,Ti,Al,Cu,Nb
基板加熱可(600℃程度まで)
水晶振動式膜厚計
真空蒸着装置 (Vacuume evaporation system)
- 設備ID
- HK-608
- 設置機関
- 北海道大学
- 設備画像
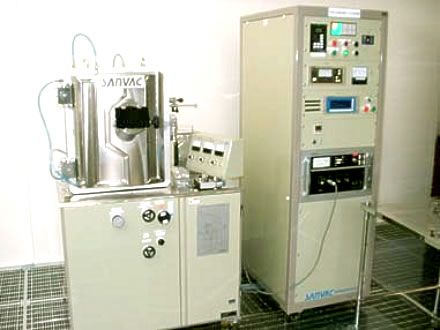
- メーカー名
- サンバック (SANVAC)
- 型番
- ED-1500R
- 仕様・特徴
- 蒸着源:抵抗加熱3元、EB3元
基板加熱可
水晶振動式膜厚計
EB加熱・抵抗加熱蒸着装置 (EB gun/resistant heating-type vacuume evaporation system)
- 設備ID
- HK-703
- 設置機関
- 北海道大学
- 設備画像
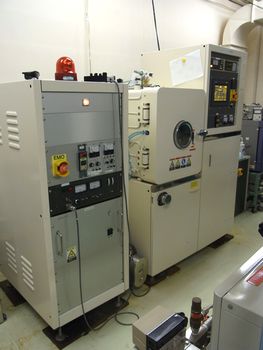
- メーカー名
- アルバック (Ujlvac)
- 型番
- EBX-8C
- 仕様・特徴
- 電子線、抵抗加熱方式
蒸着源:EB4元・抵抗加熱1元
蒸着材料:Si、Al、Fe、 Mo、Au
電子線蒸着装置 (Electron Beam Evaporator)
- 設備ID
- BA-004
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- エイコー (eiko)
- 型番
- EB-350T
- 仕様・特徴
- 到達圧力:1.0×10-6 Pa以下
蒸発源:5 kW 5連EBガン
ルツボ容量:5 cc
基板ホルダー:φ3インチ
電子ビーム真空蒸着装置 (Electeron Beam Vacuum Evaporator)
- 設備ID
- AT-023
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
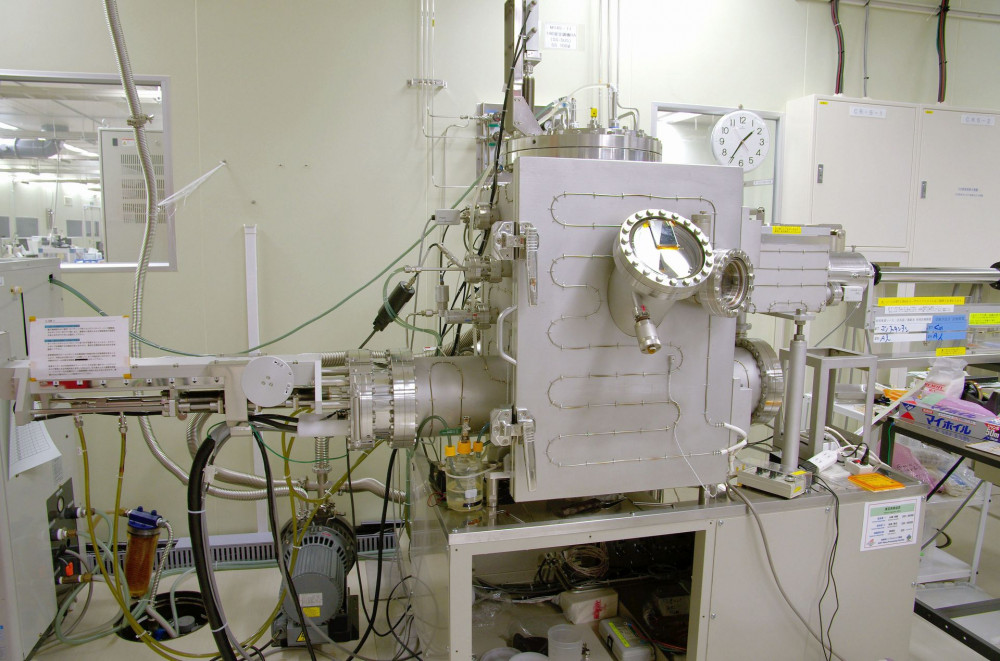
- メーカー名
- エイコーエンジニアリング (EIKO ENGINEERING)
- 型番
- 仕様・特徴
- ・試料サイズ:100 mm×100 mm×20 mm
・蒸着方式:電子ビーム加熱蒸発、180°配向型
・蒸発源:8連装(6 kW電子銃)
・クルーシブル容量:10 ml
・基板ホルダ:傾斜ホルダ、冷却機構付(マイナス10℃)
・蒸発源―基板間:300 mm
・試料導入:ロードロック自動搬送
・真空排気システム:到達圧力3×10-6 Pa以下、オイルフリー、自動排気
・成膜:水晶振動子膜厚モニタによる自動制御
・膜厚分布:10 %以内@Φ75mm
・ソース材料: Al, Al2O3, Ag, Au, Cr, Cu, Mo, Pt, Ru, SiO2, Ta, Ti, TiN, TiO2, W