共用設備検索結果
中分類から探す
スパッタリング蒸着装置 (Sputtering Deposition Apparatus)
- 設備ID
- NI-102
- 設置機関
- 名古屋工業大学
- 設備画像
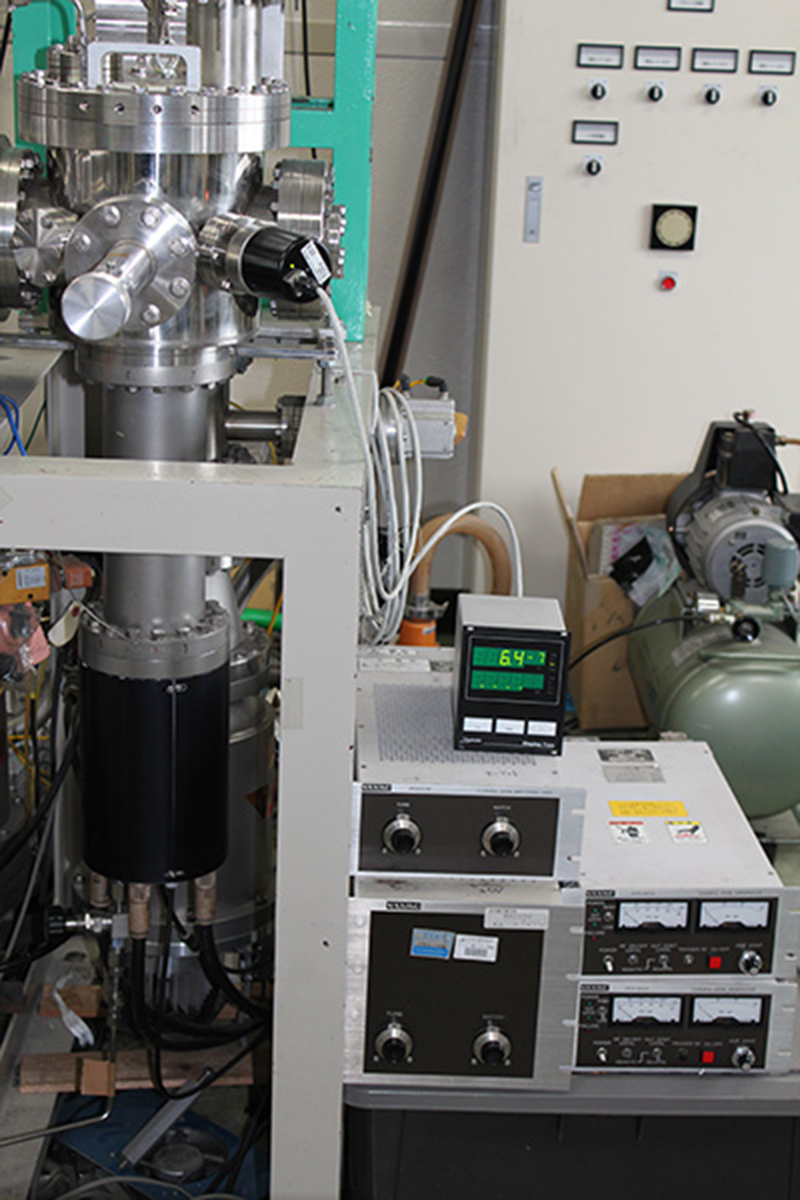
- メーカー名
- アルバック (ULVAC, Inc.)
- 型番
- SPC-2000HC
- 仕様・特徴
- ヘリコン波励起スパッタリング
RF電源13.56MHz 200W
中規模カーボンナノファイバー室温合成装置 (Room-Temperature Carbon Nanofiber Growth System (for Medium Sized Samples))
- 設備ID
- NI-104
- 設置機関
- 名古屋工業大学
- 設備画像

- メーカー名
- 自作 (Home-made)
- 型番
- 自作
- 仕様・特徴
- カーボンナノファイバー(CNF)室温合成速度:10 nm/min程度以上。
試料サイズ:1インチ角程度以下。
特型表面ナノ構造形成装置 (Nanostructure Fabrication System)
- 設備ID
- NI-105
- 設置機関
- 名古屋工業大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- 特型
- 仕様・特徴
- 基板サイズ:2インチφ程度以下。超斜め入射イオンビームによるマスクレスの表面ナノ構造・ナノドット形成可能、組成制御可能、高分子材料の加工可能。
スパッタ(金属、絶縁体)蒸着装置 (Sputtering vapor depositing equipment)
- 設備ID
- TT-001
- 設置機関
- 豊田工業大学
- 設備画像
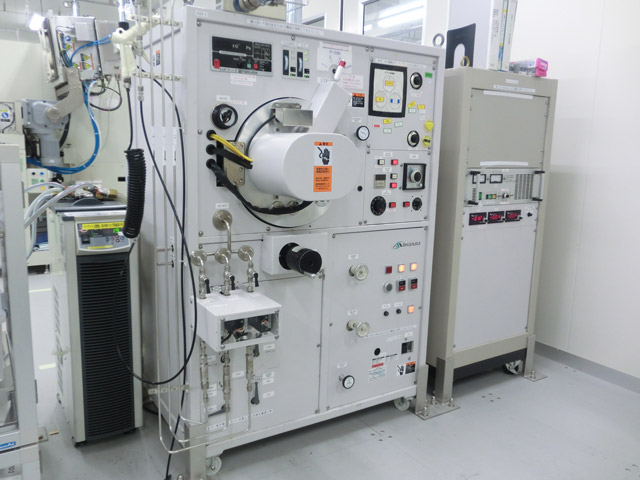
- メーカー名
- 芝浦エレテック (Shibaura eletec Corporatoin)
- 型番
- CFS-4ES
- 仕様・特徴
- ・平行平板型
・ターゲット現有(Ti, Al, Ag, Pd, SiO2, Al2O3, SiN, Au)
多機能薄膜作製装置 (Sputtering vapor depositing / Molecular vapor epitaxy equipment)
- 設備ID
- TT-002
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- アルバック (ULVAC)
- 型番
- BC2925(特注装置)
- 仕様・特徴
- 超高真空仕様
RF2元、DC2元
ターゲット2インチΦと、分子線エピタキシーMBE3元(EBガン)の複合利用可能
多層膜作成可能、主に磁性材料用
多元DC/RFスパッタ装置 (Multi-target DC/RF sputtering system)
- 設備ID
- OS-113
- 設置機関
- 大阪大学
- 設備画像
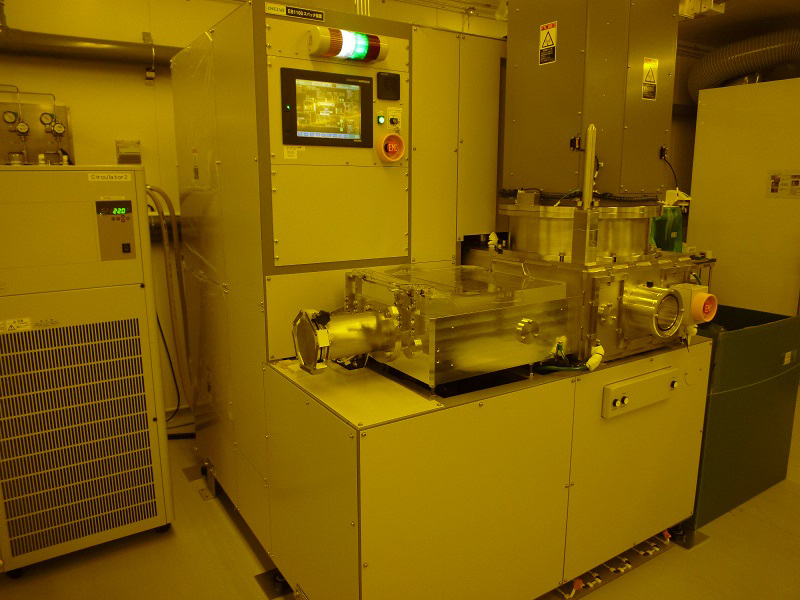
- メーカー名
- キャノンアネルバ (CANON ANELVA)
- 型番
- EB1100
- 仕様・特徴
- 【特徴】
スパッタチャンバー室、ロードロック室を備えた2室構造の平行平板型スパッタ装置。10nm以下の成膜が可能。真空を破らずに基板-ターゲット間距離を100~300mmの範囲で変更でき、搬送から成膜まで自動制御できるシステムを備える。
【仕様】
Au, Pt, Cr成膜用
ターゲット基板間距離100~300mm可変
全自動(排気、搬送、成膜)
最大200mm基板対応可能
RFスパッタ成膜装置(金属成膜用) (RF sputtering system (metal))
- 設備ID
- OS-114
- 設置機関
- 大阪大学
- 設備画像
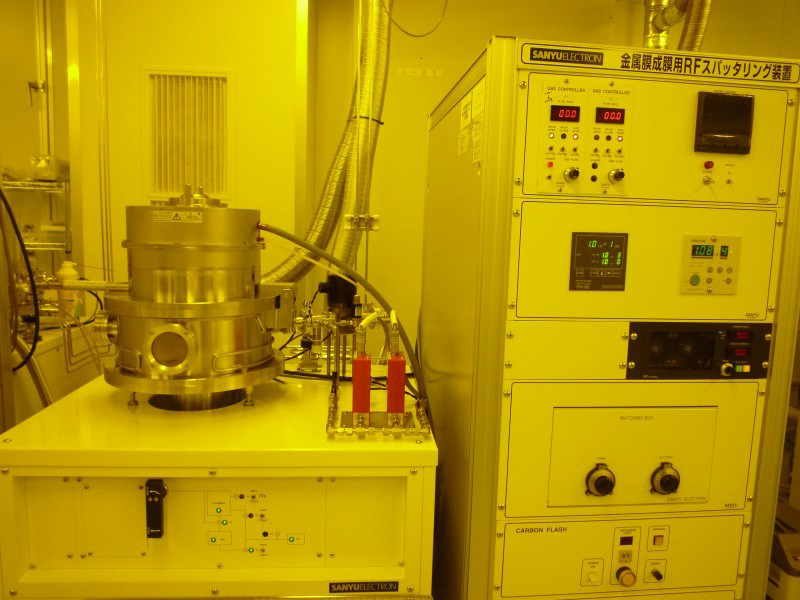
- メーカー名
- サンユー電子 (Sanyu Electron)
- 型番
- SVC-700LRF
- 仕様・特徴
- 【特徴】
Ti, Cr, W, Au, Pt等の金属のスパッタリングによる成膜が可能。TS間距離が400mmあるので、サンプル表面を均一にスパッタ加工したいユーザーに最適。
【仕様】
試料サイズ:max 4 inch
RFスパッタ成膜装置(絶縁体成膜用) (RF sputtering system (oxide))
- 設備ID
- OS-115
- 設置機関
- 大阪大学
- 設備画像
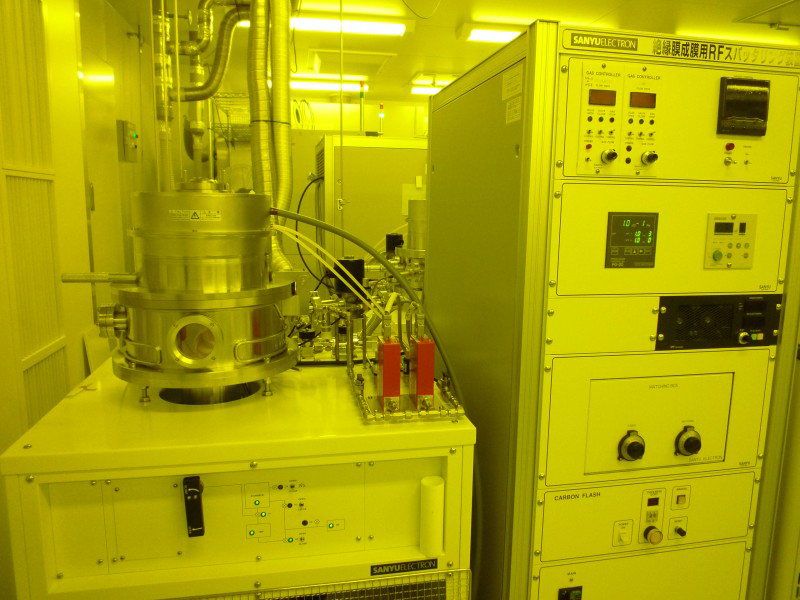
- メーカー名
- サンユー電子 (Sanyu Electron)
- 型番
- SVC-700LRF
- 仕様・特徴
- 【特徴】
SiO2, Al2O3等の絶縁体のスパッタリングによる成膜が可能
【仕様】
試料サイズ:max 4 inch
誘導結合型RFプラズマ支援スパッタ装置(ICP-RFスパッタ装置) (RF-Sputtering System with Inductively Coupled Plasma )
- 設備ID
- OS-116
- 設置機関
- 大阪大学
- 設備画像
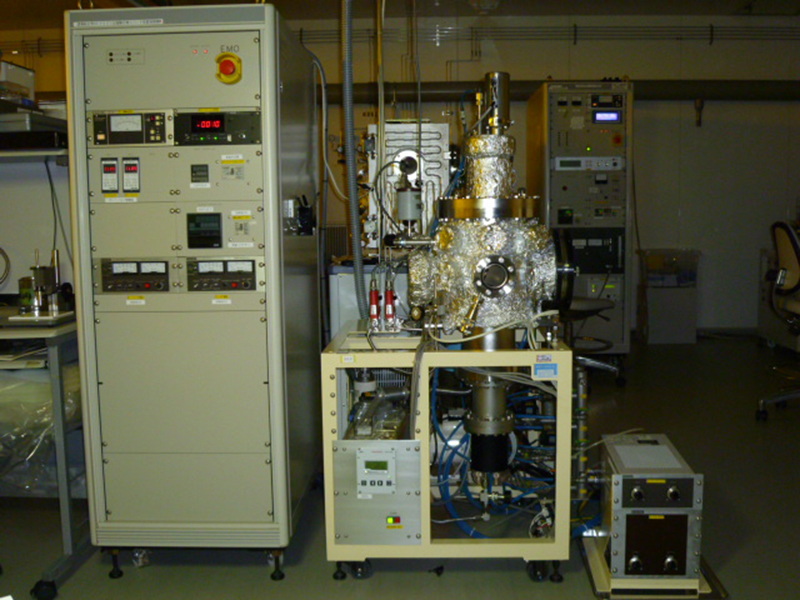
- メーカー名
- 株式会社アルバック (ULVAC, Inc.)
- 型番
- MB02-5002
- 仕様・特徴
- 【特徴】
誘導結合型RFプラズマ支援ヘリコン型スパッタ装置です。
隔膜式真空計を備えており、プロセスガス圧の高度な制御が可能です。
【仕様】
ターゲットサイズ:2inch
利用可能なターゲット:Au,Pt,Al2O3,SiO2,ITOなど(使用ごとに交換必要)
プロセスガス:Ar,O2
基板加熱温度:800℃
ターゲット基板間距離:200mm
スパッタ装置(Al用) (Sputtering system for Al, Ti, and TiN deposition)
- 設備ID
- RO-321
- 設置機関
- 広島大学
- 設備画像
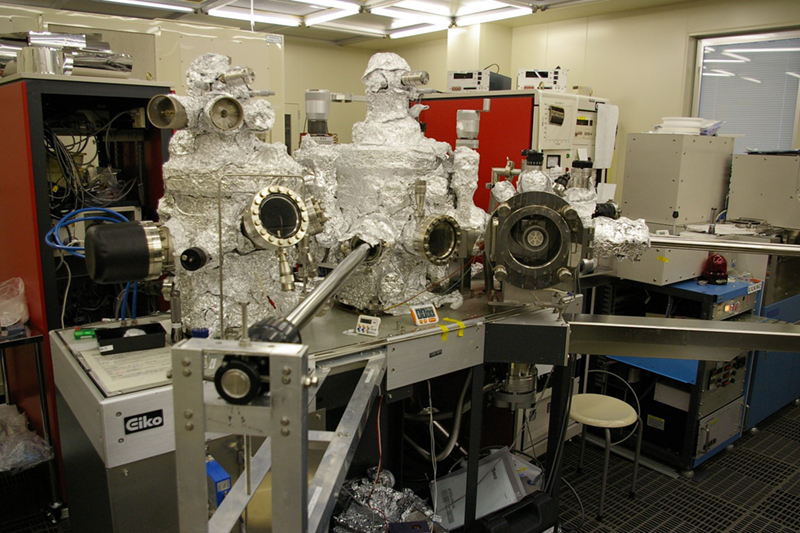
- メーカー名
- 株式会社エイコー (EIKO CORPORATION)
- 型番
- 仕様・特徴
- 対応wafer:2inch、cut wafer
超高真空仕様、Al以外にTi, TiNのスパッタが可能