共用設備検索結果
中分類から探す
スパッタ装置 (Sputtering system)
- 設備ID
- HK-704
- 設置機関
- 北海道大学
- 設備画像
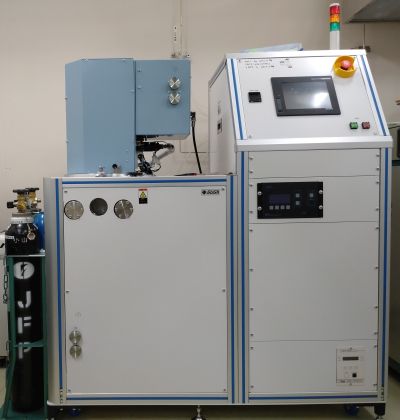
- メーカー名
- 菅製作所 (SUGA)
- 型番
- SSP3000Plus
- 仕様・特徴
- 成膜材料:1元、Au、Cr、FeNi、SiO2等
成膜温度:~300℃
最大試料料サイズ:φ 150mm
スパッタリング装置 (Sputtering System)
- 設備ID
- BA-002
- 設置機関
- 筑波大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL (i-miller)
- 仕様・特徴
- スパッタ方式:マグネトロン・サイドスパッタ RF500W (DC)
スパッタ源:3インチ×4(強磁性体材料用GUN1基含む)、逆スパッタ可
サンプルホルダ:最大φ220 mm/最小20 mm
(4インチウエハ用および不定形用ホルダあり)
加熱温度:室温~300℃
到達真空度・時間:10-5 Pa、10分以内に7 x 10-3 Pa
排気系:ロータリーポンプ、ターボ分子ポンプ、クライオトラップ
操作方式:全自動(レシピ設定可)
プロセスガス:Ar、N2、O2
スパッタ成膜装置(芝浦) (Sputtering System(Shibaura))
- 設備ID
- AT-025
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
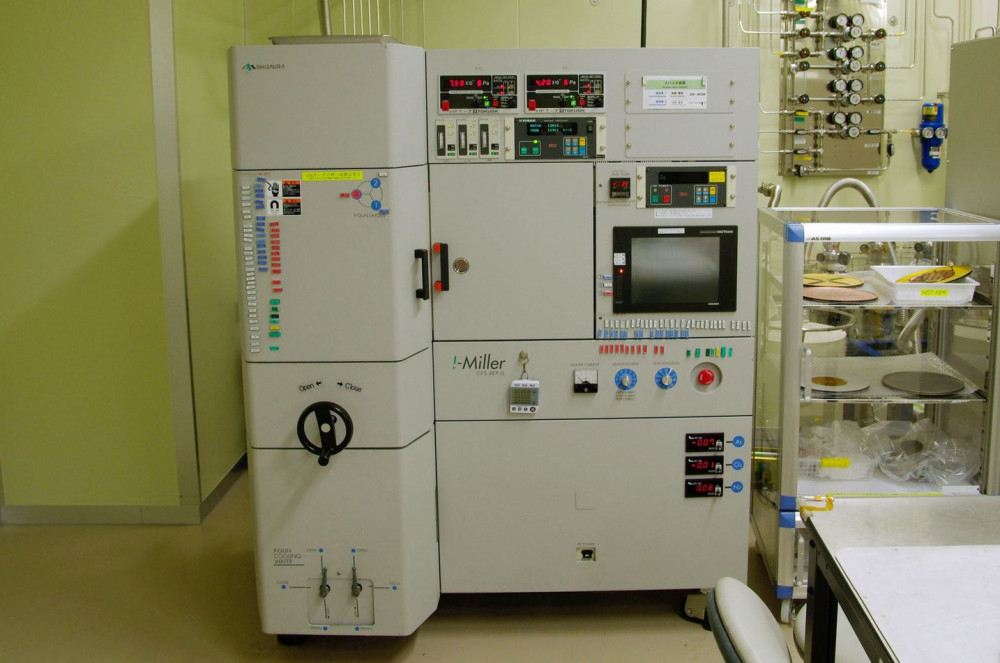
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチφ, 5mmt
・スパッタ源:3インチマグネトロン方式×3式
・高周波電源:最大出力500 W(使用最大200 W)
・RF制御:自動制御
・逆スパッタリング:200W
・試料搬送:ロードロック室付
・基板テーブル:回転機構付
・ターゲット-基板間:85 mm
・加熱温度:最大300 ℃
・膜厚分布:±5%以内@膜厚2~3 kÅ、SiO2成膜時、170 mmφ内
・到達真空度:2×10-4 Pa
・反応ガス:Ar, O2, N2
・成膜時ガス圧:0.2~1 Pa
・常備ターゲット:金属・酸化物・窒化物等、60種
RF-DCスパッタ成膜装置(芝浦) (RF-DC Sputter Deposition Equipment(Shibaura))
- 設備ID
- AT-095
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
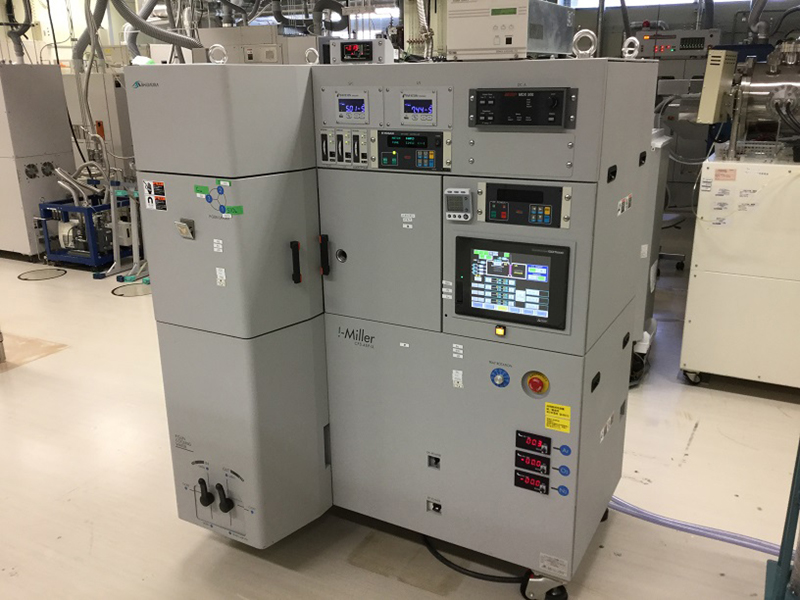
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチ
・スパッタ源:3インチマグネトロン×3式
・スパッタ方式:直流スパッタ、高周波スパッタ
・基板テーブル:回転機構付
・逆スパッタ:200W
・ターゲット-基板間距離:82 mm
・基板加熱:なし
・膜厚分布:±5%以内@膜厚~600nm(SiO2、170 mmφ)
・到達真空度:10-5 Pa台
・スパッタガス:Ar、O2、N2
・成膜時ガス圧(標準):0.5Pa
・常備ターゲット:Al, Al2O3, Au, Cr, Cu, Nb, Pt, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W
ECRスパッタ成膜・ミリング装置 (ECR sputter deposition and milling system)
- 設備ID
- AT-098
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
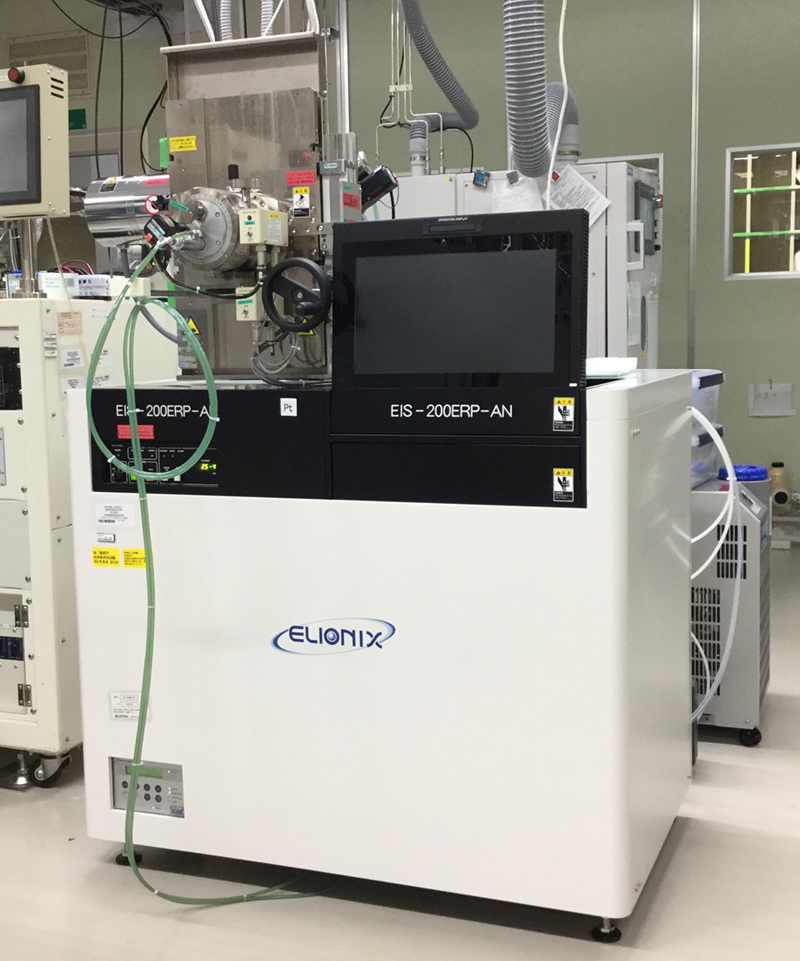
- メーカー名
- エリオニクス (ELIONIX)
- 型番
- EIS-200ERP
- 仕様・特徴
- ・型式:EIS-200ERP
・試料サイズ:75 mmφ
・イオンソース:ECR方式
・ガス種:Ar (最大流量5sccm)
・圧力:0.01 Pa
・加速電圧:30~3000 V
・マイクロ波:最大100 W
・材料ターゲットサイズ:100 mmφ
イオンビームスパッタ装置 (Ion Beam Sputter)
- 設備ID
- WS-001
- 設置機関
- 早稲田大学
- 設備画像

- メーカー名
- 伯東株式会社 (Hakuto Co., Ltd.)
- 型番
- MILLATRON 820
- 仕様・特徴
- デュアルイオンビームスパッタ装置
試料サイズ 4インチ以下
4ターゲット
基板昇温可能(約400℃)
スパッタ成膜装置(金属用) (Metal Sputtering machine)
- 設備ID
- IT-017
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702-KM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備 ・膜厚計装備 ・スパッタコントローラ装備 ・Ti, W, TiW ロードロック付き装置
スパッタ成膜装置(絶縁膜用) (Insulator Sputtering machine)
- 設備ID
- IT-018
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- ケーサイエンス (K-science Inc)
- 型番
- KS-702KAM
- 仕様・特徴
- ゲージコントローラ、CDGコントローラ装備
・膜厚計装備
・スパッタコントローラ装備
・SiN、Ta2O3、SiO2 最大2インチ程度まで
スパッタ装置(対向ターゲット式) (Facing Targets sputtering machine)
- 設備ID
- IT-028
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- エフ・ティ・エスコーポレーション (FTS corp)
- 型番
- 特注品
- 仕様・特徴
- 対向ターゲット式RFスパッタリング(2元) 最大3インチまで (ただし堆積は中央の2インチ程度)
クリーンルーム微細加工装置群 (clean room facility)
- 設備ID
- JI-017
- 設置機関
- 北陸先端科学技術大学院大学(JAIST)
- 設備画像
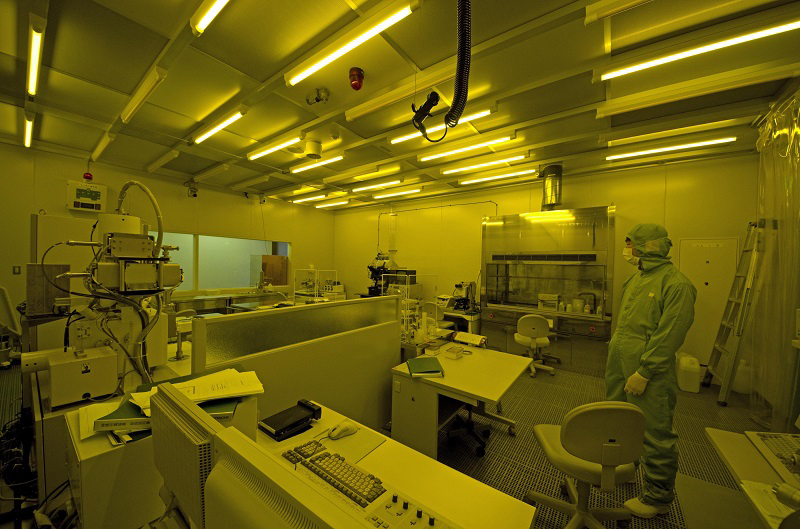
- メーカー名
- ()
- 型番
- 仕様・特徴
- EBL(30kV, 50kV)、マスクレス露光機(405nm, 375nm)、抵抗加熱蒸着、EB蒸着、RFスパッタ、ECRスパッタ、ALD、MBE、RIE、イオン注入、赤外ランプアニールなど