共用設備検索結果
中分類から探す
LL式高密度汎用スパッタリング装置(2024) (LL-type High-density General Purpose Sputtering System)
- 設備ID
- UT-716
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL !-Miller (2024)
- 仕様・特徴
- 真空引きが速く、通常10分程度でスパッタリング開始が可能。また、膜質の安定も期待できる。ターゲットはCFS-4ESと共通。 デフォルトはPt/Au/Cr/Tiを装着。それ以外のターゲットは支援員の技術補助で交換を行う。UT-711と互換。
サイドスパッタ方式、スパッタターゲット:3inchx3、ホルダーサイズ:Φ220mm、到達圧力:5x10E-4 Pa以下、RF50W(DC)、加熱温度:最大300℃
スパッタ装置 [CFS-4EP-LL #4] (Sputter [CFS-4EP-LL #4])
- 設備ID
- NM-664
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [CFS-4EP-LL #4]](data/facility_item/1711340420_11.jpg)
- メーカー名
- 芝浦メカトロニクス株式会社 (SHIBAURA MECHATRONICS CORPORATION)
- 型番
- CFS-4EP-LL
- 仕様・特徴
- ・電源:DC×2、RF×1
・電源出力:500W(最大)
・カソード:φ3インチ×4式
・基板サイズ:最大8inchφ
・プロセスガス:Ar、O2、N2
・基板加熱:設定300℃
・逆スパッタ可
スパッタ装置 [CFS-4EP-LL #3] (Sputter [CFS-4EP-LL #3])
- 設備ID
- NM-607
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [CFS-4EP-LL #3]](data/facility_item/NM-607.jpg)
- メーカー名
- 芝浦メカトロニクス (SHIBAURA MECHATRONICS)
- 型番
- CFS-4EP-LL (i-Miller)
- 仕様・特徴
- ・用途:金属・絶縁薄膜形成
・スパッタ方式:DC/RFマグネトロンスパッタ,反応性/2元同時/逆スパッタ/バイアススパッタ可能
・電源出力:Max 500W
・カソード:φ3インチ×4式
・プロセスガス:Ar,O2,N2
・最大試料サイズ:φ8inch(水冷ステージ)
・現有ターゲット:Ti, Au, Al, Si, Cu, W, Ta, Ag, Ni, Cr, ITO, ZnO, SiO2(2020年4月時点)
スパッタ装置 [JSP-8000] (Sputter [JSP-8000])
- 設備ID
- NM-608
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![スパッタ装置 [JSP-8000]](data/facility_item/NM-608.jpg)
- メーカー名
- アルバック (ULVAC)
- 型番
- j-Sputter
- 仕様・特徴
- ・用途:金属・絶縁薄膜形成
・スパッタ方式:DC/RFマグネトロンスパッタ,反応性/3元同時/逆スパッタ可能
・電源出力:Max 500W
・カソード:φ4インチ×4式
・プロセスガス:Ar,O2,N2
・最大試料サイズ:φ6inch
・その他:試料ステージ水冷/加熱可 (最大300度)
・現有ターゲット:Al, Ag, Au, Al2O3, Cr, Cu, ITO, Mo, Ni, Pt, Si, Si3N4, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W, Zn, ZnO
芝浦スパッタ装置(加熱型) (Shibaura sputtering (Heating))
- 設備ID
- TU-158
- 設置機関
- 東北大学
- 設備画像
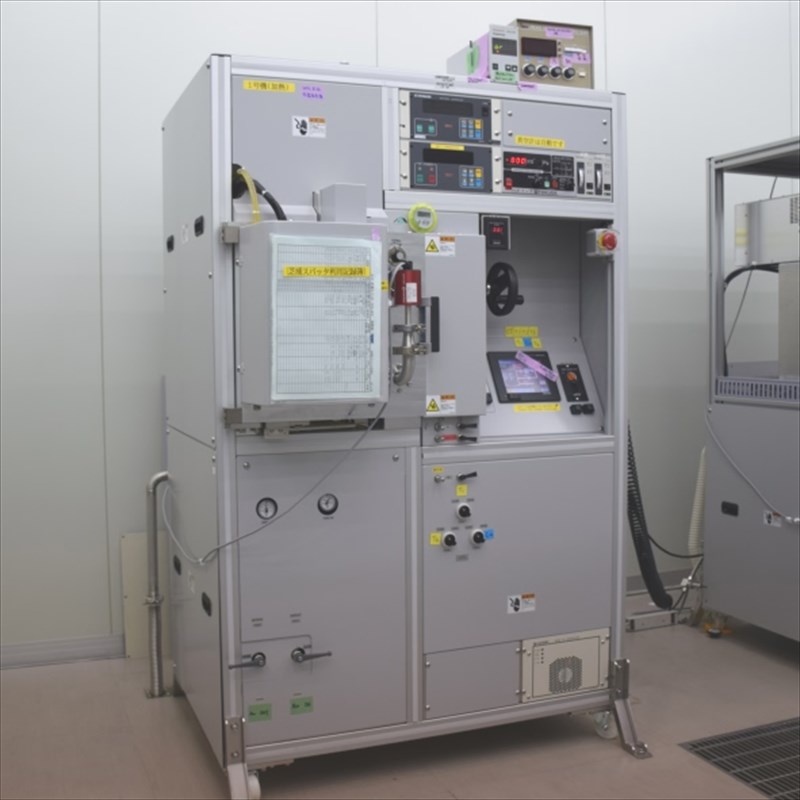
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- CFS-4ESII
- 仕様・特徴
- サンプルサイズ:小片~6インチ
サンプルステージ:直径200mm
基板温度:室温~300℃
電源:RF×1
ターゲット:3インチ×3
方式:スパッタSIDE
到達真空度:3E-4Pa
芝浦スパッタ装置(冷却型) (Shibaura sputtering (Cooling))
- 設備ID
- TU-159
- 設置機関
- 東北大学
- 設備画像
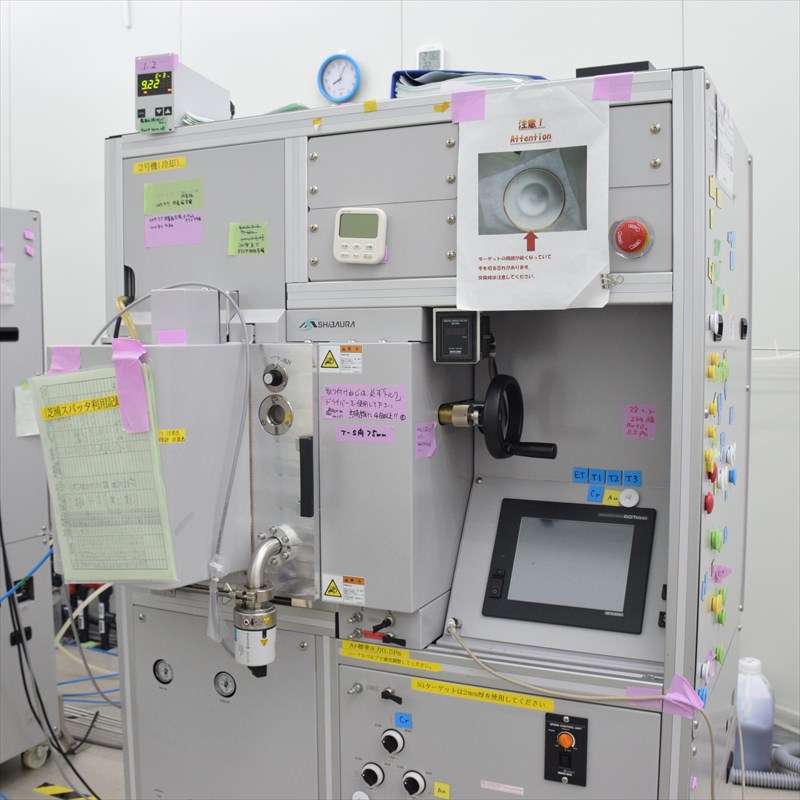
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- CFS-4ESII
- 仕様・特徴
- サンプルサイズ:小片~6インチ
サンプルステージ:直径200mm
基板温度:約20℃
電源:RF×1
ターゲット:3インチ×3
方式:スパッタSIDE
到達真空度:3E-4Pa
自動搬送 芝浦スパッタ装置(加熱型) (Automatic Shibaura sputtering (Heating))
- 設備ID
- TU-160
- 設置機関
- 東北大学
- 設備画像
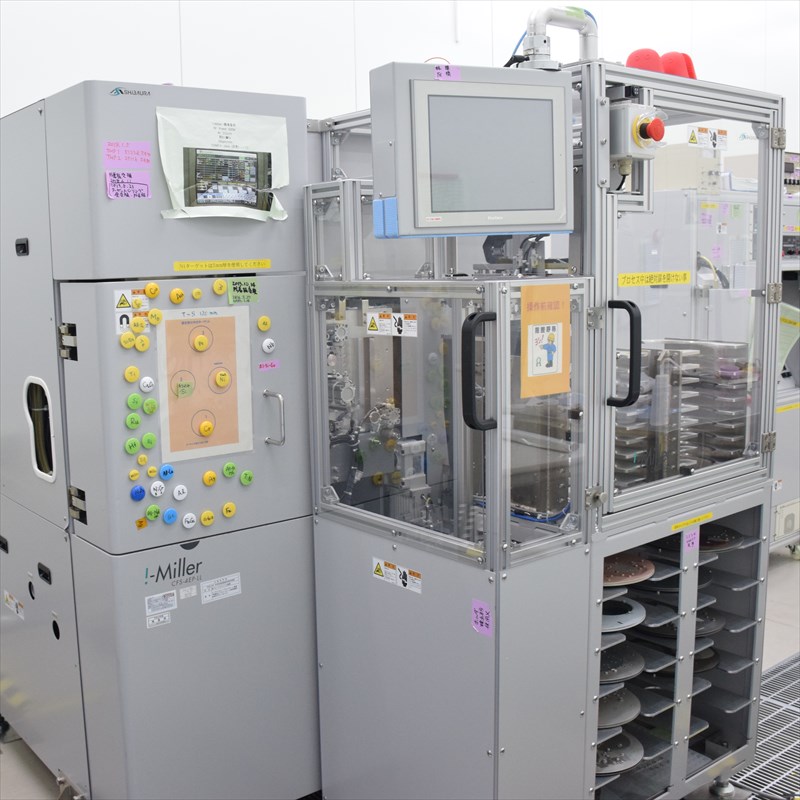
- メーカー名
- 芝浦メカトロニクス (Shibaura Mechatronics)
- 型番
- !-Miller CFS-4EP-LL
- 仕様・特徴
- サンプルサイズ:小片~8インチ
サンプルステージ:直径220mm
基板温度:室温~300℃
電源:RF×1
ターゲット:3インチ×4
方式:スパッタSIDE
到達真空度:8E-5Pa
ECRロングスロースパッタ (ECR long-throw sputter)
- 設備ID
- TU-162
- 設置機関
- 東北大学
- 設備画像
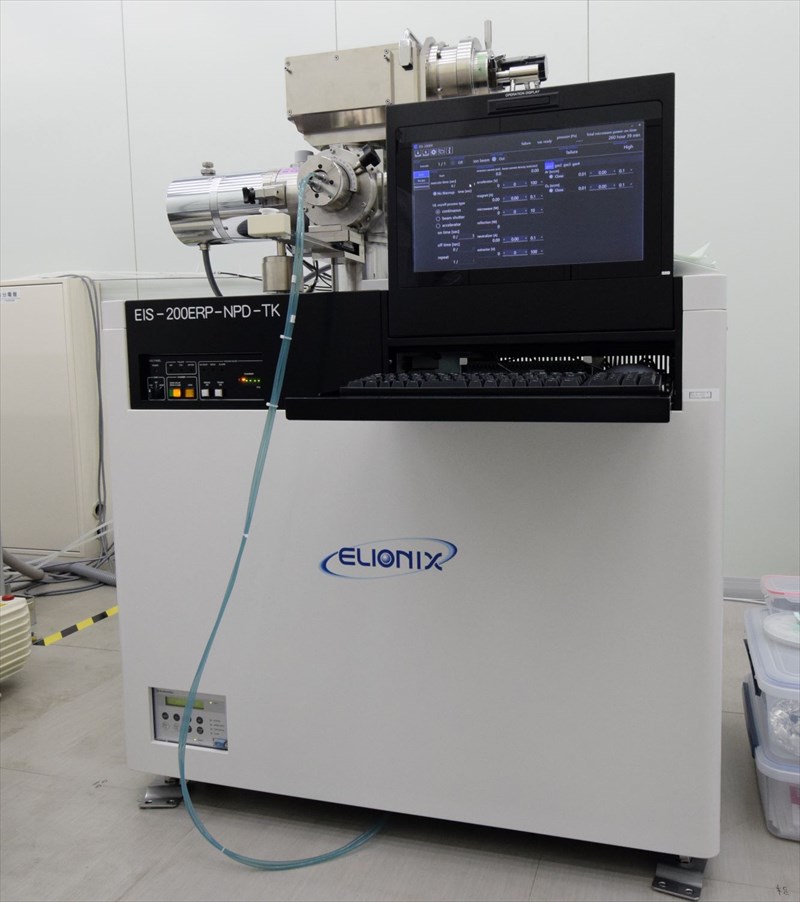
- メーカー名
- エリオニクス (Elionix)
- 型番
- EIS-200ERP-NPD-TK
- 仕様・特徴
- サンプルサイズ:小片~6インチ
基板温度:20℃
ターゲット:4インチ× 2
ターゲット‐ステージ間距離 :350mm
到達真空度:3E-4Pa
エッチング可
アネルバマルチスパッタ (Anelva multi-sputtering)
- 設備ID
- TU-163
- 設置機関
- 東北大学
- 設備画像
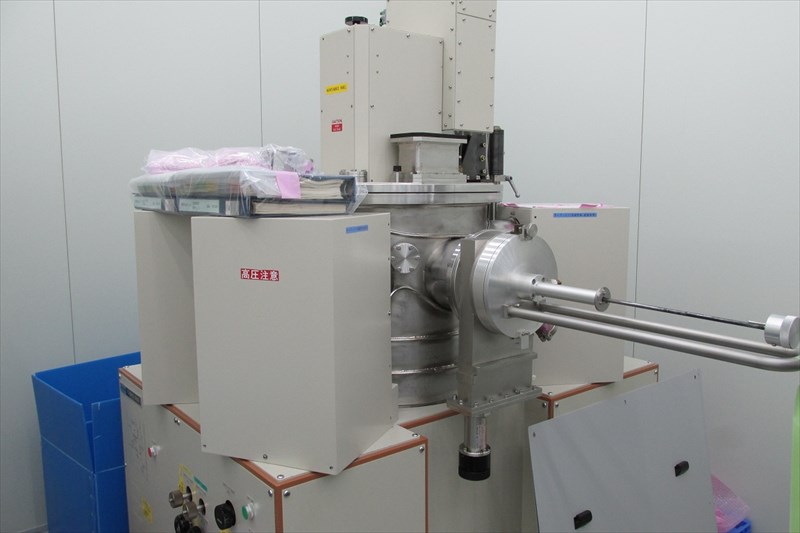
- メーカー名
- アネルバ (Anelva)
- 型番
- SPC-350
- 仕様・特徴
- サンプルサイズ、同時処理枚数:4インチ×6枚
基板温度:室温~650℃
電源:DC×2、RF×1(同時放電可能)
ターゲット:6インチ×3(強磁性体対応)
酸素加圧RTA付高温スパッタ装置 (High-temp. sputtering and O2 annealing)
- 設備ID
- TU-164
- 設置機関
- 東北大学
- 設備画像

- メーカー名
- ユーテック (Youtec)
- 型番
- 21-0604
- 仕様・特徴
- サンプルサイズ:小片~8インチ
3チャンバ構成:金属用(DC)スパッタチャンバ、酸化物用(RF)スパッタチャンバ、酸素加圧アニールチャンバ
基板温度:最高700℃(ランプ加熱方式)