共用設備検索結果
中分類から探す
原子層堆積装置_4〔FlexAL〕 (Atomic Layer Deposition_4〔FlexAL〕)
- 設備ID
- AT-104
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
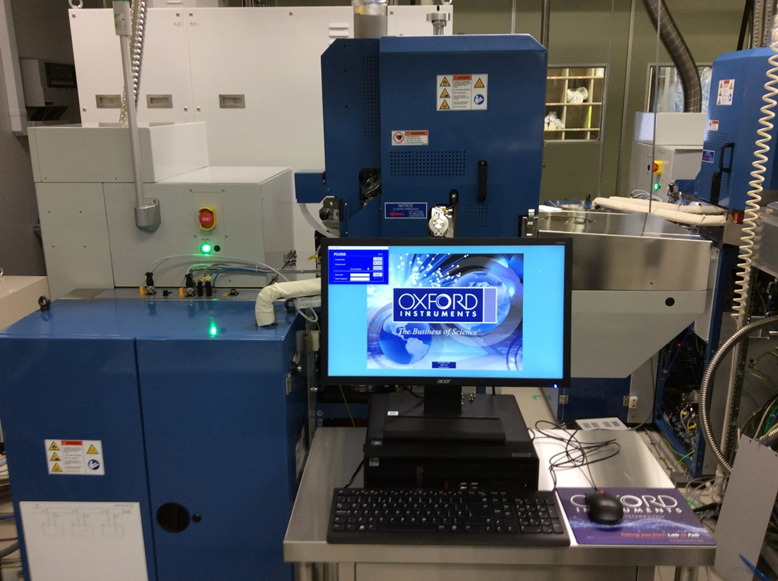
- メーカー名
- オックスフォードインスツルメント (Oxford Instruments Plasma)
- 型番
- FlexAL
- 仕様・特徴
- ・型式:FlexAL
・試料サイズ:4インチφ
・基板温度:100-550℃
・プラズマALD:600W(誘導結合型)
・基板バイアス:100W
・反応ガス:H2O,O2,N2,H2,D2, NH3, ND3
・材料ポート:3ポート
・キャリアガス:Ar
・膜厚計測用 in-situ 分光エリプソ
原子層堆積装置 (Atomic Layer Deposition Systems)
- 設備ID
- WS-004
- 設置機関
- 早稲田大学
- 設備画像
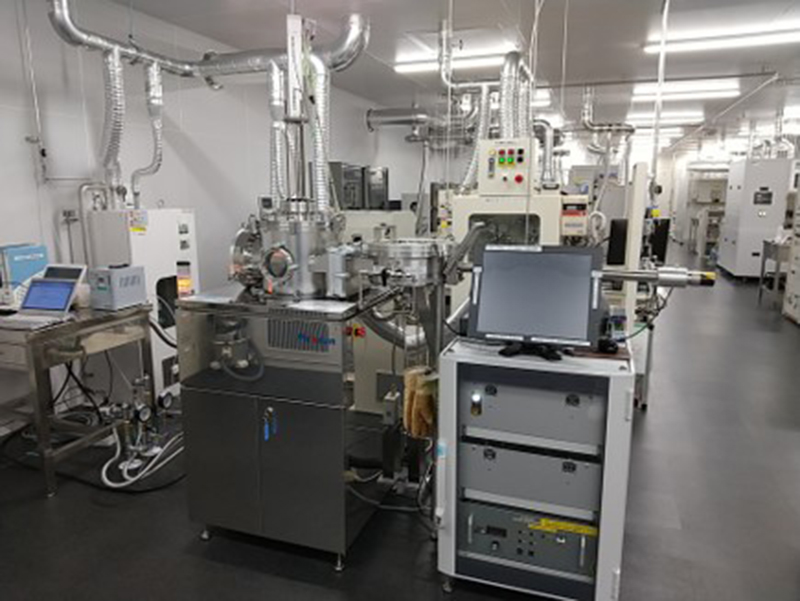
- メーカー名
- PICOSUN JAPAN株式会社 (Picosun Japan Co. Ltd.)
- 型番
- SUNALE R-150
- 仕様・特徴
- Al2O3膜を原子一層レベルで成膜可能
H2O及びO3使用可
基板サイズ小片~4インチ
4”, 6”ウエハ, 及び20×20mm試料対応
基板材料は原則としてダイヤモンドまたはSi
原子層堆積装置 (Atomic layer deposition)
- 設備ID
- IT-011
- 設置機関
- 東京工業大学
- 設備画像

- メーカー名
- Ultratech/CamnbridgeNanotech (Ultratech/CamnbridgeNanotech)
- 型番
- FijiF20
- 仕様・特徴
- ロードロック機構付
プラズマ式/サーマル式の両方のモードでの原子層堆積が可能。化合物半導体等のMIS構造での低界面準位密度などに実績あり。(成膜温度で揮発し、装置を汚染する可能性のある材料は禁止) 酸素源:オゾンおよび水の両方の利用が可能
原子層堆積装置 (Atomic layer deposition:ALD)
- 設備ID
- TT-003
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- Ultratech/Cambridge Nano Tech (Ultratech/Cambridge Nano Tech)
- 型番
- Fiji F200
- 仕様・特徴
- 成膜する試料は、基板表面に蒸気圧の高い物質が露出していないことが条件。
半導体デバイスのパッシベーションに用いており、汚染を防ぐためであり、ご理解をお願いします。
原子層堆積装置 (Atomic Layer Deposition)
- 設備ID
- KT-238
- 設置機関
- 京都大学
- 設備画像
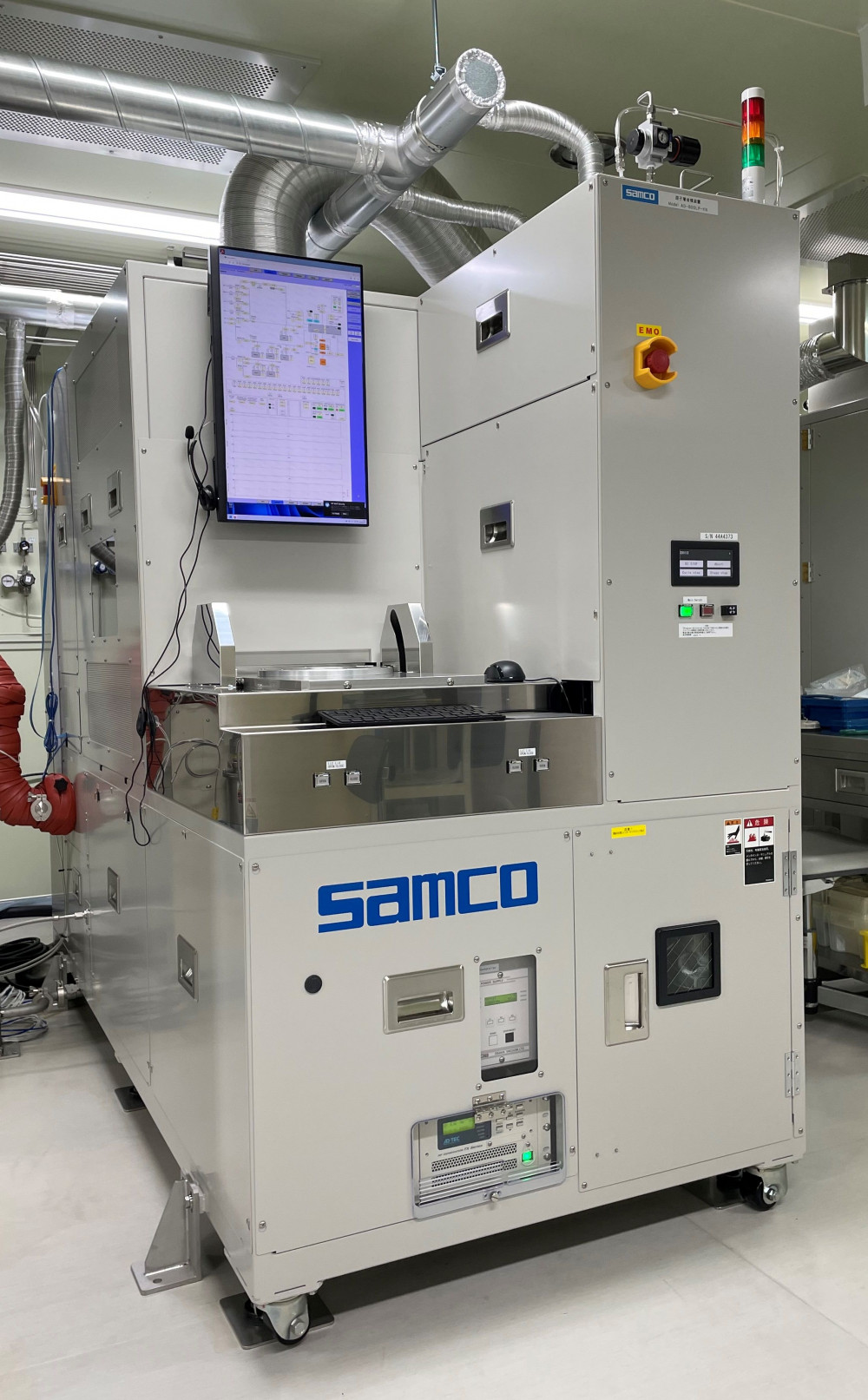
- メーカー名
- サムコ(株) (Samco Inc.)
- 型番
- AD-800LP-KN
- 仕様・特徴
- ナノレベルかつコンフォーマルの薄膜を形成するためのALD装置。ゲート酸化膜、バリア膜、透過防止膜などへの利用が可能。
・成膜方式:サーマル/プラズマ
・基板サイズ:小片~Φ8"
・材料ガス:BDEAS(Si系)、TMA(Al系)、TDMAT(Ti系) ほか(要相談)
・反応ガス:H2O、O2、O3、N2、NH3、H2
・キャリアガス:Ar、N2
原子層堆積装置 [SUNALE R-150] (ALD [SUNALE R-150])
- 設備ID
- NM-644
- 設置機関
- 物質・材料研究機構 (NIMS)
- 設備画像
![原子層堆積装置 [SUNALE R-150]](data/facility_item/1687416682_11.jpg)
- メーカー名
- PICOSUN JAPAN株式会社 (Picosun Oy)
- 型番
- SUNALE R-150
- 仕様・特徴
- ・成膜方式:サーマルまたはプラズマALD
・原料ソース:3源
・基板サイズ:最大6inchφ
・基板温度:室温~300℃