共用設備検索結果
中分類から探す
エリプソメーター (Ellipsometer)
- 設備ID
- TT-016
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- ガ-トナ- (Gartner Sci. Corp.)
- 型番
- LSE
- 仕様・特徴
- ・シリコン酸化膜あるいはSiN膜等の単層あるいは2層膜の膜厚測定
・φ6インチ以下基板
表面形状測定器(段差計) (Stylus profiler)
- 設備ID
- TT-017
- 設置機関
- 豊田工業大学
- 設備画像

- メーカー名
- KLAテンコール (KLA-Tencor)
- 型番
- アルファーステップ IQZ
- 仕様・特徴
- 触針段差計、材料は不問
φ4インチ程度
針先端が形状を沿って動けることが条件
ナノ粒子解析装置(ゼーターサイザー) (Zetasizer)
- 設備ID
- OS-123
- 設置機関
- 大阪大学
- 設備画像

- メーカー名
- シスメックス株式会社(マルバーン) (SYSMEX CORPORATION (Malvern))
- 型番
- NANO-ZS
- 仕様・特徴
- 【特徴】
動的散乱光法により溶液中に分散された粒子の粒子径や、ゼータ電位測定が可能な装置です。
低濃度または高濃度サンプルにも対応可能です。
(濃度0.1ppm~40%/Wでの測定が可能)
【仕様】
必要試料量:70μL
粒子径測定:0.6nm~6μm(動的光散乱法)
ゼータ電位測定:3nm~10μm
接触式膜厚測定器 (Stylus Profiler)
- 設備ID
- OS-126
- 設置機関
- 大阪大学
- 設備画像
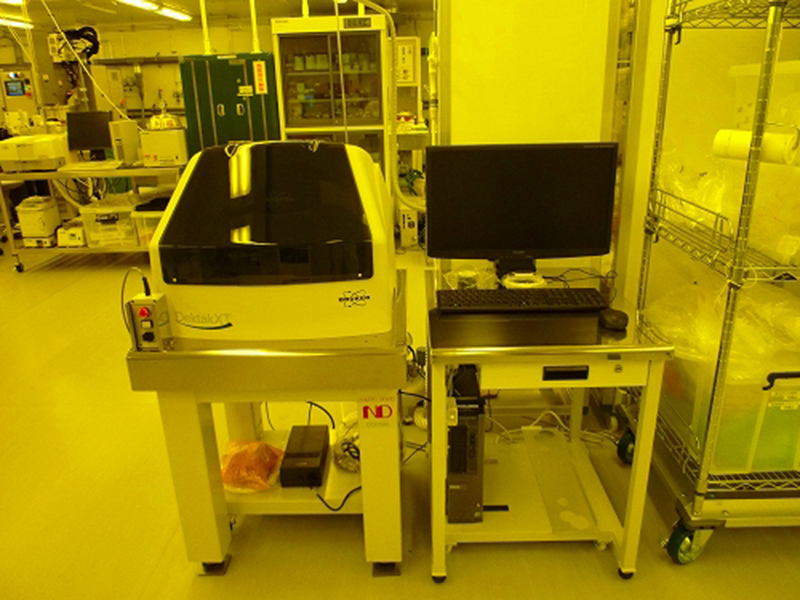
- メーカー名
- ブルカージャパン株式会社 (Bruker Japan K.K.)
- 型番
- DektakXT
- 仕様・特徴
- 【特徴】
10nm以下の段差を測定できる触針式の膜厚測定器です。
3D機能を備えたプロファイリングシステムを搭載しており、3Dマッピングが可能です。
【仕様】
試料ステージ:150mmφ
分解能:0.4nm
垂直測定レンジ:1 mm
膜厚測定再現性(1σ):5Å
走査距離上限:55mm
触針圧:1mg~15mg
ダイナミック光散乱光度計 (Dynamic Laser Scattering Spectrometer)
- 設備ID
- NR-303
- 設置機関
- 奈良先端科学技術大学院大学 (NAIST)
- 設備画像

- メーカー名
- 大塚電子 (Otsuka Electoronics)
- 型番
- DLS-6000
- 仕様・特徴
- ・角度可変
分光エリプソメーター (Spectroscopic Ellipsometer)
- 設備ID
- NR-702
- 設置機関
- 奈良先端科学技術大学院大学 (NAIST)
- 設備画像
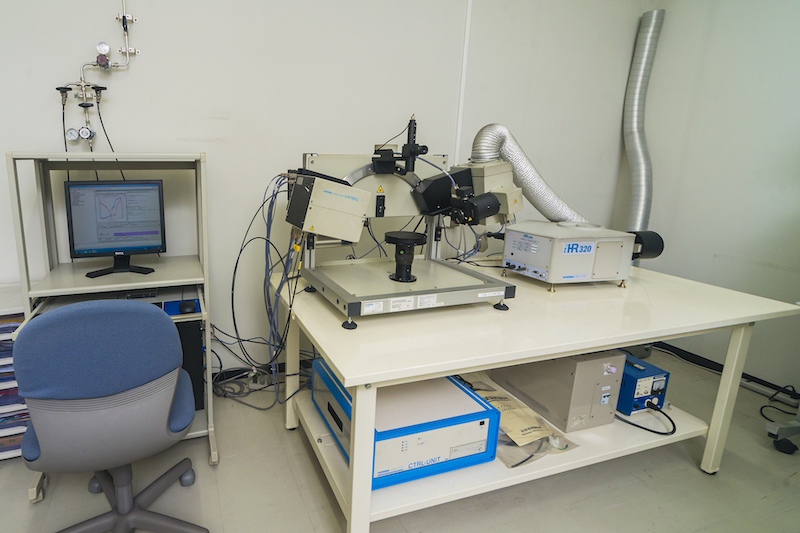
- メーカー名
- 堀場ージョバンイボン (HORIBA JOBIN YVON)
- 型番
- UVISEL ER AGMS-NSD
- 仕様・特徴
- ・波長範囲: 0.6 eV 〜 6.0 eV(206 nm 〜2066 nm )
・スポット径: 約 5 mm * 2 mm
微細形状測定装置 (Microfigure Measurering Instrument)
- 設備ID
- NR-703
- 設置機関
- 奈良先端科学技術大学院大学 (NAIST)
- 設備画像

- メーカー名
- 小坂製作所 (Kosaka)
- 型番
- ET200
- 仕様・特徴
- ・再現性 0.3nm以内
・分解能 Z:0.1nm X:0.1μm
分光エリプソメーター (Spectroscopic ellipsometer)
- 設備ID
- RO-531
- 設置機関
- 広島大学
- 設備画像
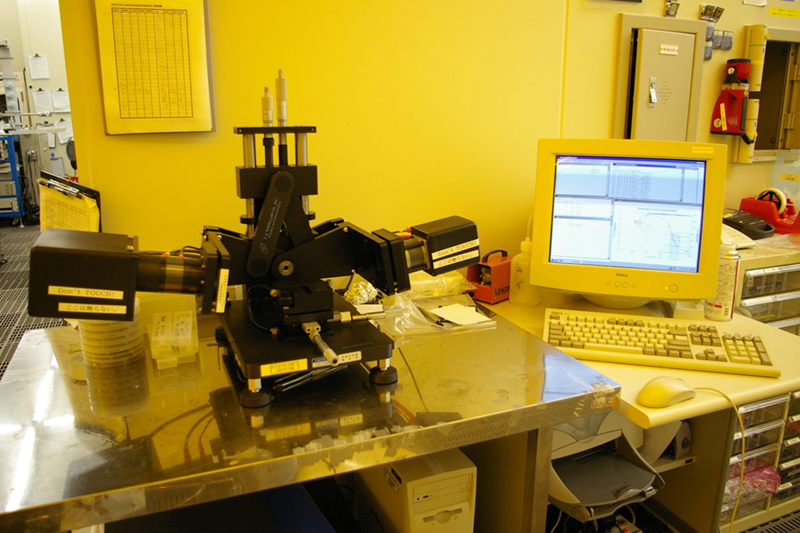
- メーカー名
- J.A. Woollam Japan (J.A. Woollam Japan)
- 型番
- M2000-D
- 仕様・特徴
- 測定可能最小膜厚10nm,分光波長範囲193~1000nm、
干渉式膜厚計 (Spectroscopic reflectometer)
- 設備ID
- RO-532
- 設置機関
- 広島大学
- 設備画像
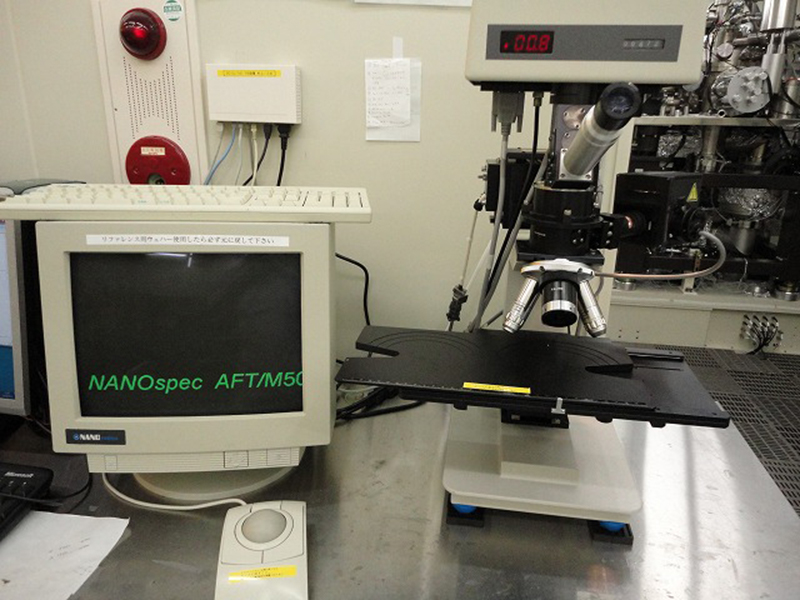
- メーカー名
- ナノメトリクスジャパン (Nanometrics Inc)
- 型番
- AFT 5000
- 仕様・特徴
- 可視光及び紫外光光源、多層膜対応解析ソフト搭載。
表面段差計 (Profilometer)
- 設備ID
- RO-534
- 設置機関
- 広島大学
- 設備画像
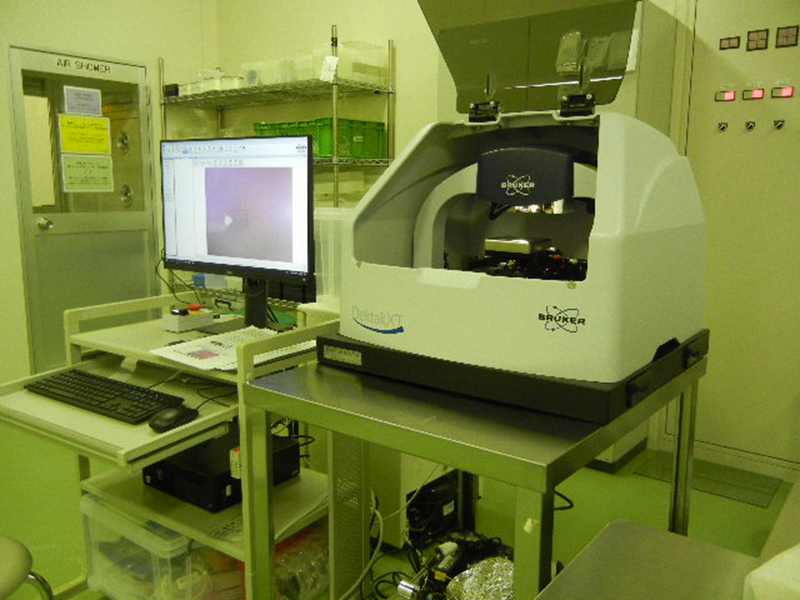
- メーカー名
- BRUKER (BRUKER)
- 型番
- Dektak XT-E
- 仕様・特徴
- 対応wafer:4inch以下
垂直範囲:10nm~1mm、
垂直解像度:最高0.1nm